一、晶圆级封装(Wafer Level Packaging)简介
晶圆级封装(WLP,Wafer Level Package) 的一般定义为直接在晶圆上进行大多数或是全部的封装测试程序,之后再进行切割(singulation)制成单颗组件。而重新分配(redistribution)与凸块(bumping)技术为其I/O绕线的一般选择。WLP封装具有较小封装尺寸(CSP)与较佳电性表现的优势,目前多用于低脚数消费性IC的封装应用(轻薄短小)。
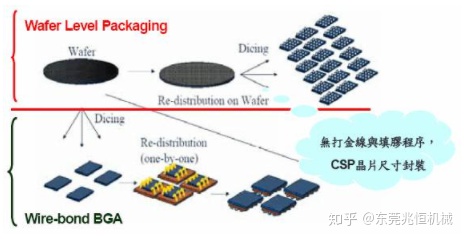
常见的WLP封装绕线方式如下:1. Redistribution (Thin film), 2. Encapsulated Glass substrate, 3. Gold stud/Copper post, 4. Flex Tape等。此外,传统的WLP封装多采用Fan-in 型态,但是伴随IC信号输出pin数目增加,对ball pitch的要求趋于严格,加上部分组件对于封装后尺寸以及信号输出脚位位置的调整需求,因此变化衍生出Fan-out 与Fan-in + Fan-out 等各式新型WLP封装型态,其制程概念甚至跳脱传统WLP封装,目前德商英飞凌与台商育霈均已经发展相关技术。
二、WLP的主要应用领域
整体而言,WLP的主要应用范围为Analog IC(累比IC)、PA/RF(手机放大器与前端模块)与CIS(CMOS Image Sensor)等各式半导体产品,其需求主要来自于可携式产品(iPod, iPhone)对轻薄短小的特性需求,而部分NOR Flash/SRAM也采用WLP封装。此外,基于电气性能考虑,DDR III考虑采用WLP或FC封装,惟目前JEDEC仍未制定最终规格(注:至目前为止, Hynix, Samsung与 Elpida已发表DDR III产品仍采FBGA封装),至于SiP应用则属于长期发展目标。此外,采用塑料封装型态(如PBGA)因其molding compound 会对MEMS组件的可动部份与光学传感器(optical sensors)造成损害,因此MEMS组件也多采用WLP封装。而随着Nintendo Wii与APPLE iPhone与iPod Touch等新兴消费电子产品采用加速传感器与陀螺仪等MEMS组件的加温,成为WLP封装的成长动能来源。
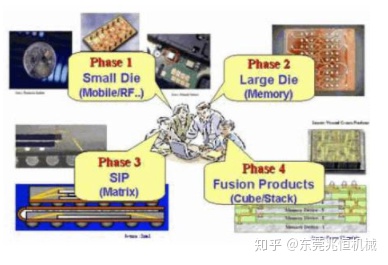




















 1万+
1万+











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








