导读
晶圆缺陷检测直接影响芯片的良率与成本。友思特高功率紫外UVLED方案通过多波长切换、高灵敏度成像,精准捕捉灰尘、遗留胶及内部划痕等缺陷,检测精度与效率显著提升,助力产业迈向更高精度与效率。
晶圆检测
在半导体芯片制造流程里,从硅片制备到芯片封装,涉及数十道复杂工序,任何细微环节的偏差都可能使晶圆产生缺陷,进而严重影响产品良率。据行业数据显示,光刻后工序中,一个微小缺陷就可能致使芯片报废,造成高达数千美元的损失。在光刻前对裸晶圆表面进行缺陷检测,成为提升芯片质量、降低成本的关键环节。
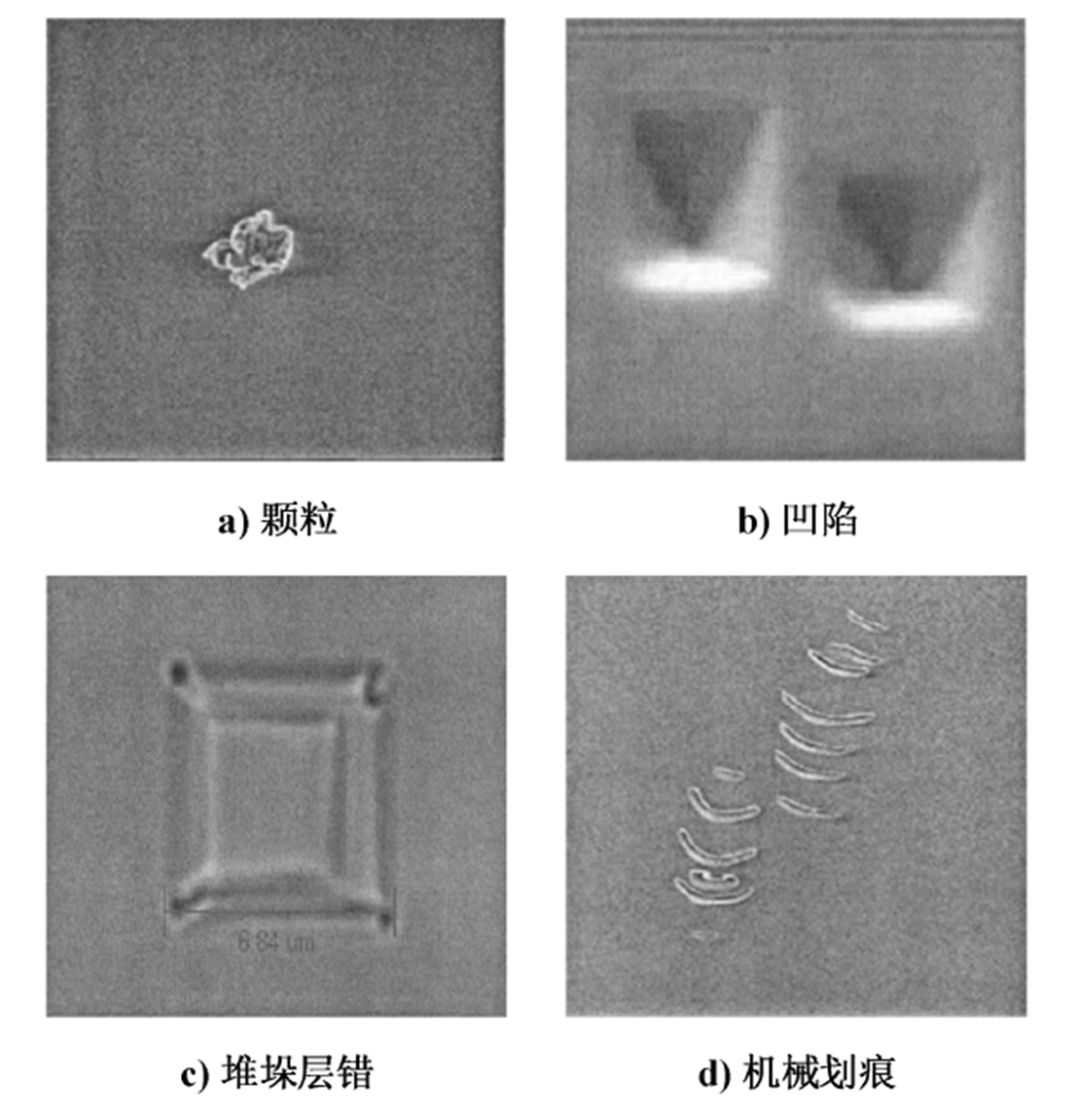
图1. 晶圆缺陷类型
当前,晶圆缺陷检测方法多样,接触式检测因易划伤晶圆已逐渐被弃用。非接触式检测中,X射线检测虽精度高,但设备昂贵、辐射大;超声波检测存在结果不直观、定量分析难的问题;电子束检测设备成本高昂,且检测效率有待提升。光学检测因操作简便、成本适中成为主流,其中基于白光光源的检测技术应用广泛,可检测常见的颗粒、灰尘等缺陷。然而,对于SiC基底小丘缺陷等特殊缺陷,白光光源检测效果不佳。
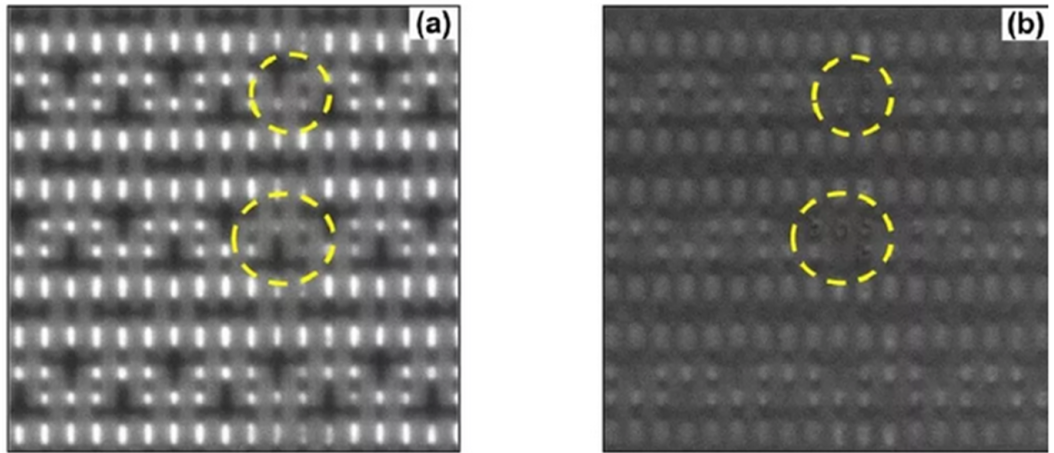
图2. 晶圆缺陷检测图例
高功率紫外UVLED光源的出现为解决这一难题带来新契机。它能激发特定缺陷产生独特光学信号,增强缺陷与背景对比度





 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章


















 548
548

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








