众所周知,目前 5nm 及以下的尖端半导体制程必须要用到价格极其高昂的 EUV 光刻机,ASML 是全球唯一的供应商。
更为尖端 2nm 制程的则需要用到 ASML 新一代 0.55 NA EUV 光刻机,售价或高达 4 亿美元。
Intel 正计划利用新一代 0.55 NA EUV 光刻机来开发其 Intel 20A(2nm)及 18A(1.8nm)制程。
但是,要想实现 1nm 以下的更先进的制程,即便是 ASML 新一代 0.55 NA EUV 光刻机也束手无策。
近日美国一家旨在开发和商业化原子精密制造 ( APM ) 技术的公司 Zyvex Labs 宣布推出了全球分辨率最高的亚纳米分辨率光刻系统 "ZyvexLitho1"。
它并没有采用 EUV 光刻技术,而是基于 STM 扫描隧道显微镜,使用的是电子束光刻(EBL)方式,可以制造出具有 0.768nm 线宽(相当于 2 个硅原子的宽度)的芯片,精度远超 EUV 光刻机。
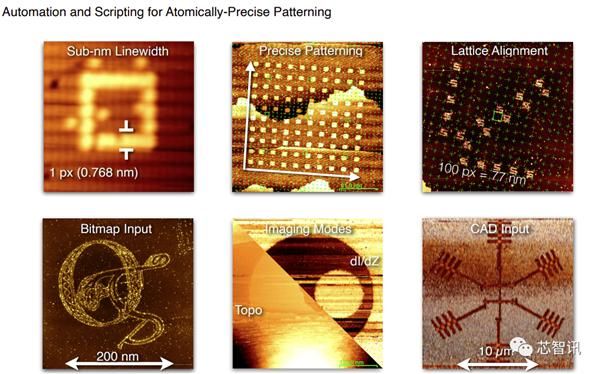 一、实现更高的分辨率和精度的关键:氢去钝化光刻
一、实现更高的分辨率和精度的关键:氢去钝化光刻
ZyvexLitho1 所采用自我显影的电子束光刻 ( EBL ) 技术的核心是使用氢去钝化光刻 ( HDL ) 从 Si ( 100 ) 2 x 1 二聚体列(dimer row)重建表面去除氢(H)原子。
氢去钝化光刻是 EBL 的一种形式,它通过非常简单的仪器实现原子分辨率,并使用能量非常低的电子。
它使用量子物理学有效地聚焦低能电子和振动加热方法,以产生高度非线性(多电子)的曝光机制。HDL 使用附着在硅表面的单层 H 原子作为非常薄的抗蚀剂层,并使用电子刺激解吸在抗蚀剂中创建图案。
传统 EBL 使用大型昂贵的电子光学系统和非常高的能量 ( 200Kev ) 来实现小光斑尺寸;但是高能电子(获得小光斑尺寸所必需的)分散在传统 EBL 使用的聚合物抗蚀剂中,并分散沉积的能量,从而形成更大的结构。HDL 实现了比传统 EBL 更高的分辨率和精度。
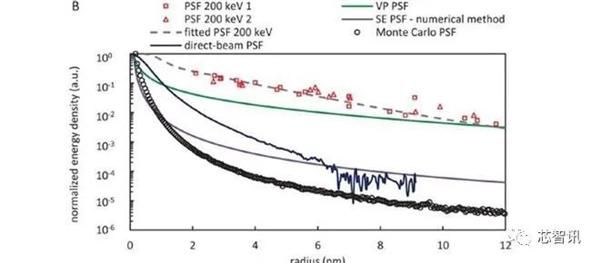 数据显示,光刻胶中的沉积能量不会下降到光束中心的 10%,直到径向距离约为 4nm。
数据显示,光刻胶中的沉积能量不会下降到光束中心的 10%,直到径向距离约为 4nm。
使用 HDL,实验团队能够暴露比 EBL 的 10% 阈值半径小>10 倍的单个原子。
这个小得多的曝光区域令人惊讶,因为 HDL 不使用光学器件,只是将钨金属尖端放置在 H 钝化硅样品上方约 1nm 处。
人们会期望,如果没有光学器件来聚焦来自尖端的电子ÿ








 Zyvex Labs利用STM技术开发出亚纳米分辨率光刻系统ZyvexLitho1,实现了0.768nm线宽的光刻,超过EUV光刻机的精度。该系统基于氢去钝化光刻,通过电子束光刻(EBL)而非EUV,可用于制造高精度量子器件和纳米材料。ZyvexLitho1具备无失真成像、自动晶格对准等功能,已接受订单,6个月后交货。
Zyvex Labs利用STM技术开发出亚纳米分辨率光刻系统ZyvexLitho1,实现了0.768nm线宽的光刻,超过EUV光刻机的精度。该系统基于氢去钝化光刻,通过电子束光刻(EBL)而非EUV,可用于制造高精度量子器件和纳米材料。ZyvexLitho1具备无失真成像、自动晶格对准等功能,已接受订单,6个月后交货。
 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章


















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








