目录
功率二极管-PN结介绍
PN结原理介绍
本征半导体
定义
本征半导体是一种纯净且结构完整的单晶体半导体材料,如硅或锗,其导电性完全由材料本身的热激发或光激发产生电子 - 空穴对决定。这类半导体不含任何杂质原子
特点
在绝对零度时,本征半导体的价带被电子填满,导带为空,无法导电。当温度升高或受光照时,价带中的电子获得足够能量跃迁至导带,形成自由电子,同时在价带中留下带正电的空穴。这两种载流子(电子和空穴)在外电场作用下分别向相反方向运动,共同参与导电。由于电子与空穴总是成对产生且浓度相等,这一特性被称为 “本征激发”,其动态平衡状态下的载流子浓度随温度呈指数增长。
“本征” 一词源于其导电机制完全依赖材料自身的内在特性,而非外部掺杂。这种纯净性使得本征半导体的电导率较低且对温度敏感,因此在工程应用中受限,主要用于理论研究或特殊场景(如高温传感器)。与之相对的杂质半导体通过掺杂特定元素显著增强导电性,成为现代电子器件的核心材料。
P掺杂
掺杂价电子为5的磷; 有一个电子可在其中自由移动。
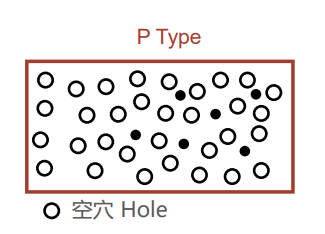
P型半导体有很多空穴,仅有少量的自由电子;
空穴为N区多数载流子(多子),自由电子为少数载流子(少子);
N掺杂
掺杂价电子为3的铝;有一个可放置电子的空穴;

相邻电子可随时填上,电子运动即空穴相对运动;
N型半导体有很多自由电子,仅有少量的空穴; 自由电子为N区多数载流子(多子),空穴为少数载流子(少子);
PN结
定义
将P型半导体和N型半导体相连

N区自由电子浓度高向P区扩散,邻近PN结的N型中的自由电子与P型中的 空穴结合(扩散运动)
中间一部分区域缺少自由电子和空穴。这一部分被称为耗尽区(或空间电 荷区space charge)
势垒区
正负离子使得P-N结中形成了一个空间电荷区,也是静电场的势垒区。

势垒区内静电场的形成
N型材料本体呈电中性(自由电子和 正供体离子'positive donor ions'数目相等)
P型材料本体呈电中性(空穴和负受 体离子'negative acceptor ions'数目相等)
在 PN 结形成初期,N 型半导体中的自由电子(多数载流子)因浓度差向 P 区扩散,导致 N 区靠近交界处的区域失去电子,暴露出不可移动的掺杂施主正离子(例如磷原子核的正电荷)。这些正离子被固定在晶格结构中,无法自由移动。
N 区原本的多数自由电子已通过扩散迁移至 P 区,而剩余的正离子周围缺乏足够的自由电子进行中和。此时,空间电荷区内的正离子形成内建电场,方向由 N 区指向 P 区。
势垒区内静电场的动态平衡
内建电场会阻碍多数载流子的进一步扩散,同时促使少数载流子(如 N 区的空穴和 P 区的电子)发生漂移运动。当扩散电流与漂移电流达到动态平衡时,空间电荷区的宽度和电荷分布趋于稳定,正负离子形成的电场持续存在,但宏观上无净电流流动。
正向偏置
当加入一个正向偏置的电场(P正N负),即与势垒区方向相反的电场时,势垒区内的静电场被破坏(动态平衡被打破),电子可以自由移动形成电流。破坏内部静电场的外加电压随PN结的材料变化而不断改变,这个电压称为正向偏置电压(硅0.7V,锗0.3V);
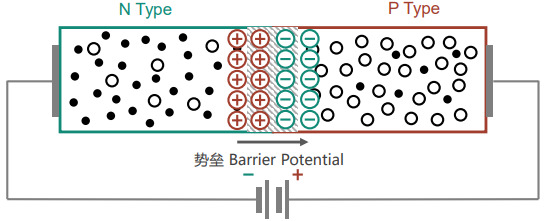
反向偏置
P区接电源负极,N区接电源正极,称为反向偏置(reverse biased);
正极吸引N区的自由电子远离PN结,负极吸引P区的空穴远离PN结;
空间电荷区随着反偏电压增加而变宽;
N区自由电子和P型区空穴不能穿过厚的空间电荷区,电流不流过二极管。

反向饱和电流
反向饱和电流的形成
当 PN 结外加反向偏压时,空间电荷区(势垒区)的电场强度增强,阻碍多子的扩散运动,但会加速少子的漂移运动。此时,P 区中的少子(电子)在反向电场作用下向 N 区漂移,N 区中的少子(空穴)则向 P 区漂移。这两种漂移运动形成的电流方向一致,叠加后构成反向饱和电流。
需特别指出,反向饱和电流的 “饱和” 特性源于少子来源的有限性。尽管反向电场持续抽取少子,但材料内部的热激发和复合过程会不断补充少子,维持其浓度梯度,从而保证电流的稳定性。
反向饱和电流的特点:
微小且稳定:由于少子浓度极低,其数量由材料本征激发速率决定,与反向电压大小无关,仅受温度影响显著。
温度敏感性:温度升高会增强本征激发,导致少子浓度指数级增长,从而使反向饱和电流显著增大。
动态平衡:在反向偏压下,多子扩散被完全抑制,仅剩少子漂移贡献电流,而少子数量受热平衡限制,故电流达到饱和值。
Q&A
PN结中的少子从何而来?
PN 结中的少数载流子(少子)来源于半导体材料的热激发和杂质电离。在热平衡状态下,即使 P 型半导体中的多子是空穴、N 型半导体中的多子是电子,材料内部仍会因晶格热振动(本征激发)和掺杂原子的不完全电离产生少量自由电子(P 区的少子)和空穴(N 区的少子)。这些少子的浓度与温度密切相关,遵循载流子浓度分布规律。
雪崩击穿
定义
当 PN 结反向电压超过临界值时,空间电荷区电场强度显著增强(通常达到 10^5 V/cm 量级),高能载流子与晶格原子碰撞时,将共价键中的价电子击出,产生新的电子 - 空穴对。新生成的载流子继续被电场加速,引发次级碰撞电离,形成几何级数增长的载流子数量。
特点
这种链式反应导致反向电流急剧增大(可达微安级至安培级),超过器件承受极限时造成不可逆击穿。此过程具有正反馈特性,电流增幅呈现指数关系。
齐纳击穿(隧道击穿)
定义
在高掺杂浓度的PN结中,P区与N区的 间距较窄; 一定的反偏电压的场强足以直接将电子 从耗尽层内的共价键拉出并产生电流; 最终致使势垒区瓦解; 该电压称为齐纳击穿电压,齐纳击穿也被称为隧道击穿。
特点
-
高掺杂浓度与窄势垒区
该效应仅发生于 P 区和 N 区均为高掺杂的 PN 结中。杂质浓度极高(约 10¹⁸/cm³ 量级)导致空间电荷区极窄(典型宽度 1-10nm),从而在反向偏压下形成超强电场(可达 10⁶ V/cm 量级),这是触发隧穿效应的必要条件。 -
量子隧穿主导机制
在强电场作用下,P 区价带顶的能级被提升至与 N 区导带底近似等高,此时价带电子无需跨越禁带宽度(约 1.12eV),而是通过量子隧穿效应直接穿透势垒进入 N 区导带,形成电子 - 空穴对。这种载流子倍增机制具有瞬时响应特性,无显著载流子加速过程。 -
击穿电压特征
典型击穿电压范围为 2-5.5V,与材料禁带宽度和掺杂浓度呈负相关。击穿电压的温度系数为负值(约 - 2mV/℃),即温度升高时击穿电压略微下降,这是隧穿概率随晶格振动增强而变化的直接结果。 -
可逆工作特性
在功率耗散允许范围内,击穿过程完全可逆 —— 反向电压降低后,载流子生成立即停止,器件恢复阻断状态。这种特性使其能够稳定应用于稳压电路,通过动态调节反向电流实现电压箝位。 -
陡峭的击穿曲线
伏安特性在击穿点呈现极陡峭的转折,击穿后电压波动范围小于 1%(典型值),这种高精度稳压特性源于隧穿效应对电场的强敏感性。电流变化范围可达三个数量级(μA 至 mA 量级)而维持电压基本恒定。
势垒电容

外加偏置电压变化(但未发生击穿),导致PN结电荷量变化,耗尽层宽度随之变化;
因耗尽层宽度变化而呈现的电容效应为势垒电容(CB );
势垒电容也被称为暂态(Transition)电容或耗尽区(Depletion Region)电容;
扩散电容

正向偏置电压较大时,耗尽层消失;
因载流子(电子)向低浓度方向扩散、积累而形成的电容效应称为扩散 电容(CD)。
结电容

结电容(CJ)又称微分电容,包括:势垒电容(CB)和扩散电容(CD)
势垒电容(CB)只在外加电压变化时才起作用,且外加电压频率越高,势垒电容越明显
扩散电容(CD)仅在正偏时才起作用,正偏时,电压较低时势垒电容为主,电压较高时扩散容为主

























 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








