文章目录
一、概述:从同一型号LDO芯片选型何如选择具体封装到“热阻与功率”
若不关心推到过程,可跳至第三节流程,快速选型
无数名硬件工程师在前辈的指导下,在人云亦云的大环境下,在“经验的”熏陶下,一片神级LDO芯片,LM1117-3.3V可谓是“叱咤江湖”多年,但比如TI公司的LM1117芯片下,就有SOT封装、TO-220封装、TO-263封装和WSON封装等等,我们如何选择具体封装,很多人(小白)没有搞清楚如何选择。
所以经常出现下面的对话,刚刚接触工作,或者哪怕是工作了多年的“老油条”也是对一些概念模糊不清。
问:X工,每次选择这些封装时候我就会犯难,为什么选这个?
答:这个封装散热好,这个体积大。
问:可是X工,数据手册上写着它们都能达到800mA电流啊,那有什么区别呢?
答:选大的,肯定供电能力就强啊,散热就好啊,功率就高啊。
问:哪到底多大是个大呢?有没有依据呢?
答:管那么多干嘛?我和你说和热阻有关,功率有关,选这个大的就行,就可以用,之前设计都没问题你按照之前的设计来就好了!
于是,你按照“前辈们”久经沙场的经验,将电路板设计出来,但很不幸的是,你的后端电路上有个不起眼的器件功耗却出奇的大,于是整体电路工作电流也大,电源芯片发热严重,运行个10分钟就死机掉电了,有的板子冒烟了,你还要去修,来回调试数把个月最终决定,还是换个“更大功率和效率”的开关DCDC芯片来解决这个问题吧,又成了一条“LDO不靠谱,以后我要用开关电源的经验”。
求人不如求己,只有自己刨根问底得搞清楚原理才有底气,在越来越拥挤的、越来越复杂的电路板中,空间显得尤为重要,如何选择一个能够满足条件的,发热满足要求的、可靠运行的LDO芯片,就需要了解一下器件的热阻的概念。

二、技术名词解释
1 结温度 TJ
结温度,说白了就是芯片内部核心的温度,这个温度不能超过一定的值,否则就烧坏啦!芯片手册里有个绝对最大额定值里,会说明允许的最大结温度,一般商用的会比工业的低些,说人话就是不耐高温些,不禁折腾些。

2 环境温度 TA temperature ambient
顾名思义,环境温度,中文手册的弊端在这里体现的淋漓尽致,TA是什么,英文手册里后边带着ambient tempeature,我们自然联想到TA就是环境温度,中文手册里直接放上一个TA,我们是小白的话直接蒙圈,这TA是啥,出自哪里?这层窗户纸捅破了自然也就知道了,所以还是啃英文手册能避免很多歧义的问题。
说跑偏了,这里的环境温度要强调下,不是简单得指室温、或者“今天天气预报报得多少度”,二十芯片所处环境得具体温度。
比方说在一个煤炭矿井下,矿井里温度可能是30℃,但是电路板安装在一个厚厚得密闭的铁壳里,铁壳里有大功率器件,这些大功率器件呼哧呼哧的散发着热量,让这个密闭空间里温度达到了40度甚至更高,那么此时这个40度才是环境温度。同理这个电路板可能放在汽车的引擎盖下面,那么就不得不考虑汽车在阳光下暴晒一下午后,引擎盖的温度可能达到60度甚至更高,那么这时60度才是器件的环境温度。

3 耗散功率 Pd power dissipation
耗散功率就是LDO损耗的功率,这部分功率以热量的形式将能量耗散掉了,所以芯片也就跟着升温了。耗散功率越大,发热也就越高,但芯片的散热能力又是一定的。
当发热量超过芯片的散热能力时,结温度就会超过最大结温,芯片也就烧坏了
但我们如何避免这种事发生呢?芯片的散热能力应该引用一个什么样的参数来描述呢,引入热阻概念。
4 热阻 Rθ,Rθ=(T1-T2)/P
就像是不同的导体电阻,对电流的阻碍作用一样。
不同材质的导热能力,对热量扩散阻碍能力不一样,所以引入热阻概念,用来描述不同材质对热量扩散的阻碍能力。
Rθ=(T1-T2)/P
R=(U1-U2)/I
是不是很像啊。
所以热阻越大,散热能力越差。
我在第一眼看数据手册,看到五花八门的RθJA啊,RθJC啊,RθJB啊,看的眼花缭乱,实际上看一眼英文就全明白了,如下图。
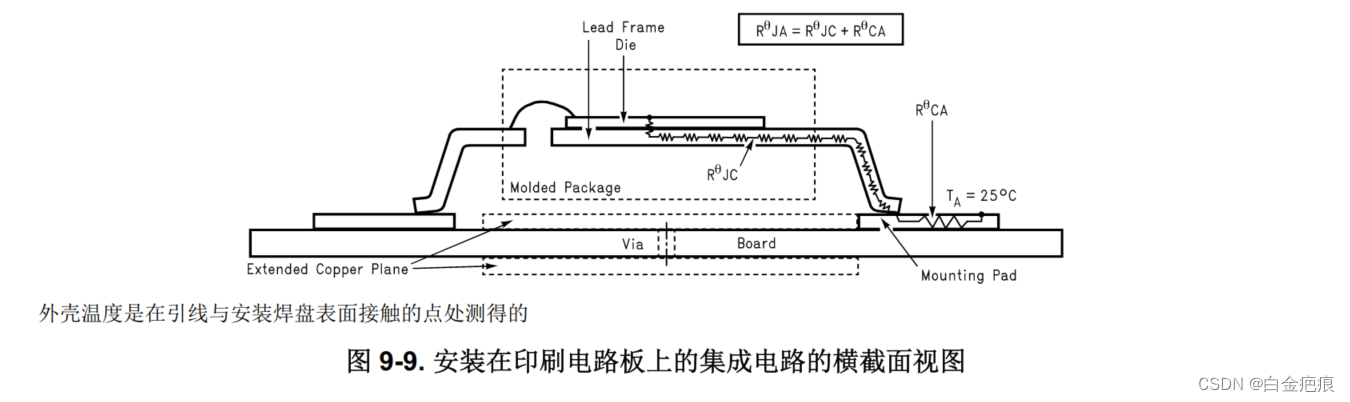
解释下缩写:
- JA:junction to ambient 结到环境
- JC:junction to case 结到外壳
- CA:case to ambient 外壳到环境
所以RθJA=RθJC+RθCA - 类似的还有JT:junction to top 结到封装顶部
- 类似的还有JB:junction to bottom 结到封装底部
说重点:热量传输路径不是一条,可以沿着引脚传输到电路板,可以沿着封装表面到空气,可以沿着底部焊盘到PCB的覆铜,这些通道可以看作时“并联”的,所以要根据芯片实际,来选择正确的热阻来计算。
5 POWER(耗散功率)
一般来说,上面计算热阻时候的功率,指的是发热功率,而不是整体电路功率。
例如,以LDO芯片LM1117-3.3为例。输入电压5V,输出电压3.3V,负载电流500mA,LDO芯片的静态电流10mA
PD=(VIN-VOUT)IL+VinIG
下面是推导过程:
LDO的模型
简化一下:
TI中给出的公式
6 新的热指标ψJT 与ψJB(junction to board) (结到封装顶、结到电路板)
ψ(psi) θ(theta)
首先不着急介绍ψ是什么,先说Rθ存在的问题
“结至环境的热阻” RθJA 是常见的指标,也是最被常误用的指标。
RθJD是JEDEC在EIA/JESD51-X中规定的标准化环境、标准化测试流程、标准化测试方法中测得参数,它只体现了 芯片的散热能力,用来和其它厂家的LDO芯片进行对比来使用。
换人话来说就是,在实验室里测得的数据,我们实际上用的时候,给芯片上贴上一个大散热片,就会大大降低它的RθJA,我们电路板覆铜形状,焊盘大小、铜厚等多方面影响RθJA,所以不能简单直接拿来使用。
所以实际应用时,当器件封装表面没有散热器时,结到封装顶部的热阻,盲目使用θT,与实际电路可能存在区别,就可能导致很大的误差,于是ψJT概念被提出。
这里偷个懒,下面是TI公司《半导体和IC封装热指标》给出的概念,大概意思就是说,Rθ是实验室中测得的,为了得到较为准确的结温与封装表面温度、功率关系,引入了ψ的概念。我给它起个名字就叫“伪热阻”,原文里叫它“特征参数”。
原文: TI英文版


这东西怎么用呢?
我们手头有红外摄像头等测量芯片封装表面温度的工具时,测得了封装表面的温度Tc,再通过公式Tj=Tc+(ψTJ x power),即可估算出芯片内部的结温。电路已经做出来了,验证芯片是否会稳定工作时用得到的参数。
7.散热片热阻
散热片的热阻计算公式为RθCS(case to heat-sink)=T/(k x A)
三、流程:数据手册中我们应关注哪些参数
其实还可以更细化,例如增加散热片等,以后再补充吧

四、技术细节
提示:把热阻想想成电阻很好理解了
- 热阻和电阻类似,热量可以想象成电流、对热量的阻碍想象成电阻,耗散功率想象成电压;
- 热阻和电阻不一样,没有看得见的通道,但是基本可以抽象出来:
a. 热量从芯片外壳流出、再从外壳到空气;
b. 热量从引脚流出到电路板,电路板再到空气;
c. 热量从底部焊盘留出到PCB覆铜,PCB覆铜再到空气;
d. 热量从芯片外壳到散热片,散热片再到空气; - 上述这些通道既有串联,也有并联,芯片手册一般会写出各个通道的热阻。
- 散热片的热阻计算公式为RθCS(case to heat-sink)=T/(k x A)

例如TO-220封装,结至底部热阻仅有1.5℃/W,实际大部分结的大部分热量可以从封装底部散掉,只需再TO-220背面加良好散热,计算出散热器热阻后,即算出TO-220的散热效率。带入公式中ⅩTO-220封装获得较大的电流输出。
这里也可以想想成,TO-220的多条热路通道,并联着这条热阻极小的通道,TO-220的RθJA(结至环境温度)热阻主要取决于此条通道
即RθJA=RθJC+RθCS,只要RθCS足够小,表格中的RθJA就没有参考意义了。
小结
本文仅简单阐述LDO芯片的输出电流、耗散功率与热阻关系,是自己对热阻的理解与总结。有不对的地方欢迎大佬们指正!











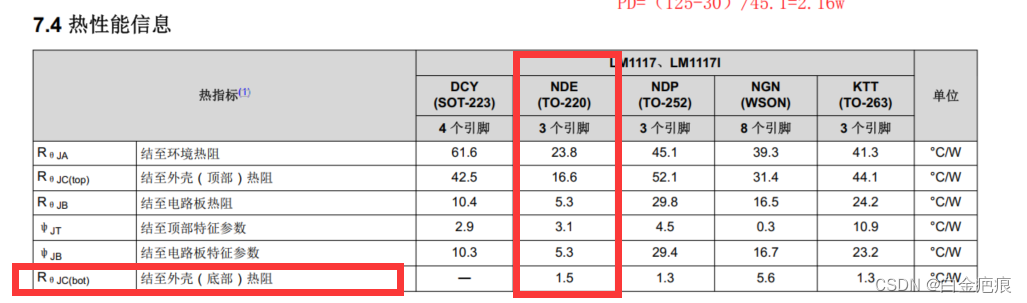














 1941
1941

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








