SMT 组装的质量与效率,取决于 “焊膏印刷、元件贴装、回流焊接、检测” 四大核心工艺的协同配合 —— 哪怕焊膏印刷的微小偏差(如 0.01mm 的钢网偏移)、回流焊的温度波动(如 ±2℃),都可能导致虚焊、元件脱落等问题。每个工艺环节都有严格的参数标准与操作要点,需结合元件类型、PCB 特性动态调整。
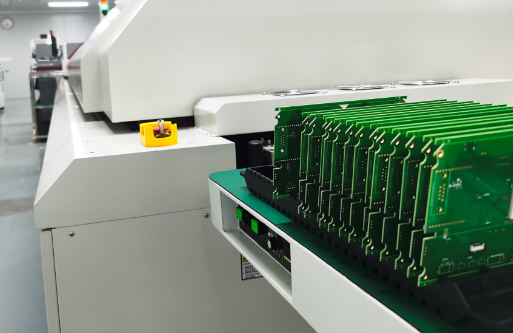
一、焊膏印刷:为元件焊接打基础
焊膏印刷是 SMT 组装的 “第一步”,核心目标是在 PCB 焊盘上精准涂覆定量焊膏(过多易短路,过少易虚焊),关键设备是 “全自动焊膏印刷机”,需重点控制 “钢网选择、焊膏参数、印刷参数”。
1. 钢网选择:匹配元件封装与焊盘
钢网是焊膏印刷的 “模板”,通过镂空图案将焊膏转移到 PCB 焊盘上,选择需遵循 “封装适配” 原则:
-
材质:不锈钢(厚度 0.1-0.2mm),硬度高、耐磨损,使用寿命可达 10 万次以上;
-
厚度:根据元件封装选择,01005/0201 元件用 0.1mm 厚钢网,0402/QFN 元件用 0.12-0.15mm 厚钢网,BGA 元件用 0.15-0.2mm 厚钢网(厚钢网可容纳更多焊膏,避免 BGA 焊点空洞);
-
开孔:开孔尺寸需比 PCB 焊盘小 5%-10%(补偿焊膏熔化后的扩散),例如 0201 电阻焊盘尺寸 0.3mm×0.15mm,钢网开孔尺寸 0.28mm×0.14mm;开孔边缘需光滑(粗糙度 Ra<0.8μm),避免焊膏粘连。
2. 焊膏参数:确保印刷与焊接性能
焊膏的 “合金成分、颗粒度、黏度” 直接影响印刷效果:
-
合金成分:普通消费电子用 Sn63Pb37(熔点 183℃),无铅场景(如欧盟 RoHS 认证)用 Sn96.5Ag3.0Cu0.5(熔点 217℃),高温场景(如汽车电子)用 Sn10Pb88Ag2(熔点 296℃);
-
颗粒度:与钢网厚度匹配,0.1mm 钢网适配 20-38μm 颗粒焊膏,0.15mm 钢网适配 38-50μm 颗粒焊膏,颗粒度过大易堵塞钢网开孔;
-
黏度:25℃时黏度为 800-1200Pa・s(旋转黏度计测量),黏度过高导致焊膏无法顺畅转移,过低易出现焊膏坍塌(导致短路)。
3. 印刷参数:精准控制涂覆量
印刷参数需通过 “试印调试” 确定,核心参数包括:
-
刮刀压力:10-20N(根据钢网尺寸调整,100mm×100mm 钢网用 10N,200mm×200mm 钢网用 20N),压力过小焊膏无法完全转移,过大易损坏钢网;
-
印刷速度:20-50mm/s,速度过快导致焊膏涂覆不均,过慢降低效率;
-
脱模速度:1-5mm/s(钢网与 PCB 分离的速度),脱模过快易导致焊膏拉尖(形成锡珠),过慢易导致焊膏残留。
案例:某厂商印刷 01005 元件焊膏时,用 0.12mm 厚钢网(适配 38-50μm 焊膏),但误选 20-38μm 颗粒焊膏,导致钢网开孔堵塞,印刷良率仅 80%;更换 38-50μm 焊膏后,良率提升至 99%。
二、元件贴装:精准定位元件
元件贴装是将 SMD 元件从料带中取出,精准贴装在 PCB 焊膏上,关键设备是 “全自动贴片机”,需控制 “定位精度、贴装压力、贴装速度”,适配不同封装的元件。
1. 定位方式:确保元件对齐焊盘
贴片机通过 “视觉定位” 实现精准贴装,分为 “元件视觉” 与 “PCB 视觉”:
-
元件视觉:通过摄像头识别元件外形(如电阻的长度、宽度),补偿元件在料带中的偏移(通常 ±0.02mm);
-
PCB 视觉:识别 PCB 上的基准点(Mark 点),补偿 PCB 的放置偏移(通常 ±0.01mm);
-
定位精度:01005/0201 元件需 ±0.005mm,QFN/BGA 元件需 ±0.01mm,精度不足易导致元件偏位(偏移 > 0.03mm 会导致焊接不良)。
2. 贴装参数:适配元件重量与尺寸
-
贴装压力:根据元件重量调整,01005 元件(约 0.001g)用 20-30g 压力,0201 元件(约 0.003g)用 30-50g 压力,QFN 元件(约 0.1g)用 100-200g 压力,压力过大易压碎元件,过小易导致元件贴合不紧;
-
贴装速度:根据产能需求调整,普通贴片机速度为 10000-20000 点 / 小时,高速贴片机可达 50000 点 / 小时,速度过快会降低定位精度。
三、回流焊接:实现元件与 PCB 的可靠连接
回流焊接是通过加热使焊膏熔化,冷却后形成焊点,关键设备是 “回流焊炉”,需根据焊膏类型设置 “温度曲线”,避免元件损坏或焊点不良。
1. 温度曲线:分阶段控制温度
典型的无铅焊膏(Sn96.5Ag3.0Cu0.5)温度曲线分为四个阶段:
-
预热阶段(室温→150℃):升温速率 1-2℃/s,时间 60-90s,目的是激活助焊剂、去除焊膏中水分,避免升温过快导致元件开裂;
-
恒温阶段(150℃→180℃):温度稳定在 150-180℃,时间 60-120s,目的是使 PCB 与元件温度均匀,避免局部过热;
-
回流阶段(180℃→240℃):升温速率 2-3℃/s,峰值温度 230-240℃(高于焊膏熔点 13-23℃),时间 30-60s,确保焊膏完全熔化;
-
冷却阶段(240℃→室温):降温速率 2-4℃/s,时间 60-90s,快速冷却使焊点形成致密的金属结构,提升可靠性。
2. 关键注意事项
-
温度均匀性:炉内各区域温度差≤±2℃,避免局部温度过高导致元件(如电容)爆裂;
-
氮气保护:对 BGA、QFN 等精细元件,可通入氮气(氧含量 < 500ppm),减少焊膏氧化,降低焊点空洞率(从 15% 降至 5% 以下)。
四、检测:排查焊接不良
焊接后需通过 “AOI(自动光学检测)”“X-Ray 检测” 排查不良:
-
AOI:检测表面元件(电阻、电容、QFN)的焊点,识别虚焊(焊点无光泽)、锡珠(直径 > 0.1mm)、元件偏位;
-
X-Ray:检测 BGA、CSP 等底部有焊点的元件,识别焊点空洞(面积 > 20% 为不良)、开路。
SMT 组装的四大工艺环节需 “参数精准、协同配合”,每个环节的细微调整都可能影响最终质量,需结合实际生产持续优化。






















 605
605

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








