SMT 锡膏印刷的参数(如刮刀压力、速度、脱模速度)是 “质量调节器”—— 同一套设备,参数设置不同,良率可能相差 30% 以上。不同场景(如细间距元件、大尺寸 BGA、超小 01005)对参数的需求差异极大,需根据 “元件类型 - 锡膏特性 - 钢网规格” 动态调整,而非套用固定参数。今天,我们解析五大关键参数的影响机制、优化步骤,及不同场景下的适配方案,帮你实现 “参数精准匹配”。
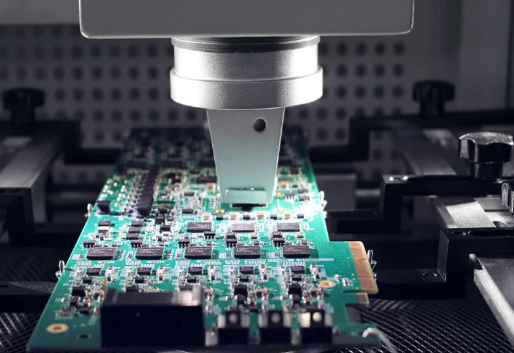
一、刮刀压力:控制锡膏填充量的核心(影响占比 40%)
刮刀压力决定锡膏能否充分填充钢网开孔,压力过小则填充不足(少锡),过大则锡膏溢出(桥连)。
影响机制:
-
压力与锡量关系:在一定范围内(2-6kg),压力每增加 1kg,锡膏厚度增加 8%-12%(如 2kg 时厚度 0.12mm,3kg 时 0.13mm);
-
临界值:超过 6kg 后,锡膏厚度不再增加,反而因挤压导致桥连风险上升。
优化步骤:
-
初始设定:根据钢网厚度设定基础压力(0.12mm 钢网设 3kg,0.15mm 设 4kg);
-
试印检测:印刷 3 片 PCB,用激光测厚仪测锡膏厚度,若平均厚度低于目标值(如目标 0.14mm,实测 0.12mm),增加 0.2kg 压力;若高于目标值,减少 0.2kg;
-
稳定验证:调整后再印 5 片,确保厚度偏差≤10%,且无桥连、少锡。
场景适配:
-
细间距 QFP(0.4mm 间距):压力 2.5-3kg(避免锡膏溢出);
-
BGA(0.8mm 间距):压力 4-5kg(确保开孔充分填充);
-
01005 元件:压力 2-2.5kg(轻柔刮锡,避免少锡)。
二、印刷速度:平衡效率与锡膏均匀性(影响占比 20%)
印刷速度太快会导致锡膏填充不充分(少锡),太慢则降低生产效率,需在 “效率 - 质量” 间找平衡。
影响机制:
-
速度与填充时间:速度每增加 10mm/s,锡膏在开孔内的填充时间减少 15%-20%(如 30mm/s 时填充时间 0.05s,50mm/s 时 0.03s);
-
极限值:超过 60mm/s 后,填充时间不足 0.02s,锡膏无法完全填充开孔,少锡率显著上升。
优化步骤:
-
基础速度:常规元件(0402、0603)设 30-40mm/s,兼顾效率与质量;
-
试印调整:若出现少锡,降低 5-10mm/s;若锡膏均匀但效率低,适当提高 5mm/s(不超过 50mm/s);
-
验证:速度调整后,检测锡膏均匀性(同一焊盘不同点厚度差≤5%)。
场景适配:
-
细间距元件(0.3mm 间距):20-25mm/s(慢速度确保填充);
-
大焊盘(如电源焊盘 2mm×5mm):40-50mm/s(快速度提升效率);
-
高粘度锡膏(>300Pa・s):25-30mm/s(慢速度帮助填充)。
三、脱模速度:防止锡膏粘连的关键(影响占比 15%)
脱模速度是钢网与 PCB 分离的速度,太快会导致锡膏粘连在钢网开孔内(少锡),太慢则影响效率。
影响机制:
-
速度与粘连率:脱模速度每增加 5mm/s,锡膏粘连率增加 5%-8%(如 5mm/s 时粘连率 0.5%,15mm/s 时 4%);
-
原理:慢脱模给锡膏足够时间脱离钢网,减少粘连。
优化步骤:
-
初始设定:常规场景设 5-8mm/s;
-
试印观察:若少锡率高,降低 2-3mm/s;若效率低但质量好,可提高 2mm/s(不超过 12mm/s);
-
检测:脱模后用显微镜观察钢网开孔,确保无残留锡膏。
场景适配:
-
超小 01005 元件:3-5mm/s(极低速度防粘连);
-
BGA 元件:8-10mm/s(平衡质量与效率);
-
低粘度锡膏(<200Pa・s):6-8mm/s(避免锡膏塌边)。
四、刮刀角度与钢网厚度:辅助参数的适配
刮刀角度:
-
常规元件:45°-50°(平衡锡量与均匀性);
-
细间距元件:55°-60°(减少锡量,防桥连);
钢网厚度:
-
01005 元件:0.1mm(薄钢网控制锡量);
-
0402-0603 元件:0.12mm(常规厚度);
-
BGA 元件:0.15mm(厚钢网确保锡量)。
五、案例:BGA 元件印刷参数优化
某电子厂 BGA(0.8mm 间距)印刷少锡率 10%,优化参数后降至 0.5%:
-
原参数:压力 3kg、速度 40mm/s、脱模 10mm/s;
-
问题:压力不足,开孔填充不充分;
-
优化:压力增至 4.5kg、速度降至 35mm/s、脱模降至 8mm/s;
-
效果:锡膏厚度从 0.12mm 增至 0.14mm(目标 0.15mm±10%),少锡率显著下降。





















 185
185

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








