当国产氮化硅基板邂逅碳化硅功率模块,中国新能源汽车开启性能狂飙模式
一、第3代半导体材料——碳化硅SiC性能优势明显
碳化硅SiC是第3代宽禁带半导体代表材料,具有热导率高、击穿电场高、电子饱和速率高、抗辐射能力强等优势,采用碳化硅SiC制材料制备的第3代半导体器件不仅能在较高温度下稳定运行,还能以较少的电能消耗,获得更高效的运行能力。
相比于首代Si硅基半导体,第3代宽禁带半导体碳化硅SiC具有2倍的极限工作温度、10倍的击穿电场强度、3倍的禁带、超过2倍的饱和电子漂移速率、3倍的热导率即3倍的冷却能力。

▲ 1-3各代半导体材料性能对比
碳化硅SiC作为第3代半导体材料性能稳定高效,广泛应用于电动汽车、充电设备、便携式电源、储能设备、通信设备、机械臂、飞行器、太阳能光伏发电、风力发电、高铁等等众多高电压和高频率工业领域。受益于5G通信、国防、新能源汽车、新能源光伏和风力发电等领域的高速发展,碳化硅二极管、碳化硅MOSFET、碳化硅功率芯片、SiC碳化硅功率模块等碳化硅功率器件市场规模急速膨胀。

▲当氮化硅基板邂逅碳化硅功率模块,国产第3代半导体材料助力我国新兴工业高速发展
二、AMB工艺氮化硅基板是第3代半导体材料碳化硅功率模块器件封装理想之选
目前,半导体电子器件行业广泛应用的陶瓷基板,通常按照基板材料划分主要有Al2O3氧化铝陶瓷基板、AlN氮化铝陶瓷基板和Si3N4氮化硅陶瓷基板三种。
氧化铝陶瓷基板优劣势。氧化铝基板最常见,通常采用DBC工艺,氧化铝基板低介电损耗、化学稳定性优良、机械强度较高,其制造工艺成熟、且成本低廉,主要在中低端工业应用领域有较大的市场需求。但是氧化铝基板导热性差,骤冷骤热循环次数仅仅200余次,无法满足日益发展的新能源电动汽车等第3代大功率半导体的应用发展需求。
氮化铝陶瓷基板优劣势。氮化铝基板导热率较高,具有优良的绝缘性,DBC和AMB两种工艺均有采用,氮化铝基板的导热性能好,且与第3代大功率半导体材料有很好的匹配性,但是氮化铝基板机械性能和抗热震性能差,不仅影响半导体器件可靠性,而且氮化铝基板属于高强度的硬脆材料,在复杂服役环境下,容易损坏,使用成本较高。
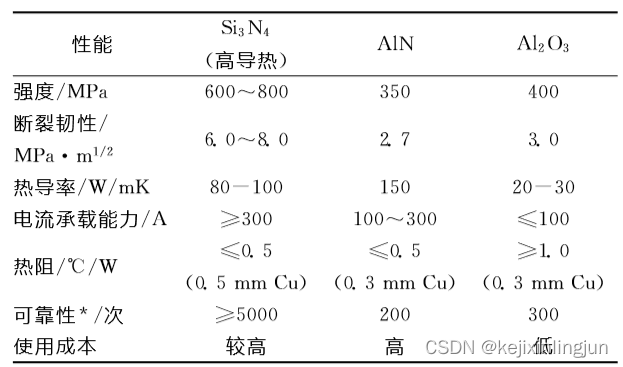








 本文介绍了氮化硅基板与碳化硅功率模块结合如何提升新能源汽车性能。氮化硅基板因其高导热性、高强度等优势,成为碳化硅功率模块的理想封装材料,从而提高汽车的加速度、续航里程、充电速度,助力汽车轻量化并降低成本。威海圆环先进陶瓷股份有限公司在氮化硅基板的研发上取得突破,为国产新能源汽车的性能提升贡献力量。
本文介绍了氮化硅基板与碳化硅功率模块结合如何提升新能源汽车性能。氮化硅基板因其高导热性、高强度等优势,成为碳化硅功率模块的理想封装材料,从而提高汽车的加速度、续航里程、充电速度,助力汽车轻量化并降低成本。威海圆环先进陶瓷股份有限公司在氮化硅基板的研发上取得突破,为国产新能源汽车的性能提升贡献力量。
 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章



















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










