(获取报告请登陆未来智库www.vzkoo.com)
一、智能机进入 5G 时代,主板方案望迎阶数跃迁
5G 手机主板需求升级或将带来行业高端产能供给偏紧,A 股高端 HDI 供应商望受益。 当前时点手机各个维度的创新升级都对主板技术路线产生影响,芯片 I/O 数增加导致 PCB 焊盘节距、直径缩小、走线密度增加(数量增加),压缩 PCB 的线宽线距;内部 功能模组的升级更加占用空间;信号传输要求提高,如频段数提升带来所需的射频元器 件数量提升、单位面积打件数量提升,以上变化都需要更高阶的主板去实现。
历史来看,苹果引领手机主板升级技术路线。目前大多数 HDI PCB 使用减成法 ELIC(任 意层)技术电镀工艺无法实现线宽线距下降到 30 mm,因此可实现更小线宽线距的 SLP 预计将是下一代 HDI 的主流方案。
4G 时代(安卓)手机主板为 2-3 阶 HDI、8-10 层,5G 将升级到至少 8-12 层的 4 阶 HDI、有些需要任意层(anylayer)HDI,每提升一阶均价可增大 800-1000 元。预计 19-21年5G手机HDI主板市场需求约0.1/5.7/6.3亿美金,SLP市场约9/19/19亿美金。 且平均毛利率有望高于 30%。而考虑高阶主板受制于技术难度、投资门槛、电镀线环 保审批等壁垒产能无法短期释放,因此 20 年行业高阶产能供应或将偏紧、带来量价提 升机会。
1、5G 手机芯片、信号、集成度要求提到,主板将迎阶数跃迁
芯片维度,安卓阵营的旗舰处理器高通骁龙系列芯片的半导体制作工艺从 2015 年的骁 龙 810 时代采用 20 纳米,到 2016 年底的骁龙 835 进入 10 纳米时代,目前最新的骁 龙 865 采用 7 纳米制程,且后续有望进一步升级。
芯片复杂度提升通常意味着它们具有比过去更多的 I/O (Input/Output,输入/输出),由于 手机内部 PCB 面积和层数通常不能轻易增加、否则会占用空间、提高成本,为了推动 I/O 数的增加,一个总的发展趋势是减小封装焊料球直径和焊料球之间的节距。与此同 时,I/O 数的增加也意味着需要更多的布线来扇出那些 I/O,通常需要通过更细的走线 来实现。
芯片 I/O 数增加导致焊盘节距、直径缩小,走线密度增加(数量增加),这三个变量会 影响 PCB 的线宽线距。具体来看,焊盘尺寸与 PCB 线宽有直接关系,也取决于焊盘 之间通过的走线数量。对于“简单”或低 I/O 数的封装,我们只需要在 BGA 焊盘之间 布一条走线,很明显最大走线宽度是焊盘之间可用空间的 1/3。如焊盘节距 300mm, 焊盘直径为 150mm,因此建议的线宽和线距要求为 50mm。但是如果更多的 I/O 数要 求在同样的焊盘节距内布两条走线,那么线宽/线距就会下降至 30µm,并且很明显,随 着焊盘节距的减小,将进一步限制线宽和线距。
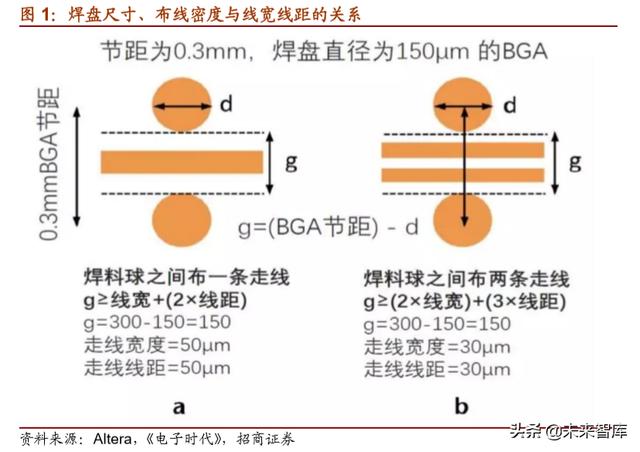
目前高端激光设备的加工能力不断提升,允许更小的微通孔更密地排列在一起。这将有 助于采用更小的 BGA 焊盘,与更多的 I/O 数器件相结合,减小线宽/线距的需求,推动 HDI 路线图的发展,后续可能从现有的每层生产布线转变为半加成法工艺(MSAP) 。
目前的发展阶段来看,5G 手机芯片制程工艺的长线升级需求(未来可能下降至 5 纳米) 迫使 PCB 线宽线距将进一步下降;内部功能模组的升级更加占用空间,如 5G 手机功 耗提升、电池模组体积厚度变大;信号传输要求提高,如频段数提升带来所需的射频元 器件数量提升、单位面积打件数量提升(虽然 5G 手机主板面积变大,但单位面积承载 的元器件数量增加)。以上变化都需要集成度更高的主板去实现。
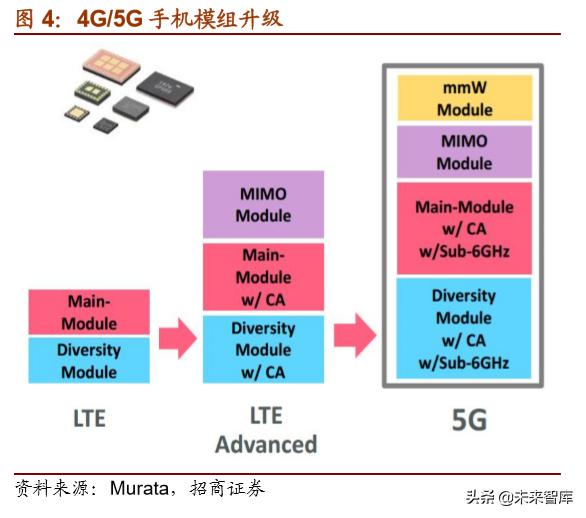
2、苹果引领手机主板升级路线,SLP 望成下一代 HDI 方案
(1)苹果引领手机主板升级路线
苹果手机主板经历了四个发展阶段,从最初的普通多层板到 1-3 阶 HDI(8-12 层),到 iPhone4S 首次导入 anylayer(任意层)HDI(10 层 5 阶,5 次激光打孔),到 iPhone X 首次导入 SLP,且 2020 年起所有出货机型均将搭载 SLP 主板。
减小手机用 PCB 的特征尺寸是为了让智能手机变得更薄功能更强。随着电路板上特征 尺寸的减小,需在固定的面积里实现更多的集成。从 iPhone 5s 开始,苹果 iPhone 手 机 PCB 面积占比逐渐减少,到 iPhone X 系列面积占比已经减少了 3%,功能却增加了, 电池的容量也增加了。与此同时,iPhone X 不仅采用了 SLP,而且还将两个 SLP 堆叠 了起来,以进一步增加在固定面积内的集成。

iPhone 的手机设计对最小线宽/线距的要求从前几代的 50μm 降至了 30μm。采用全减 成法 PCB 工艺无法达到这一要求,








 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章














 137
137











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








