内容摘要
散热器通常被认为是解决所有电子冷却挑战的神奇答案。散热器使热量扩散,因此热量通过比其他方式大得多的表面积传递到空气中。然后,空气将热量带走,冷却产生热量的电子设备。那么,为什么不在任何热关键组件的顶部放置一个散热器呢?
仿真可以说明答案。借助Simcenter Flotherm等3D热仿真和分析工具,产品设计人员可以对产品或产品的一部分进行建模,然后观察有关其内部和周围的空气和热流的大量信息。仿真有助于做出有关如何使用散热器以及放置位置的明智决策。
“为什么不在每个发热组件的顶部放置一个散热器呢?”
我们设置了一个实验来回答这个问题
我们在PCB上放置了两种不同类型的表面贴装封装,带散热器和不带散热器,并观察了结果(图1)。
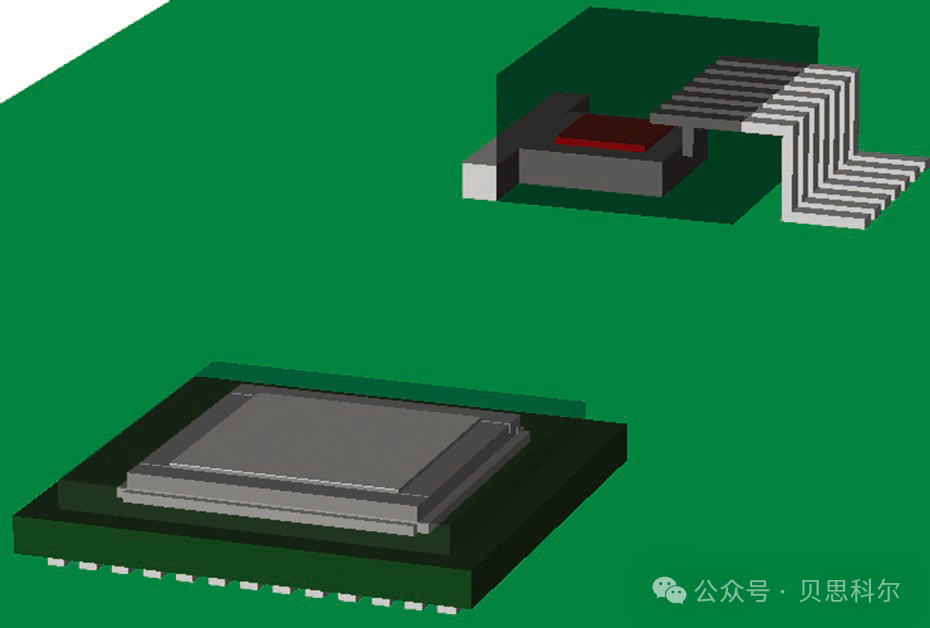
图1.Simcenter Flotherm模型的BGA和TO263封装,带封装。
前景中的封装是倒装芯片,陶瓷球栅阵列(BGA),通常用于微处理器。芯片上的一块金属有助于将热量扩散并诱导到封装顶部。背景中的封装是七引脚TO263–一种更简单的封装设计,通常用于分立式功率器件。在此展示的模型中,封装有点透明,所以可以看到内部。
在Simcenter Flotherm™软件中,我们将这两个器件放在2S2P高k系数测试板上,并放入35摄氏度的气流中,以每秒3米(约600lfm)的速度移动。它们的结温,即热源处的温度,在硅芯片本身中被记录下来。然后,在每个封装的顶部放置一个标准的铝制挤压板翅片散热器,并再次记录结温(图2)。

图2.电路板上带有建议散热器的器件。
最佳做法是在比较和对比两种或多种电子产品或配置的热性能时,查看温升高于环境温度的比率。当在BGA封装上使用散热器时,高于环境温度的结温温升是没有散热器的值的27%,下降幅度巨大。对于TO封装,在没有散热器的情况下,温升降至81%(图3)
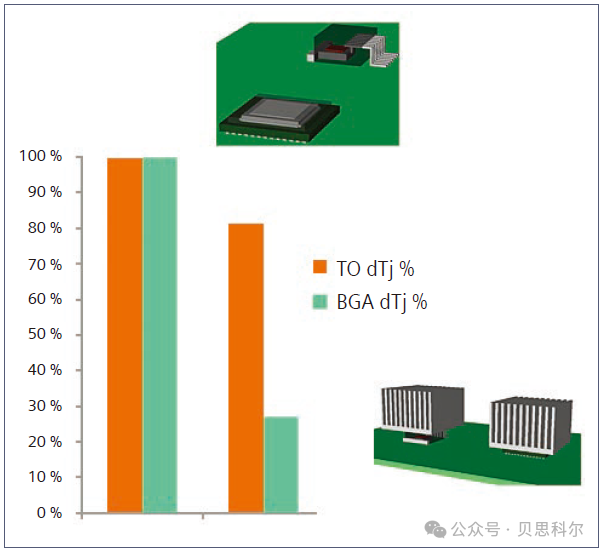
图3.带和不带散热器的温升比率。
TO封装的温度下降幅度远超预期。内部封装结构决定了所选择的散热器类型及其在封装上的位置。可以说,并非所有的封装样式都是相同的。为了使散热器有效工作,它们必须放置在有散热的地方(或需要扩展的区域)。此外,了解封装周围的气流行为可以解释这种意想不到的热性能。
了解潜在的热行为——热流预算
在部署散热器之前,我们观察了每个封装内的热流,以了解为什么会有这样的差异。图4中的黑色热通量矢量显示了热量如何离开其在芯片活性层上的源并通过封装扩散。低热通量矢量已截取以澄清图像。

图4.不带散热器的BGA(顶部)和TO(底部)器件的热流模式。
热设计工程师经常根据热流预算来表征热流,这是对主要热流路径的描述,即流向每个区域的总热量的百分比。有时,这种预算用于总计对流、传导和辐射通过表面的热量比例。
对于没有散热器的BGA,77%的热量直接流过芯片,并在封装的顶面附近通过。这是由放置在封装顶部的金属散热片和散热块引起的。对于TO封装,95%的热量倾向于直接传递到PCB,正如设计中所预期的那样。
那么,如果我们在两个封装的顶部放置一个金属散热器,预算会发生什么变化(图5)?

图5.带散热器的热流模式,用于BGA(顶部)和TO(底部)器件。
对于BGA,在将散热器放在顶部之前为77%的热量,现在已经上升到90%。散热器为金属散热片和散热块提供了可观的帮助,它们已经将热量传送到封装顶部。
结果是结温温升显著降低。热量越容易离开,温升就越低。
TO封装的预算只发生了3%的变化。为什么结温温升降低了19%?答案不在于散热器的导电效应,而在于散热器对气流的影响。
散热器将更多的空气输送到组件周围的PCB表面。这可以从上面的风速图(图6)中看出,就在电路板表面上方,比较了带和不带散热器的移动空气(大于1m/s)。这提高了风速,冲刷了电路板表面,更有效地去除了已经通过TO封装传递并扩散到电路板中的热量,从而使温度比环境温度升高降低了19%。在这个例子中,压力损失、流速和热性能之间没有发生耦合,这是我们在现实中发现的。

图6.固定流量环境,旁路余量有限。
在Simcenter Flotherm的帮助下,我们可以就是否在电子封装中添加散热器做出更明智的决定。对于BGA来说,散热器大大提高了封装的冷却能力。BGA封装旨在将热量引入其结构的顶部。当我们将散热器放在BGA顶部时,它会吸收并消散产生的大部分热量。然而,TO封装将热量引导到电路板中,因此放置在TO封装顶部的散热器不会明显改变耗散。在这种情况下,散热器可能不是冷却TO封装的经济高效的选择。所以,无处不在的散热器并不是电子冷却的神奇答案。
想要了解更多Simcenter产品信息,欢迎联系贝思科尔!
贝思科尔(BasiCAE),专注于为国内高科技电子、半导体、通信等行业提供先进的电子设计自动化(EDA)、工程仿真分析(CAE)、半导体器件热阻(Rth)及功率循环(Power Cycling)热可靠性测试,以及研发数据信息化管理的解决方案和产品服务。





















 802
802

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








