引言
目前,硅的电气和热性能在微电子技术领域中应用广泛。锗化硅(SiGe)合金的使用频率越来越高,在互补金属氧化物半导体技术中,英思特通过使用SON结构以及进行各向同性刻蚀,将该工艺扩展到对Si进行Si选择性刻蚀。
为了提高晶体管性能,基于SiGe中的传导沟道的技术目前已经在开发中。这种蚀刻是基于四氟化碳/N2/O2的气体混合物中的过程,其特征具有选择性,即Si隧道深度与SiGe层消耗之间的比值(图1)。
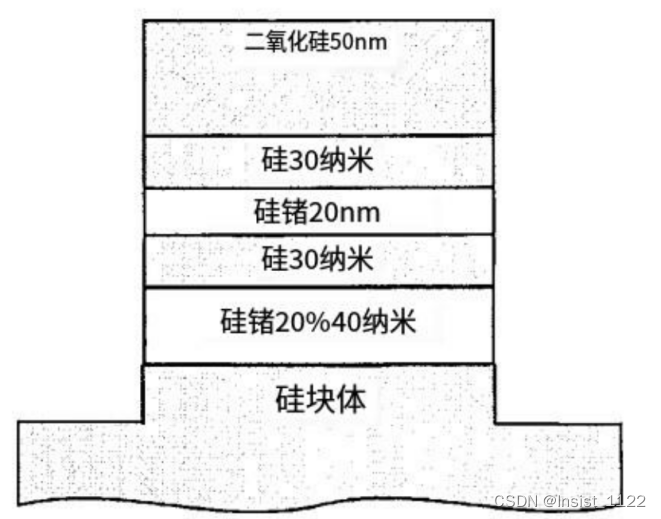
图1:样品用于研究该过程的选择性
实验与讨论
该工艺在减压化学气相沉积设备中进行,其用于表征各向同性蚀刻的样品是由多层Si和SiGe层组成的。当在单晶硅衬底上通过外延生长SiGe时,只要厚度低于塑性临界厚度,SiGe层就会在压缩中产生应变。我们通过光学光刻连接0.4微米厚的光刻胶层,然后使用各向异性蚀刻工艺转移多层中的图案,从而使掩埋的Si和SiGe层可接触到蚀刻物质。
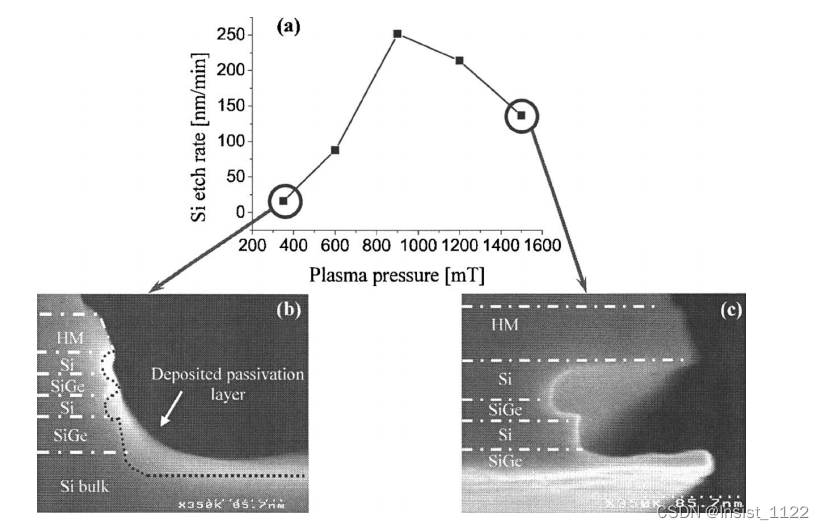
图2:一个蚀刻速率








 本文介绍了英思特在SiGe合金中采用SON结构和各向异性刻蚀技术,实现对硅的高选择性刻蚀,以提升晶体管性能。研究了在减压CVD设备中的蚀刻过程,发现有选择性蚀刻现象并探讨了沉积物形成机制。结果表明,已优化的工艺可达到250nm/min的蚀刻速率,适用于先进器件制造需求。
本文介绍了英思特在SiGe合金中采用SON结构和各向异性刻蚀技术,实现对硅的高选择性刻蚀,以提升晶体管性能。研究了在减压CVD设备中的蚀刻过程,发现有选择性蚀刻现象并探讨了沉积物形成机制。结果表明,已优化的工艺可达到250nm/min的蚀刻速率,适用于先进器件制造需求。
 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章


















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








