引言
锗是下一代背面成像器的有希望的替代品,因为最近的同质外延生长已经产生了非常低的缺陷密度。锗的固有特性使其能够进行高速硬X射线检测,并在硅基本透明的近红外区域吸收。此外,锗适合作为日益发展的量子计算领域的潜在基础材料。超薄二极管器件的制造需要去除用于同质外延生长的衬底。对于硅来说,这一任务通常通过选择性蚀刻来实现。然而,对于锗来说,由于与硅相比在化学和氧化行为上的根本差异,需要新的蚀刻技术。蚀刻由氧化剂(通常为过氧化氢或硝酸)引发,以形成氧化锗络合物。
实验
五种不同的蚀刻溶液中进行单晶n型未掺杂锗晶片(》50欧姆-厘米)的(100)表面的蚀刻。在蚀刻之前和之后,清洁每个样品丙酮、去离子(DI)水和甲醇的超声浴,并吹干至镜面光洁度。对于电接触,300 nm的银被热蒸发到锗晶片的背面和侧面上。基于氢氧化钾的蚀刻剂溶液由45重量%的KOH溶液(电子级)组成水(∼16mω-cm)和叔丁醇(TBA),体积组成比分别为5:14:1。基于过氧化氢的溶液由体积比为6∶11∶1的30% H2O2(电子级)、去离子水和TBA与5 g钠组成添加磷酸二氢一水合物以稳定过氧化物。磷酸溶液由等体积的85% H3PO4(电子级)、H2O2和去离子水组成。基于氢氧化钠的溶液含有溶解在去离子水和30% H2O2的体积比为2∶1的混合物中的浓度为2 N的NaOH。蚀刻也在纯去离子水中进行。
基于NaOH和H3PO4的蚀刻实验在25℃下进行,将Ge晶片中途浸入装有相应蚀刻剂溶液的烧杯中。在25℃下,在1800 rpm的连续搅拌下,在前述定制的电解蚀刻池2中进行H2O2和KOH基溶液的蚀刻实验。在实验过程中,标记为“隔离”的Ge晶片是电绝缘的,没有使用参考电极(re)或反电极(ce)。标记为“接地”的实验采用铂CE,Ge晶片充当工作电极(WE)。对于循环伏安法和偏压蚀刻实验,使用汞/氧化汞环。
使用微分阶梯高度接触表面光度仪(2D布鲁克德克塔克公司)来确定蚀刻表面的形貌轮廓。为了校准,形貌轮廓在未蚀刻区域上延伸,并且有效蚀刻深度和速率由获得的轮廓确定。
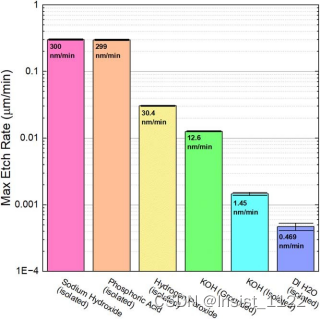
图一。不同腐蚀环境中(100)锗表面的最大腐蚀速率。“隔离”表示电绝缘样品。
r是气体常数,F是法拉第常数。先前在实验中在位于锗表面的金属颗粒附近观察到空穴辅助蚀刻。16数字2 是通过快速扫描偏压和收集瞬时电流记录的KOH基蚀刻剂中锗的循环伏安图(CV)。在CV采集过程中,样品表面的极性会发生转换,从而导致观察到的滞后行为。以5.6步/秒的轮询速率收集cv,增量为负电流代表锗的阳极溶解。在0.9 V负偏置下观察到的电流平台为11.5 mA,在+2.7 V正偏置下观察到的电流平台为11 mA
0.5 V和+0.8 V之间,明显的峰值表明锗表面氧化,还原反应发生在+1 V和之间
标有星号的数据是在静态偏压为0.9 V的蚀刻实验中记录的。11 mA的起始电流在实验的前1500秒内下降,并达到约4.7 mA的稳定电流(参见图1的插图)。2).静态偏压蚀刻实验期间电流的降低是由于双电层(EDL)的形成阻碍电荷向样品表面传输8,9,15,17并将总反应速率限制为扩散速率。在CV采集期间,没有足够的时间建立稳定的EDL。因此,在CV实验中观察到的蚀刻电流与静态偏压蚀刻开始时最初观察到的类似。然而,随着EDL
形式,通过蚀刻剂的电位降增加,导致电流下降(参见等式)。1).这一解释得到了图1中插图的支持。2显示前200 s记录的电流再现了CV采集期间观察到的电流。
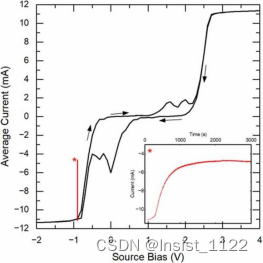
图二。在KOH基蚀刻溶液中循环伏安法期间记录的电流与施加的偏压的函数关系。箭头指示方向电压扫描。插图:0.9 V静态偏置下记录的电流与时间的函数关系(也包含在标有星号的CV中)。
为了防止EDL形成并保持较高的溶解电流,蚀刻实验在0.9 V下进行,每隔5分钟中断一次,以获得间歇的CVs。记录的电流在静态和间歇蚀刻实验期间,绘制在图3。在恒定偏压的每个间隔期间,电流的下降为与静态蚀刻实验相同。每次间歇CV采集后,观察到的电流重置为约11 mA的峰值。我们之前已经展示了积分电流与蚀刻的总质量直接相关
。因此,图1中曲线下方阴影区域的差异。3代表由于EDL形成的中断而额外蚀刻的锗。静态蚀刻产生的有效蚀刻速率为97±2nm min-1,而间歇蚀刻将该速率提高至138±2nm min-1。成像和形貌表征显示在以下方面没有降解蚀刻表面质量(见补充材料中的图S1)。在蚀刻过程中更新的CVs的可用性具有提供蚀刻过程的增强监控的额外优势。恒定偏压间隔期间记录的电流斜率的相对突然变化(见图。3)识别EDL形成的开始,指示恒定偏压应用的理想持续时间。恒定偏压下的较短时间将限制蚀刻。更长时间的恒定偏压将通过降低总电流来限制有效蚀刻速率。
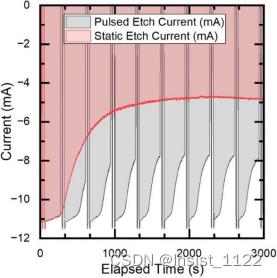
图3。在0.9 V静态偏压下进行蚀刻和在0.9 V下每隔5分钟间歇采集CV进行蚀刻时,电流与蚀刻时间的函数关系(单位:KOH)。曲线下的区域被加阴影以突出显示总电荷转移的差异。
结论
英思特的这项研究表明,在电解条件下,锗在KOH基蚀刻剂溶液中的蚀刻速率提高了两个数量级。氧化反应将电子注入锗表面,这延缓了蚀刻过程。电解蚀刻池中的电荷转移维持了表面蚀刻,并将蚀刻速率提高了8倍以上。发现通过偏压控制表面电荷可以进一步将蚀刻速率提高一个数量级。表面电荷促进蚀刻溶液中EDL的形成,并抑制反应物质的扩散。通过循环施加的偏压对EDL形成的周期性破坏维持了较高的蚀刻电流和提高的蚀刻速率。对表面电荷的控制提供了一种新的蚀刻选择性方法,这种方法既可以通过有意偏置表面来实现,也可以通过掺杂来调节空穴浓度。























 995
995

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








