英文缩写
- 倒片封装(Flip Chip Packaging)
- 高阻抗(impedance)
- 焊颈(solder neck)
- 重布线层 (Re-distribution Layer,RDL)
- 引线键合(Wire Bonding)
- 凸块(Bump)
- 混合键合(Hybrid Bonding)互联方式
- 球限位阵列(Ball Grid Array,BGA)
- 探针封装(Cavity Down)
倒片封装
倒片封装(Flip Chip Packaging)原理
芯片的焊盘是在正面,所以传统的引线键合,是芯片的背面粘在基板上,正面用金属丝跟基板之间接通(如下图)。利用金属引线进行连接的引线键合法有如下几个缺点:
- 怎么连接问题中的缺点:金属引线比凸点要长,且直径更小,因此传输电信号耗时长。且由于金属引线的高阻抗(impedance),信号很容易失真
- 怎么装的问题中的缺点:由于焊颈(solder neck)容易断开、且结合强度相对较弱,因此拉伸强度相对较差
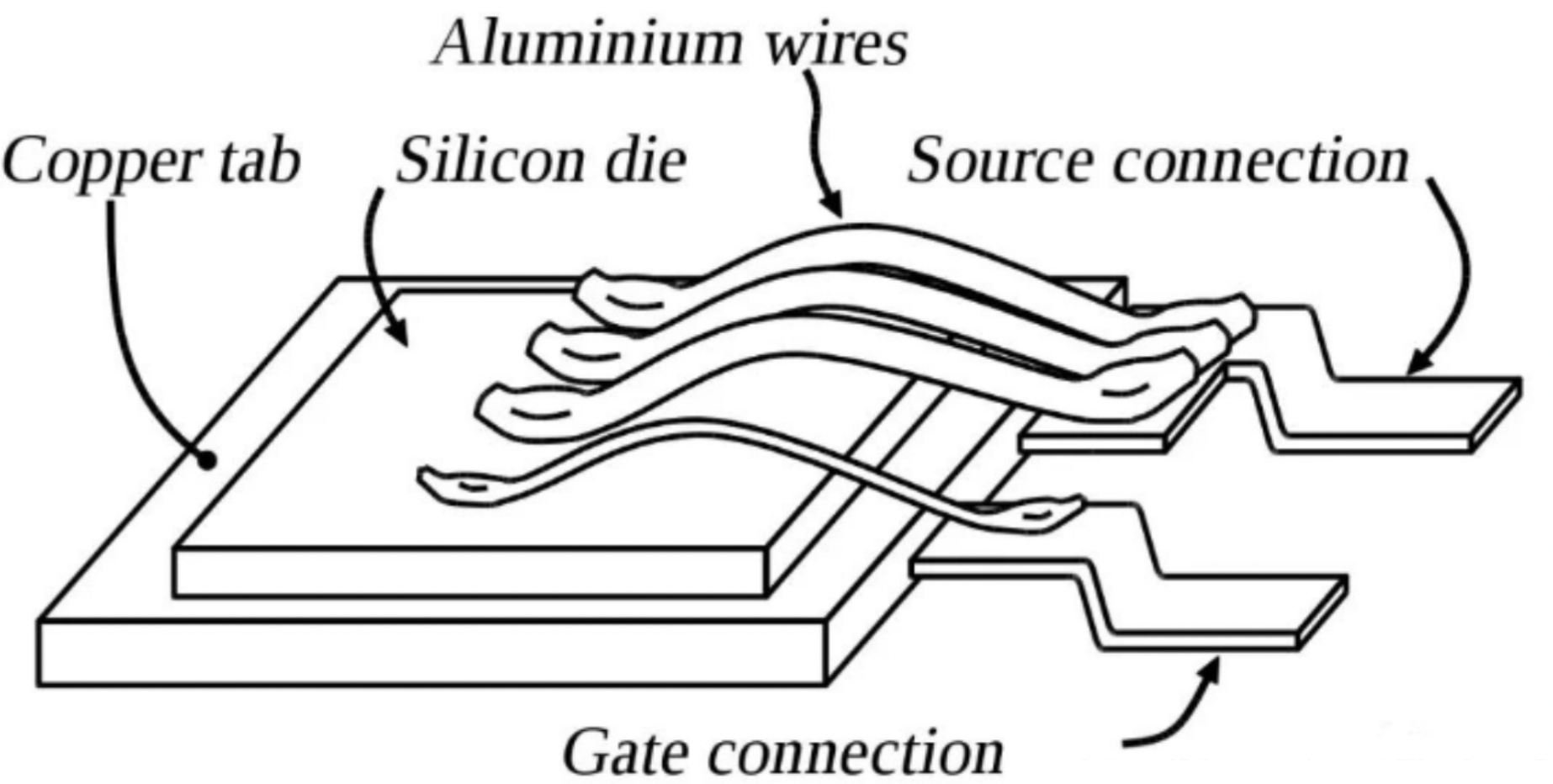
倒片封装直接在芯片 I/O 焊盘上或重布线层 (Re-distribution Layer,RDL)上沉积凸块,然后将芯片电气面朝下,直接把芯片正面倒扣在封装衬底上,中间用小金属球连接实现电气互联的封装技术。
鉴于引线键合的缺点,与传统封装引线键合(Wire Bonding) 方式相比,这个思路就巧妙地解决了怎么连接和怎么装的问题:
- 倒装封装使用小球链接大幅缩短了互联距离,连接密度大幅提升,并且电阻电感更小,芯片电性能和散热性更好
- 由于没有引线框架,这样封装可以更加紧凑,尺寸更小,具有更强的抗冲击性
降低了封装难度、简化封装过程、满足尺寸要求,对于移动设备和工业应用 等领域具有重要意义。以下为与传统引线键合封装的对比

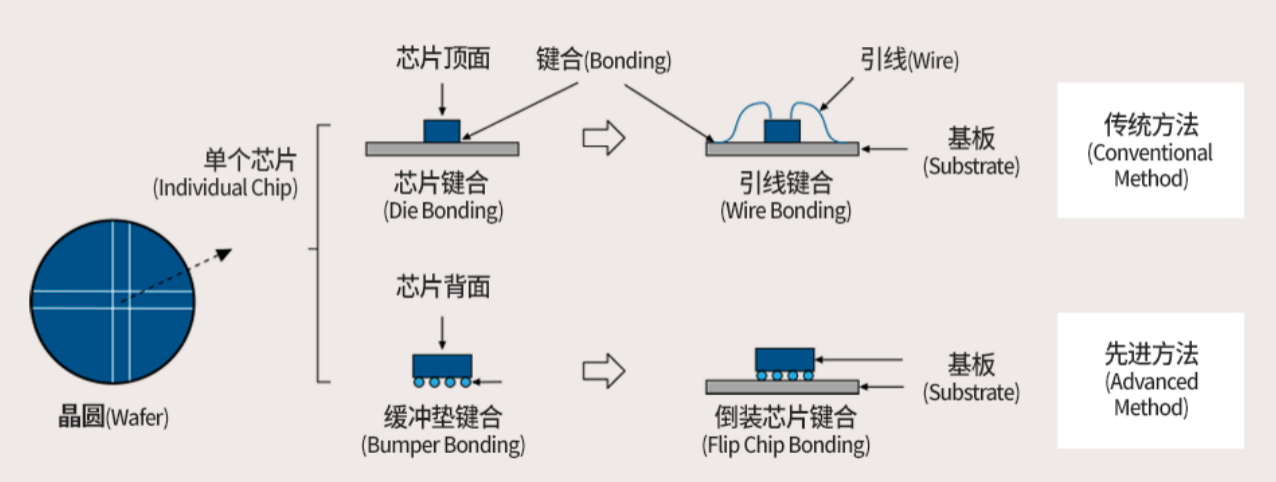
倒片封装键合
凸块(Bump)键合
凸块键合运用于倒片封装中,该工艺利用凸块代替了金属引线,从而增加了引线连接的柔韧性,在晶圆或芯片表面焊接球状或柱状金属凸点来实现界面间的电气互联和应力缓冲。
随着技术进步,凸块尺寸越来越小,发展出不需要凸块的混合键合(Hybrid Bonding)互联方式,连接密度大幅提升。
根据凸块材料的不同,凸块工艺可以分为金凸块、铜柱凸块、铜镍金凸块、锡凸块四种工艺。
球限位阵列(Ball Grid Array,BGA)
倒片封装技术的键合方式的一种,芯片的底部布有一定数量的焊球,这些焊球通常以网格状或阵列状排列在芯片的底部。通过将芯片倒置,焊球与基板上的相应焊盘对齐并进行热焊接,实现芯片与基板之间的电连接。
探针封装(Cavity Down)
倒片封装技术的键合方式的一种,芯片的底部布有柱状金属凸点,称为探针,这些探针通常以阵列状或线性排列在芯片的底部。探针封装通过将芯片倒置并将探针与基板或PCB上相应的焊盘或插座接触,实现电连接。

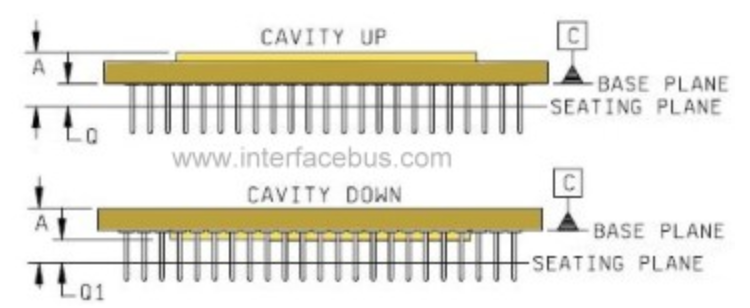























 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








