电子器件封装总结
- 前言
- 电子封装
- 常用封装分类
- 发展进程
- TO封装(Transistor Outline)
- SIP封装(single in-line package)
- DIP封装(dual in-line package)
- PGA封装(Pin Grid Array Package)
- SOJ封装(Small Out-Line J-Leaded Package)
- SOP封装 (Small Out-Line Package)
- PLCC( plastic leaded chip carrier)
- LCCC封装(Leadless Ceramic Chip Carrier)
- QFP封装(Quad Flat Package)
- QFN封装(Quad Flat No-leads Package)
- BGA封装(Ball Grid Array Package)
- CSP封装(Chip Size Packaging or Chip Scale Package)
- MCM封装(multi-chip module)
- SIMM(single in-line memory module,单列存贮器组件)
- DIMM(Dual-Inline-Memory-Modules,双列直插式存储模块)
前言
了解常用的常用的电子器件封装,对学习PCB的设计有着很大的帮助。平时你使用绘制原理图过程当中,需要对每一个器件设置相应的封装。如果其中一个器件没有设置封装,就无法生成网表。如果设置的封装名字或者封装器件存放的路径设置错误,在PCB软件设置时,就无法调出该器件的封装进行布局。在进行高速数字系统设计的时候,由于信号的上升时间很快,信号的最高频率很高,电路设计不好,信号容易出现反射、振铃和过冲等现象,轻则影响电路的性能,重则电路板不能正常工作甚至出现器件烧毁的情况。不同的器件封装的类型,由于引脚的长度或者构造不同,寄生的电感也不同。在高速电路设计当中,电感是要优先考虑的。
电子封装
封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接。封装形式是指安装半导体集成电路芯片用的外壳。它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。另一方面,封装后的芯片也更便于安装和运输。由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的PCB(印制电路板)的设计和制造,因此它是至关重要的。
衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1越好。封装的目的在于保护芯片不受或少受外界环境的影响,并为之提供一个良好的工作条件,以使电路具有稳定、正常的功能。
常用封装分类
各类引脚
直插式、 J形脚、翼形脚、无引线(LCC等)、扁平封装I形引脚、球栅阵列(BGA)
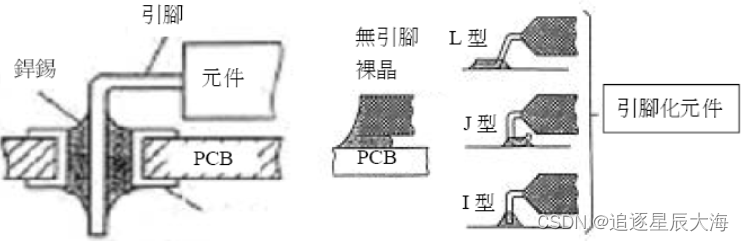
常用封装
插装:TO封装、SIP、DIP、PGA
表面安装: PLCC、 SOJ、SOP、QFP、BGA
新型CSP:COB、Flip-Chip、三维封装
其它: SIMM,DIMM
发展进程
结构方面:TO->DIP->PLCC->QFP->BGA->CSP;
材料方面:金属、陶瓷->陶瓷、塑料->塑料;
引脚形状:长引线直插->短引线或无引线贴装->球状凸点;
装配方式:通孔插装->表面组装->直接安装
TO封装(Transistor Outline)
金属-玻璃封装外壳为主,后发展为各类陶瓷、塑料封装外壳

SIP封装(single in-line package)
单列直插,引脚从封装一个侧面引出,排列成一条直线。
引脚中心距通常为2.54mm,引脚数从2至23。

DIP封装(dual in-line package)
双列直插,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。引脚中心距2.54mm,引脚数从6到64。

PGA封装(Pin Grid Array Package)
PGA封装,英文全称为(Pin Grid Array Package),中文含义叫插针网格阵列封装技术,由这种技术封装的芯片内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列,根据管脚数目的多少,可以围成2~5圈。安装时,将芯片插入专门的PGA插座。
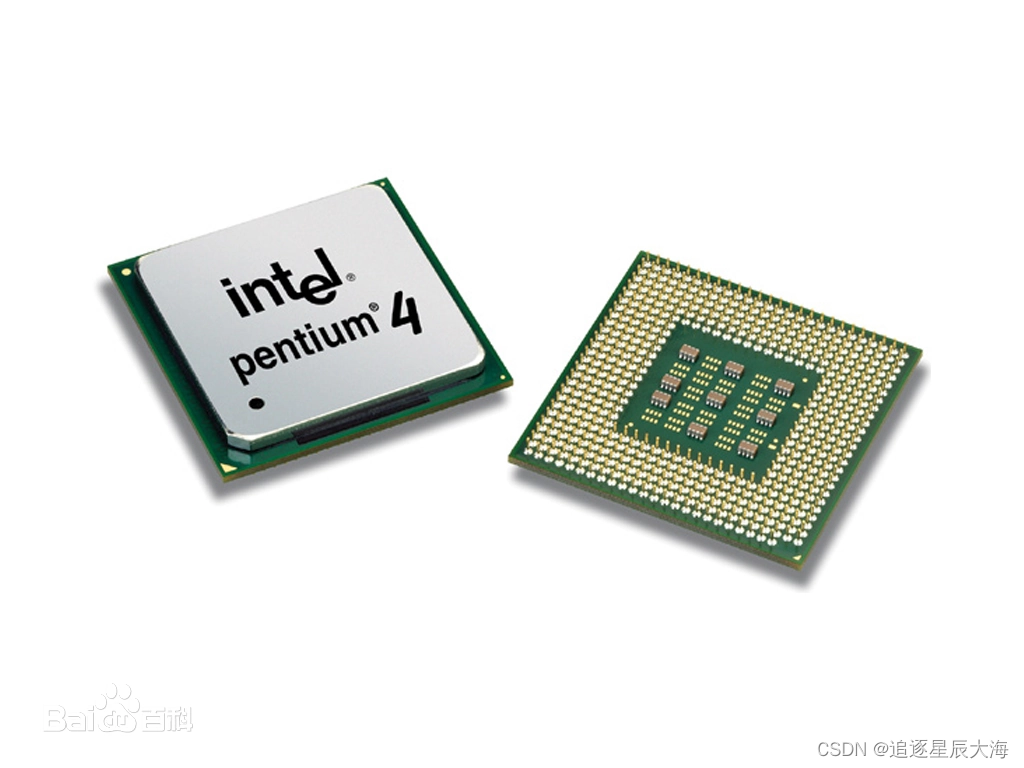
SOJ封装(Small Out-Line J-Leaded Package)
J形引脚小外型封装
引脚从封装两侧引出向下呈J字形,通常为塑料制品
引脚中心距1.27mm,引脚数从20至40

SOP封装 (Small Out-Line Package)
SOP是小外形封装,常见的封装材料有:塑料、陶瓷、玻璃、金属等,基本采用塑料封装。
引脚从封装两侧引出呈海鸥翼状(L字形),材料有塑料和陶瓷两种。另外也叫SOL和DFP。
引脚中心距1.27mm,引脚数从8~ 44。
引脚中心距小于1.27mm的SOP也称为SSOP;装配高度不到1.27mm的SOP也称为TSOP。
SOP封装的应用范围很广,而且以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)等在集成电路中都起到了举足轻重的作用。像主板的频率发生器就是采用的SOP封装。

PLCC( plastic leaded chip carrier)
J型引脚从封装的四个侧面引出,是塑料制品
引脚中心距1.27mm,引脚数从18到84

LCCC封装(Leadless Ceramic Chip Carrier)
LCCC(Leadless Ceramic Chip Carrier)无引线陶瓷封装载体,是SMD集成电路的一种封装形式。
在陶瓷封装体四周的引脚处有城堡式镀金凹槽,可直接焊接到PCB的焊盘。寄生电感和寄生电容小,适合高频、高速芯片封装。


QFP封装(Quad Flat Package)
方型扁平式封装技术,该技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。该技术封装CPU时操作方便,可靠性高;而且其封装外形尺寸较小,寄生参数减小,适合高频应用。

脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm等多种规格。0.65mm 中心距规格中最多引脚数为304。
QFN封装(Quad Flat No-leads Package)
方形扁平无引脚封装,表面贴装型封装之一。值得注意的是,QFN封装与LCC封装完全不同,LCC仍有外延引脚,只是将引脚弯折至底部,而QFN封装则完全没有任何外延引脚。

BGA封装(Ball Grid Array Package)
BGA封装的I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,BGA技术的优点是I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,从而提高了组装成品率。共面性好。
采用BGA技术封装的内存,可以使内存在体积不变的情况下内存容量提高两到三倍,BGA与TSOP相比,具有更小的体积,更好的散热性能和电性能。
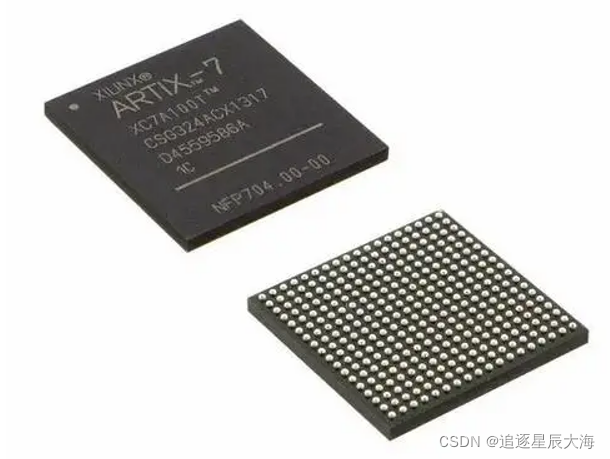
缺点:难以用肉眼判断是否焊接正常,拆卸不方便。
CSP封装(Chip Size Packaging or Chip Scale Package)
芯片尺寸封装。
CSP是最先进的集成电路封装形式,
可分为:柔性基片CSP,硬质基片CSP,引线框架CSP,圆片级CSP,焊区阵列。
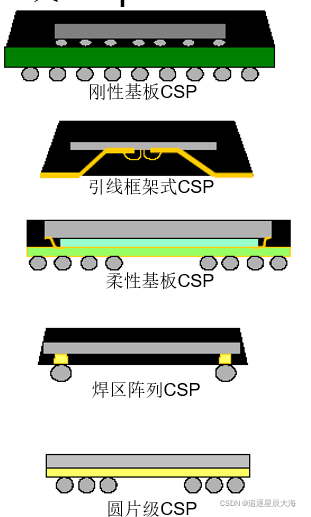
特点:
- 体积小,重量轻。在各种封装中,CSP是面积最小,厚度最小,因而是体积最小的封装。在输入/输出端数相同的情况下,它的面积不到0.5mm间距QFP的十分之一,是BGA(或PGA)的三分之一到十分之一。
- 可容纳的引脚最多。对于40mm×40mm的封装,QFP的输入/输出端数最多为304个,BGA的可以做到600-700个,而CSP的很容易达到1000个
- 电性能好,寄生参数小,信号传输延迟时间短,有利于改善电路的高频性能。
- 散热性能优良。CSP很薄,芯片产生的热可以很短的通道传到外界。通过空气对流或安装散热器的办法可以对芯片进行有效的散热。
MCM封装(multi-chip module)
多芯片组件
将多块半导体裸芯片组装在一块布线基板上的一种封装

优点
增加组装密度
缩短互连长度
减小信号延迟
减小体积
减轻重量
提高可靠性
SIMM(single in-line memory module,单列存贮器组件)
单列存贮器组件(SIMM),只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插座的组件。标准SIMM有中心距为2.54mm的30电极和中心距为1.27mm的72电极两种规格。在印刷基板的单面或双面装有用SOJ封装的1兆位及4兆位DRAM的SIMM已经在个人计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM都装配在SIMM里。如今的内存模块大部分是把若干个内存芯片颗粒集成在一小块电路板上,然后通过SIMM插槽与主板相连。

DIMM(Dual-Inline-Memory-Modules,双列直插式存储模块)
SIMM是只在印刷基板的一个侧面附近配有电极的存贮器组件。
DIMM的金手指两端各自独立传输信号,因此可以满足更多数据信号的传送需要。
SIMM和DIMM主要用于插件上面,比如内存条,这样的好处是便于更换。
严格意义上SIMM和DIMM更像是电子模块,而不是传统意义上的封装。

资料和图片来自于互联网,个人加以总结。
























 1018
1018

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








