半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(Eg)。通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。
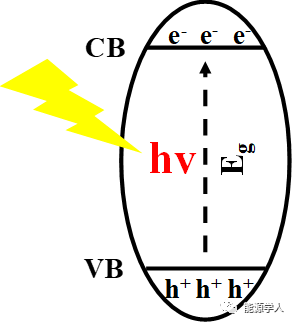
图1. 半导体的带隙结构示意图
在研究中,结构决定性能,对半导体的能带结构测试十分关键。通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2):
紫外可见漫反射测试及计算带隙Eg;
VB XPS测得价带位置(Ev);
SRPES测得Ef、Ev以及缺陷态位置;
通过测试Mott-Schottky曲线得到平带电势;
通过电负性计算得到能带位置.
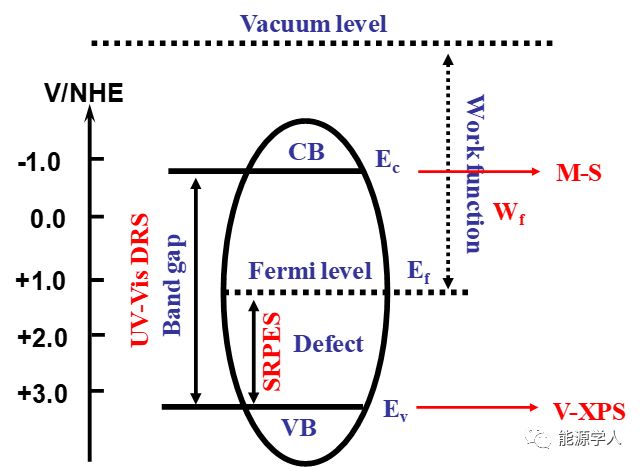
图2. 半导体的带隙结构常见测试方式
一、紫外可见漫反射测试及计算带隙Eg
1.1. 紫外可见漫反射测试
1)制样:
背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。
样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。
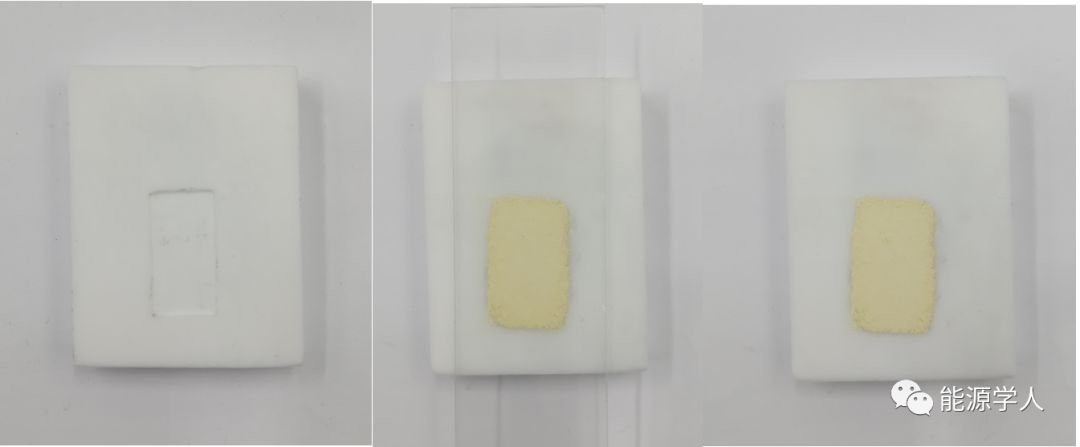
图3. 紫外可见漫反射测试中的制样过程图
2)测试:
用积分球进行测试紫外可见漫反射(UV-VisDRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。测试完一个样品后,重新制样,继续进行测试。
1.2. 测试数据处理
数据的处理主要有两种方法:截线法和Tauc plot法。








 本文详细介绍了半导体能带结构的测试方法,包括紫外可见漫反射测试计算带隙、VB XPS测定价带位置、SRPES分析、Mott-Schottky曲线获取平带电势等。通过这些方法,可以深入理解半导体材料的光电性能,为半导体器件的设计提供依据。
本文详细介绍了半导体能带结构的测试方法,包括紫外可见漫反射测试计算带隙、VB XPS测定价带位置、SRPES分析、Mott-Schottky曲线获取平带电势等。通过这些方法,可以深入理解半导体材料的光电性能,为半导体器件的设计提供依据。

 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章

















 668
668

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








