篇一:原文链接:https://zhuanlan.zhihu.com/p/599404296
半导体量测检测包括什么?
半导体量测检测,主要包含:
一、三大方向
1、Metrology(度量/测量)
Metrology,从字面上看,意味着度量或测量科学,特别是在半导体行业,它涉及到使用精密仪器和技术来测量薄膜的厚度、晶圆的平整度、以及材料的成分等关键参数。
2、Defect inspection(缺陷检测)
专门用来识别和定位芯片表面的异常或缺陷。
3、Review(复检)
Review用于详细检查Metrology(量测)和Defect inspection(缺陷检测)中发现的问题,以确保产品质量和生产效率。它通过高分辨率成像技术,如光学显微镜或电子显微镜,来观察和分析晶圆表面的细微特征,从而帮助工程师识别和解决制造过程中的潜在问题。
二、八种分类
Metrology包含4种分类、Defect inspection包含3种分类、Review包含1种分类
简要介绍如下:
三、Metrology关注方向:
1、膜厚测量THK(Thickness)
光学方法量测或半透明薄膜。Film stack可达几百层,金属层几百A(埃,厚度单位, 10−10� )。如果model建的合理,不同入射光波长下的折射率(n, RI, refractivity index)和k值(消光系数),都可以report出来。
2、光学方法测关键尺寸(OCD,Optical Critical Dimension)
原理同THK,但加了一套立体建模的算法。这是组强大的3D建模组件,熟练其功能,几乎没什么画不出的结构。
3、层与层之间的套刻OVL(Overlay)
半导体之难,难在成百上千的步骤前后配合,一步步根据设计目标,做出器件。Process间配合,前后对准是起码的要求。所以,需要monitor.
4、其他
比如Wafer基体厚度,弯曲翘曲(Bow/Warp),1D/2D stress,晶圆形貌Profiler,四点探针测电阻RS,XPS测dose含量等,AFM(原子力显微镜)/Metal plus(超声波)测台阶高度(Step Height)等。
四、Defect inspection关注方向:
1、无图形Unpattern缺陷检测
partical inspection, 包含颗粒的尺寸,位置,种类等。
2、有图像缺陷检测
Pattern inspection. 机台,涵盖明场暗场等,多种mode和缺陷比对算法,偶尔听人讲起,非常佩服。
3、掩模版缺陷检测
Reticle inspection.
五、Defect review关注方向
针对inspection扫出的defect(位置,大小,种类),用OM或SEM,确认其存在。
OM review,显微镜复检。
SEM review,扫描电镜复检,用电子束,精度大概1um左右。扫出的Defect Klaf文件有机会去SEM上review. 但由于SEM与SFS机台的location有offset(尤其是inspection和review机台来源于不同厂商时,位置差异更明显),常需要fine tune recipe或手动寻找。
篇二:原文链接:https://zhuanlan.zhihu.com/p/599400485
半导体检测和量测设备概述
一、半导体检测和量测设备概述
1、产业概述
检测指在晶圆表面上或电路结构中,检测其是否出现异质情况,如颗粒污染、表面划伤、开短路等对芯片工艺性能具有不良影响的特征性结构缺陷;量测指对被观测的晶圆电路上的结构尺寸和材料特性做出的量化描述,如薄膜厚度、关键尺寸、刻蚀深度、表面形貌等物理性参数的量测。
(1)检测:异物缺陷、气泡缺陷、颗粒缺陷
(2)量测:光刻套刻偏移量(OVL)、薄膜厚度(THK)、三维形貌
2、分类状况
从技术原理上看,检测和量测包括光学检测技术、电子束检测技术和X光量测技术等。目前,在所有半导体检测和量测设备中,应用光学检测技术的设备占多数。光学检测技术基于光学原理,通过对光信号进行计算分析以获得检测结果。在生产过程中,晶圆表面杂质颗粒、图案缺陷等问题的检测和晶圆薄膜厚度、关键尺寸、套刻精度、表面形貌的测量均需用到光学检测技术。
检测和量测技术分类状况:
(1)光学检测技术
主要内容:基于光学原理,通过对光信号进行计算分析以获得检测结果,具有速度快、精度高、无损伤的特点。
应用现状:28nm及以下全部先进制程。
发展趋势:通过提高光学分辨率,并结合图像信号处理算法,进一步提高检测精度。
(2)电子束检测技术
主要内容:通过聚焦电子束扫描样片表面产生样品图象以获得检测结果,具有精度高、速度较慢的特点,通常用于部分线下抽样量测部分关键区域。
应用现状:应用于28nm及以下全部先进制程,一部分应用于研发环节,一部分应用在部分关键区域抽检。
发展趋势:提升检测速度,提高吞吐量,由单一电子束向多道电子束技术发展。
(3)X光量测技术
主要内容:基于X光穿透力强及无损伤特性进行特定场景的量测。
应用现状:应用于28nm及以下全部先进制程。如检测特定的金属成分。
发展趋势:扩大应用场景范围。
二、检测和量测技术背景
1、检测
在检测环节,光学检测技术可进一步分为无图形晶圆激光扫描检测技术、图形晶圆成像检测技术和光刻掩膜板成像检测技术。
检测环节光学检测技术分类情况

2、量测
在量测环节,光学检测技术基于光的波动性和相干性实现测量远小于波长的光学尺度,集成电路制造和先进封装环节中的量测主要包括三维形貌量测、薄膜膜厚量测、套刻精度量测、关键尺寸量测等。
量测环节光学检测技术分类状况

三、全球检测和量测设备现状
1、市场规模
全球半导体检测和量测设备市场规模来看,随着半导体下游消费电子和PC等需求2020-2021年市场回暖尤其是2021年明显增长,量检测设备全球市场空间持续扩张。根据数据,全球市场2020年半导体检测与量测设备市场规模为76.5亿美元,2016-2020年CAGR12.6%,2021年整体半导体产业大增,估计检测和量测设备规模提升明显。
2016-2020年全球半导体检测和量测设备市场规模及增长率

2、细分市场
量测设备细分品类较多。根据数据,2020年半导体检测和量测设备市场各类设备占比中,检测设备包括无图形晶圆缺陷检测设备、图形晶圆缺陷检测设备(可细分为微米级和纳米级)、掩膜检测设备等;量测设备包括三维形貌量测设备、薄膜膜厚量测设备(晶圆介质薄膜量测设备)、套刻精度量测设备、关键尺寸量测设备、掩膜量测设备等。
2020年全球半导体检测和量测设备细分设备规模及占比

3、技术结构
量检测设备分为光学和电子束技术路线,其中光学占主流。2020年全球半导体检测和量测设备市场中,光学、电子束占比分别为75.2%、18.7%。由于下游厂商对量产高速的需求,光学检测技术设备仍然占据了主要的市场份额。
2020年全球半导体检测和量测设备技术结构占比

四、中国检测和量测设备现状
就国内检测和量测设备现状而言,目前国内整体半导体检测和量测设备市场规模占比全球市场25%左右且保持持续提升趋势,数据显示,2021年我国检测和量测设备规模为29亿美元,同比2020年增长61.1%,增速远高于全球规模,占比全球份额持续提升,但目前国内市场仍主要被国际企业占据主要市场,技术和企业之间适配性待提升。
2016-2021年中国检测与量测设备市场规模及增长率

五、检测和量测设备竞争格局
1、竞争格局
全球半导体检测和量测设备市场呈现国外设备巨头垄断格局。根据数据,全球市场中,2020年科磊半导体市占率超过50%,应用材料、日立、雷泰光电、创新科技等前五大公司合计市场份额占比超过了82.4%,市场集中度较高。中国市场中,科磊半导体达到58.4%,呈一家独大格局,前五大公司合计市场份额占比达到78.1%。
本土企业市场份额较低,其中中科飞测产品主要包括无图形晶圆缺陷检测设备系列、图形晶圆缺陷检测设备系列、三维形貌测量设备系列和薄膜膜厚量测设备系列等产品,已应用于国内28nm及以上制程的集成电路制造产线。上海睿励致力于集成电路生产前道工艺检测领域设备研发和生产,产品主要为光学膜厚测量设备和光学缺陷检测设备,以及硅片厚度及翘曲测量设备等。上海精测半导体前道检测设备领域,以椭圆偏振技术为核心开发了适用于半导体工业应用的膜厚测量以及光学关键尺寸量测系统的产品,目前中科飞测、精测电子、上海睿励2021年在国内检测量测设备市场份额仅1.9%、0.7%、0.2%。
2020年中国半导体检测和量测设备市场格局

2020年中国半导体检测和量测设备市场格局
2020年中国半导体检测和量测设备市场格局

2、主要企业
KLA Instruments和 Tencor Instruments相继成立于1976年和1977年,并于1997年合并成立科磊半导体,总部位于美国硅谷。该公司聚焦于检测设备的研发、生产和销售,其产品线涵盖了质量控制全系列设备。根据科磊半导体2022年年报披露显示,其检测和量测设备实现营业收入79.25亿美元,占比企业整体营收86%左右。
2019-2022财年科雷半导体半导体过程控制营收

康特科技成立于1987牛,总部位寸以色列米格达勒埃姆克。该公司是半导体行业高端检测和量测设备的制造商,其产品应用于前道、先进封装等领域,为众多行业内领先的全球IDM、OSAT和代工厂提供服务。根据康特科技2021年年报披露显示,其全年实现营业收入2.70亿美元,其中检测和量测设备营收2.59亿美元,占比96.2%。
2017-2021年康特科技检测和量测设备营收变动
阿斯麦(荷兰)量测业务优势领域在套刻误差测量、电子束检测,应用材料(美国)优势领域也在电子束检测,新星测量仪器(以色列)优势领域在膜厚检测设备,日立(日本)则主要是CD-SEM(关键尺寸量测-电子束)处于行业领先地位,雷泰光电(日本)则聚焦EUV掩模版检测,创新科技(美国)优势在于关键尺寸测量和缺陷检测。
六、发展趋势
1、技术趋势
随着集成电路器件物理尺度的缩小同时逐渐向三维结构发展,需要检测的缺陷尺度和测量的物理尺度也在不断缩小的同时三维空间的检测业在持续渗透。
为满足检测和量测技术向高速度、高灵敏度、高准确度、高重复性、高性价比的发展趋势和要求,行业内进行了许多技术改进,例如增强照明的光强、光谱范围延展至DUV波段、提高光学系统的数值孔径、增加照明和采集的光学模式、扩大光学算法和光学仿真在检测和量测领域的应用等,未来随着集成电路制造技术的不断提升,相应的检测和量测技术水平也将持续提高。
2、国产化趋势
整体半导体设备领域存在较高的技术、资金及产业协同等壁垒。与国外企业相比,本土企业进入该领域时间较晚,整体实力和规模与国外竞争对手存在较大差距。然而,经过多年来的不懈追赶,本土企业技术水平迅速提高,检测和量测设备从无到有,中科飞测等国产企业带动量检测设备国产化持续突破,目前在28nm已实现突破并向2Xnm以下节点推进。
篇三、原文链接:https://zhuanlan.zhihu.com/p/586900849
半导体量测与缺陷
监控晶片 VS 图案化晶片

监控晶片 图案化晶片
制造区域中晶片制造的品质检验

薄膜厚度
(1)电阻率与片电阻:四点探针
(2)片电阻(不透明材质) :范德波 、轮廓圆
(3)椭圆偏光仪
(4)反射光谱仪
(5)X-ray
(6)光声技术
正方形薄膜
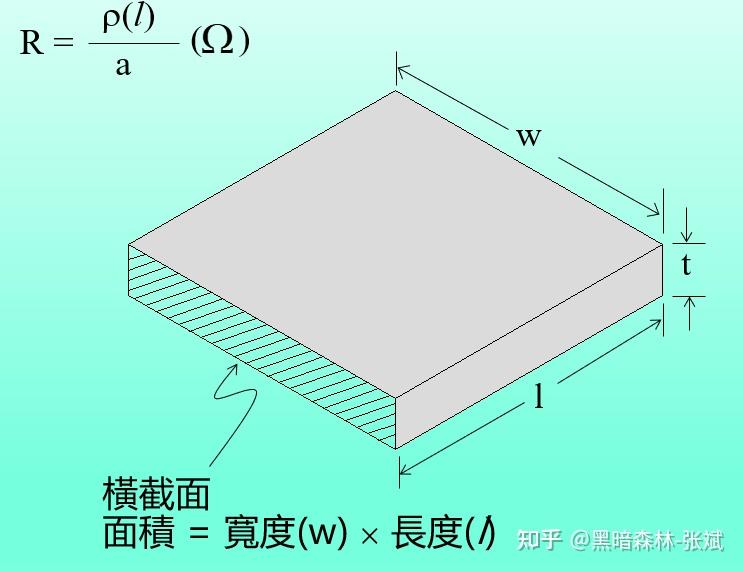
四点探针
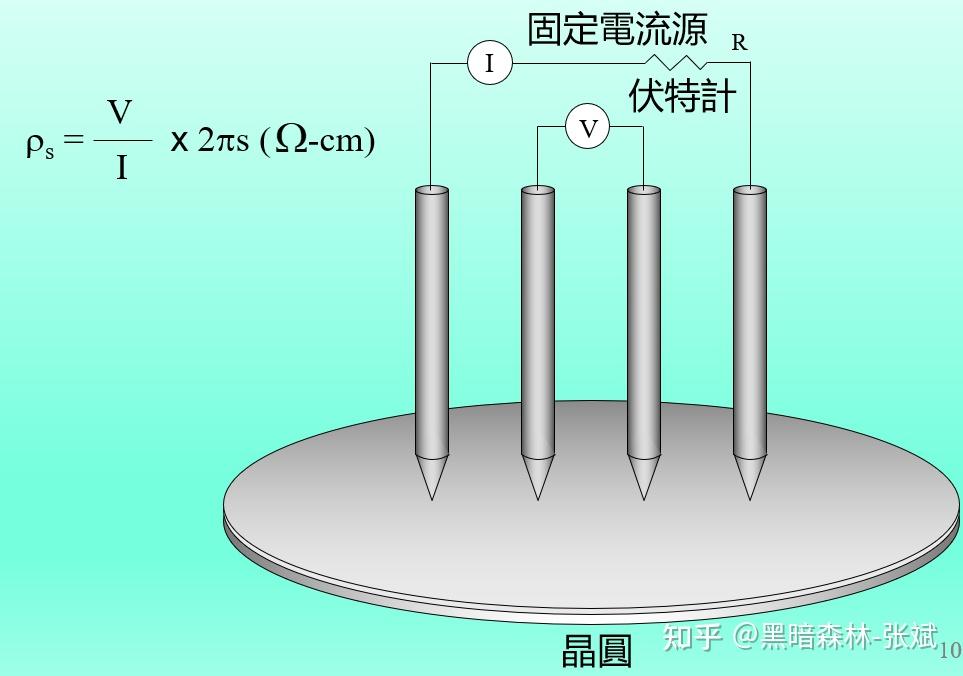
范德波片电阻率
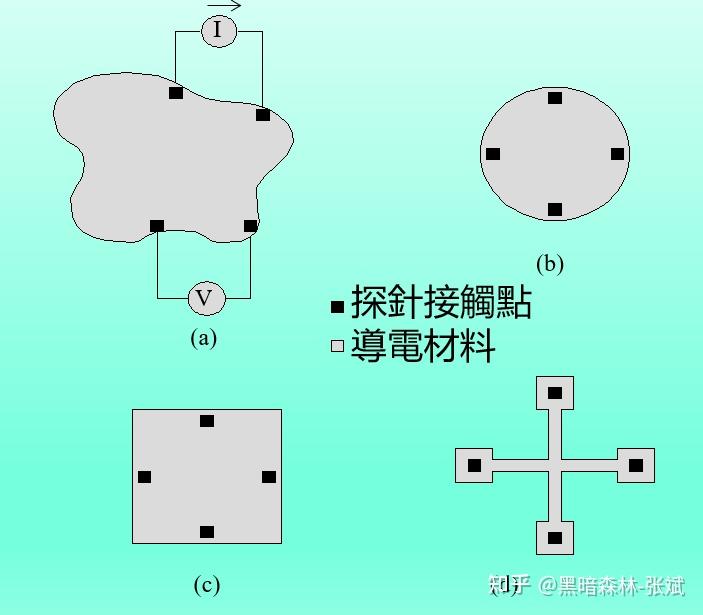
片电阻轮廓图

椭圆偏光仪的基本原理

薄膜层的光反射

XRF的薄膜厚度量测
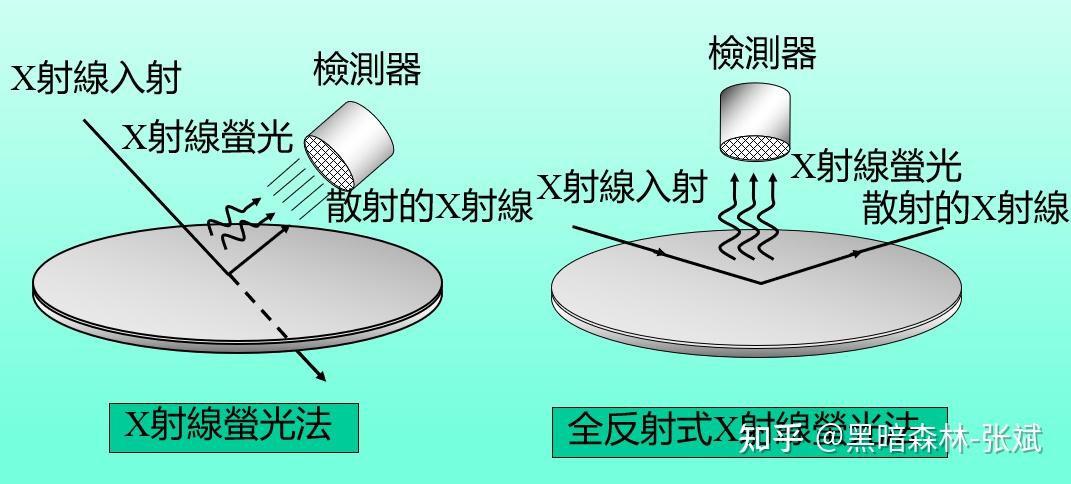
光声薄膜厚度量测
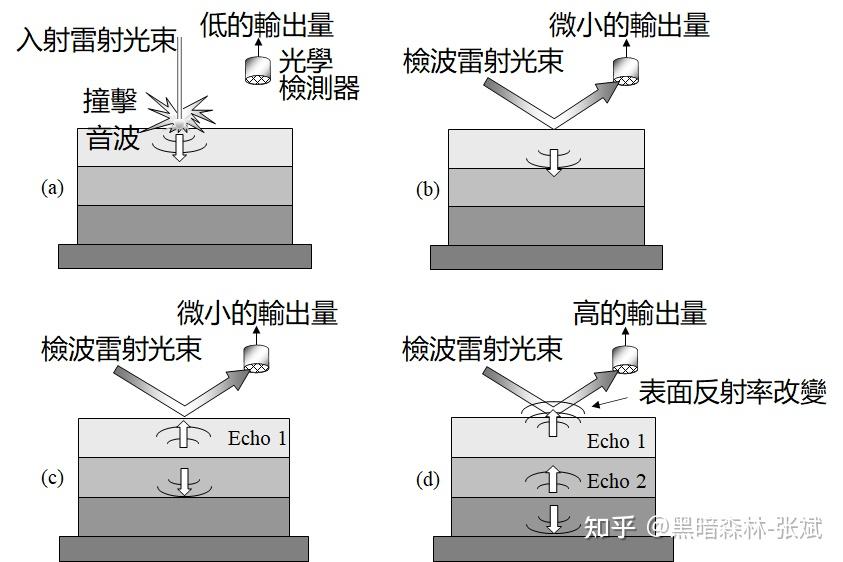
晶片的详细应力图

折射圆
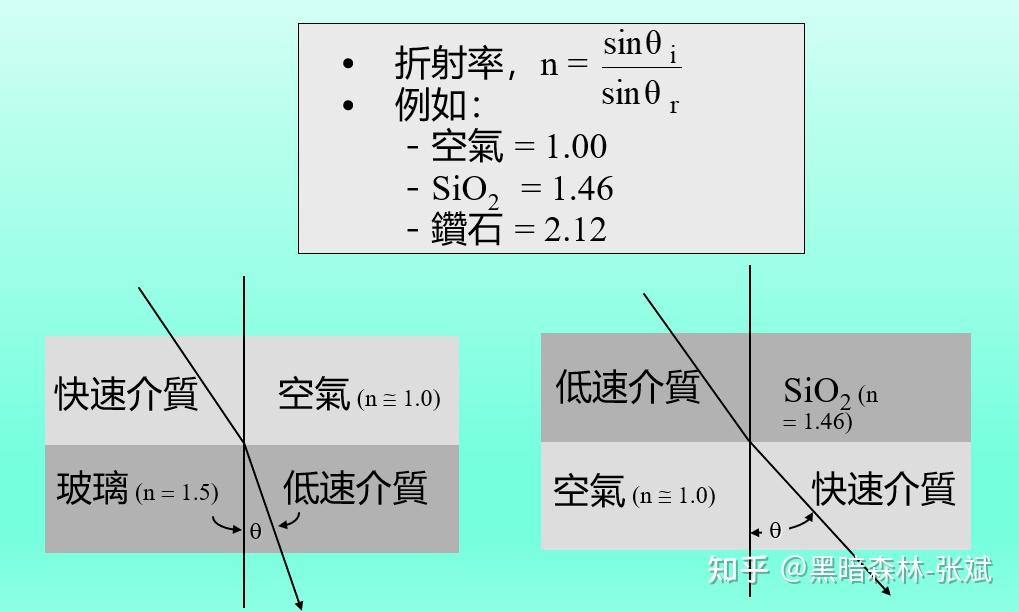
PN接面
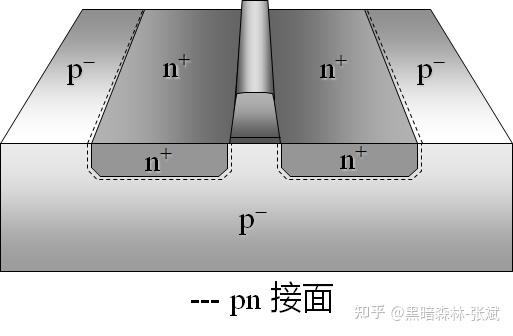
量测掺杂浓度的热波系统
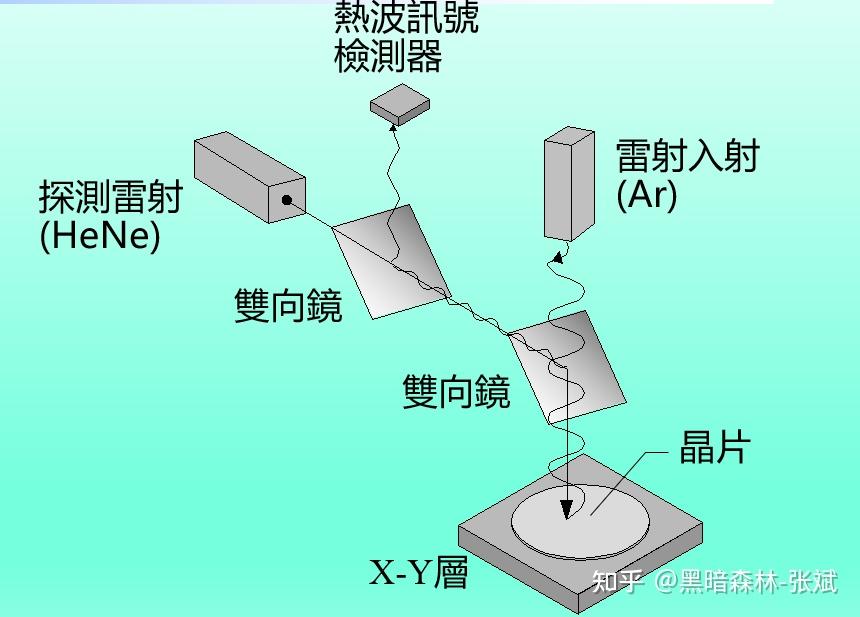
散布电阻探针
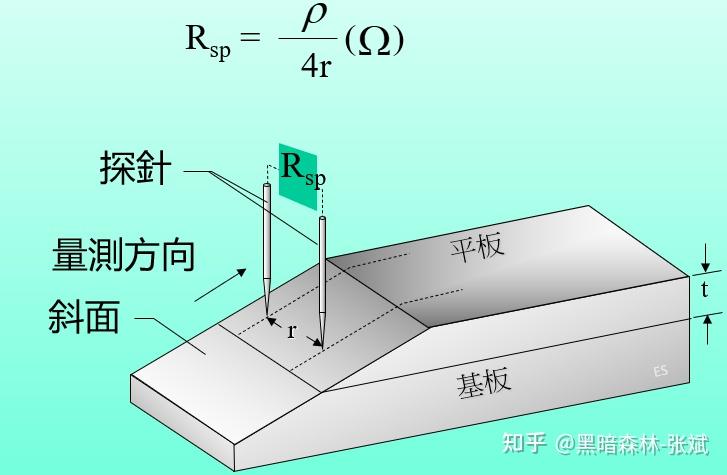
表面缺陷
1、未图案化表面缺陷
(1)光学显微镜(光学系统)
(2)光散射缺陷侦测(每片晶圆通过制程的微粒数)
2、图案化表面缺陷:图案化晶圆的光散射
暗场及亮场团侦测
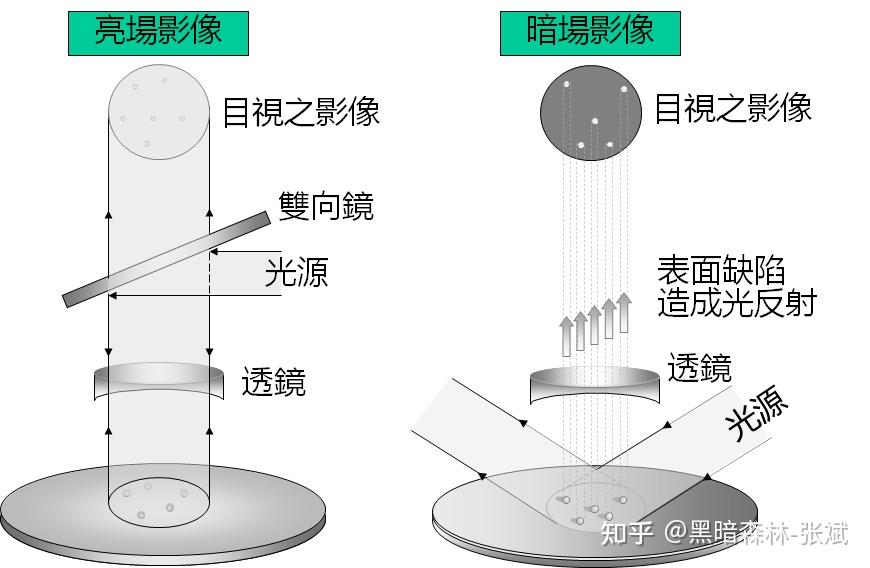
晶片检验系统

光学系统图解

共焦显微镜的原理
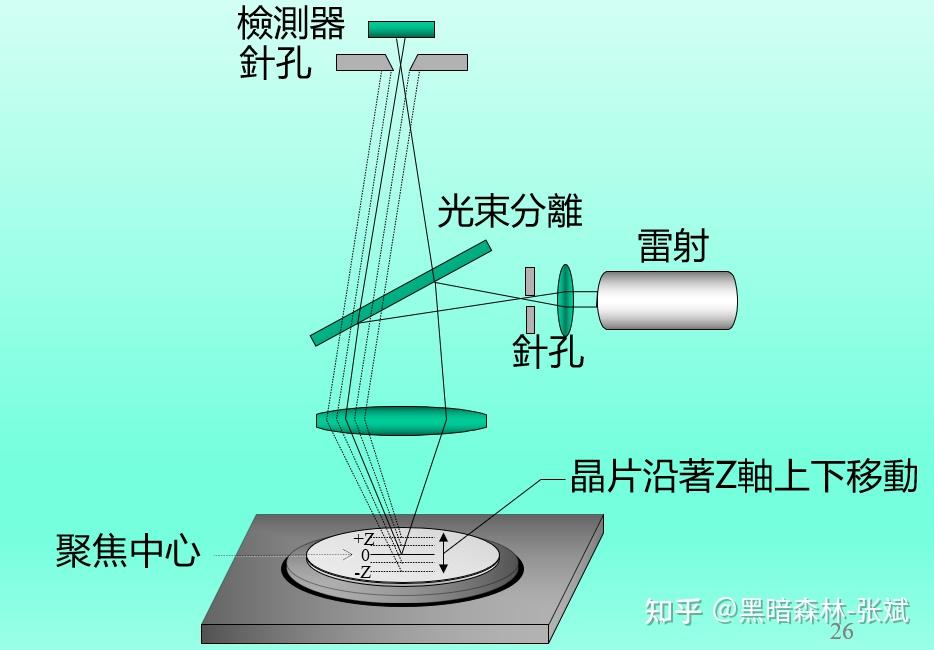
利用光散射侦测微粒
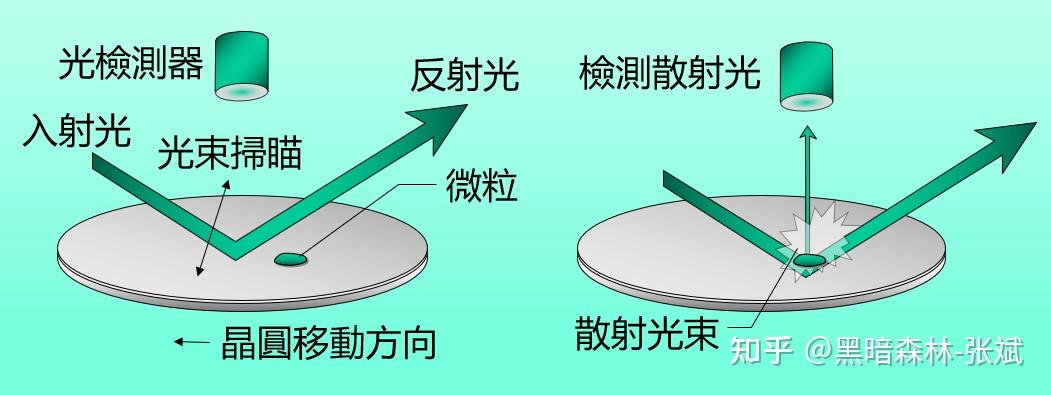
微粒分布图

其他量测设备
1、临界尺寸(CD):扫描式电子显微镜、CD SEM
2、阶梯覆盖
3、重叠对准
4、电容-电压测试
5、接触角度
CD SEM的简要概略图
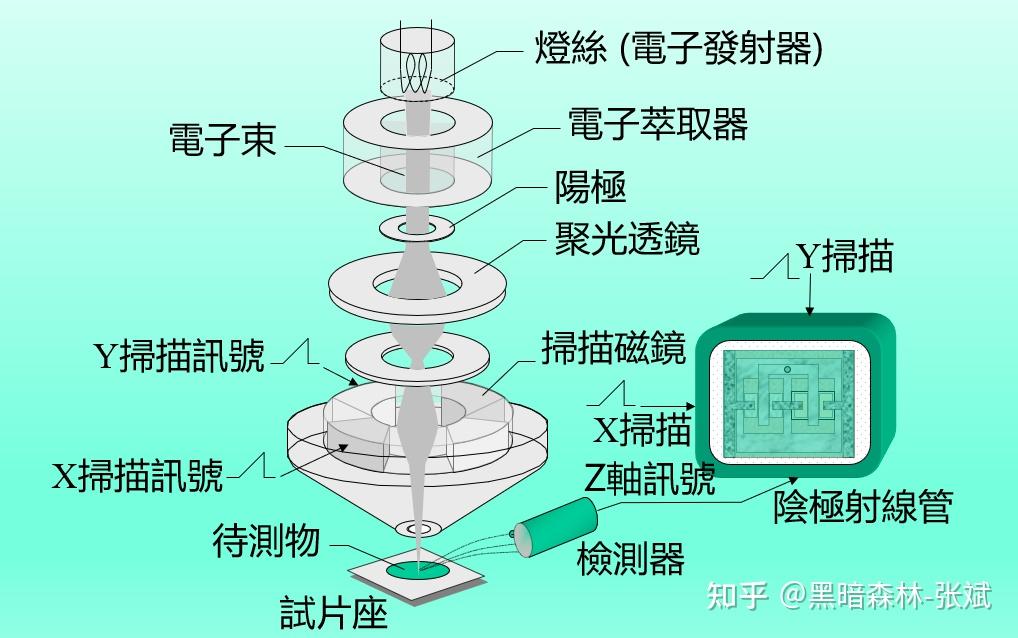
阶梯覆盖
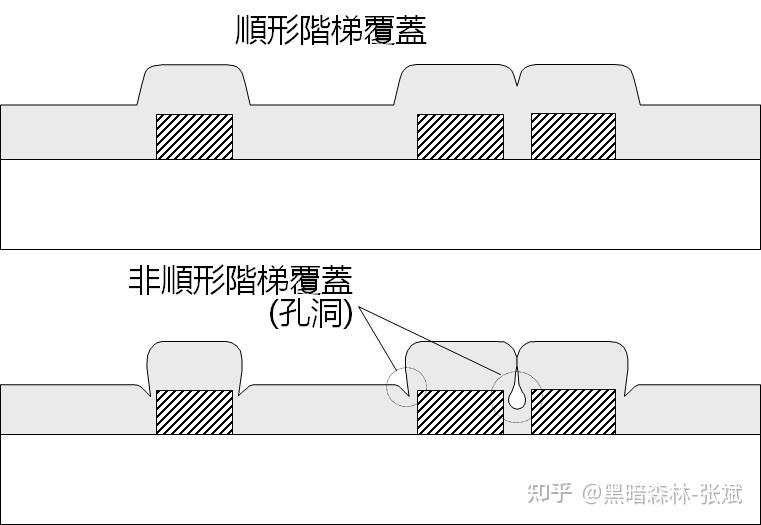
表面轮廓
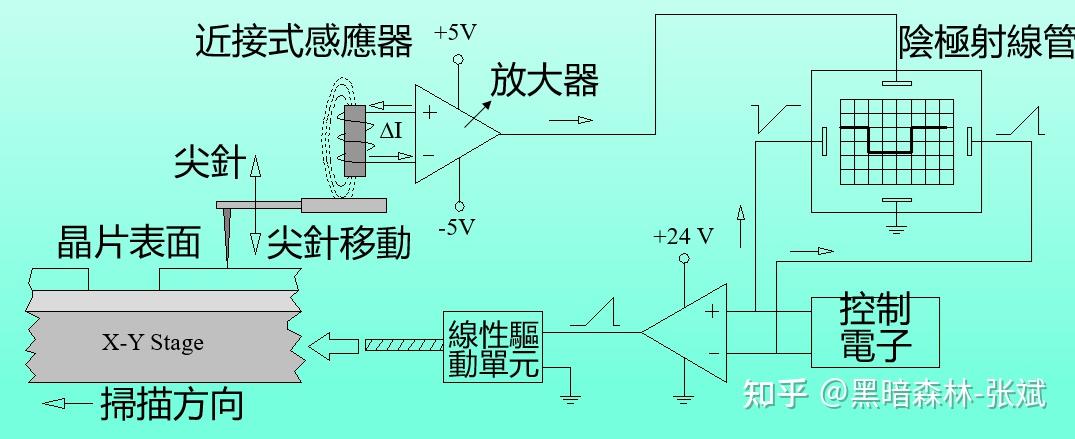
重叠对准图示
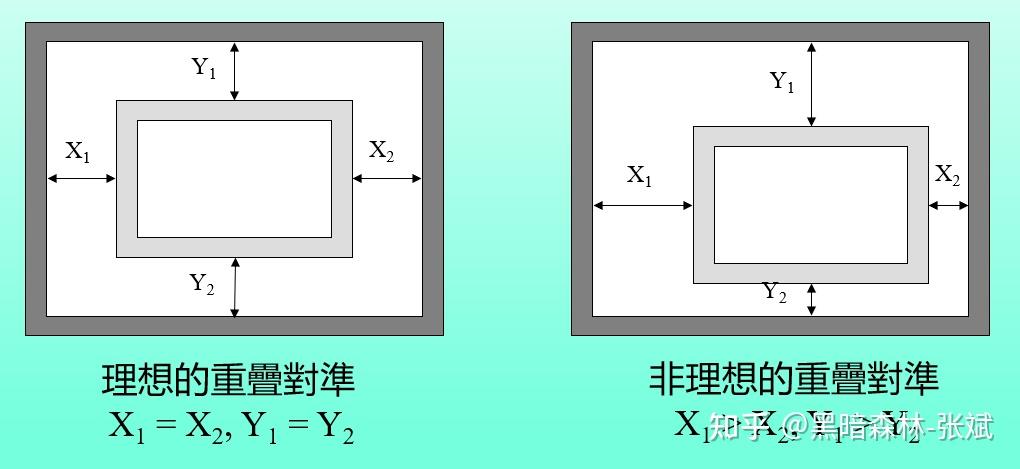
C-V测试设定和略图
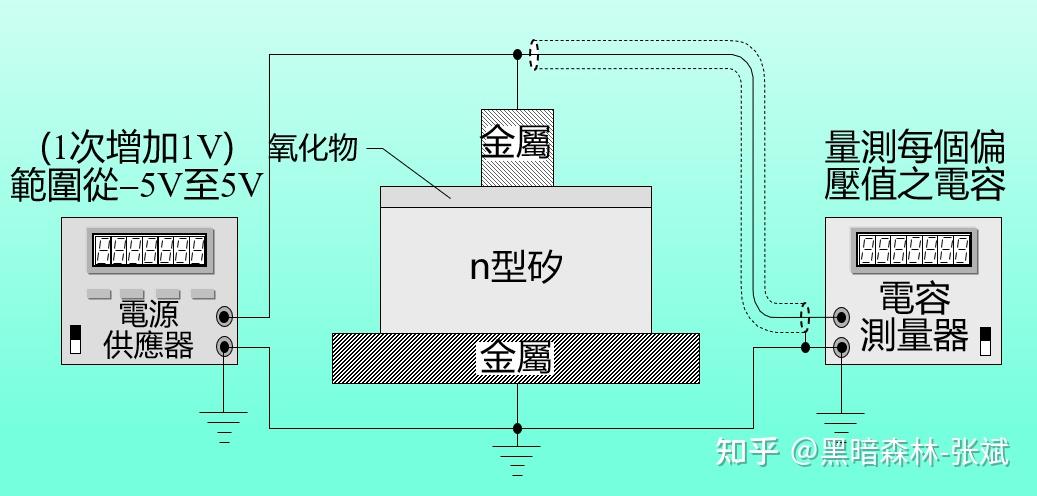
发布


























 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








