碳化硅功率器件具有耐高压、开关速度快和导通损耗低等优点,因此正在逐渐成为电力变换系统的核心器件,尤其在新能源汽车、可再生能源、储能、数据中心、轨道交通和智能电网等领域,器件的应用越来越广泛。碳化硅作为宽禁带半导体的代表,理论上具有极其优异的性能,有望在大功率电力电子变换器中替换传统硅 IGBT,进而大幅提升变换器的效率以及功率密度等性能。
在工业电源、电动汽车与航空航天领域,碳化硅(SiC)功率器件的高效率与耐高温特性正逐步替代传统硅基器件。然而,SiC芯片的高功率密度与高温运行需求,对封装技术提出了前所未有的挑战——传统焊料在高温下易疲劳失效,成为制约性能释放的关键瓶颈。
银烧结技术凭借低温工艺与超高可靠性,成为解锁SiC潜力的‘银钥匙’。爱仕特基于此技术开发的碳化硅模块,已在多个应用场景中验证其性能优势,为行业提供高效、稳定、可靠的解决方案。


34mm模块特点:1. 采用全焊片工艺,Cu底板+低热值AlN绝缘陶瓷;
2. 高功率密度,低寄生电感,低开关损耗;
3. 适用高温、高频应用;
4. 参数表现: VDS:650~1700V ID:30~300A RDS(on) :4~80mΩ


62mm模块特点 1. 采用全焊片工艺,Cu底板+低热值AlN绝缘陶瓷;
2. 高功率密度,低寄生电感,低开关损耗;
3. 适用高温、高频应用;
4. 参数表现: - VDS:650~1700V - ID:30~600A - RDS(on) :2~80mΩ

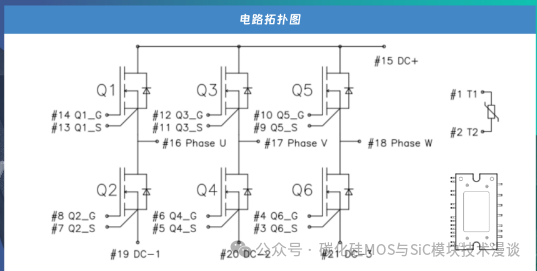
D21系列碳化硅模块的性能特点:高性能封装技术:采用高导热性AlN陶瓷基板,内置NTC,实现高效散热 高开关速度:碳化硅材料的高电子迁移率,提升系统响应速度和动态性能 高功率密度:搭载第三代自研碳化硅芯片,实现小尺寸下的大电流承受能力 低寄生电感设计:紧凑内部布局,降低功率回路中的寄生电感


DCS12模块特点 1. 采用单面水冷+模封工艺,最高工作结温175℃;
2. 功率密度高,适用高温、高频应用,超低损耗;
3. 集成NTC温度传感器,易于系统集成;
4. 参数表现: - VDS:650~1700V - ID:400~800A - RDS(on) :1.5~6.2mΩ

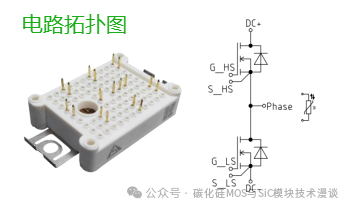
EP模块特点 1. 采用先进的真空回流焊工艺,Al2O3绝缘陶瓷,最高工作结温150℃; 2. 高功率密度,低寄生电感,低开关损耗; 3. 适用高温、高频应用; 4. 集成NTC温度传感器,易于系统集成; 5. 参数表现: - VDS:650~1200V - ID:30~200A - RDS(on) :6~80mΩ


MD3模块特点 1. 采用真空回流焊工艺,AlSiC底板+低热值AlN绝缘陶瓷,最高工作结温175℃; 2. 第三代模块寄生电感低于10nH,比现有模块小50%以上,降低开关损耗; 3. 适用高温、高频应用,超低损耗; 4. 集成NTC温度传感器,易于系统集成; 5. 参数表现: - VDS:650~1700V - ID:300~800A - RDS(on) :1.7~8.3mΩ


MED模块特点 1. 采用真空回流焊工艺,Cu底板+低热值AlN绝缘陶瓷,最高工作结温175℃; 2. 功率密度高,适用高温、高频应用,超低损耗; 3. 集成NTC温度传感器,易于系统集成; 4. 常关功率模块,零拖尾电流,寄生电感小于15nH,开关损耗低;
5. 参数表现: - VDS:650~1700V - ID:270~800A - RDS(on) :1.5~8.7mΩ

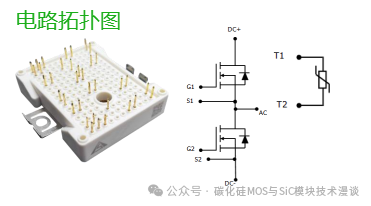
MEP模块特点 1. 采用先进的真空回流焊工艺,Al2O3绝缘陶瓷,最高工作结温150℃; 2. 高功率密度,低寄生电感,低开关损耗; 3. 适用高温、高频应用; 4. 集成NTC温度传感器,易于系统集成; 5. 参数表现: - VDS:650~1700V - ID:30~300A - RDS(on) :4~80mΩ
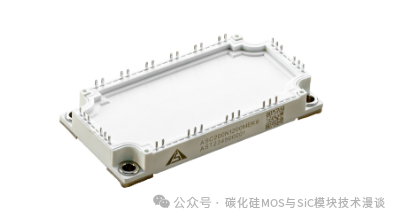

MEK6模块特点1. 最高工作结温175℃; 2. 高功率密度,低开关损耗; 3. 适用高温、高频应用; 4. 参数表现: - VDS:650~1700V - ID:100~300A - RDS(on) :3~25mΩ



HPD模块特点 1. AlN+AlSiC散热,最高工作结温175℃;
2. 第三代模块寄生电感低于10nH,比现有模块小50%以上,降低开关损耗;
3. 参数表现: - VDS:650~1700V - ID:400~800A - RDS(on) :1.5~6.5mΩ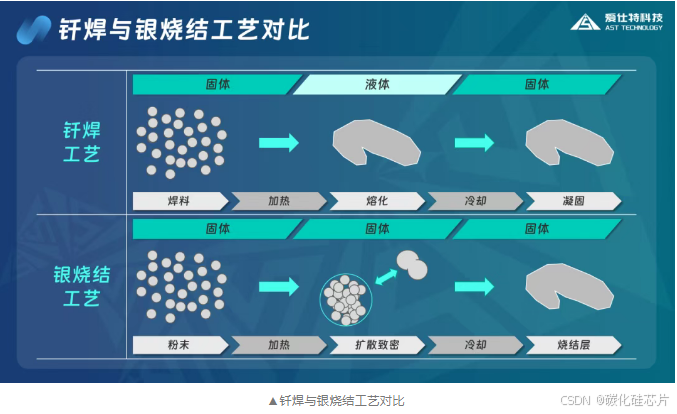
银烧结如何解决SiC器件的关键问题?
· 高温稳定性:烧结温度低于250℃,避免芯片热损伤;连接层在200℃以上仍能稳定工作。
· 高效散热:优化单面散热设计,热阻降低至0.1℃/W(传统焊料>0.3℃/W)。
· 抗疲劳性:弹性模量低,抵御热循环应力,寿命比传统焊料延长5倍以上。
高精简四步工艺流程
· 衬板印刷:银膏厚度误差<3%,确保SiC芯片与陶瓷基板的低阻抗连接,适配车规级模块设计。
· 银膏固化:梯度预热工艺去除溶剂,抑制气泡生成,提升结构致密性。
· 芯片贴装:±10μm精度满足高密度封装需求,适配高频、高压场景。
· 加压烧结:通过低温和压力辅助烧结,孔隙率<3%,支持双面散热设计。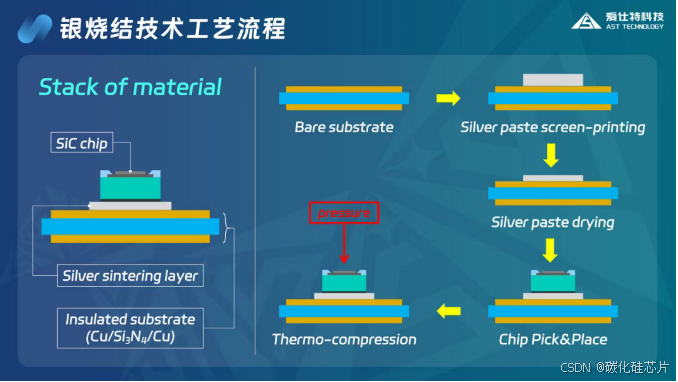

结论
碳化硅功率模块的冷却系统设计已经逐渐成为其应用的关键组成部分,为满足日益增长的功率密度和模块可靠性需求,先进热管理技术必须与其封装紧密结合,才能获得最大收益。




























 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








