书籍:《炬丰科技-半导体工艺》
文章:EUV光刻中的随机效应
编号:JFKJ-21-647
作者:炬丰科技
关键词:随机效应、随机印刷故障、缺失触点、微桥、诺克度量、斯托查利斯、实际光盘分辨率极限
摘要
本文主要研究随机印刷故障,如空间中的微桥或随机缺失触点。本文用一个称之为NOK(不确定)的度量来量化这种故障,这个度量本质上代表了故障概率。本文使用一个名为Stochalis的内部软件包,通过扫描电镜图像分析来测量这个NOK量。本文将论证这种失效概率的最基本的依赖性是它的CD依赖性:NOK(CD)。使用目前可用的光盘扫描电镜或电子束检测工具,现在可以将这种氮氧化物(光盘)依赖性测量到ppm-ppb水平。这不足以证明或否定产量,但NOK(CD)函数是比较材料和条件的极好工具,即。量化对图案化条件的敏感性并显示改进方向。本文将举例说明剂量、间距、抗蚀剂、蚀刻和照明模式的影响。本文还将展示从非常局部到全局的光盘非均匀性如何进一步影响局部故障概率。最后,本文将讨论随机故障概率和光盘非均匀性一起,在光盘和音高上设置实际分辨率限制。这些限制不是绝对的,因为它们取决于图案设置和使用的材料,但是在设置EUVL工艺时,需要非常仔细地考虑它们。
介绍
岩性1中的术语“随机效应”是指发生在原则上应完全相同的结构之间的随机局部变化。“传统的”LWR和LCDU指标量化了由此产生的局部CD可变性。但比局部光盘可变性严重得多的是局部印刷故障,例如空间中的微桥或触点缺失,因为它们直接影响产量。当图案尺寸变得非常小时,这种随机印刷故障开始发生。随着EUV的引入,目标尺寸大幅跃升至更小的值,这意味着随机故障现在更接近甚至出现在临界尺寸目标和标称条件下。因此,对随机故障的研究,即它们开始出现的时间,它们依赖于什么,以及如何将其最小化,就成为一个非常重要的问题。这是本文的主题。
在本文中,本文将首先简要地提醒本文已经介绍的用于量化随机故障的度量,一种称为——诺克(不正常)。
诺克:量化随机印刷故障的度量标准

说明了信用证和接触式或点式印刷的挪
威克朗印刷失败标准的定义。本文使用一个名为Stochalis的内部软件包来进行图像分析。Stochalis自动运行许多扫描电镜图像,在检测到故障的地方放置一个标记,并从名义上相同的结构计算所有图像的像素点或点。

诺克(光盘):依赖关系
长期以来,人们已经知道并理解了暴露剂量对EUV随机理论的影响,因此本文描述了一个实验,本文做这个实验是为了量化剂量大小对LWR的影响,通过选择固定的掩模结构,并将其暴露于相同的晶片CD,对每种抗蚀剂使用适当的剂量,我们有效地生成了恒定CD下的pixNOK(剂量-尺寸)曲线。正如所预期的,随机失效概率非常强烈地依赖于剂量。当剂量从~25 mJ/cm2增加到~70 mJ/cm2时,pixNOK下降3个数量级以上.这非常清楚地表明,剂量是对抗随机故障的非常强的武器,在设置任何关键的EUV应用时都应该仔细考虑,即使较高的剂量不可避免地也会导致较低的吞吐量。因此,在吞吐量和现场之间找到正确的平衡是每个应用程序需要解决的重要问题之一。
当然,除了剂量-大小之外,抗蚀剂还有许多影响其随机失效性能的特性。
还有一个重要的问题是,在蚀刻过程中,在石层面观察到的随机故障如何转移(或不转移)预期至少一些故障(例如非常窄的微桥)不能在蚀刻过程中“存活”。
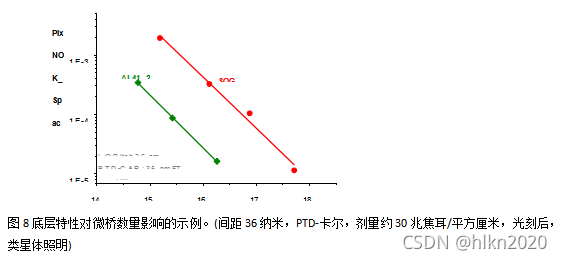
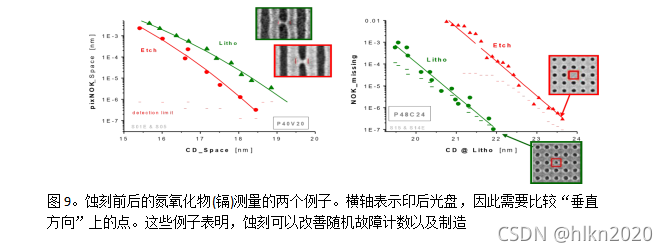
总结
本文中的数据,以及我们之前的工作和许多其他人的工作都向我们展示了这一点,随机印刷故障是现实,并已成为EUV石印15的主要问题。随机故障一直存在,但它们过去主要发生在远离标称运行条件的地方。因此,随机印刷故障会对产量产生很大影响,并因此对最小产量光盘和产量间距设定了新的实际限制。根据我们自己的研究结果,并利用当前的EUV工具和材料,我们估计实际的间距分辨率极限对于L/S结构在32-36 nm范围内,对于触点在36-40 nm间距范围内。幸运的是,随机故障可以通过基于扫描电镜的工具、光盘扫描电镜或EBI型工具来检测,使用“车载”或离线软件来检查图像。(对于光盘扫描电子显微镜图像,后期平版印刷或后期蚀刻,我们使用我们自己的内部软件包,称为Stochalis。
























 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








