倒装铝基板之倒装芯片技术概述
倒装芯片(FC)不是特定的封装(如SOIC ),甚至是封装类型(如BGA )。 倒装芯片描述了将管芯与封装载体电连接的方法。 封装载体,衬底或引线框,然后提供从管芯到封装外部的连接。 在“标准”封装中,裸片和载体之间的互连使用导线制成。 将模具面向上连接,然后将导线首先粘合到模具上,然后环绕并结合到载体上。 电线长度通常为1-5毫米,直径为15-35微米。 相比之下,倒装芯片封装中的管芯和载体之间的互连通过直接放置在管芯表面上的导电“凸点”来实现。 碰撞的模具然后“翻转”并且面朝下放置,凸块直接连接到载体。 凸块通常为60-100μm高,直径为80-125μm。 倒装芯片连接通常由两种方式形成:使用焊料或使用导电粘合剂。 到目前为止,最常见的封装互连是焊料。
当前的焊料选择是:共晶Sn / Pb,无铅(98.2%Sn,1.8%Ag)或Cu柱组成。 焊料凸起的裸片通过焊料回流工艺附接到基板,非常类似于将BGA球附接到封装外部的工艺。 在模具被焊接之后,在模具和衬底之间加入底部填充物。
底部填充物是一种专门设计的环氧树脂,其填充模具和载体之间的区域,围绕焊料凸块。 其设计用于控制由硅晶片和载体之间的热膨胀差引起的焊点中的应力。 一旦固化,底部填充物将吸收应力,减少焊料凸块上的应变,大大增加了成品包装的使用寿命。 芯片连接和底层填充步骤是倒装芯片互连的基础。 除此之外,围绕模具的封装结构的其余部分可以采取许多形式,并且通常可以利用现有的制造工艺和封装形式。
最近的倒装铝基板的封装解决方案介绍已经开始使用称为TCNCP(热压缩非导电糊)的替代的倒装芯片互连技术。 TCNCP而不是两步焊接 - 底部填充工艺,而是在一个步骤中完成。 焊接尖端的非熔化铜柱凸起被推入液态环氧树脂底部填充物中,然后施加热量以形成冶金结合并固化环氧树脂。 使用TCNCP + Cu柱可以通过保持间隙和减少短路问题来实现更好的凸点间距几何形状。
关于FC-BGA基板
FC-BGA(Flip Chip-Ball Grid Array)基板是能够实现LSI芯片高速化与多功能化的高密度半导体封装基板。
凸版利用独创发展的微细加工技术和积层布线板技术,开发了超高密度布线结构基板,提供支持半导体工艺微细化需求的产品。
本公司提供从基材设计到制造的全方位支持,需求客户对LSI的多样化应用需求,除PC和游戏机用微处理器和图形处理器外,还包括服务器、人工智能和网络设备用高端处理器,以及高品质车载SoC。
此外,本公司还能够满足无铅及无卤素的需求。
转自:https://www.toppan.co.jp/electronics/sc/semicon/package/fc-bga/
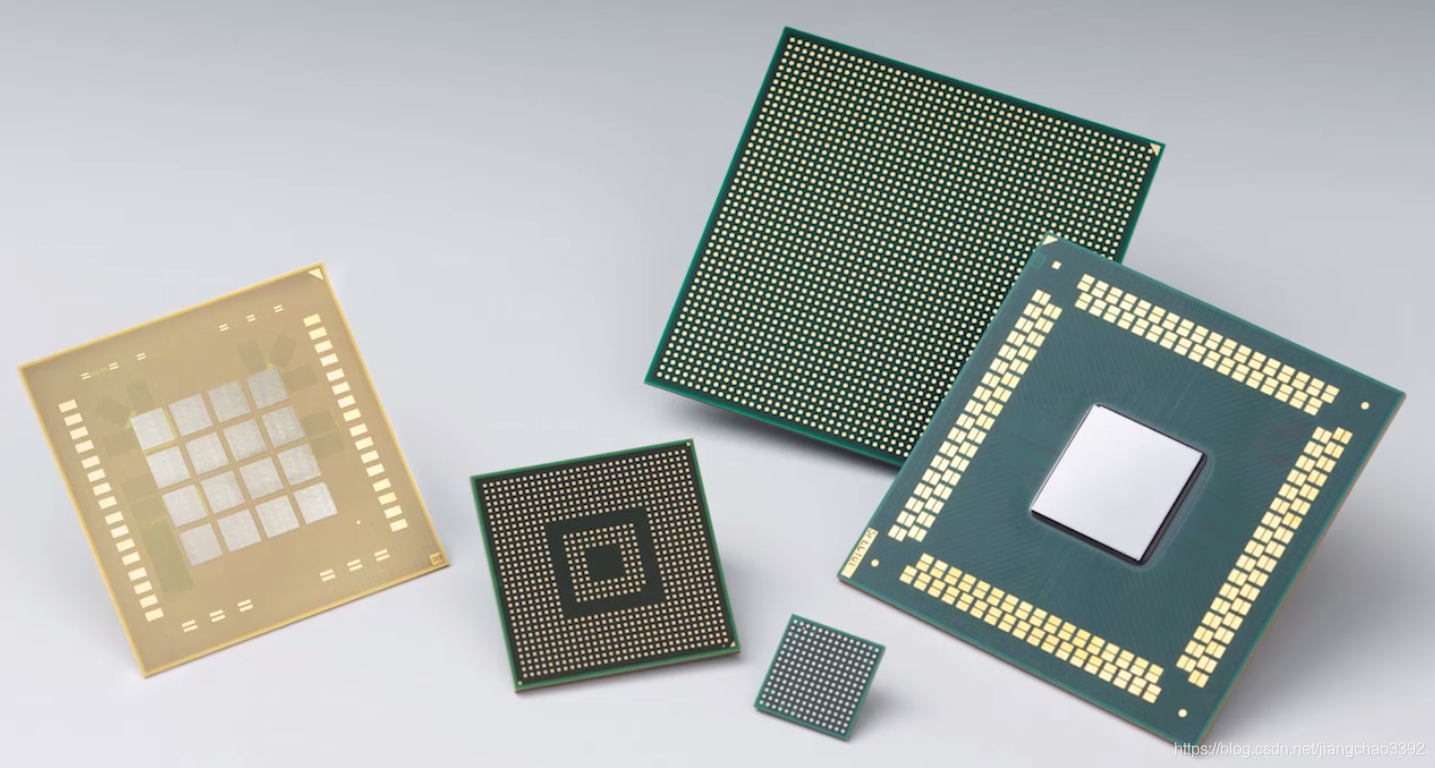

FC-BGA的结构
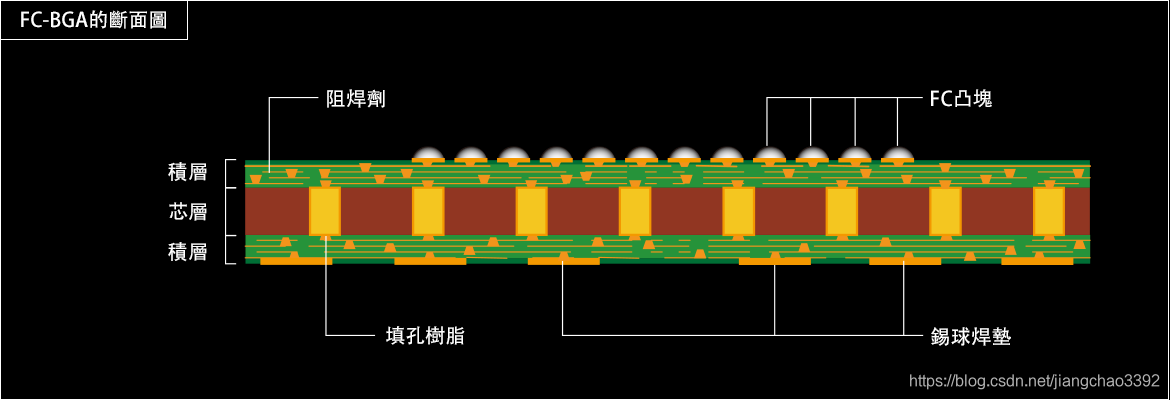
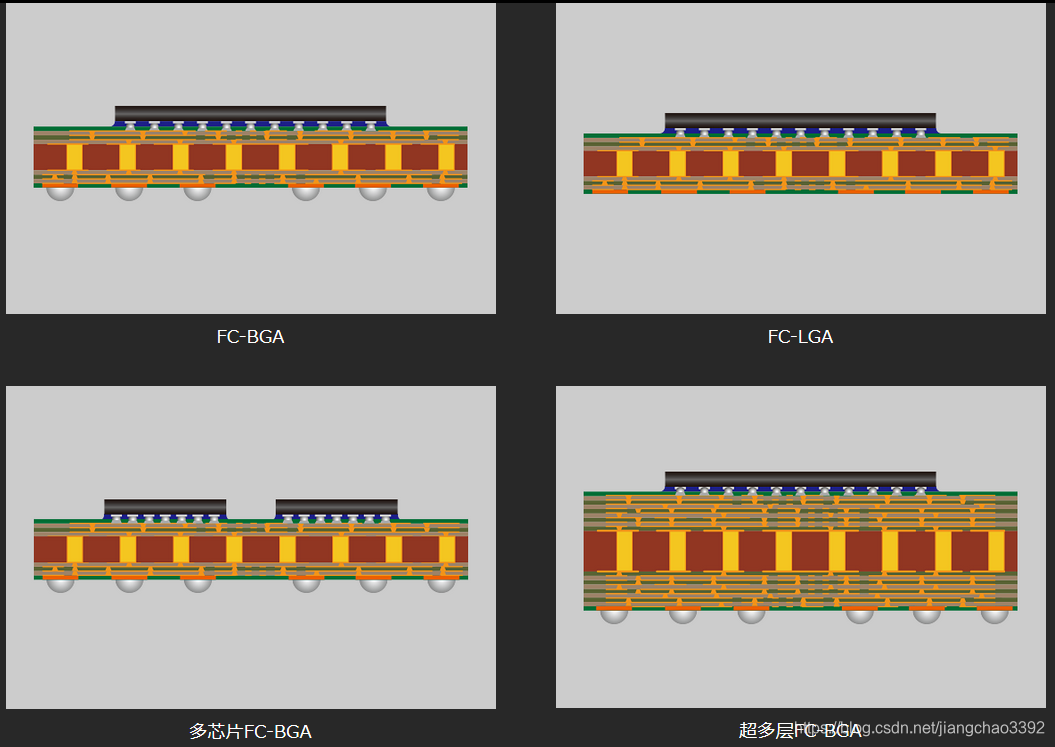
参考:https://www.sohu.com/a/194042900_657428
https://baike.baidu.com/item/FC-BGA%E5%B0%81%E8%A3%85/7379341?fr=aladdin


























 1954
1954

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








