厚铜板(铜厚≥3oz)的PCB打样需求显著增长。本文针对4-8层厚铜板的层压工艺,解析树脂流动性控制与固化参数匹配的核心技术要点。
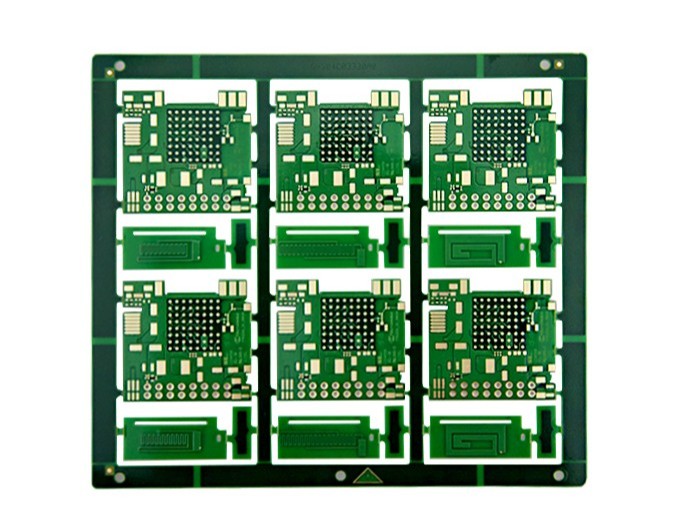
一、树脂流动性的关键控制要素
-
半固化片选型策略
厚铜板推荐使用高树脂含量(55%-65%)的1080或2116材质半固化片,其流动度需控制在25-35%区间。对于内层铜厚≥5oz的板件,需采用非流动性PP片(如生益SP120N),其树脂流动度<10%,可避免压合时树脂过度流失导致的填胶不足。 -
温度曲线设计原则
-
预升温阶段(50-140℃):采用1.5-2℃/min的缓升速率,确保树脂均匀浸润铜面
-
流动窗口期(140-160℃):维持30分钟,此时树脂黏度降至50-80Pa·s,流动性达到峰值
-
固化阶段(170-180℃):快速升温至5℃/min,配合压力提升实现树脂交联固化
-
-
压力分段实施方法
-
初压阶段(50-100PSI):排出层间气泡,持续10-15分钟
-
主压阶段(200-300PSI):强制树脂填充0.3mm以上的线路间隙,时长40-60分钟
-
终压阶段(50PSI):平衡板内应力,防止铜箔变形
-
二、厚铜板固化参数优化方案
-
升温速率与铜厚的对应关系
铜厚升温速率(℃/min)树脂类型3-5oz2-37628半固化片6-8oz1.5-22116半固化片≥10oz1-1.5非流动型PP片
-
真空辅助压合技术
采用-80kPa真空度可减少30%的气泡缺陷,尤其适用于内层残铜率<40%的厚铜板。需注意铜箔厚度对压力传递的影响:1oz铜箔需降低10%压力值,避免压溃内层线路。 -
热应力平衡措施
-
铜板黑化处理:增加铜面粗糙度至Ra 0.8-1.2μm,提升树脂结合力
-
缓冲层配置:在钢模与板件间添加2mm硅胶垫,可降低50%的层间剪切应力
-
阶梯冷却工艺:从180℃以5℃/min降至120℃,再自然冷却至室温,减少Z轴膨胀系数差异
-
三、典型工艺缺陷及解决方案
-
填胶不足(Void)
成因:树脂流动度过低(<20%)或主压阶段温度不足
对策:-
改用1080高树脂含量材料
-
在140℃时施加200PSI冲击压力
-
-
层间滑移(Layer Shift)
成因:树脂流动度过高(>40%)或定位方式不当
对策:-
采用热熔胶+铆钉复合定位
-
在无铜区增加铺铜平衡点
-
-
白斑(White Spot)
成因:挥发物含量>0.3%或冷却速率过快
对策:-
压合前烘板(120℃×4小时)
-
延长180℃恒温时间至90分钟
-
四、生产验证与参数监控
-
实时监测指标
-
树脂黏度变化曲线(目标值:160℃时<100Pa·s)
-
压力分布均匀性(板内四点压差<10PSI)
-
层间温度梯度(≤3℃)
-
-
可靠性测试标准
-
热应力测试:288℃±5℃浸锡10秒×3次,无分层
-
电流温升:100A持续通电1小时,温升<30K
-
耐压测试:AC 3000V/1min无击穿
-
通过实时采集20组工艺数据,可自动优化树脂流动窗口期。配合非破坏性X-Ray检测技术,能将层压良率提升至98.5%以上,满足车规级PCB的可靠性要求。

























 504
504

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








