实验名称:半导体封装实验
1. 实验目的:
- 根据热敏电阻的伏安特性和电阻温度特性,根据设计要求制订设计方案,标定温度计。
- 了解非平衡电桥的工作原理及其在非电量电测法中的应用。
2. 实验器材:
扩晶机
离子风机
显微镜
微电脑自动点胶机
电热鼓风烘干箱
半自动超声波金丝球焊机
真空烘干箱
玻璃烧杯
搅拌棒
AB胶
针管
模具和铝船
脱模机
一切机
测试机
二切机
扩晶环
刺晶笔
支架
刺晶座
芯片
3. 实验原理
LED封装主要是提供LED芯片一个平台,让LED芯片有更好的光、电、热的表现,好的封装可让LED有更好的发光效率与好的散热环境,好的散热环境进而提升LED的使用寿命。LED封装技术主要建构在五个主要考虑因素上,分别为光学取出效率、热阻、功率耗散、可靠性及性价比(Lm/$)。
以上每一个因素在封装中都是相当重要的环节,举例来说,光取出效率关系到性价比;热阻关系到可靠性及产品寿命;功率耗散关系到客户应用。整体而言,较佳的封装技术就是必须要兼顾每一点,但最重要的是要站在客户立场思考,能满足并超出客户需求,就是好的封装。
针对LED的封装材料组成,LED封装主要是由基板、芯片、固晶胶、荧光粉、封装胶等组成,我们先将芯片利用固晶胶黏贴于基板上,使用金线将芯片与基板作电性连接,然后将荧光粉与封装胶混合,搭配不同荧光粉比例,以及适当的芯片波长可得到不同的颜色,最后将荧光粉与封装胶的混合体灌入基板中,加热烘烤使胶材固化后,即完成最基本的LED封装。

4. 实验内容与步骤
扩晶工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 打开扩晶机控制面板上的电源开关。
3. 打开扩晶机的顶盖。
4. 将扩晶环内环放在托盘上。
5. 打开离子风机的电源。
6. 在离子风机前慢慢将芯片保护膜与芯片分离,并将撕开的芯片朝上放置在托盘上。
7. 放下压圈并钩好拉钩。
8. 缓慢地按“上升”按钮,慢速将芯片扩开至所需间隔(800~1000)μm。
9. 平整地套上扩晶环外环后按“下压”按钮,待内外环完全啮合后松开。
10. 取下已经扩好的芯片,按“下降”按钮,松开压圈,取出多余的空膜片。
点胶工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 默认粘接胶已经注入到点胶机的针管内,支架已经用夹具夹好。
3. 点胶机和显微镜的电源线默认是连接好的。
4. 双击打开显微镜的操作大视图,点击电源开关,打开环形灯的开关。
5. 打开点胶机的电源开关。
6. 实验场景中将支架移动到显微镜的物镜下方,双击打开显微镜,在显微镜的目镜视场中可以清晰的看到支架上所要点胶的位置。
7. 鼠标点击显微镜上方 踏板,开始点胶。
8. 点胶结束取出支架。
刺晶工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 将桌面上的支架放置到显微镜的物镜下方。
3. 将桌面上的刺激笔放置到显微镜的下方。
4. 双击打开显微镜的电源开关。
5. 默认扩晶好的芯片是放置到刺晶座上的,且双击打开刺晶座,提示:“已经扩晶好的芯片凸起的一面向下,并通过调节刺晶座四角上的螺丝,调整刺晶座与支架之间的垂直距离处于2mm~4mm”。
6. 将刺晶座拖动到显微镜物镜下方。
7. 点击显微镜上的刺晶按钮,开始刺晶。
8. 取出刺晶结束的支架。
9. 将刺晶结束的支架放置到烘箱内。
10. 取出烘箱内的支架。
焊接工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 双击打开实验场景中的金丝球焊机,打开金丝球焊机电源。金丝球焊机的工作温度默认设置好,实验中不需要调节。
3. 点击金丝球焊机大视图上的“放置支架”按钮,金丝球焊机的夹具内出现支架。按钮变为“取出支架”。
4. 点击操纵柄上的过片按钮,夹具内的支架就会向右移动。
5. 点击烧球和和焊接按钮,完成焊接操作。
6. 点击按钮,取出焊接好的支架。
封装工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 先将100ml灌封胶的A胶倒入到烧杯中。
3. 将装有A胶的烧杯放入到电热鼓风干燥箱内预热。(125度25分钟)。
4. A胶预热结束以后,将100ml B胶倒入到烧杯内。
5. 用搅拌棒将A胶和B胶搅拌均匀。
6. 将搅拌均匀的灌封胶放入到真空干燥箱内进行抽真空操作。
7. 取出真空箱内的灌封胶,双击打开烧杯,用针管抽取适量的灌封胶。
8. 模具和铝船默认是固定好的。双击打开模条和铝船,进行灌胶操作。
9. 将灌胶完成的模具和支架放入到电热鼓风干燥箱内固化灌封胶(电热鼓风干燥箱 125度45min)。
10. 在常温下冷却一段时间,将支架与模具分离。
11. 在样品分离设备上将冷却之后的支架与模具分离。
切筋工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 双击打开桌面上的LED切筋设备,将分离后的支架放置到设备操作台上。
3. 点击切筋按钮,切筋LED。
4. 检测切筋后的LED。
检测工艺
1. 实验之前提示使用手套、鞋套和防静电服。
2. 双击打开桌面上的LED检测设备,点击按钮放置半成品剪切完成的支架。
3. 通过检测设备检测,支架上的LED是否完好。(仿真实验中默认LED都是好的)。
4. 完成检测之后进行第二次切筋,形成成品。
5. 实验记录


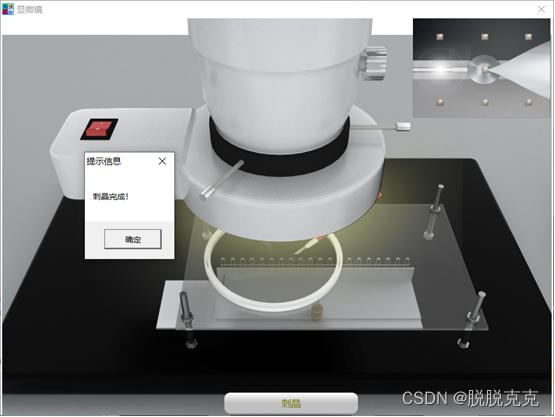
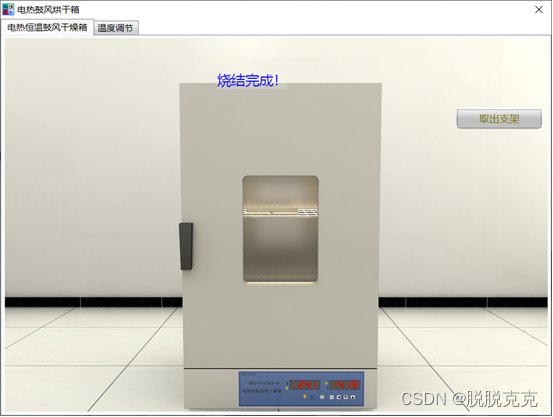


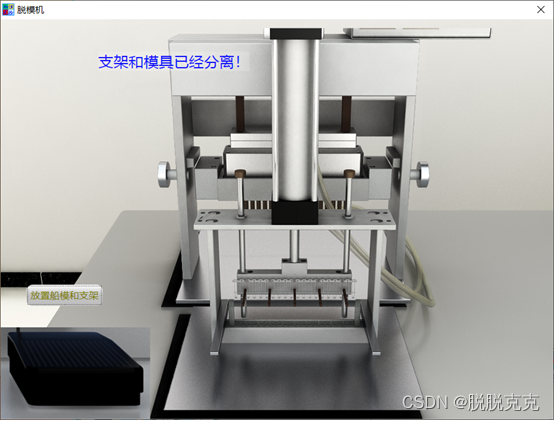
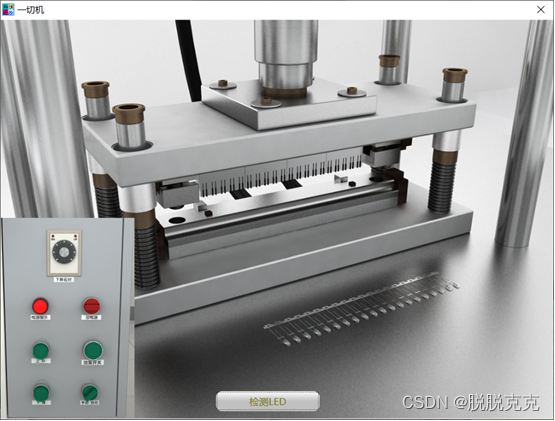
6. 数据处理及误差分析
无
7. 思考题及实验小结
1.芯片应该如何存放?
答:芯片应存放于普通电子干燥箱。 干燥箱的温度应该控制在室内的温度, 约 20~30℃左右,湿度不易大于 40%。
2.为什么要对芯片进行扩晶操作?
答:扩晶也叫绷片,是将原本排列密集在一起的芯片分开至适合刺晶的距离。
3.扩晶工艺对要扩晶的芯片有什么要求?
答:芯片扩晶前间距约为(200~250μm),不宜过大,绷片后芯片不能达到边缘,扩晶前需要进行翻膜工作。
4.扩晶后对芯片与芯片之间间距的要求多大?
800~1000μm
5.扩晶工艺进行前,为什么要进行翻膜操作?
答:为了减少扩晶过程中对芯片边缘的芯片的损耗,减少了后期背胶工序的背胶面积,降低了工序难度。
6.扩晶过程有哪些环节会产生静电?如何避免?
答:(1)人体的摩擦会产生静电,避免方法是佩戴防静电手环。
(2)分离芯片保护膜时会产生静电,避免方法是在分离芯片保护膜时尽量慢,且要对着离子风机。
(3)取下扩晶好的芯片时会产生静电,避免方法带防静电手套。
7.为什么要对生产的芯片进行镜检?
答:对产品进行必要的筛选,通过对芯片的电、光、色、热等参数的测试,剔除废品和次品,提高产品的可靠性和一致性。
8.半导体光电器件产业中,有哪些产品分选的方法?
答:目前光电器件的测试分选可在两个阶段进行:一是以芯片为基础的测试分选,二是对封装好的器件进行测试分选。
9.请说出单面电极芯片与双面电极芯片有哪些区别。
答:单面电极芯片的正负电极位于芯片的同一面上,因而封装时使用的粘结胶可以使用绝缘胶。
双面电极芯片正负电极位于芯片的两个面上,负电极所在的芯片面也起着导电的作用,因而封装时使用的粘结胶要具有导电的性能。
10.半导体光电器件的封装工艺中为什么要进行装架操作?
答:装架也叫固晶、刺晶,是用粘结胶通过加热烧结的方法使芯片牢固的粘结在支架(或PCB板)上,起到固定芯片的作用,对于双面电极的芯片,装架还有一个目的就是使芯片背面电极与支架形成良好的欧姆接触。
11.半导体发光二极管封装工艺中装架时应该选择什么样的粘结材料?封装工艺中使用的粘结胶应该在何环境下贮存?使用前应该对粘结胶进行何种处理?
答;粘结材料除了起到固定芯片作用以外,还要求其在导电、导热、吸潮等方面也能起到一定的作用。性能优异的导电胶不仅要求其粘结能力强,而且要求其导电、导热性好,剪切强度大,流变性好,并且吸潮性好。
不同厂家、不同类型的粘结胶其贮存和使用的条件也是有不同要求的,粘结胶通常要在低温环境下保存,在使用时要提前一定的时啊从冰箱中取出恢复到常温状态(即醒料),才能正常使用。
12.为什么在装架结束后要进行烧结操作?
答:要使粘结胶达到粘结的效果,在装架工艺结束后,必须按照材料的性质进行必要的烧结,才能使得粘结胶固化,芯片才会更牢固地与支架固定,为进行下一步的键合工作做好准备。
13.点胶工艺与背胶工艺各有什么优缺点?应该注意什么?
答:点胶和背胶工艺的目的都是为了涂敷粘结胶,不同的是,背胶可以更快地将胶涂敷到芯片的背面,但是背胶不容易控制胶面的厚度及平整度,点胶尽管比较慢,但是更容易相对精准的控制点胶点及点胶量。
14.如何避免背胶过程中掉片、反片等不良情况的产生?
答:背胶过程要保证胶量要适量,匀胶时要保证胶体均匀,同时在背胶时不要让芯片与胶体长时间接触,背胶过程尽量一次完成,不要多次重复。
15.装架工艺有什么技术要求?
装架工艺对支架及PCB板外观、装架后单芯片外观、粘结胶高度、位置等都有严格的技术要求。
16.画出一个合格的装架效果图。
如图
17.为什么在装架过程中要控制粘结胶的高度?
答:粘结胶过少会导致装架不牢、芯片易掉落等情况,而粘结胶过多则会出现表面不洁、爬胶、短路等现象,因此装架过程要控制粘结胶的高度。
18.列举五种装架失效模式,并写出其处理方法?
答:常见的封装缺陷包括气泡、粘接不良(剥离)、芯片的基片位移和引线弯曲不当。
此外,模制化合物含有杂质或沾污物。这些缺陷可造成塑封开裂、金属化层变形、焊头翘起、互连线腐蚀断开、电气开路、短路或中断等等,因而使器件失效;粘接不良(剥离)是由于引线框架表面受到沾污或在键合温度下受到氧化而造成的。其他原因还包括应力消除不足和脱模剂过量等。在封装过程中,除了应加大工艺控制,如减少封装体内水汽含量,减小金属框架对封装的影响外,对塑封料的选择也是非常关键的。
18.有哪些措施可以有效的控制装架失效情况的发生?
答;在装架过程中严格按照装架的技术要求进行工艺操作,装架后要及时检查,若出现装架不合格的情况,不要放任不合格产品流入下步工序,要及时补救和调整等。
20.在半导体光电器件封装工艺中为什么要进行引线焊接?它有什么作用?
答:引线焊接又叫键合或压焊,通常是采用热超声键合工艺,利用热及超不要放任不合格产声波,在压力、热量和超声波能量的共同作用下,使焊丝在芯片电极和外引线键合区之间形成良好的欧姆接触,完成芯片的内外电路的连接工作,使芯片与产品引脚形成良好的电性能。
21.按焊线形式分,键合工艺可分为哪几类?封装企业常用哪一种?
答:从焊线形式上来划分,键合可分为热压焊、超声楔型焊接、焊三种。封装企业常用自动热超声球焊工艺。
22.简述金丝球焊工作流程。金丝球焊和铝丝焊机的工作流程有什么差别?
答:超声金丝球焊工艺过程可简单表示为:烧球→一焊→拉丝→二焊→断丝→烧球。
铝丝压焊的过程是先在LD芯片电极上压上第一点,再将铝丝拉到相应的支架上方,压上第二点后扯断铝丝。金丝球焊过程则在压第一点前先烧个球,其余过程同铝丝焊类似。
23.引线焊接工艺有什么技术要求?
引线焊接工艺对材料、键合位置、键合焊点形状及尺寸、焊线走向、键合拱丝弧线、键合产品表观等有着严格的技术要求,具体参见“键合技术要求及注意事项”一节。
-
合格的引线焊接的外观如何?画出一个合格的引线焊接效果图
-
有哪些原因会引起键合频繁失线?
A、金丝被污染或金丝品质异常。B、线夹不清洁或是劈刀己经到使用寿命。C、焊线机参数设定不良,参数太小等情况。D、引线框架不平整或表面不洁。 -
列举5种焊接失效模式,并写出其处理方法。
常见的封装缺陷包括气泡、粘接不良(剥离)、芯片的基片位移和引线弯曲不当。
此外,模制化合物含有杂质或沾污物。这些缺陷可造成塑封开裂、金属化层变形、焊头翘起、互连线腐蚀断开、电气开路、短路或中断等等,因而使器件失效;粘接不良(剥离)是由于引线框架表面受到沾污或在键合温度下受到氧化而造成的。其他原因还包括应力消除不足和脱模剂过量等。在封装过程中,除了应加大工艺控制,如减少封装体内水汽含量,减小金属框架对封装的影响外,对塑封料的选择也是非常关键的。 -
在键合工艺过程中可通过控制哪些环节来避免键合失效模式?
在键合过程中严格按照键合的技术要求进行工艺操作,键合后要及时检查,若出现键合不合格的情况,不要敷任不合格产品流入下步工序,要及时补救和调整,这些措施可以有效的控制键合失效情况的发生。






















 1623
1623











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








