关注作者了解更多
我的其他CSDN专栏
关注作者了解更多
资料来源于网络,如有侵权请联系编者
目录
常压化学气相沉积(APCVD)最早的CVD工艺,常用沉积较厚的介质薄膜(如SiO2)
回顾:气相外延(VPE)
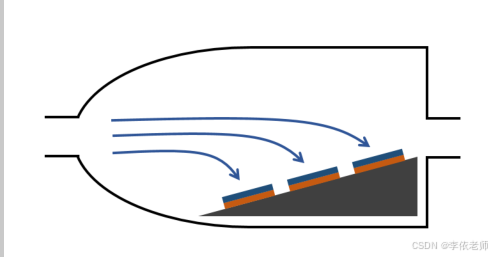

化学气相沉积:定义
化学气相沉积(Chemical Vapor Deposition, CVD)
将气态源材料通入反应器中,通过化学反应进行薄膜沉积的一种集成电路制造单项工艺。
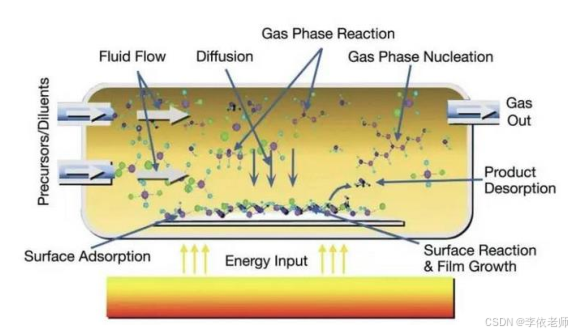
化学气相沉积;特点
沉积薄膜得到的是非晶态或多晶态的薄膜,衬底不要求是单晶材料,只要具有一定的平整度,能够经受沉积温度即可。(沉积温度通常远小于外延温度)
化学气相沉积:分类
按工艺特点分类:
常压化学气相沉积
低压化学气相沉积
等离子增强化学气相沉积
金属有机物化学气相沉积
微波化学气相沉积
按温度特点分类:
低温CVD;
中温CVD;
高温CVD
CVD工艺原理
以多晶硅薄膜为例
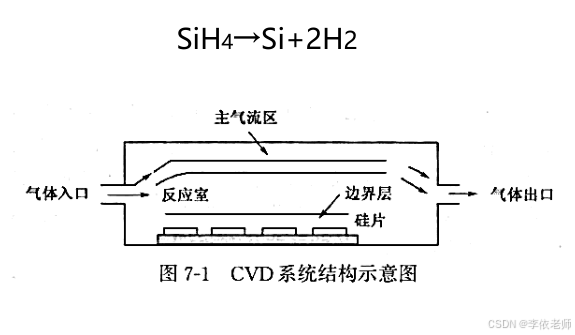
5个基本步骤
1. 通入气体
2. SiH4气体以扩散方式穿过边界层到达衬底表面
3. SiH4与分解的Si吸附在表面
4. 化学反应
5.副产物解吸,扩散,并排出

思考:经过CVD后为什么形成的是多晶硅
1. 衬底温度低,迁移速率小,导致硅原子未能全部迁移到节点位置
2. 沉积速度快
3. 衬底不是单晶
(此三点也显示了CVD与气相外延的不同)

沉积速度与影响因素
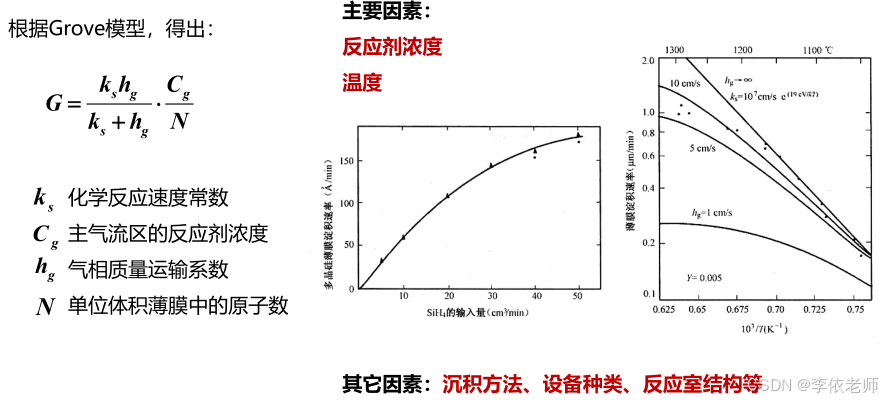
薄膜质量控制
1. 台阶覆盖特性
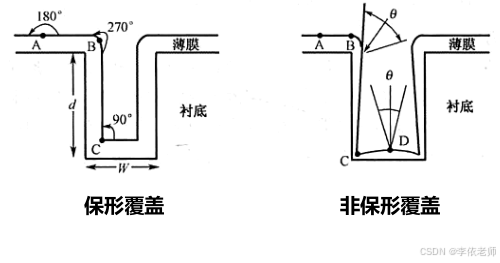
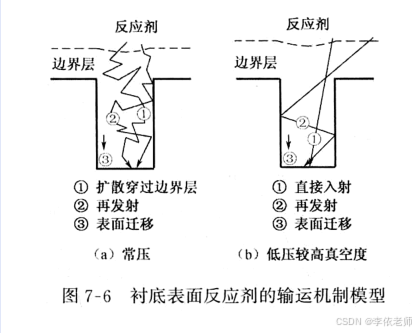
2. 薄膜中的应力
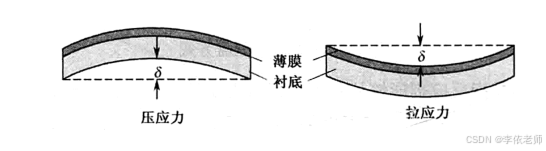
本征应力:薄膜中原子或分子排布混乱引起。可由退火方法释放。
非本征应力:薄膜之外的因素引起,入薄膜与衬底的热膨胀系数不同。
3. 薄膜的致密性
主要受衬底温度以及沉积速度影响。温度越高,扩散越快,越致密;沉积速度越慢,越致密。
4. 薄膜厚度均匀性
主要由沉积速度影响。沉积速度越慢,越均匀
5. 薄膜的附着性
主要由衬底温度影响。温度越高,薄膜与衬底形成的化学键越多,附着性越强
CVD工艺方法
常压化学气相沉积(APCVD)
最早的CVD工艺,常用沉积较厚的介质薄膜(如SiO2)

优点:
• 在大气压下进行,气体分子密度较高,化学反应速率快,因此沉积速率较高
• 不需要复杂的真空系统,设备结构相对简单
缺点:
• 气体分子碰撞频繁,台阶覆盖性和均匀性较差
• 气体分子在喷头处相遇发生反应,形成的颗粒物会污染衬底
低压化学气相沉积(LPCVD)
气压在1~100Pa,主要用于沉积介质薄膜
由于有真空系统,导致扩散速度提高,因而适合大批量生产,基本取代了APCVD
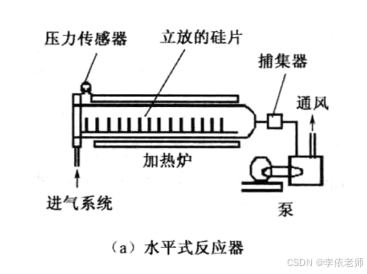
优点:
• 在装载量大大增加,可大批量生产
• 气体利用率提高,节省原料
• 在低压环境下进行沉积,减少了反应副产品的产生,提高了成膜质量
缺点:
• 通常需要在较高温度下进行,能耗较高
• 需要真空系统来维持低压环境,增加了设备复杂性和成本
等离子体增强化学气相沉积(PECVD)
利用等离子体技术把电能耦合到气体中,激活并维持化学反应进行薄膜沉积的一种工艺方法。
特点:能够增强较低温度下的化学反应速率
等离子体是什么?
等离子体是由阳离子、中性粒子、自由电子等多种不同性质的粒子所组成的电中性物质,其
中阴离子(自由电子)和阳离子分别的电荷量相等,这就是物理学上所谓“等离子”
生活中你看到过哪些等离子体?

等离子体增强化学气相沉积(PECVD)
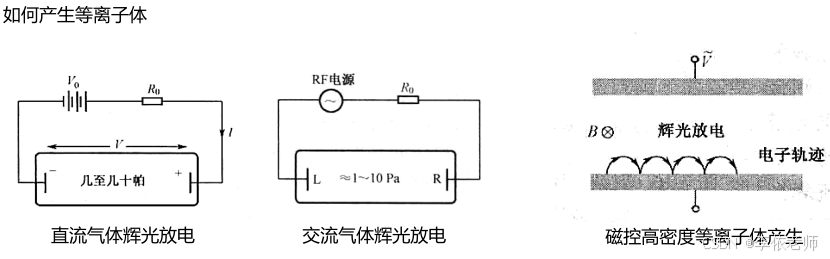
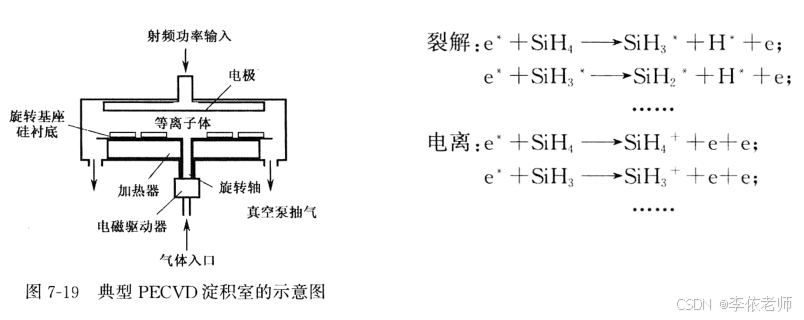
优点:
• 利用等离子体增强反应,降低了沉积温度,并在低温下提高了沉积速率
• 薄膜应力小,保形性好,更均匀
缺点:
• 增加了等离子体产生设备,成本增加
• 低温产生的副产物不能完全排除,一般含有高浓度的H
常见薄膜的沉积:SiO2薄膜沉积
用途:
• 金属沉积前的介电质层
• 多层布线中多晶硅与金属层之间
• 金属层间介电层
• 扩散和离子注入中的掩膜
• 防止杂质外扩的覆盖层
• 钝化层
• 前沟槽绝缘
• 侧壁间绝缘层
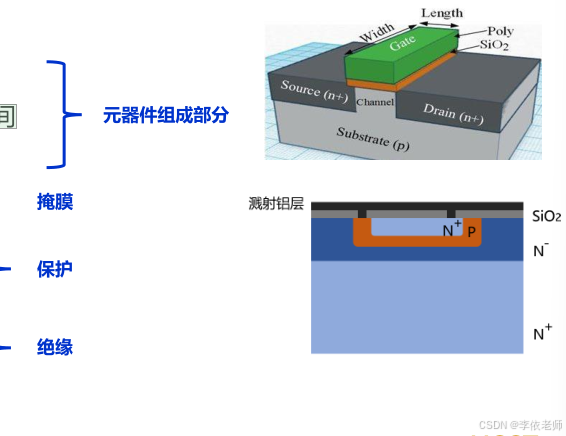
APCVD-SiO2





SiH4/N2O的混合气体能生成均匀的薄膜。
H能够以Si-H、Si-O-H、H-O-H的形式存在于薄膜中,因此以SiH4/N2O制备的PECVD-SiO2薄
膜一般很少在MOS晶体管和电路中使用,因为O-H基团对MOS结构电学特性有不良影响。
常见薄膜的沉积:氮化硅薄膜沉积

特点与用途:
• 薄膜抗钠、耐水汽能力强,薄膜硬度大,致密性好,可用于钝化膜和保护膜
• 化学稳定性好,可作为浅沟隔离工艺技术的CMP停止层
• 掩蔽能力强,可作为多种杂质的掩膜
• 介电系数高,可作为绝缘材料
• 热氧化的掩膜
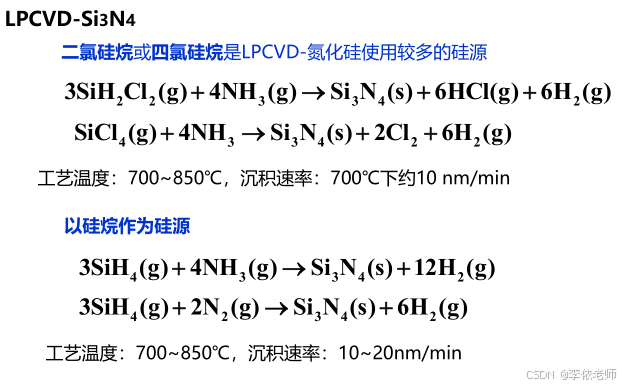

常见薄膜的沉积:多晶硅薄膜沉积
多晶硅(Poly-Si)
质:
• 晶粒尺寸~100nm,晶界宽度~0.5~1 nm
• 本征多晶硅电阻率很高,通常称为半绝缘多晶硅
• 同等掺杂情况下,导电能力比单晶硅更低
• 耐高温
• 与热生长氧化层接触性能良好
• 与硅衬底兼容性好,保形覆盖性好,薄膜应力较小

用途:
• 高掺杂的多晶硅薄膜在MOS集成电路中被普遍用于栅极
和互连引线
• 多层互连工艺中,使用多层多晶硅技术
• 利用多晶硅耐高温特点,可作为扩散掩膜
• 低掺杂的多晶硅薄膜可用于制作高值负载电阻
• 作为沟槽隔离中的填充物
• 作为半绝缘薄膜
见薄膜的沉积:金属与金属化合物薄膜
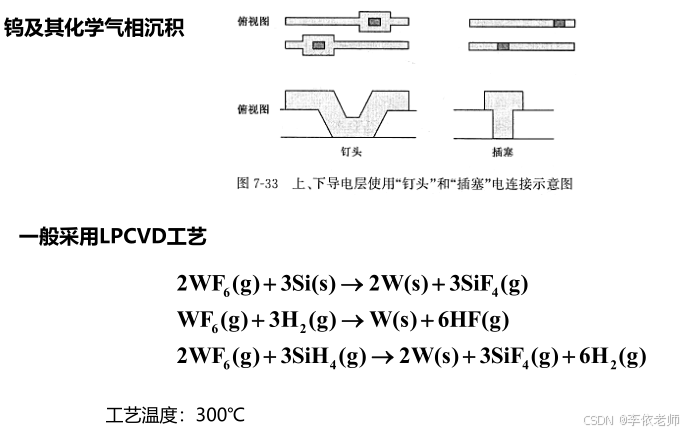



























 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










