参考文献:
[1] 杨依霖. 单晶硅双面研磨机工艺参数优化研究[D].浙江大学,2020.DOI:10.27461/d.cnki.gzjdx.2020.003888.
[2] https://mp.weixin.qq.com/s/fFCQ5CBIB2W-TFVZyNUkBg
[3] https://zhuanlan.zhihu.com/p/340070315
[4] https://zhuanlan.zhihu.com/p/371609556
1 什么是硅晶圆,硅晶圆有什么用?
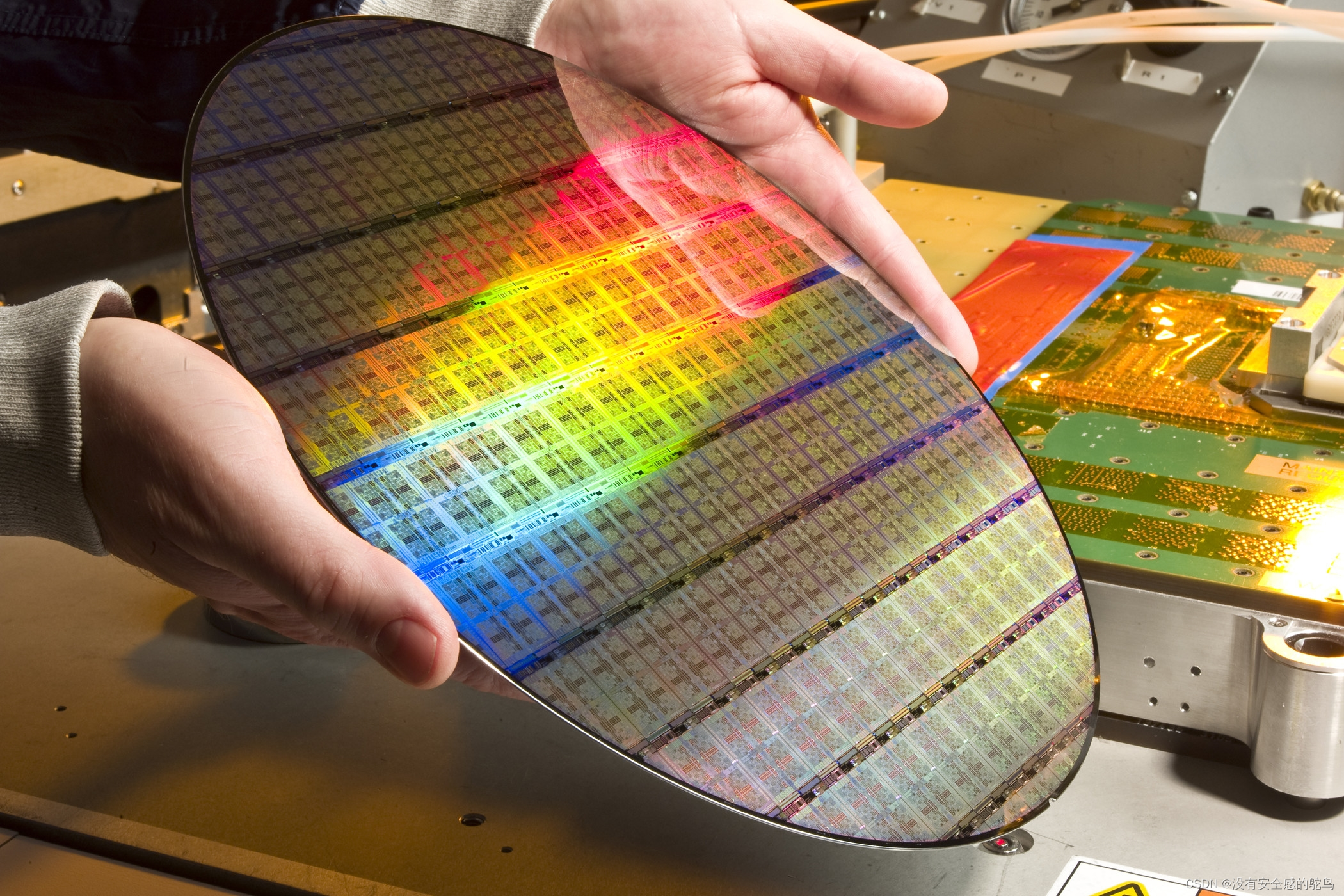
- 芯片就是集成电路的载体;集成电路就是 在晶圆(硅晶片)上用激光雕刻出的电路,经封装形成芯片。当今半导体工业大多数应用的是基于硅的集成电路。
- 硅晶圆属于半导体材料中的基底材料,硅晶圆片全部采用单晶硅片,对硅料的纯度要求较高,一般要求硅片纯度在 99.9999999%以上。
- 从下游应用来看,12英寸大硅片主要应用于90nm以下制程的集成电路芯片,如逻辑芯片(GPA、CPU、FGPA)、存储芯片(SSD、DRAM)等先进制程的芯片,直接受益于智能手机、计算机、云计算、人工智能等终端半导体产品的需求拉动;8 英寸硅片主要应用于90nm以上制程的特色工艺芯片,包括模拟电路、射频芯片、嵌入式存储器、图像传感器等,主要驱动力来自汽车电子、工业电子等物联网应用增加。
2 硅晶圆如何生产
- 单晶硅片生产过程包括:硅晶棒的生长和硅片的加工
- 如果从头开始讲就是:硅砂(二氧化硅) - 冶金级硅(纯度99%) - 电子级硅(99.999999%) - 硅晶棒 - 单晶硅片(圆晶片、硅晶圆)
2.1 硅晶棒的生长
- 硅晶棒的生长主要有两种方法:直拉法(CZ)和区熔法(FZ)
- 目前超过98%的电子元件材料全部使用单晶硅。其中用CZ法占了约85%,其他部份则是由浮融法FZ生长法。
- CZ法生长出的单晶硅,用在生产低功率的集成电路元件。而FZ法生长出的单晶硅则主要用在高功率的电子元件。
- CZ法所以比FZ法更普遍被半导体工业采用,主要在于它的高氧含量提供了晶片强化的优点,且CZ法更容易生产出大尺寸的单晶硅棒。
2.1.1 直拉法(CZ)
- 直拉法的发明者是“切克劳斯基”( J.Czochralski),故此法又称切克劳斯基法。
- 主要流程为:原料置于一个高纯度的石英坩埚中,坩埚上方的籽晶杆可以进行旋转和升降运动,其下方连接一根籽晶。等到多晶硅原料受加热器的作用加热熔化后,将籽晶伸入多晶硅熔体表面进行熔接,注意控制温度,在转动籽晶并反转坩埚同时提拉籽晶杆,通过引晶、放肩、转肩、等径生长、收尾等一系列工艺流程最终获得所需的单晶硅棒。
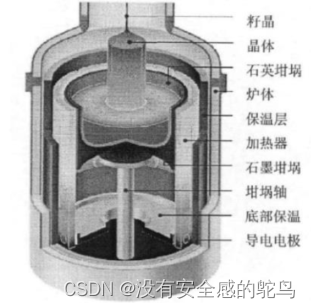
2.1.2 区熔法(FZ)
- 区熔法是采用多晶锭分区熔化和结晶的办法来完成长晶过程。工艺流程包括:多晶硅棒料打磨、清洗、装炉、高频电力加热、籽晶熔接、缩颈、放肩等。
- 对比直拉法,区熔法生长的单晶硅棒直径低,工艺流程相对更繁琐,耗资成本大,市场占有率低。
2.2 硅片的加工
- 硅片的加工主要是对经过生长环节得到的硅晶棒进行切片、研磨和抛光等处理, 最后得到满足工艺要求的硅片的过程。主要包括:切断、外径滚磨、平边处理(或 V 型槽处理)、切片、研磨、抛光、清洗、包装等流程
- 切断:目的是切除单晶硅棒的头部、尾部及超出客户规格的部分,将单晶硅棒分段成切片设备可以处理的长度。
- 外径磨削:由于单晶硅棒的外径表面并不平整且直径也比最终抛光晶片所规定的直径规格大,通过外径滚磨可以获得较为精确的直径。
- 平边或V型槽处理:指定向基准平面加工,用单晶硅捧上的特定结晶方向平边或V型槽。
- 切片:指将单晶硅棒切成具有精确几何尺寸的薄品片。
- 倒角:指将切割成的晶片锐利边修整成圆弧形,防止晶片边缘破裂及品格缺陷产生
- 研磨:指通过研磨除去切片和轮磨所造成的锯痕及表面损伤层,有效改首单品硅片的翘曲度,平坦度与平行度,达到一个抛光过程可以处理的规格。
- 硅片研磨加工质量直接影响到其抛光加工质量及抛光工序的整体效率,甚至影响到IC的性能。
- 腐蚀:指经切片及研磨等机械加工后,晶片表面受加工应力而形成的损伤层,通常采用化学腐蚀去除。
- 抛光:指单晶硅片表面需要改善微缺陷,从而获得极高平坦度、极小表面粗糙度值的晶片表面,并要求表面无变质层、无划伤的加工工艺。抛光的方式包括粗抛,主要作用是去除损伤层,般去除量约在10~20um;精抛,主要作用是改善晶片表面的微粗糙程度,一般去除量在1pm以下。
- 清洗:这里的清洗主要是抛光后的最终清洗,清洗的目的在于清除晶片表面所有的污染源。
























 598
598

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








