
1. 硅基光电器件研究进展
硅基激光器
与硅基光子技术在无源波导器件、调制器以及探测器等领域取得的丰硕成果相比,片上硅基光源依然缺少成熟的方案。硅材料的间接带隙特性,决定了其发光效率低下,难以作为有源材料制作高性能的发光器件。近年来人们从发光原理、材料、器件结构等多个角度,开展了大量的硅基光源的研究,硅基拉曼激光器、纳米硅发光、硅稀土掺杂发光、锗/锗硒合金光源等,发光效率不断提高,甚至实现了激射。但这些光源的性能与III-V激光器相比还有一定的差距。因此,目前相对较成熟的硅光子片上光源方案主要是基于III-V材料,通过一定的集成手段在硅光子芯片上实现III-V材料激光器的制作。 硅基片上光源按照集成方式的不同分为两类:混合集成与单片集成。混合集成是指激光器或其增益材料并不是直接在硅材料上生长制作,而是采用特定的工艺,将激光器或其增益材料转移至硅光芯片上,构成片上光源。而单片集成则是采用优化的工艺,直接在硅材料上生长特定的材料作为激光器的增益介质,实现片上光源的制作。两种集成方式各有千秋,混合集成技术发展较早,所采用的工艺也比较成熟,能够保证增益介质的最佳性能,但其工艺成本较高,也难以实现较大规模的集成。单片集成技术虽然发展稍慢,光源性能有待提高,但单片集成光源一直被认为是硅光子片上光源的终极解决方案,能够最大程度的整合工艺,不断缩小线宽,实现大规模光电子集成回路。 1. 混合集成 混合集成方案主要包括激光器直接放置(directmounting)技术和晶圆键合技术。直接放置技术主要是指采用倒装焊或贴装工艺,将预先制作好的III-V族材料激光器放置在硅光子芯片表面,通过焊球完成电连接,实现光源与硅光波导器件的混合集成。富士通实验室的学者Tanaka等设计了一种无需温度控制的硅光子发射机芯片,采用高精度倒装焊设备将III-V族材料半导体光放大器(semiconductoropticalamplifier,SOA)集成在SOI衬底上,与波导端面对准,和SOI波导一起构成混合集成激光器,如图1所示。采用倒装焊有助于使硅光器件和SOA的设计更加灵活,同时也能够为SOA提供更好的导热性。但端面耦合对倒装焊的精度提出了很高的要求。为了提高对准容差,需要在SOI波导上制作一段由SiON构成的宽波导作为光斑转换器,将SOI波导中的强限制光斑扩展到与SOA的模场相当的尺寸。因此,虽然倒装焊技术较成熟,也能充分发挥III-V族材料的光增益特性,但高对准精度要求导致了其工艺成本较高。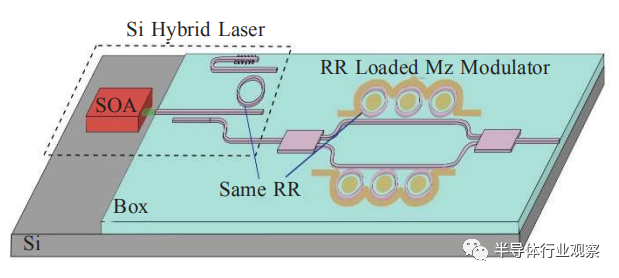 图1. 无需温度控制的硅基光发射机芯片示意图 晶圆键合是目前混合集成方案中被人们寄予期望最高的光源集成技术。采用晶圆键合技术,人们可将III-V族材料外延层集成至硅波导等硅光器件上方,由III-V族材料产生的光可通过倏逝波耦合的方式进入硅光子回路,完成片上光源与硅光子芯片的混合集成。由于键合时III-V族材料外延层还未做图形化,所以键合工艺的对准容差很高,有源区与下方硅波导的对准则通过光刻工艺完成,相比倒装焊等直接放置技术具有更高的对准精度。 晶圆键合技术主要分为两类:直接键合(directlybonding)与粘结键合(adhesivebonding)。直接键合技术是指不借助粘结材料,直接将光滑、平整、洁净的两晶圆接触,在界面键作用下,两晶圆间形成牢固结合。粘结键合是指借助特定的粘结材料完成晶圆间键合的技术。常见的粘结材料包括金属和聚合物,而针对III-V族材料与硅的集成,应用最成熟的是基于苯并环(BCB)辅助的粘结键合技术。BCB具有牢固的键合效果,平整度高,热稳定性好,对III-V材料工艺中多种化学品具有较高的惰性,非常适用于III-V材料与硅材料的晶圆键合。但相对直接键合技术而言,BCB材料自身的导热性能较差,因此对激光器的散热有一定负面影响,会导致光源性能下降。此外,BCB层的引入增大了III-V材料有源区与SOI波导的间距,进而降低了光场在有源区与SOI波导间的耦合效率,影响激光器的性能。针对这些问题,Keyvaninia等提出了一种“冷键合”工艺,能够显著降低BCB键合层厚度,将其控制在50nm以下。采用该技术,制作了BCB厚度约35nm的III-V族与硅混合集成DFB激光器,如图2所示,并且通过对顶层二氧化硅过刻的方式,进一步将BCB厚度减小10nm,实现了56Gb/s的直接调制速率。
图1. 无需温度控制的硅基光发射机芯片示意图 晶圆键合是目前混合集成方案中被人们寄予期望最高的光源集成技术。采用晶圆键合技术,人们可将III-V族材料外延层集成至硅波导等硅光器件上方,由III-V族材料产生的光可通过倏逝波耦合的方式进入硅光子回路,完成片上光源与硅光子芯片的混合集成。由于键合时III-V族材料外延层还未做图形化,所以键合工艺的对准容差很高,有源区与下方硅波导的对准则通过光刻工艺完成,相比倒装焊等直接放置技术具有更高的对准精度。 晶圆键合技术主要分为两类:直接键合(directlybonding)与粘结键合(adhesivebonding)。直接键合技术是指不借助粘结材料,直接将光滑、平整、洁净的两晶圆接触,在界面键作用下,两晶圆间形成牢固结合。粘结键合是指借助特定的粘结材料完成晶圆间键合的技术。常见的粘结材料包括金属和聚合物,而针对III-V族材料与硅的集成,应用最成熟的是基于苯并环(BCB)辅助的粘结键合技术。BCB具有牢固的键合效果,平整度高,热稳定性好,对III-V材料工艺中多种化学品具有较高的惰性,非常适用于III-V材料与硅材料的晶圆键合。但相对直接键合技术而言,BCB材料自身的导热性能较差,因此对激光器的散热有一定负面影响,会导致光源性能下降。此外,BCB层的引入增大了III-V材料有源区与SOI波导的间距,进而降低了光场在有源区与SOI波导间的耦合效率,影响激光器的性能。针对这些问题,Keyvaninia等提出了一种“冷键合”工艺,能够显著降低BCB键合层厚度,将其控制在50nm以下。采用该技术,制作了BCB厚度约35nm的III-V族与硅混合集成DFB激光器,如图2所示,并且通过对顶层二氧化硅过刻的方式,进一步将BCB厚度减小10nm,实现了56Gb/s的直接调制速率。
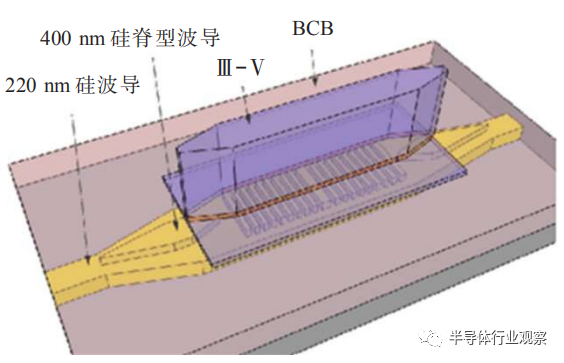 图2. 基于B
图2. 基于B








 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章















 6752
6752











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








