原子力显微镜(Atomic Force Microscope, AFM)是一种利用微力探针对样品表面进行成像和测量的高分辨率显微镜技术。它是由斯坦福大学的物理学家Gerd Binnig、Heinrich Rohrer和Calvin Quate于1986年共同发明的。

Fig1. AFM High-resolution imaging
AFM有三种基本成像模式,它们分别是:
1. 接触式(Contact mode):探针尖端和样品做柔软性的“实际接触”,当针尖轻轻扫过样品表面时,接触的力量引起悬臂弯曲,进而得到样品的表面图形。这种模式不适用于研究生物大分子、低弹性模量样品以及容易移动和变形的样品。
2. 非接触式(Non-contact mode):在非接触模式中,针尖在样品表面的上方振动,始终不与样品接触,探测器检测的是范德华作用力和静电力等对成像样品没有破坏的长程作用力。
3. 轻敲式(Tapping mode):轻敲式模式中,针尖以一定的频率和振幅在样品表面振动,始终不与样品接触。探测器检测的是针尖受迫振动时的共振频率和振幅变化,从而获得样品的表面形貌信息。
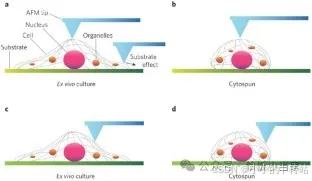
AFM工作原理
AFM的工作原理基于微力探针与样品表面之间的相互作用力。微力探针通常是一个非常细小的尖端,其直径可以达到纳米尺度。在扫描过程中,微力探针通过机械臂与样品表面接触,并受到样品表面的力作用。这些力的变化被检测和测量,然后转换成电信号,最终形成图像。
AFM常用功能
表面形貌成像:
AFM可以通过探测样品表面的微小力变化,获得高分辨率的表面形貌图像。它可以显示材料的凹凸、纹理、颗粒等细节,能够观察到纳米尺度下的表面特征。

薄膜厚度测量:
AFM可以用于测量薄膜的厚度。通过扫描薄膜表面,并测量微力探针与薄膜之间的相互作用力的变化,可以确定薄膜的厚度。
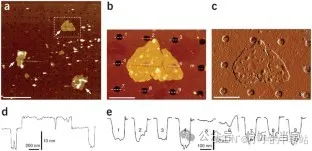
KPFM是一种测量技术,通过探针与样品之间的接触电势差(Contact Potential Difference,CPD)来获取样品的功函数和表电势分布图。此技术还提供了表面形貌的信息,广泛应用于金属、半导体、生物等材料表面电势变化和纳米结构电子性能的研究。
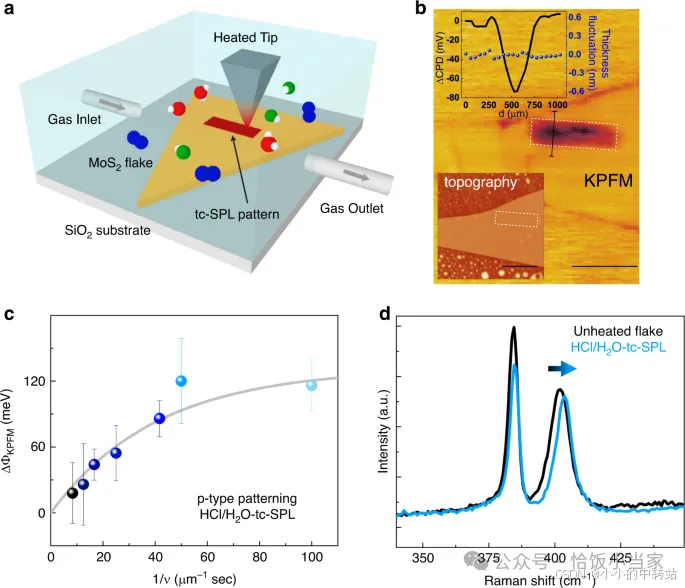
AFM制样要求
由于原子力显微镜(AFM)是一种纳米级别的表征手段,因此其对样品表面的平整度有着严格的要求。如果样品表面存在较大的起伏,可能会导致部分样品表面无法被探测到,从而无法获得真实的形貌。在制备样品时,通常需要将样品固定到基底上,并且要求基底干净无杂质。如果样品未固定好或者表面起伏较大,可能会导致图像异常或者无法扫描出数据。
常用的样品固定方法有胶固定和静电吸附。常规样品一般使用胶将样品粘到基底上,导电实验可使用银胶。在液下成像模式下,需要注意的是所使用的胶不能在该液体环境中发生溶解。而对于带负电的DNA样品,则可以通过静电吸附作用将其固定到带正电的云母片上。此外,还可以通过探针修饰来固定样品。
在选择基底时,可以使用云母片、硅片、石墨、石英片等。其中,云母片和硅片是最常用的基底材料。基底的选择取决于样品的亲疏水性。在使用云母片之前,需要新鲜剥离最表面一层。而对于硅片,则需要双面抛光并超声清洗。
Reference
1. Gonçalves, R., Agnus, G., Sens, P. et al. Two-chamber AFM: probing membrane proteins separating two aqueous compartments. Nat Methods 3, 1007–1012 (2006). https://doi.org/10.1038/nmeth965
2. Cross, S., Jin, YS., Rao, J. et al. Applicability of AFM in cancer detection. Nature Nanotech 4, 72–73 (2009). https://doi.org/10.1038/nnano.2009.036
3. Jiao, F., Cannon, K.S., Lin, YC. et al. The hierarchical assembly of septins revealed by high-speed AFM. Nat Commun 11, 5062 (2020). https://doi.org/10.1038/s41467-020-18778-x
























 6117
6117

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








