可以说,所有的CMOS集成电路的基础都是MOS晶体管,而MOS晶体管则是由两个基本的半导体结构组成的,即p-n结(p-n junction)和MOS电容(MOS capacitor),本篇文章将主要总结pn结,并不会涉及太多MOS电容的知识
1. 物理结构
在nMOS中,pn结的分布如图所示:
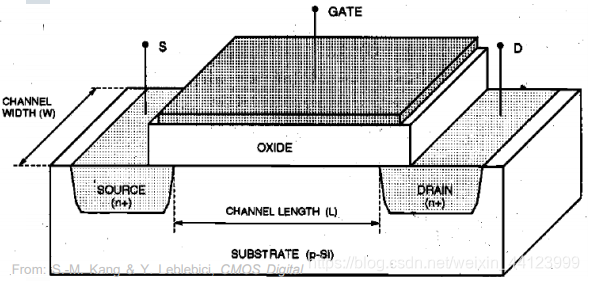
可以看到source 和 drain 充当的是pn结中的n,中间的基底充当p
正常情况下,这里的pn结都是反向偏置的,并不会导电,但pn结却可以直接影响晶体管的表现,比如pn结的寄生电容(parasitic capacitance)可以影响MOS电路的开关速度
为了方便表达,我们通常把pn结表现为两个区域:

其中p中掺有浓度为
N
a
N_a
Na受主杂质(硼等)
n中掺有浓度为
N
d
N_d
Nd的施主杂质(磷或砷等)
根据上一篇文章中的内容,我们明白p和n是两个被不同杂质掺入的半导体,其中p端的载流子,也就是空穴浓度在室温下为
p
p
≈
N
a
p_p\approx N_a
pp≈Na
n端的载流子,电子浓度在室温下为
n
n
≈
N
d
n_n\approx N_d
nn≈Nd
同样的,每一端的本征载流子浓度
n
i
n_i
ni 都是常数,所以我们可以得出:

2. 扩散
我们知道如果半导体内存在浓度梯度差,就会出现扩散
pn结的两端掺入了相反功能的杂质,一个提供电子,一个提供空穴,那么理所当然p和n之间就会有浓度差
之后,这个浓度差会让空穴从p向n移动,让电子从n向p移动
少部分移动的空穴停留在了n端的表面,电子停留在了p端的表面,而大部分的电子和空穴仍待在原处,如图所示:

这些离子形成了一个从n端指向p端的电场,从而造成电子和空穴的漂移
3. 漂移
我们知道,电场会催生出漂移电流,pn结中由扩散的离子形成的电场也一样会在pn结中催生漂移电流,他们的漂移速度如下:
V
d
n
=
−
μ
n
E
V_{dn}=-\mu_nE
Vdn=−μnE
V
d
p
=
μ
p
E
V_{dp}=\mu_pE
Vdp=μpE
可以看到电子漂移的方向与电场相反
由于漂移的方向和扩散的方向相反,电子和空穴的运动达到了平衡
我们称中间这一团由p中的电子和n中的空穴组成的区域为耗尽区(depletion region)或空间电荷区(space-charge region)
4. 静电分析
pn结每个位置对应的电荷密度,电场强度,电势如图所示:
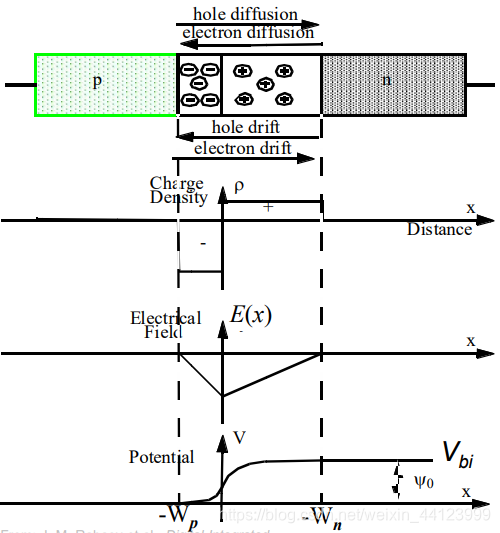
其中最后一幅图中的电势也可以理解为势垒
当我们给pn结施加一个反向偏置的电压
V
R
V_R
VR,我们可以得到变化的图形为:
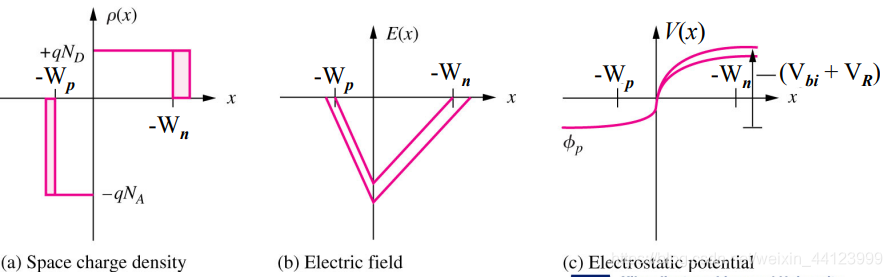
可以看到空间电荷密度拓宽了,反向偏置的电压将更多
电场下移了,电场强度增加
静电势的末端上移了,静电势增加???
在施加反向电压时,p端接电源负极,n端接电源正极
此时电源会试图从p端获取空穴,从n端获取电子,因此,p中的空穴会被向左拉,n中的电子会被向右拉,从而使p和n的区域缩减,相应的,耗尽区就会变大
通过绘制pn结的能带图,我们可以看到均衡后两边的费米能级统一在一条水平线上,如图:
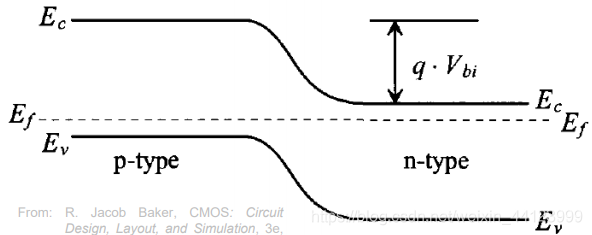
相连区域的费米能级统一,是因为我们使用费米能级作为参考系
5. 关键参数
接下来我们看pn结中的一些关键参数,这都是我们在分析pn结时需要考虑的:
- 内部电势 ϕ b i \phi_{bi} ϕbi,也叫内部电压 V b i V_{bi} Vbi
- 耗尽区宽度 W 0 W_0 W0,包含p端耗尽区宽度 W p W_p Wp和n端耗尽区宽度 W n W_n Wn
- 耗尽区电容 C d C_d Cd,也叫junction capacitance C j C_j Cj
其中 V b i V_{bi} Vbi 可以用来计算 W 0 W_0 W0,而 W 0 W_0 W0则可以决定 C d C_d Cd
5.1 内部电压计算
V
b
i
V_{bi}
Vbi 的计算方式如下:
V
b
i
=
V
T
l
n
(
N
A
N
D
n
i
2
)
V_{bi}=V_Tln(\frac{N_AN_D}{{n_i}^2})
Vbi=VTln(ni2NAND)
其中
V
T
V_T
VT是热电压
一般来说,掺杂浓度
N
D
N_D
ND和
N
A
N_A
NA大概在
1
0
16
c
m
−
3
10^{16}cm^{-3}
1016cm−3
室温下
V
b
i
V_{bi}
Vbi此时约为
0.7
V
0.7V
0.7V
5.2 耗尽区宽度计算
零偏置下的耗尽区宽度为:
W
0
=
W
p
+
W
n
=
2
ϵ
S
i
(
N
A
+
N
D
)
V
b
i
e
N
A
N
D
W_0=W_p+W_n=\sqrt{\frac{2\epsilon_{Si}(N_A+N_D)V_{bi}}{eN_AN_D}}
W0=Wp+Wn=eNAND2ϵSi(NA+ND)Vbi
W
p
=
N
D
N
A
+
N
D
W
0
W_p=\frac{N_D}{N_A+N_D}W_0
Wp=NA+NDNDW0
W
n
=
N
A
N
A
+
N
D
W
0
W_n=\frac{N_A}{N_A+N_D}W_0
Wn=NA+NDNAW0
其中
ϵ
S
i
\epsilon_{Si}
ϵSi是硅的介电常数
在反向偏置下,耗尽区的宽度随反向偏置电压
V
R
V_R
VR增大而增大,此时的耗尽区宽度为:
W
0
=
W
p
+
W
n
=
2
ϵ
S
i
(
N
A
+
N
D
)
(
V
b
i
+
V
R
)
e
N
A
N
D
W_0=W_p+W_n=\sqrt{\frac{2\epsilon_{Si}(N_A+N_D)(V_{bi}+V_R)}{eN_AN_D}}
W0=Wp+Wn=eNAND2ϵSi(NA+ND)(Vbi+VR)
正向偏置时,耗尽区的宽度随正向偏置电压
V
F
V_F
VF增大而减小,耗尽区宽度为:
W
0
=
W
p
+
W
n
=
2
ϵ
S
i
(
N
A
+
N
D
)
(
V
b
i
−
V
F
)
e
N
A
N
D
W_0=W_p+W_n=\sqrt{\frac{2\epsilon_{Si}(N_A+N_D)(V_{bi}-V_F)}{eN_AN_D}}
W0=Wp+Wn=eNAND2ϵSi(NA+ND)(Vbi−VF)
6. pn结电容
之前我们谈论过,在扩散作用后,pn结内会形成一个耗尽区,耗尽区两边是不会移动的离子,这就形成了一个平行板电容器,我们称它为耗尽区电容(depletion capacitance)
电容器的电容为:
C
=
ϵ
A
d
→
C
j
=
ϵ
S
i
A
j
W
0
C=\frac{\epsilon A}{d}\rightarrow C_{j}=\frac{\epsilon_{Si}A_j}{W_0}
C=dϵA→Cj=W0ϵSiAj
然而和一般平行板电容器不同的是,pn结中的电容器与通过pn结的电压有关
在反向偏置时,耗尽区电容为:
C
j
=
C
j
0
1
+
V
R
V
b
i
C_j=\frac{C_{j0}}{\sqrt{1+\frac{V_R}{V_{bi}}}}
Cj=1+VbiVRCj0
其中
C
j
0
C_{j0}
Cj0是零偏置时的耗尽区电容
在正向偏置时,耗尽区电容为:
C
j
=
C
j
0
(
1
−
V
D
V
b
i
)
m
C_j=\frac{C_{j0}}{(1-\frac{V_D}{V_{bi}})^m}
Cj=(1−VbiVD)mCj0
这个m是一个常数,取决于pn结的种类
若为突变结(abrupt junction)则为1/2
若为线性结(linear junction)则为1/3
6.1 侧壁电容
零偏置时的电容
C
j
0
C_{j0}
Cj0实际上包含两部分,一部分由面积决定,一部分由周长决定
由周长决定的电容被称为侧壁电容(sidewall capacitance)
完整的零偏置电容表达式为:
C
j
0
=
C
j
0
a
×
(
面
积
)
+
C
j
0
s
w
×
(
周
长
)
C_{j0}=C_{j0a}\times(面积)+C_{j0sw}\times(周长)
Cj0=Cj0a×(面积)+Cj0sw×(周长)
7. pn结制图
了解pn结之后,我们需要知道如何在layout中表现它,这个我们之后再提

























 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








