- 背景
当前集成电路技术已全面进入纳米时代,先进集成电路几乎全部采用100nm以下工艺。现代及未来电子系统将需要大量性能更高、功耗成本更低(通常体现在电晶体的阈值电压更低)、数据处理能力更强大的深亚微米器件及纳米器件。与高性能需求对应的先进工艺器件更容易受到辐射效应影响,辐射产生的单粒子效应与总剂量效应对芯片功能性能的影响相比大制程工艺会尤为明显。
简单分类一下芯片的辐射效应,有以下几种:
| 编号 | 效应类型 | 英文及缩写 | 定义 |
| 1 | 单粒子瞬态脉冲 | SET(Single Event Transient) | 瞬态电流在组合逻辑电路中传播导致输出错误 |
| 2 | 单粒子翻转 | SEU(Single Event Upset) | 时序电路或存储单元的逻辑状态改变 |
| 3 | 单粒子多位翻转 | MBU(Multiple Bit Upset) | 一个粒子入射导致存储单元多个位的状态改变 |
| 4 | 单粒子扰动 | SED(Single Event Disturb) | 存储单元逻辑状态出现的瞬时改变 |
| 5 | 单粒子快速反向 | SES(Single Event Snapback) | 在 NMOS 器件中产生的大电流再生状态 |
| 6 | 单粒子功能能中断 | SEFI(Single Event Functional Interrupt) | 一个翻转导致控制的部件出错 |
| 7 | 单粒子闩锁 | SEL(Single Event Latchup) | pnpn 结构中的大电流再生状态 |
| 8 | 单粒子硬错误 | SHE(Single Hard Error) | 单粒子出现不可恢复性错误 |
| 9 | 单粒子烧毁 | SEB(Single Event Burnout) | 大电流导致的器件烧毁 |
| 10 | 单粒子栅穿 | SEGR(Single Event Gate Rupture) | 大电流流过造成的栅介质击穿 |
| 11 | 总剂量效应 | TID(Total Ionizing Dose) | 因能量粒子积累导致芯片永久性故障 |
其中编号1~6的单粒子效应被称为软错误,电路重启即可恢复,2~6的效应是由SET引起的后续效应;7~8为器件层面的辐射效应,不及时解决会烧毁电路,被称为硬错误。总剂量关乎芯片在轨寿命。
工程师为解决辐射对芯片的影响做了很多复杂的设计,这些设计可以为芯片可靠性提供多大的保护能力,软件模拟验证与实际效果还是有差别的。
考虑到芯片应用到辐射环境的场景,很难进行人工调试观测,像卫星、空间站这些应用场景,一旦发生错误,可能造成重大损失。在芯片应用之前进行严谨的辐射耐性测试自然不可或缺。
那么我们怎么对芯片进行辐照测试呢?
- 辐射测试
现阶段常用的测试方法分为两种:
- 用辐射源等粒子发射器,模拟太空中的辐射环境。
这种方法非常直观,原理便于理解,也是学术界与工程人员最认可的方式。但是这类重离子发射设备实验资源少,离子束也比较难控制。
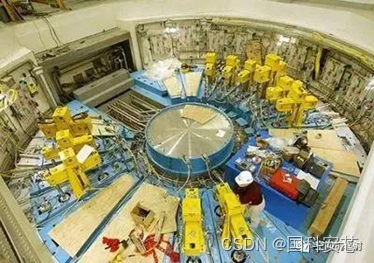
图1.from:空间环境效应研究室
- 采用脉冲激光模拟
虽然产生电子空穴对机理与重离子不同(光子电离与直接电离),但是电离径迹中电荷与pn结的相互作用十分类似。有不少国外研究员如J.S.Melinger等人对机理进行过详细分析与实验,尤其在单粒子效应实验方面有明显的优势,受到不少科研院所青睐。

图2. 多处实验室多台试验装置,且对外开放服务
两者对比,各有特点。显然用粒子模拟最能还原真实应用场景,成本较高。拥有专业设备的单位屈指可数,且不少人认为有一定危险性。激光脉冲胜在设备小巧,精准可控,目前已经有针对SEU,SET特征测试的成熟方法。如D.McMorrow等人甚至研究出了脉冲激光能量等效重离子LET的基本换算关系,让激光方法更具参考意义。

图3. 测试实例
- 激光模拟原理
激光模拟原理根据能带理论沉积能量,当入射激光光子能量大于半导体禁带宽度时(硅半导体的禁带宽度为1.1eV),光子被半导体吸收并产生一对电子-空穴对。简单来说即为光电效应,电子吸收能量发生逃逸,激光强度足够高时,电子漂移出来形成电子-空穴对。这种现象是激光照射下发生的最标准的线性吸收效应,也是最理想的情况。

图4. 硅半导体吸收光子发生的线性效应
在现有的激光设备中较为常见的1.064μm波长Nd:YAG激光,其光子能量(1.17eV)仅略大于硅半导体禁带宽度(1.1eV),吸收较弱,为了激发电子-空穴对则需要加大激光强度,这导致时常会发生两个光子被一个电子吸收但只激发一个电子-空穴对的现象,这种现象被称为双光子效应。
另外,半导体器件中通常都掺有杂质,使半导体的禁带宽度变窄,相当于光子能量相对较大,单位深度内激光产生的电子-空穴对增加但穿透深度减小,这种现象受激光波长影响较大,被称为带宽收缩效应。
还有一种情况,当激光频率与半导体中的等离子体振荡频率接近,光子能量会被等离子体中的自由电子吸收使其能量增加,发生共振吸收,这种自由载流子吸收情况只产生电子加热效果而不发生电离。
结合芯片工作和半导体器件特性,根据上述效应我们不难分析出,实验采用的脉冲激光需要满足波长、脉冲能量、脉冲宽度的要求。
- 操作
4.1设备
目前激光脉冲模拟设备有:
1硅器件单粒子效应激光试验装置(PLSEE),基于单光子吸收机制;

2宽禁带器件单粒子效应激光试验装置(FLSEE),基于脉冲激光单双光子吸收机制;
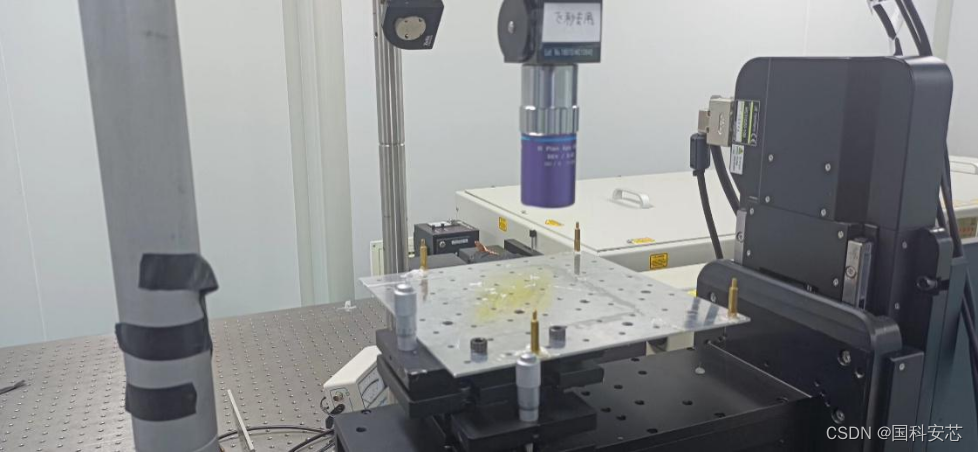
3核瞬态剂量率效应激光试验装置(NLTDRE),该设备原理是发射瞬间高剂量率γ射线,能量很高,因光斑均匀且可调整,通常用于测量瞬态剂量敏感区域。

这些设备能够开展单粒子效应(SEU、SEL、SET、SEFI、SEB)定量评估与筛选、加固设计验证的操作,针对不同禁带宽度器件,聚焦敏感部位扫描测绘,控制定时、定点、指定类型单粒子效应故障注入和原始电荷脉冲测试采集。
关于实验平台,很多设备可以使用Z轴进行角度微调,对入射角度进行一些补偿。
*ps.以上设备均摘自国家空间天气重点实验室装置平台。
4.2准备操作
被测芯片需要提前做一些处理。为保证激光正常入射,根据不同的芯片产品需要做正面开封装或者背部开封装。正面开封装器件通常要求芯片裸芯的金属层数不超过3层;而背部开封装芯片需要裸芯背部没有做金属化,且根据采用的设备不同衬底厚度小于700μm或300μm等不同要求,超过厚度需要减薄操作。值得一提的是,很多芯片采用倒封装工艺,在选择正开封还是背开封时需要注意这一点。
实验室确定激光脉冲选择和设备需要获知:
- 工艺制程;
- 被测芯片面积;
- 金属层数;
- 晶圆背面有无金属化;
- 钝化层材料:SiO2/SiNx或是其他;
- 晶圆材质是什么;
- 有源区、衬底掺杂浓度(这一条通常难以获知,属于晶圆厂工艺Recipe 一部分,不开放给客户通常实验室会选取一个经验值)
4.3测试
通常一些标准化实验各大实验室会有测试方法模板,例如总剂量,某部分单粒子翻转的发生概率等,实验室也会配套若干设备进行监测。
对于客制化的需求,需要芯片提供方根据芯片手册设置实验流程,需要观测的引脚,对于片上系统集成芯片甚至需要软件等人员配合。通常,同样的测试需要两次以上测试。为更清晰地观测单粒子闩锁和总剂量实验,通常需要有一组检测把例如时钟信号等波动信号拉平的测试。
对于不含存储功能的芯片,我们更关注单粒子闩锁(SEL)的抗性,而数字芯片更关注单粒子反转的影响。对于不同的辐照效应有标准制定的测试,测试流程如下:
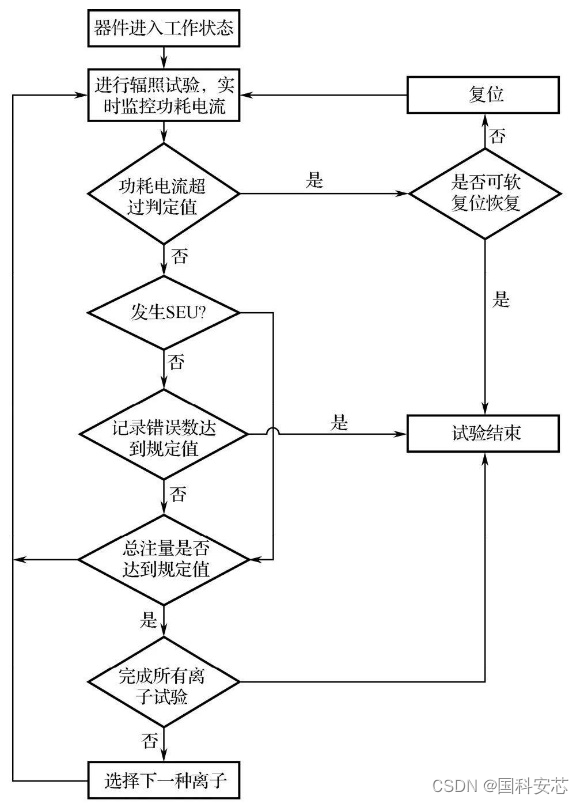
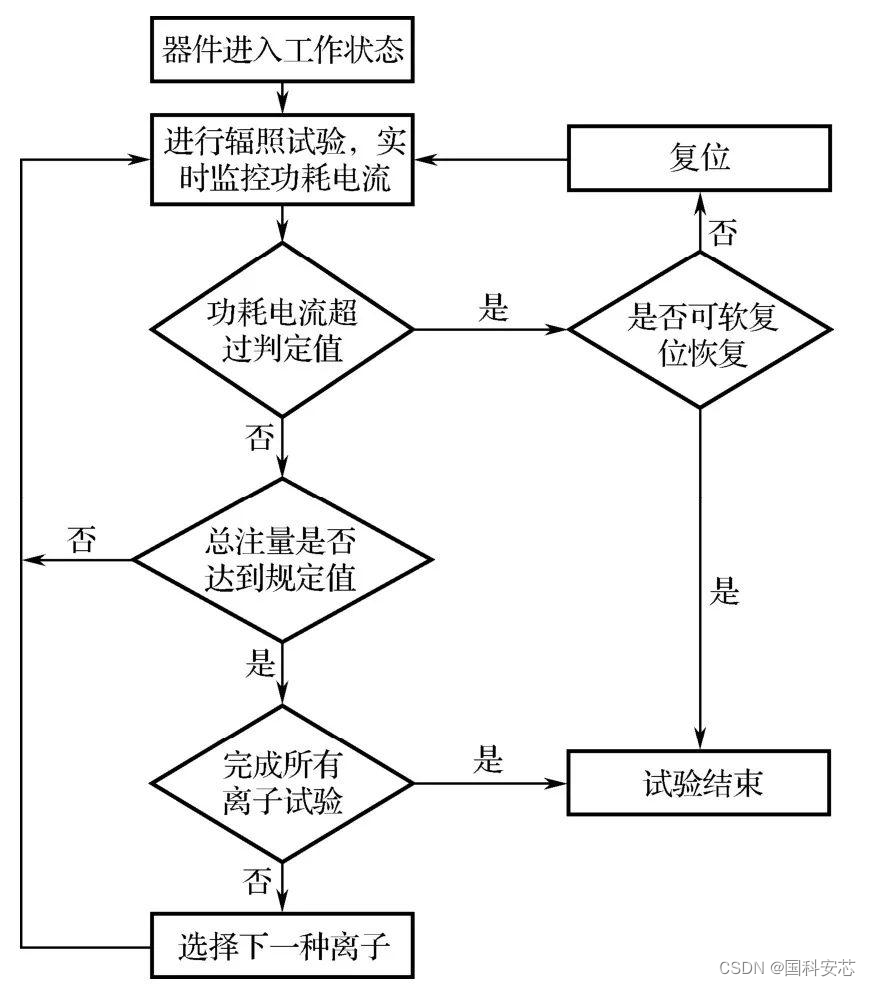
针对举例
我们以DCDC类的模拟芯片为例。DC/DC器件的单粒子效应主要有两种:单粒子瞬态和单粒子功能失效。
DC/DC 器件的单粒子瞬态指的是入射粒子引起 DC/DC 出现输出电压瞬时跳变(增加或减小)的现象,而且该瞬时跳变发生后 DC/DC 器件的输出电压即恢复正常。DC/DC 器件的单粒子瞬态引起输出电压的瞬时跳变的脉冲宽度一般较小,最小可以达μs级。
DC/DC 器件的单粒子功能失效是指入射粒子引起 DC/DC 不能正常工作的现象。该效应发生时,DC/DC 器件的输入模块输入电流将会发生异常,输出电压将会突然变为 0 或非正常值。有测试系统如下:

DC/DC 器件的单粒子功能失效主要是通过实时监测电路模块的各输出端的输出电压,以及实时监测输入电源电流的方式来检测单粒子功能失效,当输出电压突然为 0 或非正常值,输入电源电流为非正常值时,表明器件发生单粒子功能失效。DC/DC 器件发生单粒子功能失效后,断电重启,DC/DC电源模块功能不正常。
DC/DC 器件的单粒子瞬态时通过实时监测器件各输出端的输出电压波形,当输出电压瞬态波形的幅度、脉宽超过规定的阈值时,认为发生单粒子瞬态。
对于单粒子闩锁效应,需要关注各引脚的漏电流,如果发生闩锁,场效应管的可控硅结构会形成两个正反馈的三极管连接形式,电流持续增加,体现在外部引脚上的现象就是漏电流的增加。
- 与粒子实验对比
根据本文上半部分讲解的实验原理与操作我们不难发现,激光脉冲模拟在单粒子效应里很有优势,但没怎么提到总剂量实验。传统的加速离子束流实验可以轻松实现较大面积的辐射效应实验,但是操作简单的实验方式不能保证重复实验的例子条件完全一致,因为较大的粒子照射半径中的粒子数随机性较大,在具体某个器件上的作用有一定的随机性。并且实验成本较大,设备占地面积较大,拥有设备的实验室通常预约时间较长。在单粒子实验方面缺乏激光脉冲的灵活性。虽然离子加速也可以实现聚焦但聚焦装置比较复杂,造价昂贵,在研究单粒子效应方面远不如光束聚焦方法方便可控。
总结来讲,激光模拟实验可以聚焦关键器件,并且方便微调操作,在单粒子软错误和硬错误方面有着巨大的优势。但由于激光同时可以照射的面积较小,在评估芯片整体抗辐照能力方面较为吃力,通常认为总剂量实验(TID)用粒子照射的方法实验更具有性价比和参考价值。虽然在前文中提到有研究人员提出了激光与粒子照射之间的能量换算关系,但学界一般认为二者不具备严格的可比性。
以目前技术来言,激光脉冲在整体评估方面缺乏优势。但在一些会议与期刊上,有一些学者提出了激光器测试总剂量的实验方法,例如全国抗辐射电子学与电磁脉冲学术交流会上,近几年发表一些激光器的电离总剂量辐照试验技术的相关研究。























 1143
1143

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








