引言
铝膜广泛用于集成电路中的互连线。随着电路的集成规模和密度变得越来越大,有必要将互连线和间隔的宽度减小到几乎薄膜厚度。为了实现这一点,已经开发了具有定向蚀刻能力的平行平面电极型等离子体蚀刻。这被称为反应离子蚀刻,因为它采用垂直于电极的定向离子轰击。至于铝蚀刻,可以在氯化等离子体中蚀刻,因为挥发性氯化铝可以在等离子体中生成。
使用四氯化碳作为蚀刻气体的铝蚀刻在某些条件下可以提供铝图案的选择性和各向异性蚀刻轮廓。然而,其也存在一些缺点:(a)在高选择性条件下或在长时间过蚀刻期间,在抗蚀剂掩模下会发生侧面蚀刻。(b)在蚀刻过程中形成含氯的碳膜。这些降低了蚀刻的再现性,蚀刻后由于高氯会腐蚀图案,导致即使通过等离子体清洗也很难去除。(c)反应室和旋转泵油受到严重污染。英思特建议使用SiCl作为蚀刻气体,在这种气体中,硅不会形成聚合物膜,因此,几乎不可能污染样品、样品室或旋转泵。
实验与讨论
本研究中使用的反应离子蚀刻(R.I.E .)反应器的示意图如图1所示。反应器有两个平行的电极。晶片被放置在rf侧电极上。该电极直径为28厘米,覆盖有3毫米厚的石英板。一个13.56兆赫的射频发生器通过一个匹配连接到这个电极上。对于SiCl,反应器的两个电极间隔75毫米,对于CCl,间隔95毫米。
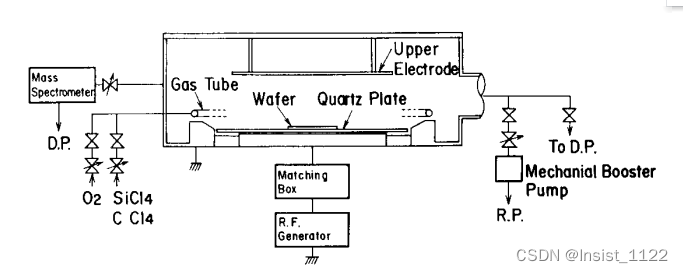
图1:RIE仪器示意图
为了研究使用抗蚀剂掩模的蚀刻图案轮廓的方向性,在各种条件下过度蚀刻如图2所示的样品(图3)。与在5pa和8Pa下蚀刻的样品中没有观察到侧面蚀刻的现象,英思特推测,此现象的发生时由于抗蚀剂延缓了横向蚀刻。为了揭示抗蚀剂对横向蚀刻的影响,使用具有等离子体CVD Si,N掩模的1cm2样品进行实验。将样品放置在三个不同的位置,并在8 Pa,0.16 W/cm-1下蚀刻20分钟。在置于涂有抗蚀剂的晶片中心的样品中,我们没有观察到侧面蚀刻现象,而在晶片边缘的样品中观察到有轻微的侧面蚀刻,并且在石英上的样品中明显有相当多的侧面蚀刻。这些结果表明,在垂直蚀刻期间,从抗蚀剂产生的一些有机物质沉积在侧壁上。因为侧壁上的这些膜不容易被氯自由基去除,所以抑制了掩模下的侧面蚀刻。在更高的压力下,随着自由基浓度的增加,侧壁上频繁的自由基攻击抑制了有机膜的生长,这导致铝的侧向蚀刻。观察发现抗蚀剂的存在并不影响垂直蚀刻速率。英思特认为,与沉积速率相比,具有离子辅助机制的有机膜的蚀刻速率较大,因此抑制了有机膜的生长。
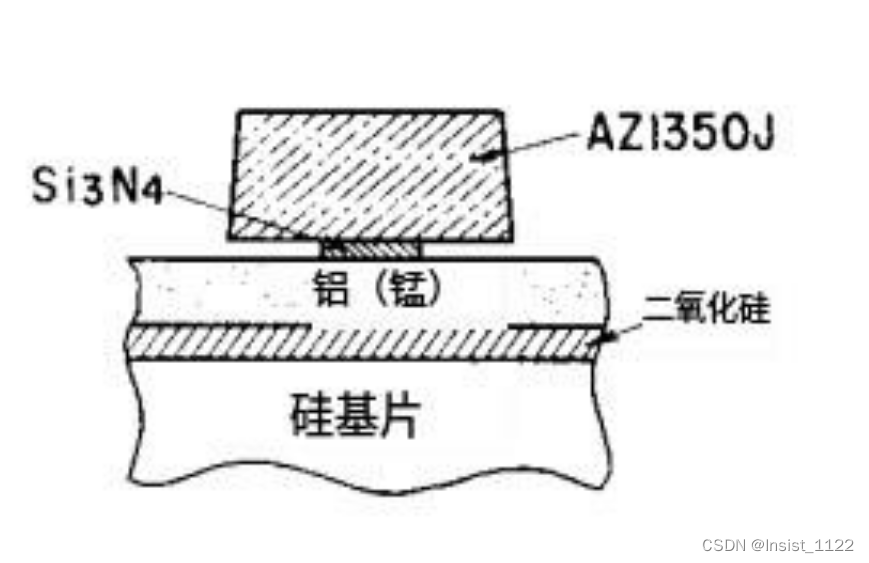
图2:使用抗蚀剂掩模的蚀刻图形实验的样本轮廓
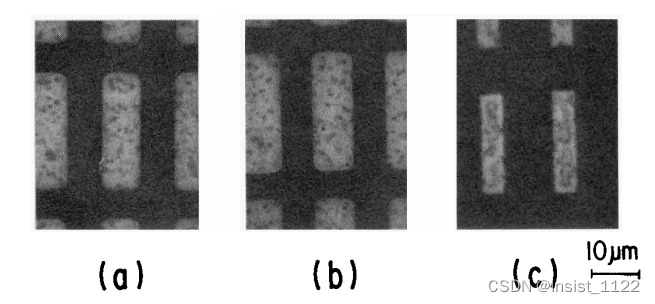
图3:过蚀刻的图案
结论
英思特检验了用四氯化硅对铝的反应离子刻蚀,并与用CCI的刻蚀进行了比较。 研究显示铝可以在更宽的压力范围下被蚀刻,并且在SiCl等离子体中对SiO2、Si3N4、多晶硅和抗蚀剂都具有高选择性。我们通过分析蚀刻后的铝表面,观察到表面在SiCl中比在CCI中被碳和氯污染得更少。
在SiCl4等离子体中的铝蚀刻具有以下显著优点:(a)当使用抗蚀剂掩模时,实现了对抗蚀剂和下层的高选择性,而没有侧面蚀刻。{b)在蚀刻过程中,表面较少被碳和氯污染。(c)蚀刻后没有残留物。(d)反应室污染较少,旋转泵的寿命延长。























 229
229

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








