关注作者了解更多
我的其他CSDN专栏
关注作者了解更多
资料来源于网络,如有侵权请联系编者
目录
回顾1:集成电路制造流程
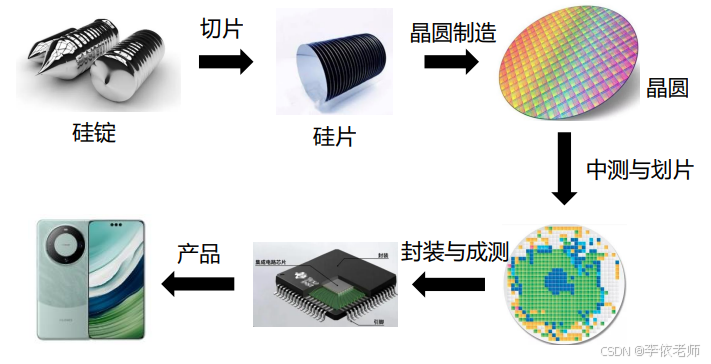
回顾2:集成电路制造工艺

集成电路封装
集成电路封装,简称封装,指安装集成电路芯片外壳的过程。集程电路芯片的外壳材料可以是塑料、
金属、陶瓷、玻璃等。通过特定的工艺,用外壳将芯片包装起来,以保证集成电路在不同的工作环
境下都能稳定、可靠地工作。

集成电路封装的功能
电压分配:集成电路与外部电路进行“沟通”;不同位置的电压适当分配,减少损耗。
信号分配:电信号延迟尽可能小。
散热通道:考虑如何将元器件、部件长时间工作时聚集的热量散发出去,不同封装材料和结构具有 不同的散热效果。
机械支撑:封装要为集成电路和其它连接部件提供牢固、可靠的机械职称,并能适应各种环境和条 件的变化。
集成电路封装的层次


集成电路封装的分类
按照封装中组合的芯片数目区分,芯片封装可分为:
• 单芯片封装(Single-Chip Package, SCP)
• 多芯片封装(Multi-Chip Package, MCP)
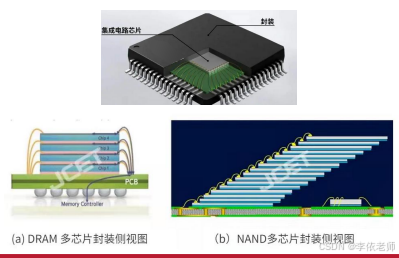
按照封装材料区分,芯片封装可分为:
• 陶瓷封装
• 高分子材料(塑料)封装

按照元器件与印制电路板(PCB)的互连方式区分,芯 片封装可分为:
• 双列直插封装元器件(Dual In-Line Package,DIP)
• 表面安装元器件(Surface Mount Device,SMD)
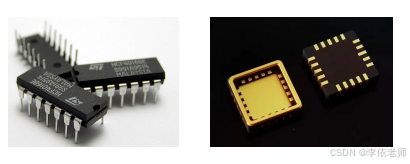
按照引脚分布形式区分,芯片封装可分为:
• 单边引脚、双边引脚、四边引脚、底部引脚

封装工艺流程

晶圆切割:磨片
磨片的目的:
• 去掉氧化物:去掉晶圆背面的氧化物,保证芯片焊接时具有良好的黏 结性
• 去掉扩散层:消除晶圆背面的扩散层,防止寄生结的存在
• 减薄:使用大直径的晶圆制造芯片时,由于晶圆较厚,需要减薄才能 满足划片、压焊和封装工艺的要求
• 减电阻增散热:减小串联电阻和提高散热性能,同时改善欧姆接触
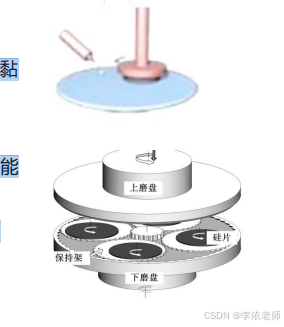
晶圆切割:贴片
在晶圆背面贴上胶带(常称为蓝胶),并置于钢制引线框架上,此动作
称为晶圆贴片。贴片完成后,就可以送至芯片切割机进行切割。
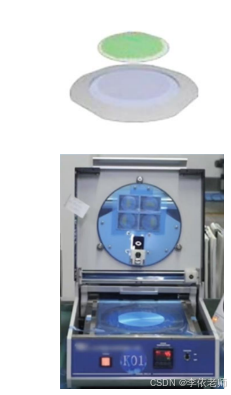
晶圆切割:划片
划片的目的是将加工完成的晶圆上的一颗颗晶粒切割分离。切割完后,
一颗颗晶粒会井然有序地排列在胶带上。
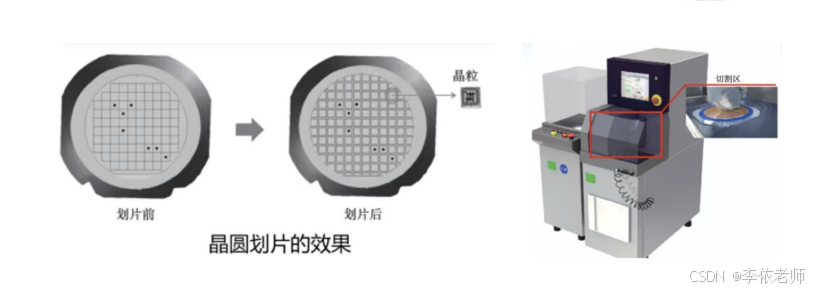
减薄前划片 (切口→减薄)
减薄划片 (切口→减薄→刻蚀去掉余量)
这两种方法可以很好地避免或减少减薄引起硅片翘曲以及划片引起的芯片边缘破损。

芯片贴装
芯片贴装又称为芯片粘贴,简称装片或黏晶,就是把芯片装配到管壳底座或引线框架上。芯 片贴装的目的是将一颗颗分离的晶粒放置在引线框架上并固定。
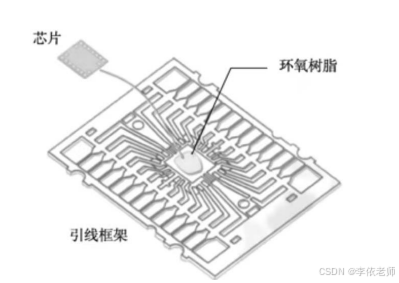
芯片贴装:共晶粘贴法
共晶粘贴法指利用金-硅低共熔合金在363℃时产生共晶反应的特性进行晶粒的粘贴。在使 用金-硅低共熔合金(一般是69%Au-31%Si)时,首先将焊料切成小块,放到引线框架的芯 片焊盘上,然后将晶粒放在焊料上,将焊料加热到熔点以上。但是,由于晶粒、引线框架之 间的热膨胀系数严重失配,合金焊料贴装可能会造成芯片开裂的现象。
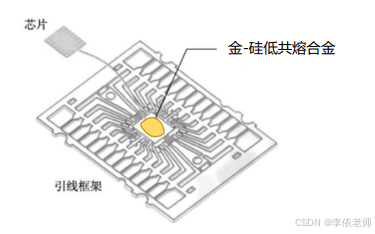
共晶反应:一定成分的液体同时结晶出两种一定成分的固相的反应
芯片贴装:高分子胶粘贴法
高分子胶粘贴法也称为树脂粘贴法,它采用环氧树脂、聚酰亚胺树脂、酚醛树脂、聚胺树脂 及硅树脂等作为黏结剂,加入银粉填充料作为导热材料。
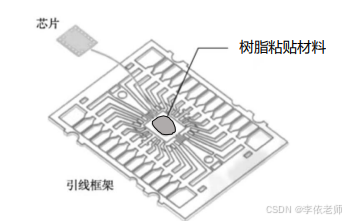
树脂通常是指受热后有软化或熔融范围,软化时在外力作用下有流动倾向,常温下是固态、半固态,有时也可以 是液态的有机聚合物树脂通常是有机化合物的混合物。广义上的定义,可以作为塑料制品加工原料的任何高分子 化合物都称为树脂。
由于高分子材料与引线框架材料的热膨胀系数相近,高分子胶粘贴法称为塑料封装常用的芯 片粘贴法。该方法利用戳印、网印或点胶等方法将环氧树脂涂在晶粒座上,放置晶粒后加热, 从而完成黏结。高分子胶中加入银等金属是为了提热传导性质。
芯片互连
芯片互连(Chip Interconnection)是指将芯片焊区与封装外壳的I/O引线或基板上的金属布线焊区相连接。
芯片互连常用的方法有引线键合、带式自动键合、倒装焊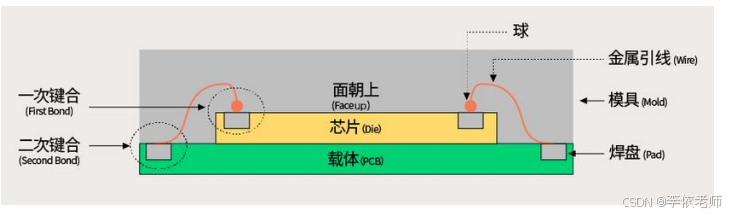
理想的键合线材料应具有以下特点:
• 能与半导体形成低电阻欧姆接触
• 化学性能稳定,不会形成有害的金属间化合物
• 与半导体材料的黏结力强
• 可塑性好,容易实现键合
• 弹性小,在键合过程中能保持一定的几何形状
主要的键合线有:金线、铜线、铝线
芯片互连:不同引线材料的比较

芯片互连:引线键合技术
焊线的目的是将晶粒上的接点用极细(直径为18~50 μm)的金线连接到引线框架上的内引脚
上,从而将晶粒中的电路信号传输到外界。
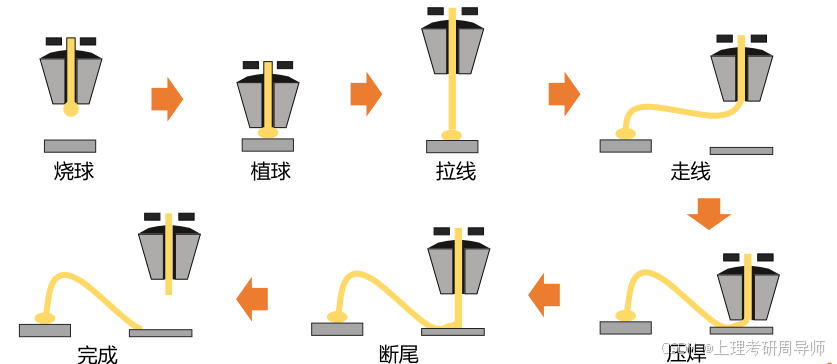
芯片互连:引线键合的方式与特点
热压焊:在一定温度下,施加一定压力,劈刀带着引线与焊区接触并达到原子
间距,产生原子间作用力,从而达到键合的目的。

超声焊:劈刀在超声波作用下,在振动的同时除去焊区表面的氧化层,并与焊
区达到原子间距,产生原子间作用力,从而达到键合的目的。
热声焊:超声波热压焊方式,即在一定压力、超声波和温度共同作用一定时间
后,将金球压接至芯片的铝盘焊接表面。意义如下:
• 借助超声波的能量,可以使芯片和劈刀的加热温度降低。芯片温度为
125~300℃;劈刀温度为125~165 ℃ 。
• 可以键合不能耐300℃以上高温的元器件;
• 键合压力、超声功率可以降低一些;

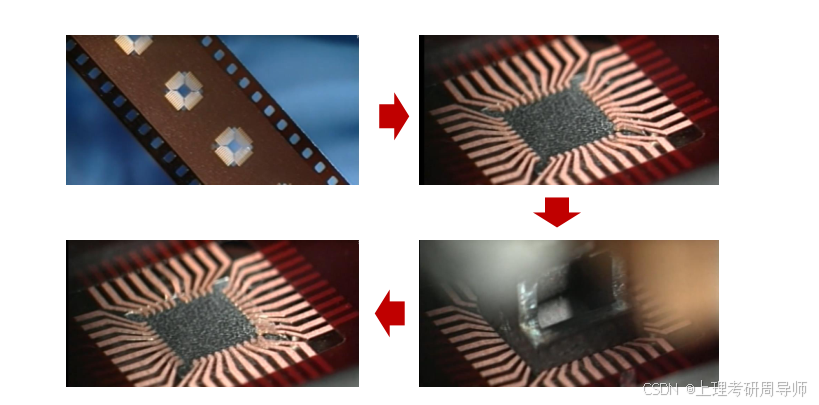
芯片互连:载带自动键合技术
载带自动键合技术有以下优点:
• 结构轻、薄、短、小;
• 电极尺寸、电极与焊区节距都比引线键合小
• 可容纳更多I/O引线
• 引线电阻更小
• 大大提高了电子组装的成品率
• 采用Cu箔为引线,导热和导电性更好,机械强度更高
• 使用标准化的卷轴长带(长100m),对芯片实行自动化多点一
次焊接
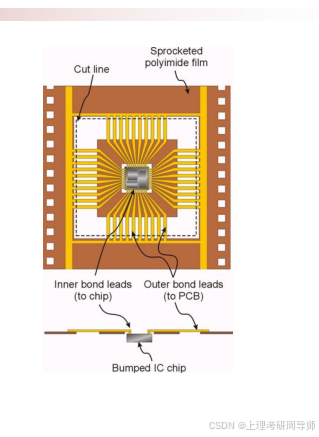
芯片互连:倒装焊技术
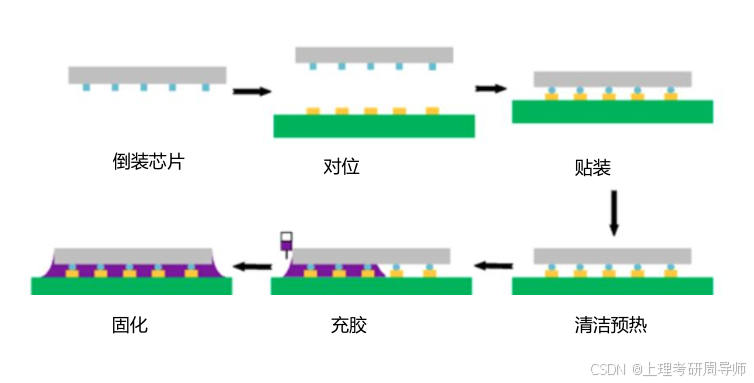
封装成型技术
将芯片与引线框架“包装”起来。这种成型技术有陶瓷封装、塑料封装、金属封装等。从成本等方面考虑,塑料封装是非常常用的封装方式,占据了约90%的市场。
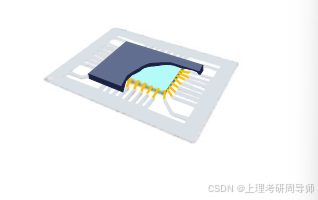
封装成型技术:陶瓷封装
在各种IC元器件的封装中,陶瓷封装能提供IC芯片气密性的封装保护,具有优良的可靠性。陶瓷被用作集成电路芯片封装的材料,是因为它在热、点、机械特性等方面极稳定。它既可作为封装的封盖,有课作为基板。

封装成型技术:陶瓷封装
陶瓷封装存在以下缺点:
• 与塑料封装相比,陶瓷封装的工艺温度较高、成本较高
• 陶瓷封装工艺自动化与薄型化封装能力有限,不如塑料封装
• 陶瓷材料具有较高的脆性,会导致应力损害
• 难以满足低介电常数与高连线密度的封装需求
封装成型技术:塑料封装
塑料封装的散热性、耐热性、密封性虽不如陶瓷封装,但塑料封
装具有低成本、薄型化、工艺简单、适合自动化生产等优点,应
用极为广泛,是目前微电子工业使用非常多的封装方法。
热硬化性和热塑型高分子材料均可作为塑料封装材料,酚醛树脂、
硅胶是塑料封装的主要材料。
去毛刺与电镀
封装后需将引线框架上多余的残胶去除,并且进行电镀以增强外引
脚的导电性及抗氧化性。
• 若封装料只在模块外的引线框架上形成薄薄的一层,面积也小,通
常称为溢料;若溢出的部分较多、较厚,则称为毛刺或飞边毛刺。
去飞边毛刺工序工艺主要有介质去飞边毛刺(Media Deflash)、
溶剂去飞边毛刺(Solvent Deflash)、水去飞边毛刺(Water
Deflash)。其中,介质和水去飞边毛刺的方法用得最多。
• 介质去飞边毛刺:用研磨料(如粒状塑料球)和高压空气一起冲洗;
• 水去飞边毛刺:利用高压的水流冲击模块
电镀就是利用电解原理在某些金属表面上镀上一薄层其它金属或合金的过
程,是利用电解作用使金属或其它材料制件的表面附着一层金属膜的工艺
• 电镀是封装后引线框架外引脚的后处理,该工序是在引线框架引脚上做保
护性镀层,以增加导电性、抗氧化性及可焊性。
切筋打弯
切筋的目的是将整条引线框架上已封装好的晶粒独立分开,同时把不需要
的连接用材料及部分凸出树脂切除,也要切除引线框架外引脚之间的堤坝
以及引线框架带上连在一起的地方。
• 打弯的目的是将外引脚压成各种预先设计好的形状,以便在电路板上使用。
封装外形一般要满足以下参数要求:
(1)共面性
(2)引脚位置
(3)引脚分散
(4)站立高度

























 2068
2068

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










