半导体芯片封装是指利用精密焊接技术,将芯片粘贴并固定在框架或PBC板等基座上,并通过金丝、铜丝、铝丝或其他介质将芯片的键合区与基座连接起来,再用绝缘材料将它们保护起来,构成独立的电子元器件的工艺。实物如下图
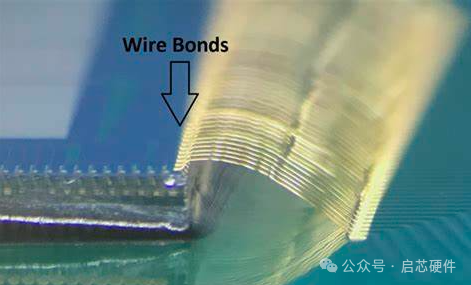
半导体芯片封装的目的,在于保护芯片不受或少受外界环境的影响,并为它提供一个发挥半导体芯片功能的良好工作环境,以使之稳定、可靠、正常地完成相应的功能。但是芯片的封装只会限制而不会提高芯片的功能。
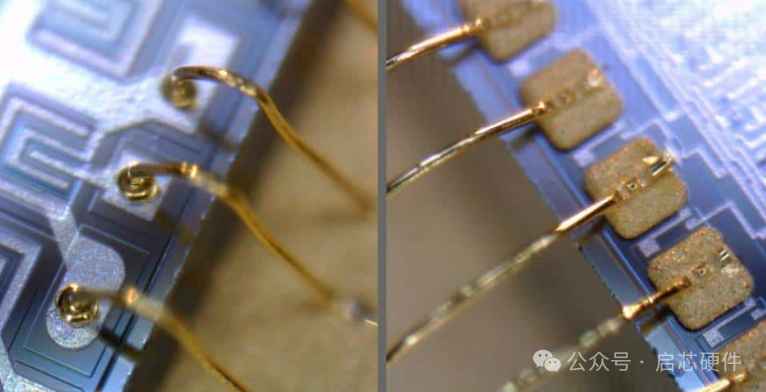
键合法的对比:早期主要都是引线键合(Wire Bonding),更为先进的则是加装芯片键合(Flip Chip Bonding)

如上图,中间区域是芯片,也是DIE区域,四周是wirebondin键合线,底下则是基板部分,封装实际芯片。
封装是为了让芯片能使用,因为单die无法应用于产品,但另一方面芯片封装会限制芯片的性能等,因此全世界都在努力研究并并不断推出新的封装形式,以 限度地发挥半导体芯片尤其是半导体集成电路本应有的功能,减小因封装对芯片功能产生的影响。半导体芯片封装流程可以分为“前道”流程和“后道”流程两部分。其中,“前道”流程包括贴片(Die Bonding)和键合(Wire Bonding)两道工序,是整个半导体芯片封装流程中至关重要的两道工序,它们决定了整个封装流程的成败;“后道”流程则包括塑封、后固化、高温贮存、去飞边、浸锡(电镀)、切筋(打弯)、测试分类、mark、包装等工序,“后道”流程中测试分类也是比较重要的一道工序,它决定了产品的“去留”。
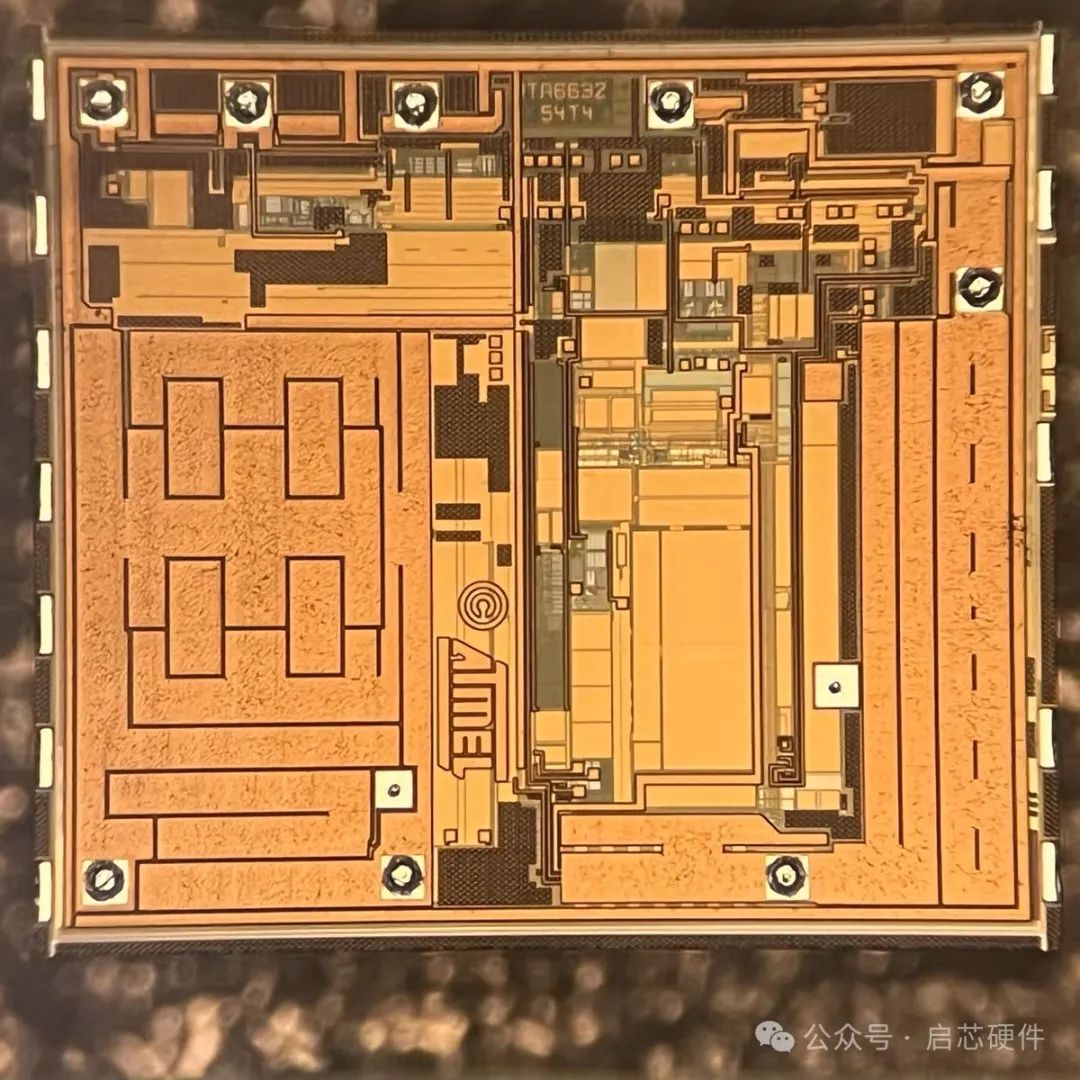
贴片(Die Bonding),是将半导体芯片固定于基板或引线框架的Pad上的工艺工程。装片需要选择与芯片相匹配的基座或Pad的引线框架,因为若基座或Pad太大,则会使内引线宽度太大,在“后道”塑封过程中会由于塑封体流动产生的应力而造成内引线断裂、塌丝等现象,从而导致TEST不良品增多。 另外,为了形成良好的装片成品率,还需要完善的工艺要素与之相配合,主要包括:温度、时间、气氛、压力等几种因素。 因此装片工序有两大质量要求:产品质量要求和工艺质量要求。
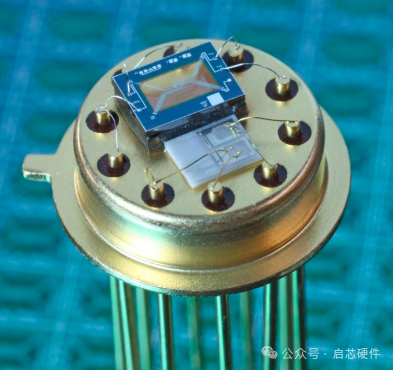
键合(Wire Bonding) 键合就是用金丝、铜丝或铝丝将半导体器件芯片表面的电极引线与底座或引线框架外引线相连接起来。键合的目的是把半导体器件芯片表面的电极与引线框架的外引线连接起来,键合也有其相应的工艺要素,分别是超声功率、 压力、时间、温度(相对于金、铜丝键合而言)。Wire bonding指的上面的引线。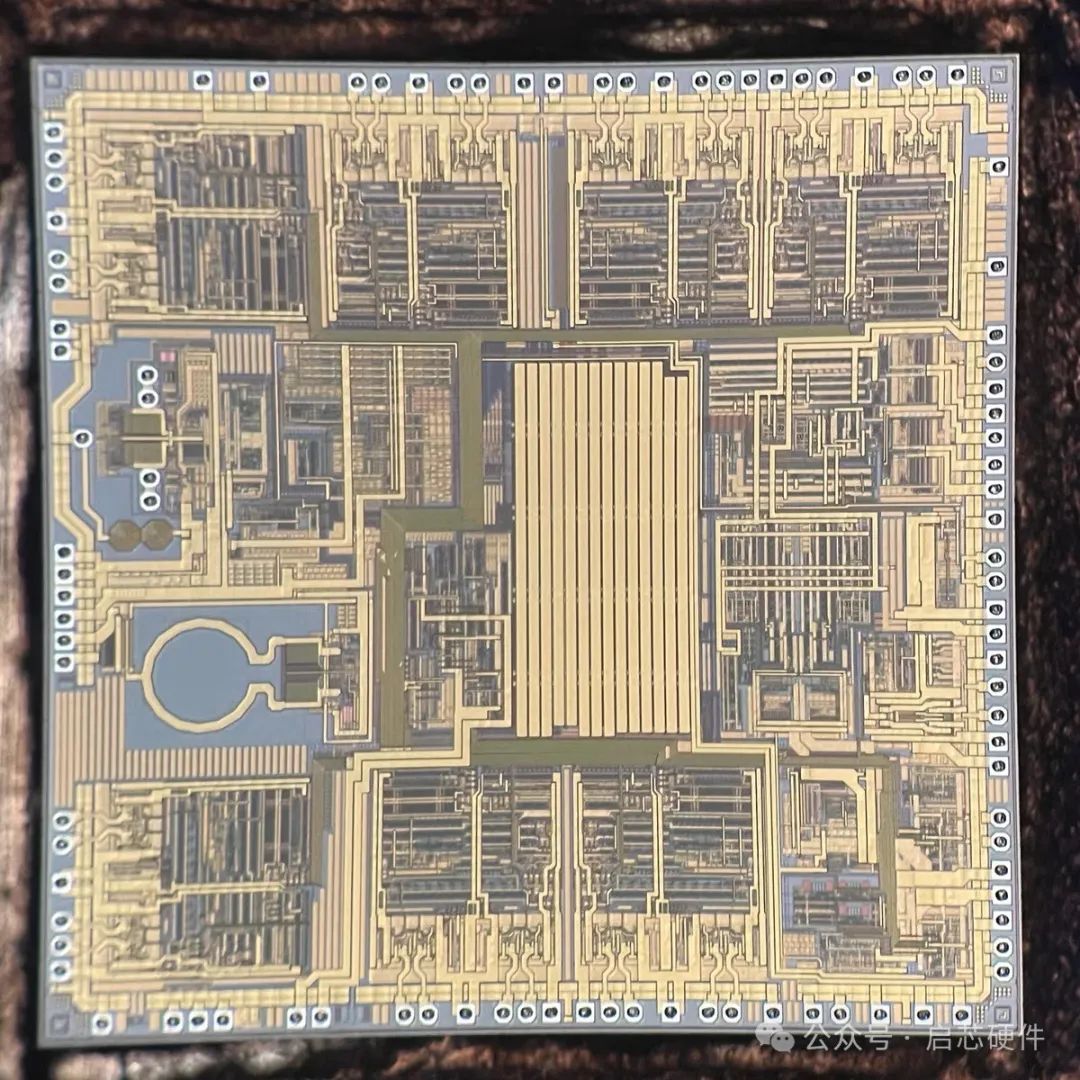

Wirebonding的优化-flipchip
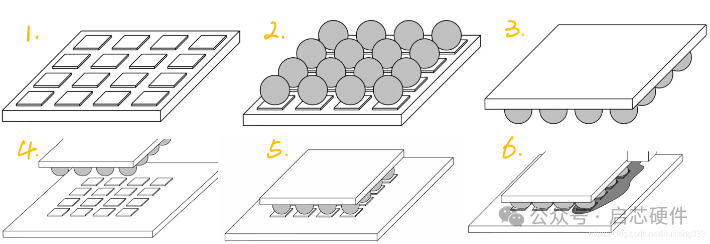
Flip Chip的优点在于:
更多的IO接口数量,更小的封装尺寸,更好的电气性能,更好的散热性能,更稳的结构特性,更简单的加工设备。
但缺点在于价格高,主要原因是:
芯片需要在AP层设计RDL用于连接bump,RDL的生产加工需要多一套工艺flip chip基板的生产加工,基板的工艺会更加精细,价格自然水涨船高。


























 3681
3681

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










