半导体的技术门槛一直增加,除了将晶体管尺寸缩小、还要同时加倍晶体管的单位面积,现在各大厂商都在竞争的「超越摩尔定律」是什么?
所有人都还在讨论台积电、三星和Intel在先进制程上面的战争,ASML的EUV以及Moore’s Law还能延续多久时,其实这几年来半导体的格局已经慢慢地产生了变化。 Moore’s Law发展到现在,下一代的工艺变得越来越复杂,对于技术的门槛要求也越来越高,连带地造成这几年来让制程微缩的阻力越来越高。 也因为如此,其实各家大厂都在思考在晶体管尺寸微缩越来越难的情况下,要怎么将单位面积的晶体管数量继续加倍。 今天我们要讨论的主题就是大家可能比较少注意到的,各家大厂已经在竞争的More than Moore(超越摩尔定律)的展开。
首先,为了要让大家对整个半导体发展有一个整体的概念,容许我先前情提要一下Moore’s Law。
Moore’s Law:已经引领了过去50年半导体产业/高科技领域的成长
首先我们简单介绍一下Moore’s Law, 这个定律其实不算是一个「定律」,而算是一个观察。 它是Intel的共同创办人Gordon Moore在1975年提出他对晶体管数量成长速度的观察,他的预测是每两年晶体管数量会变成两倍,也就是说每隔两年电脑的运算速度会变成两倍,或是说,同样运算速度的芯片会变成二分之一的价格。 虽然Gordon Moore没有要做一个非常精准的预测,但是事隔几十年再回来看,这个预测比他原本想象得还要精准。 而Moore’s Law也变成每个大的半导体的研讨会必定会提到的题目,很多人都会从Moore’s Law的讨论来当作是一个引子,进而阐述他们对接下来半导体产业趋势的看法。
而Moore’s Law的讨论为什么这么重要? 其实不是重要在讨论这个定律是不是仍然会延续下去,对业界来说,其实更重要的是藉由这个讨论来了解整个业界的趋势是否得以延续下去,还有这背后产业结构的变化以及其经济意涵。 Moore’s Law代表的是芯片成本下降的趋势,也代表不同终端产品的应用能力的提升(20年前大家绝对没有办法在手机上面做这么多事情)。

More than Moore定律(超越摩尔定律):Moore’s Law之上的成长动能
TSMC、Intel和Samsung这些大厂其实也注意到其实先进制程的开发复杂度是指数级增加,而当制程的复杂度指数增加时,开发的成本也会大幅提高。 有鉴于此,目前的大厂都纷纷在寻找新的方法来延续半导体产业的持续成长,而目前的方向除了进行尺寸微缩的创新以外,系统整合端/封装端的创新是目前TSMC、Intel和Samsung还有很多封装大厂正在积极布局的部分。
More than Moore讲正的是在这个万物互连蓬勃发展的时代,各种不同类型的sensor和IoT装置所触发的下一个半导体成长动能。 根据ITRS,整个半导体产业的发展可以分为两个部分,一个就是我们提到的Moore’s Law尺寸微缩的部分,另一个就是各种不同型态芯片还有sensor的发展,即More than Moore的部分(如图2)。
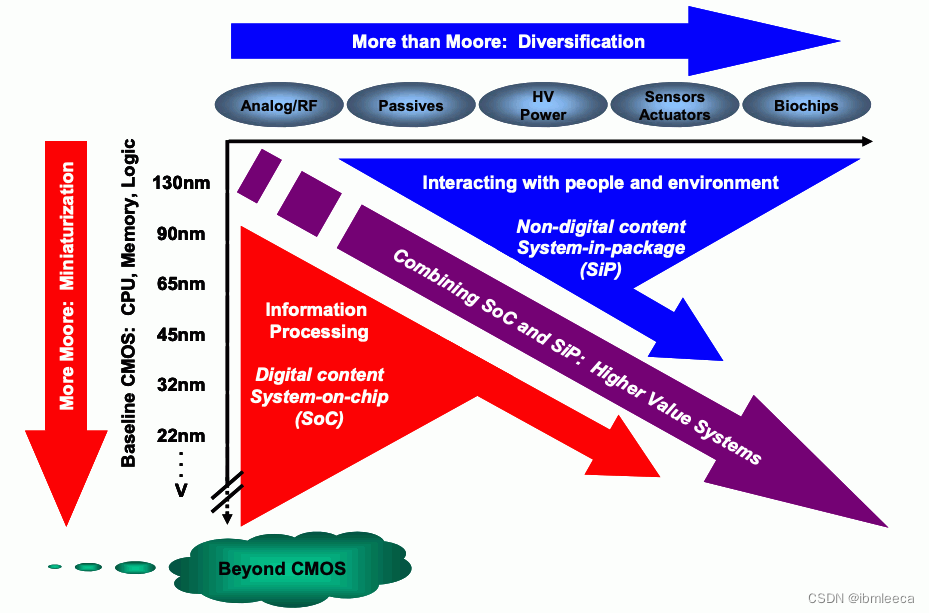
而为了要在一个系统里面更有效的整合 /应用各种不同的芯片和sensor,不管是半导体大厂或是封装厂都发展出了许多先进封装的技术。 根据台积电共同执行长刘德音在ISSCC 2021的演讲内容(见图3),台积电也发展了许多先进封装的制程,如CoWoS,InFo和SoIC… 等,让客户可以将不同型态的芯片整合在一个系统里面,持续提升在系统尺度的晶体管数量。 而一直以来,逻辑芯片(CPU、GPU等等)晶体管数量大量增加的关系,芯片对外带宽或I/O引脚数量的需求也大量增加,这些在持续发展中的先进封装的技术,也可以大幅度增加这些芯片对外的接脚数量,满足这方面的需求(如图4)。
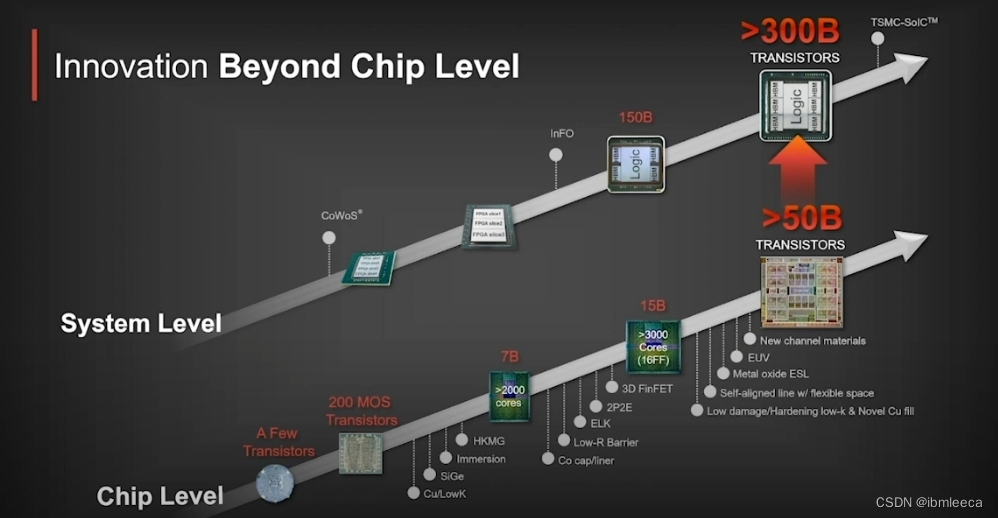

而不止TSMC,这几年Intel和Samsung也都积极布局先进封装。 以Intel为例,在最近的Intel Architecture Day 2020,Intel秀出了他们最新的封装Roadmap。 从这个Roadmap我们可以发现,未来的Bump(从芯片接出来的接脚)pitch(接脚到接脚间的距离)会一路从普通封装的100um左右,Bump density(接脚密度)~100/mm^2,一直发展到现在最新的Foveros制程(如图6),其Bump density(接脚密度)变为10倍左右(Bump pitch为25um~50um & Bump density ~1000/mm^2),大幅度增加接脚的数量。 而未来的Intel更计划微缩Bump pitch到小于10um(Bump density>10000 /mm^2),这也揭示了, 不管是TSMC、Intel或其他封装厂,都已经注意到这个系统尺度的趋势而且早就积极布局了。
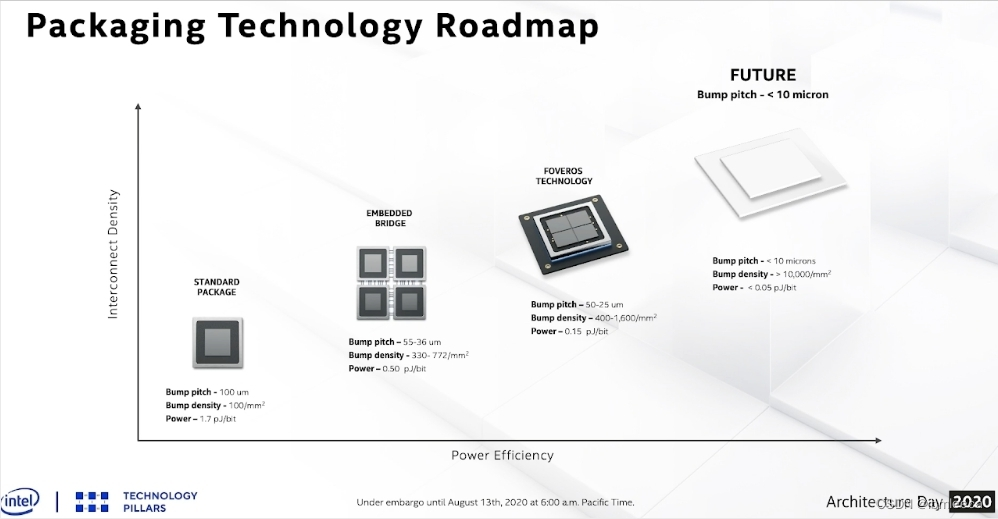
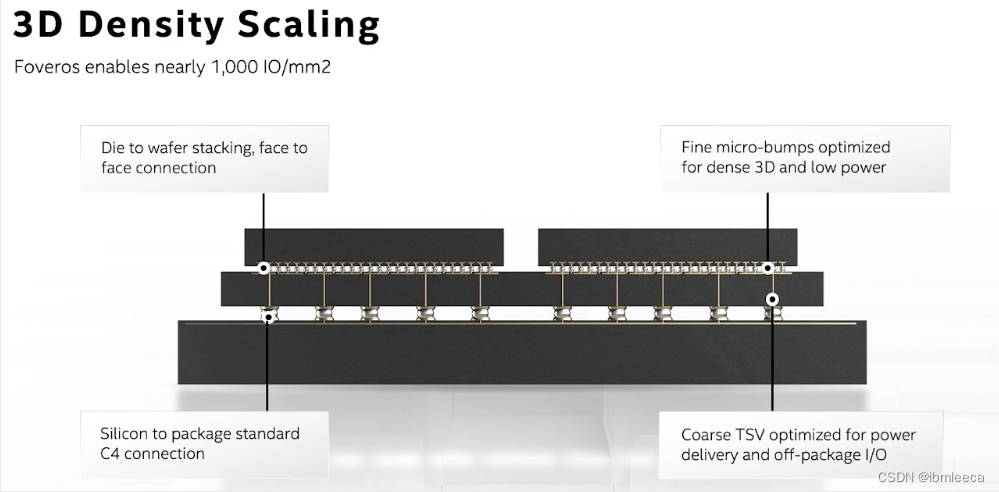
而从上面TSMC和Intel的例子也可以发现,半导体工艺上面的进展,已经从单纯专注在尺寸微缩的Moore’s Law,到整合不同种类芯片Sensor的More than Moore。 这上面的竞争已经从单纯Moore’s Law单线的竞争,一直延伸到系统整合层面的竞争了。 顺带一提,大家可以注意一下,这样子的趋势接下来也会影响到IC载板或PCB产业的产业格局。
总结:半导体产业格局的渐变:摩尔定律和超越摩尔定律并进
总体来说,虽然大家现在讨论最多的还是Moore’s Law尺寸微缩的部分,但因为IoT市场最近开始快速发展的原因,整个半导体业发展的趋势也从单纯Moore’s Law的尺寸微缩,到现在尺寸微缩(Moore’s Law)还有各种装置应用的市场(More than Moore)两个维度并进的格局。 而因应More than Moore的发展,各种不同先进封装的技术也在蓬勃发展中,想办法把各种不同的芯片以更小的尺寸封装在一起。 这样的现象也就造就了对PCB/IC载板技术要求的演进,以符合更多不同终端装置的需求。
而除了半导体厂以外,原本的封装大厂也极力发展先进封装技术(比如说System in Package技术),把更多的芯片透过封装的方式变成更小更薄的系统,满足更多终端装置市场的需求(如Apple watch就大量的采用System in Package技术),所以我们相信在未来万物联网的时代,先进封装的技术将会运用得更为广泛,接下来的发展, 是很令人值得注意的。








 本文探讨了半导体行业如何从摩尔定律的传统发展转向MorethanMoore(超越摩尔定律),重点在于系统整合和先进封装技术的进步,以应对复杂度增加和成本上升。大厂如台积电、Intel和Samsung都在研发更高效的芯片整合和封装方案,以满足万物互联时代的需求.
本文探讨了半导体行业如何从摩尔定律的传统发展转向MorethanMoore(超越摩尔定律),重点在于系统整合和先进封装技术的进步,以应对复杂度增加和成本上升。大厂如台积电、Intel和Samsung都在研发更高效的芯片整合和封装方案,以满足万物互联时代的需求.
















 3884
3884

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








