在上一篇笔记中,我们提供了bulk MOSFET的sde和sdevice代码。
这一篇,我们来讨论,对于300K的bulk MOSFET,有哪些影响它IV的参数。
1. 几何参数
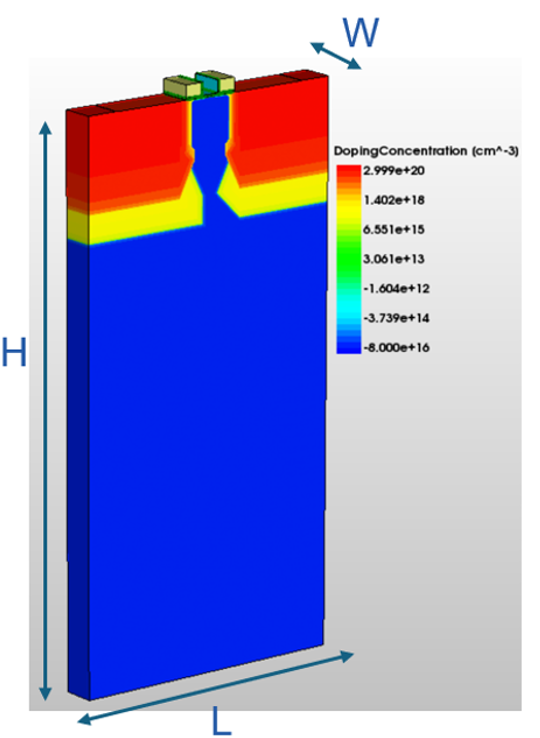
基底的高度H:在1-3um内,基本无影响。
基地的宽度W【重要】,栅宽W:如果结构在W方向拉伸的,那么电流大小跟W成正比。可以理解为I=I/微米*W;
S/D之间的距离【重要】:距离越小,Ion越大 ,Ioff越大。
总长度L:Ion会随L增大而增大,在2-3um到达饱和。
氧化层Tox厚度【重要】:对Vd=0.1V,Vg-Id的shape有较大影响。一般来说越薄栅控能力越好,Ion越大,Ioff越小。
2. 掺杂浓度【重要】
衬底掺杂浓度 dop_sub: 1e15-1e17 一般低掺杂, 降低dop_sub 一般增大Ion和Ioff
S/D 掺杂浓度 dop_sd: 1e17-1e20 ,增大掺杂浓度可以提高Ion
S/D 掺杂深度 d_sd: 50nm以内,深度越深 Ion越大 最后饱和
LDD 掺杂浓度 dop_ldd: 1e18-1e19
LDD 掺杂深度 h_ldd:10-20nm
LDD 掺杂长度 l_ldd: 10-20nm 为了降低Ioff 可以适当把LDD区变长变薄
3.迁移率大小【重要】
迁移率对Ion Ioff的影响是很重要且直观的。在Sentaurus TCAD内有很多迁移率模型。
3.1 默认迁移率模型
修改迁移率的方法:如果在sdevice内没有选择特定的moility模型,比如PhuMob,那么调用的是默认的迁移率模型。直接在parameter文件中修改即可。

#define ParFileDir .
Material = "Silicon"
{
* mu_const = mumax (T/T0)^(-Exponent)
ConstantMobility:
{
mumax=@mu@, 4.7e2
Exponent=@exp@,1.2 *1.5
mutunnel=@mutunnel@,0.05 *0.05
deltheta=@deltheta@,0.43
}
}
这里的mumax 默认是1470(电子)和4.7E2 (空穴)。
为了方便调参,可以写成@mu@,再在sdevice中调不同参数。
mu的大小对Ioff基本没有影响,电压越大影响越大。把迁移率从1470调到5000,Ion的变化不超过15%。
Exponent 参数,由公式可知,只对非300K下的迁移率有影响。
3.2 用高场饱和模型调Ion
有时会遇到,Vg=0.8-1.2V区间,电流已经饱和 但是我们需要在这个区间使电流继续增大。
这个时候可以调用HighFieldSaturation模型。【可以和默认mobility模型一起用】
如下图:(sdevice文件中加)
Physics {
temperature=@T@ #
Fermi
Mobility (
HighFieldSaturation(DensityDependentVsat)
)
}饱和速度在parameter文件中调整
#define ParFileDir .
Material = "Silicon"
{
HighFieldDependence:
{
Vsat_Formula=1,1
vsat0=@vsat0@,@vsat1@ *1e1e7 8E6
vsatexp=@vexp@,0.52
}
}为了增大Ion,可以调大vsat0。
【note】:有时候我们在手册中找具体模型参数的调整方法很麻烦。这个时候有一种简单方法:
在材料.par文件中直接ctrl+F 对应模型,即可找到对应模板。

3.3 Philips Unified Mobility Model
有时为了严谨考虑散射对迁移率的影响,例如低温条件下。我们需要用Philips Unified Mobility
Model 模型。这时不能通过constantmobiilty改迁移率了。在sdevice中调用方法如下:
Physics {
Mobility (
PhuMob
)
}在.para中模板如下: 主要修改mumax_As或mumax_B(取决于掺杂种类),具体公式可以找help 手册。

4. 其他
WF【重要】:nmos功函数的范围要在4.0-4.5v之内。对nmos,WF越大,Ioff越小。笔者一般对上Ion之后,Ioff跟理想差一点时,会调整WF的大小。
总结:对于300K 的bulk mosfet,重要的参数大概有这么多。调整合适的IV是一个枯燥且花时间的过程。希望能节省读者的时间。
邮箱:rujia_sj@sjtu.edu.cn


























 378
378

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








