在说生产工艺之前,我们先说下芯片里面的最小结构(举例子哈)
完整版请参考视频: https://www.bilibili.com/video/BV1RDKweMEAP/?vd_source=0fe44b59f009ec279f1191988a29b5d3
最小的一颗MOS管长这样,芯片里面大部分都是这种晶体管

关于MOS的工作原理请参考文章: https://zhuanlan.zhihu.com/p/22800303725
整个芯片里面有成千上亿个类似的晶体管组成,就像搭积木一样,

看到没,他有好多层,所以我们将这个制造过程就类比于盖楼一样.
好,我们现在一边看图,一边看这个积木是怎搭起来的
文章分两部分,这次讲第一部分:芯片生产制造工艺
下一次讲制造生产的设备,比如大家熟知的光刻机之类的,在里面起到什么作用
这篇是基础,你只有知道流程,才知道为啥要用那个设备
制造流程:
- 准备硅晶圆:将石英岩提炼成纯硅,生长出单晶锭,再切割成约 3/4 毫米厚的 300 毫米晶圆,晶圆侧面有条形码,有小凹口指示晶格方向。

- 制作掩模层相关步骤:
- 在晶圆顶部沉积一层绝缘二氧化硅。

- 在晶圆表面涂上感光光刻胶。
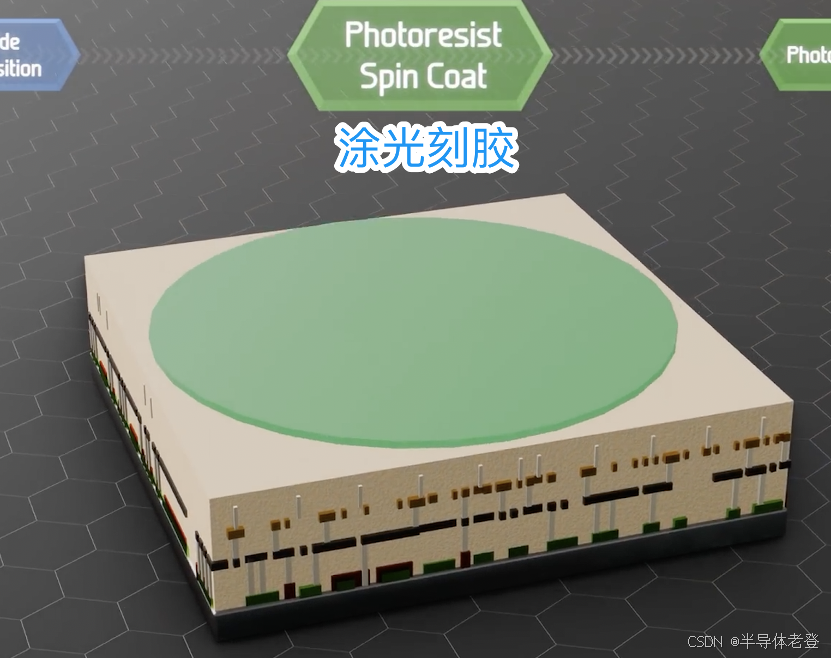
- 进行软烘烤,加热晶圆以蒸发光刻胶中的溶剂。
- 晶圆进入光刻工具,通过模板(光掩模)照射紫外线,光线穿过模板缩小后在晶圆上产生纳米级图案,使光刻胶变弱。

- 晶圆进入显影器,冲洗掉变弱的光刻胶,留下图案化的纳米级模板。

- 进行硬烘烤,使剩余的光刻胶变硬,形成掩模层。
- 蚀刻步骤:晶圆进入蚀刻工具(如等离子蚀刻机),使用腐蚀性化学物质或高能等离子体与晶圆表面反应,去除掩模层暴露的材料,形成孔。
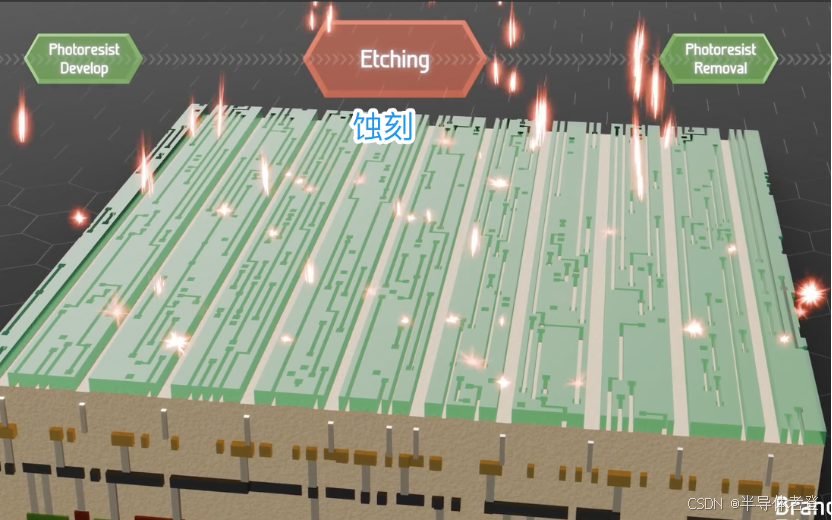
- 去除掩模层:晶圆被送到光刻胶剥离器,使用溶剂去除光刻胶掩模层。

- 沉积材料步骤:晶圆进入物理蒸汽沉积工具,填充金属(如铜)等材料到暴露的图案,并在晶圆上涂上金属。


- 化学机械平坦化:晶圆被送往化学机械平面化工具(CMP),施加浆料并使用研磨垫研磨和抛光晶圆顶面,使其平坦,形成平坦的绝缘二氧化硅和导电铜互连层。


- 重复循环:完成单个金属层后,准备开始下一个循环,添加绝缘二氧化硅,重复上述步骤构建多层。
- 如图所示(这张图就是流程工艺图啊,每一层基本上都是这个流程的循环,除了第一层)

- 细心的小伙伴会发现,是不是上面有些流程步骤我没讲啊 ,
- 对的 ,因为那些步骤主要用做在建立第一层的时候用的,相当于打地基的时候采用,比如离子注入ion implation之类的,因为只有对P半导体或者N半导体才做这些例子注入和掺杂,如下图所示,他们单单是金属,还有半导体,所以我们单独拎出来讲啊

- ---------------------我是分割线------------------
- 芯片第一层(类似于建造楼层的打地基的工艺工序)
- 晶体管制造:使用离子注入机,用磷、硼或其他元素轰击未掩蔽的区域,制造形成晶体管所需的 p 区和 N 区,此过程会损坏硅晶格,需用分析仪加热晶圆修复。

- 清洁步骤:使用晶圆清洗机,用超纯水清洁晶圆,然后用氮气或热异丙醇干燥,以去除污染物和颗粒。

- 检查步骤:使用计量工具(如具有纳米级分辨率的扫描电子显微镜)拍摄晶圆顶面照片,检查晶体管和金属层是否存在缺陷。
- 芯片测试与分类:完成的晶圆送到单独建筑,每个 CPU 经过严格测试,根据测试结果对半功能电路进行分类或合并。
- 切割与安装:将晶圆运送至另一栋建筑,用激光切割芯片,翻转放置在插入器上,将连接点分配到印刷电路板,放置保护性导热盖,安装集成散热器。
- 最终测试与包装:对整个组件进行测试,然后包装出售,CPU 可安装到主板和台式计算机中。
好了,关于工艺我们就先说到这,下一篇我们说说生产线和生产用的设备
有问题请留言交流
喜欢的朋友们可以点赞👍关注 ,谢谢
转载请注明来源 半导体老登
























 9669
9669

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








