上一篇我写了一个IC版图布局layout的设计
相关文章请参考:https://zhuanlan.zhihu.com/p/24966374244
视频:半导体EDA布局工具Virtuoso,从CMOS晶圆到电路仿真,全流程设计CMOS inverter_哔哩哔哩_bilibili
好多朋友表示难以理解,我那里面也强调了,这个和制成强相关,
那么我们就单独开一篇来说一下,芯片制作过程啊
以cmos为例子
第一步,准备晶源啊 wafer ,

第二,在wafer上面形成氧化层
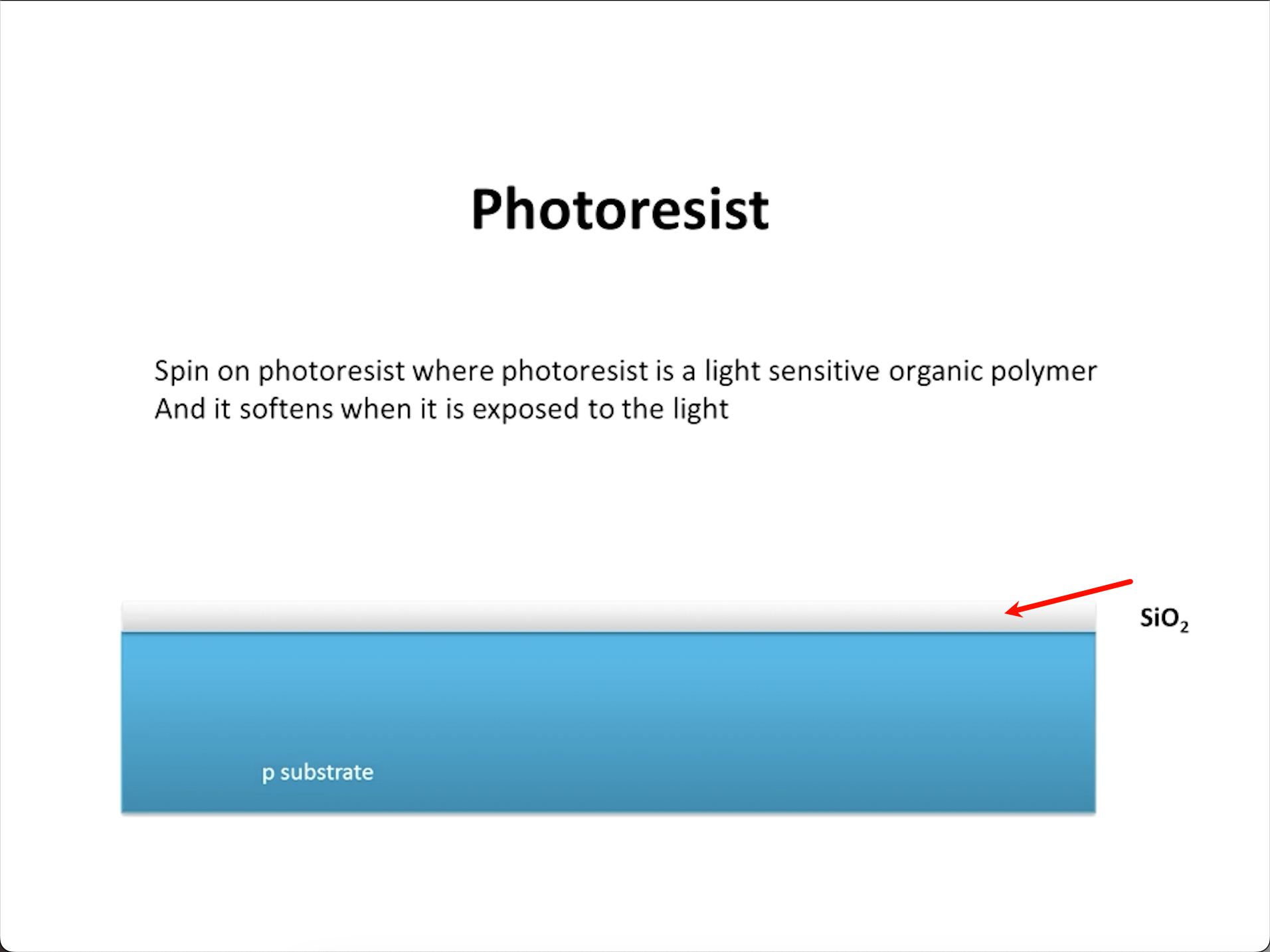
第三 涂光阻剂
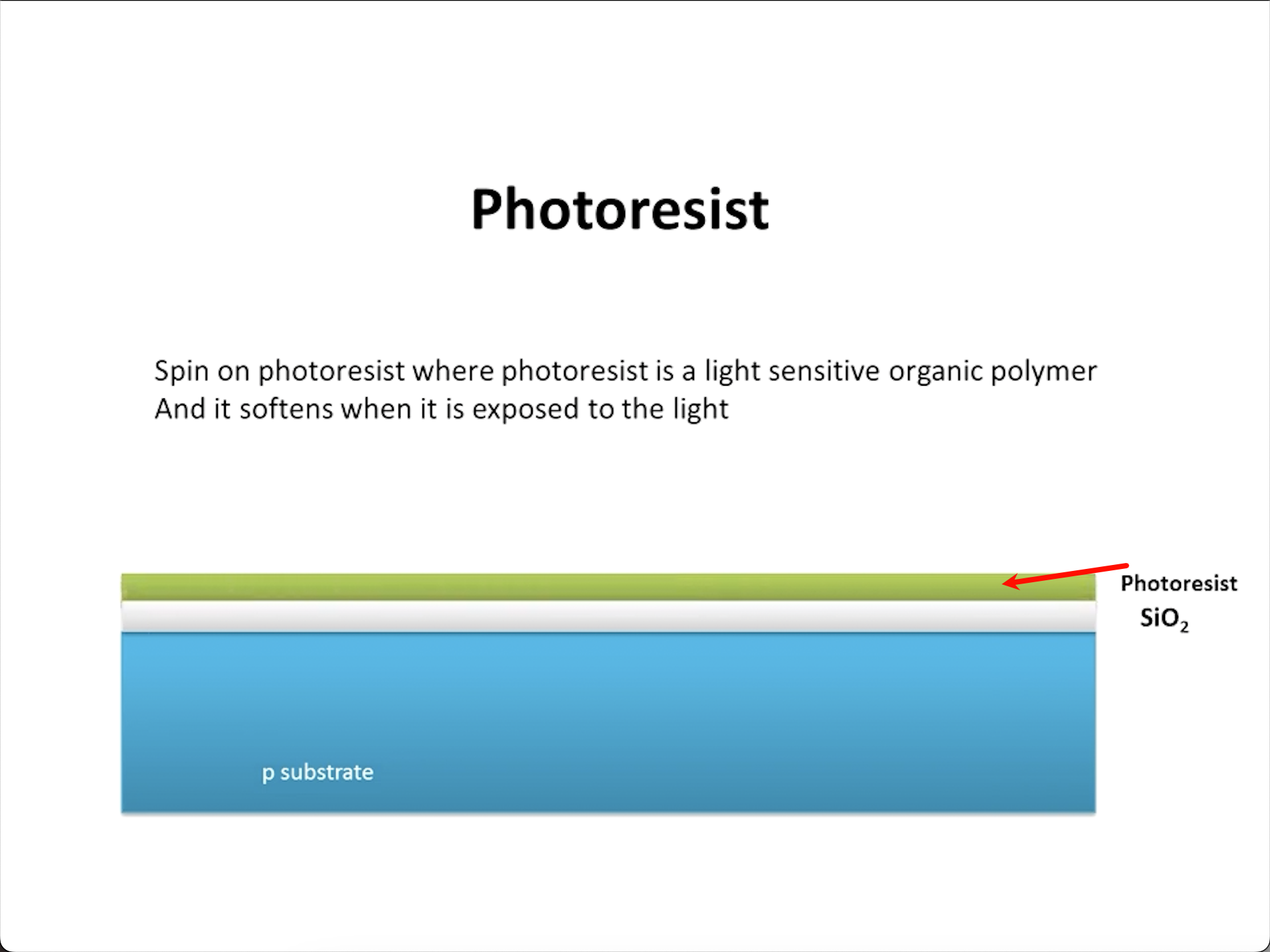
第四,用nwell 罩子罩住要蚀刻的部分
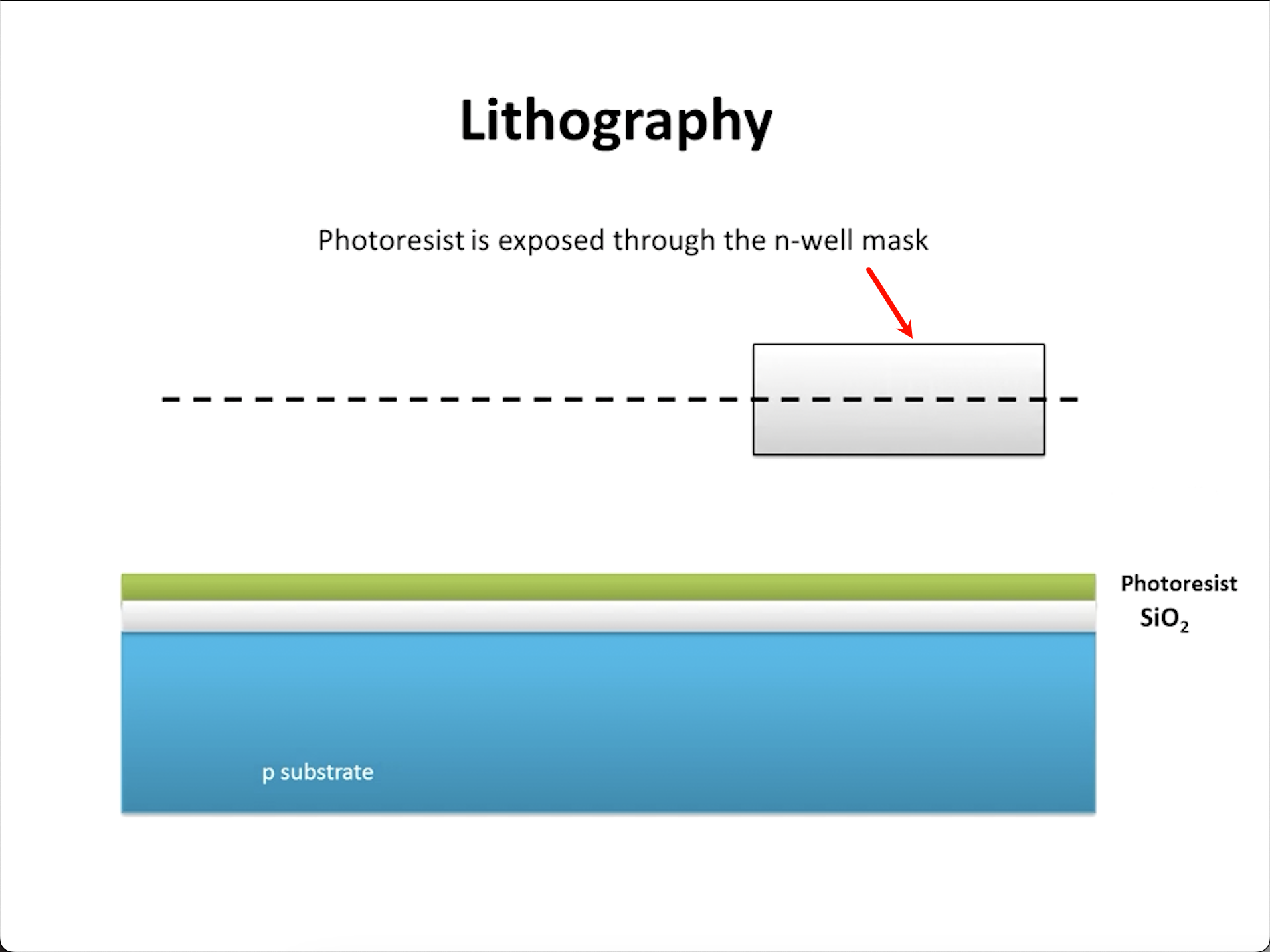
第五 显影
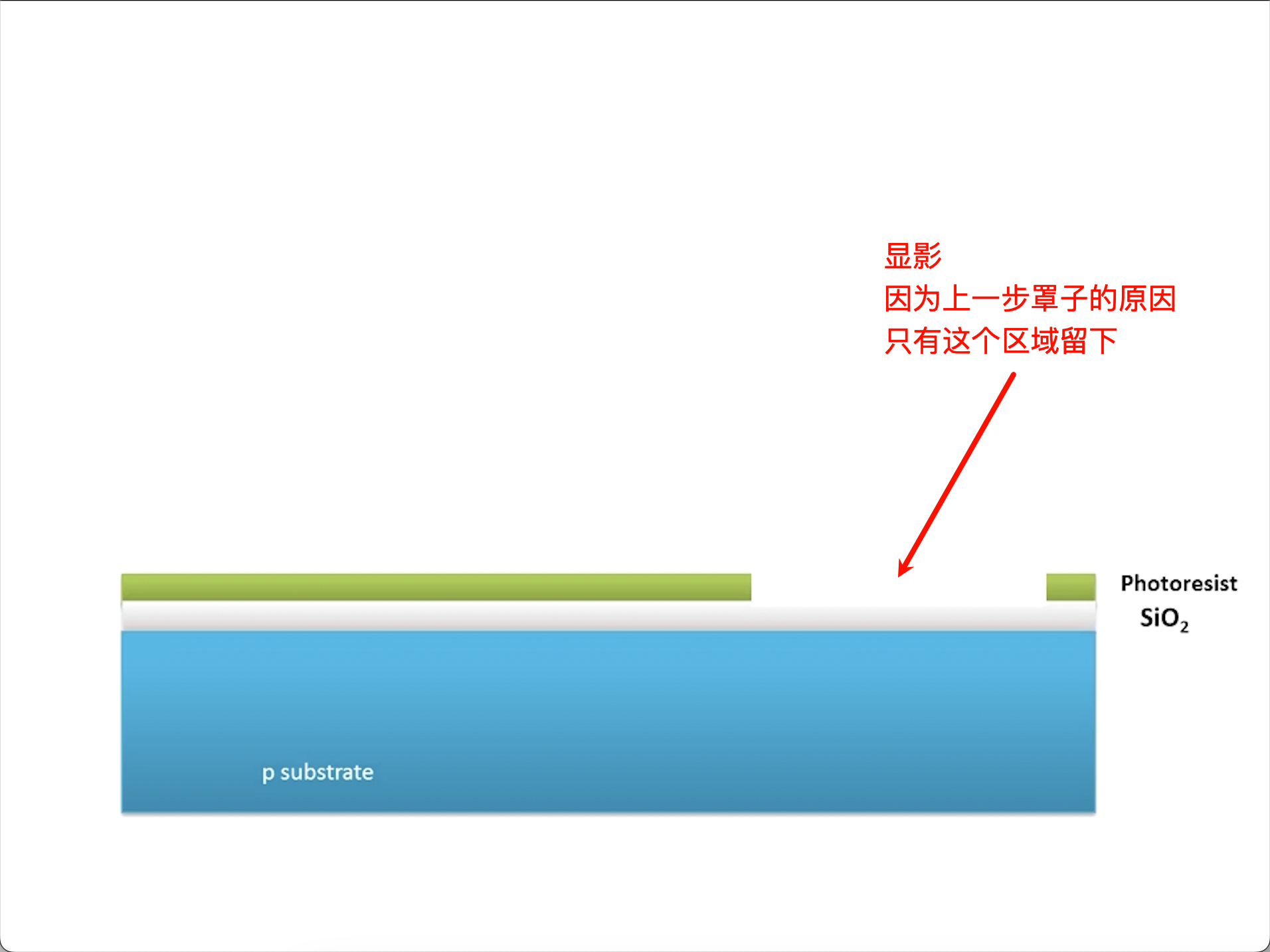
第六 蚀刻
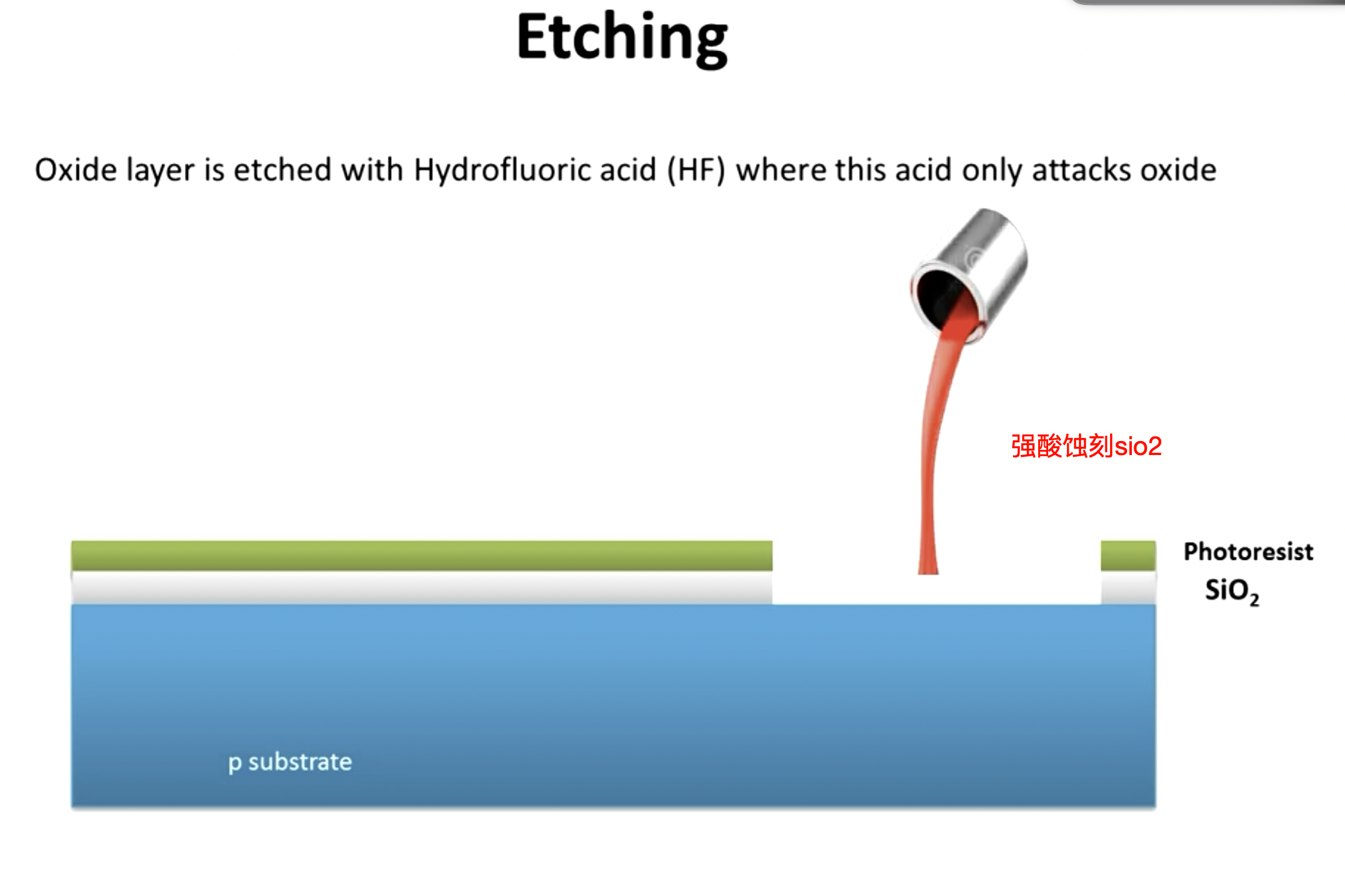
第七 去除多余的光刻胶
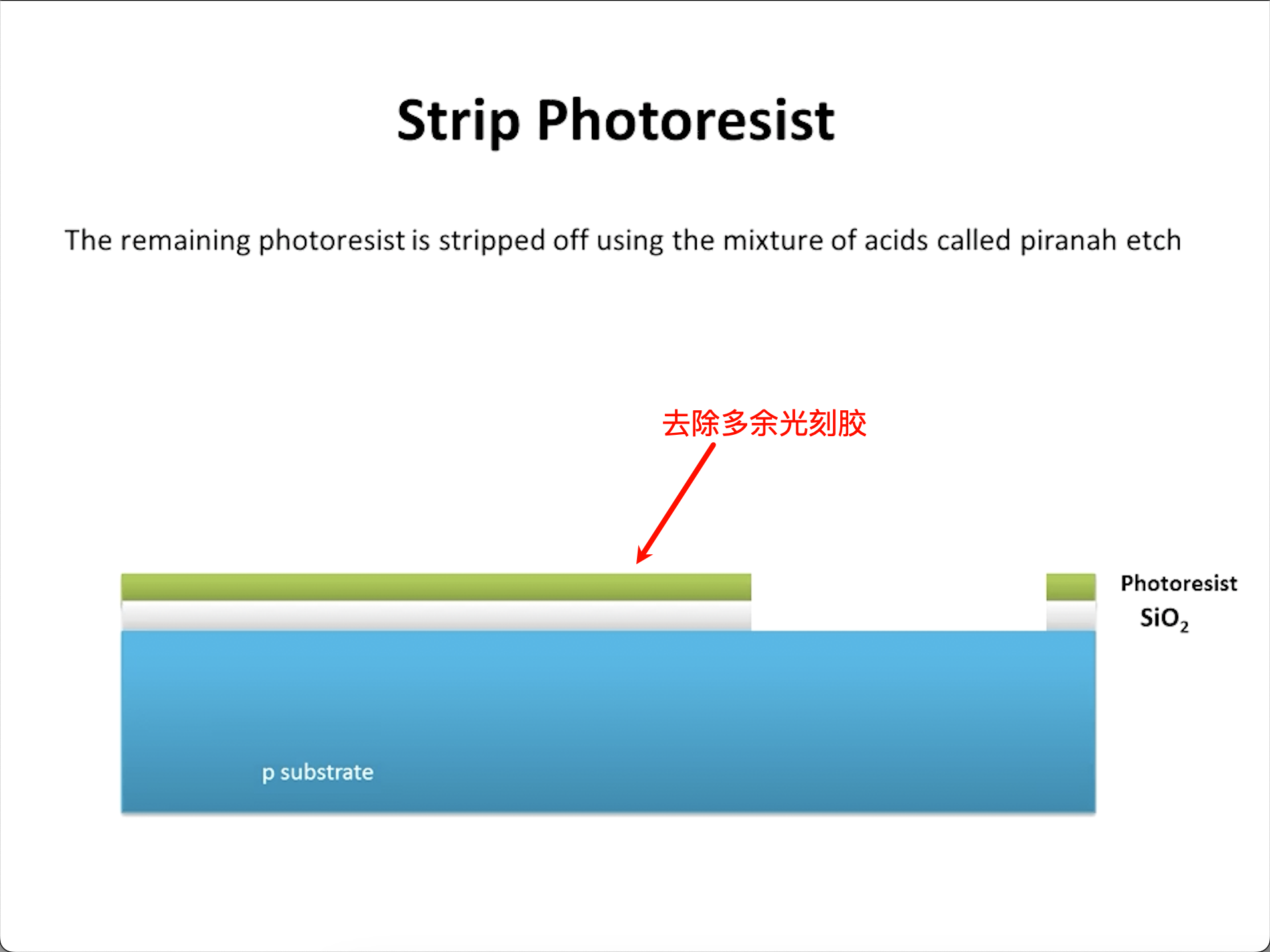
第八 扩散法或者离子注入法 形成nwell区域

第九 在用强酸腐蚀掉多余的二氧化硅

第十 再沉积一层很薄的sio2层,为后面的铺poly做准备 也就是gate栅极
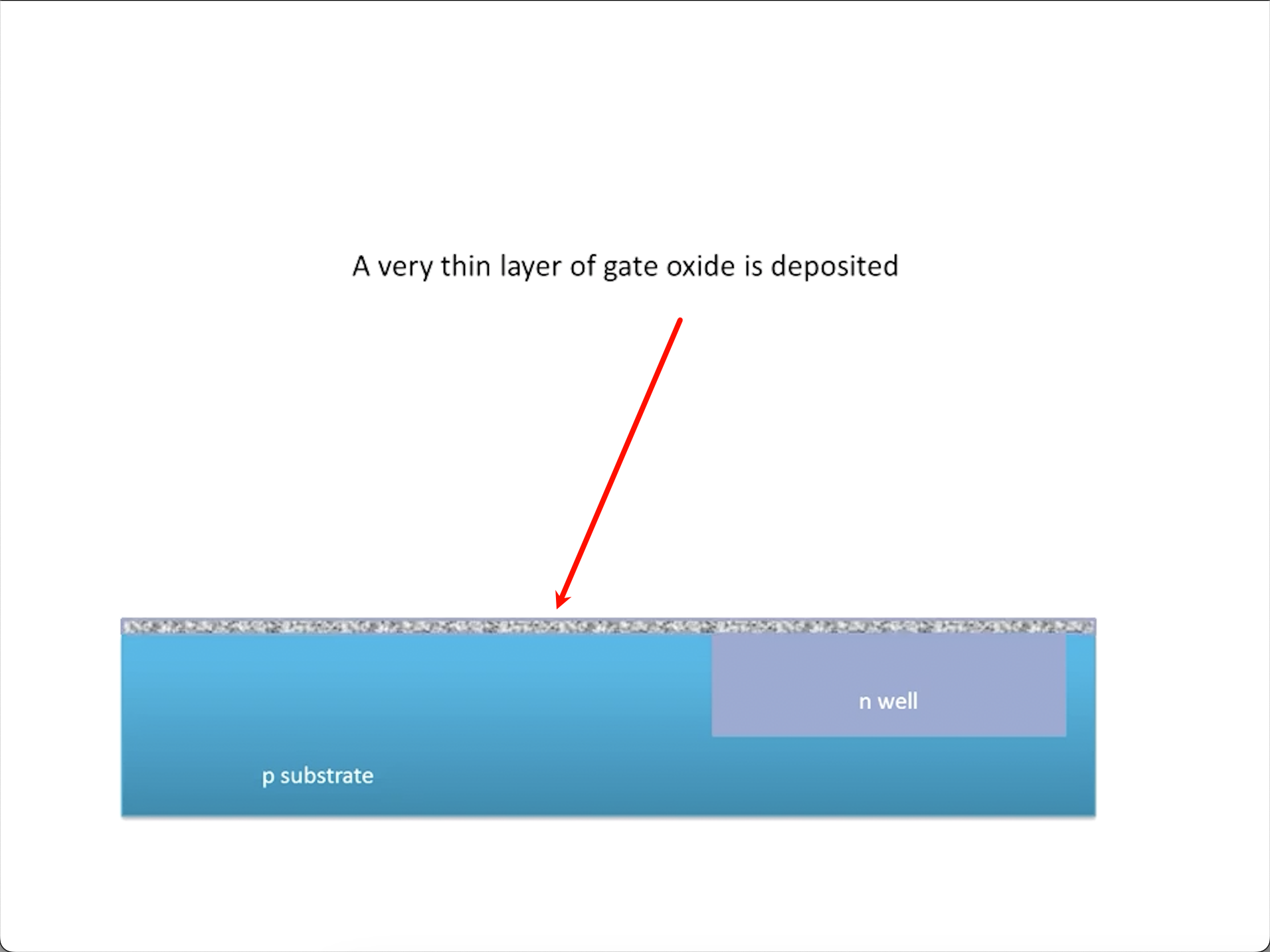
第十一步
化学沉积法铺一层多晶硅

第十二步 折poly罩子, 和前面的遮nwell罩子一样 ,留下需要的,
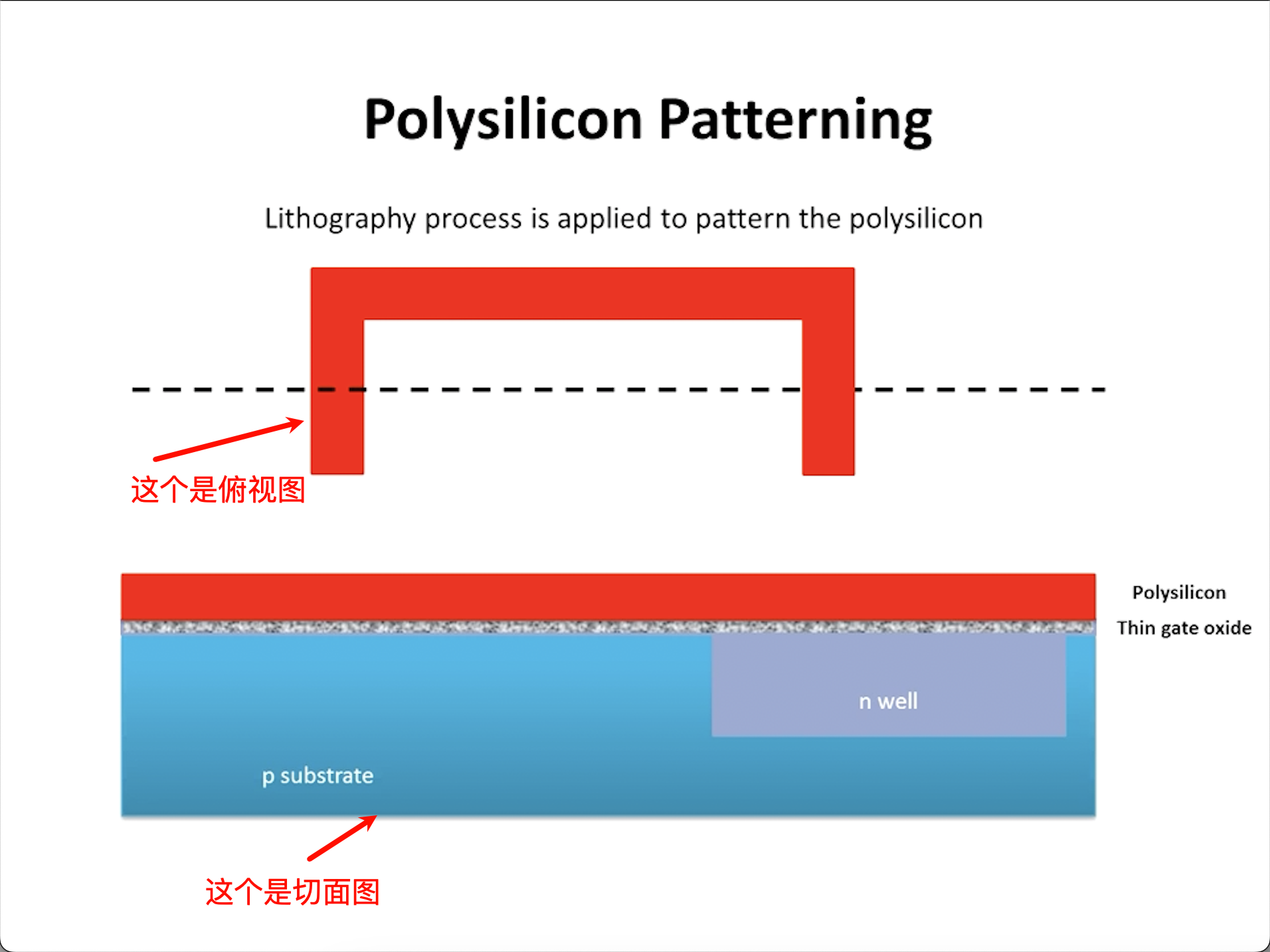
第十三步。多晶硅蚀刻 ,留下需要的
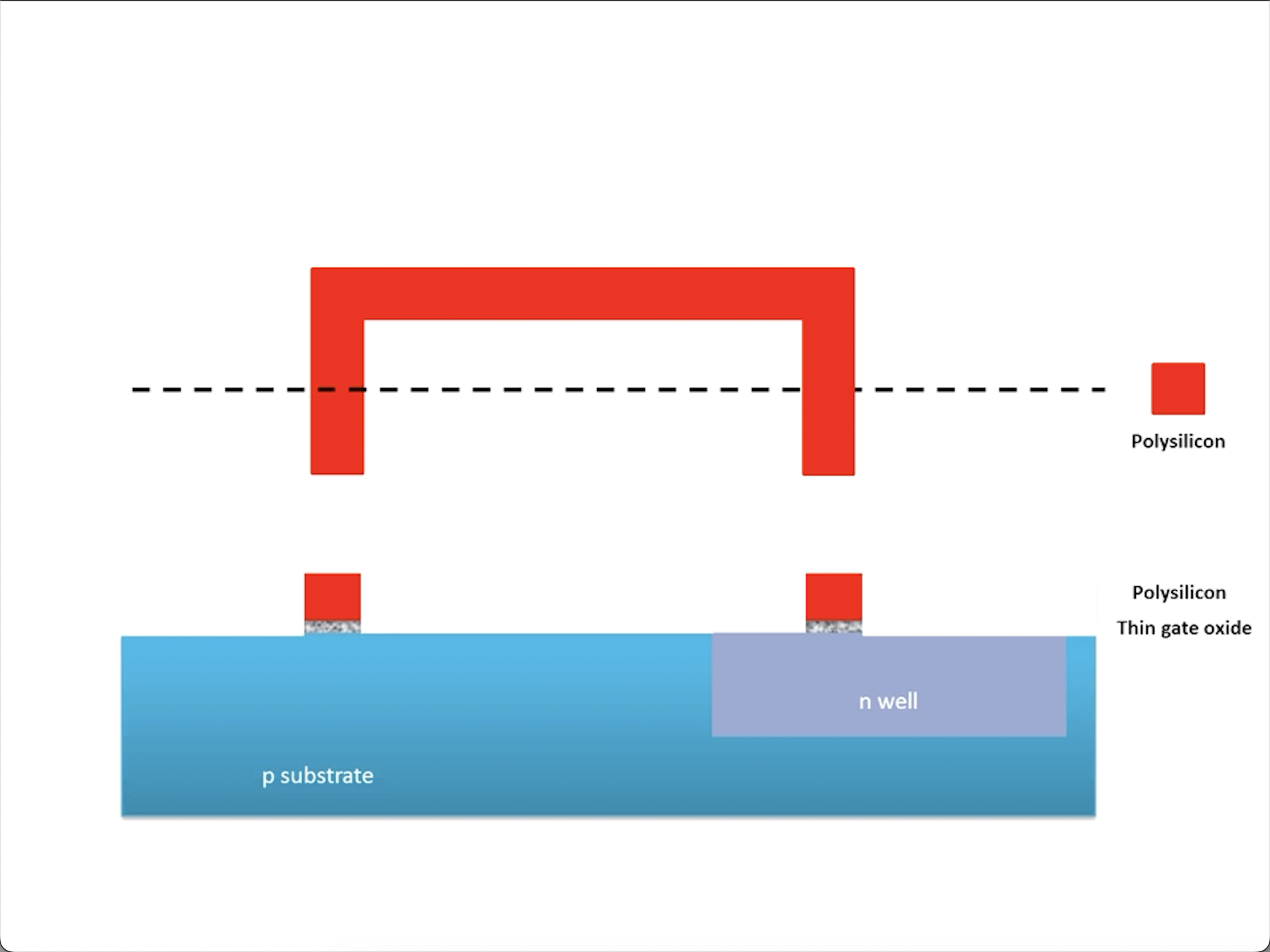
第十四 氧化
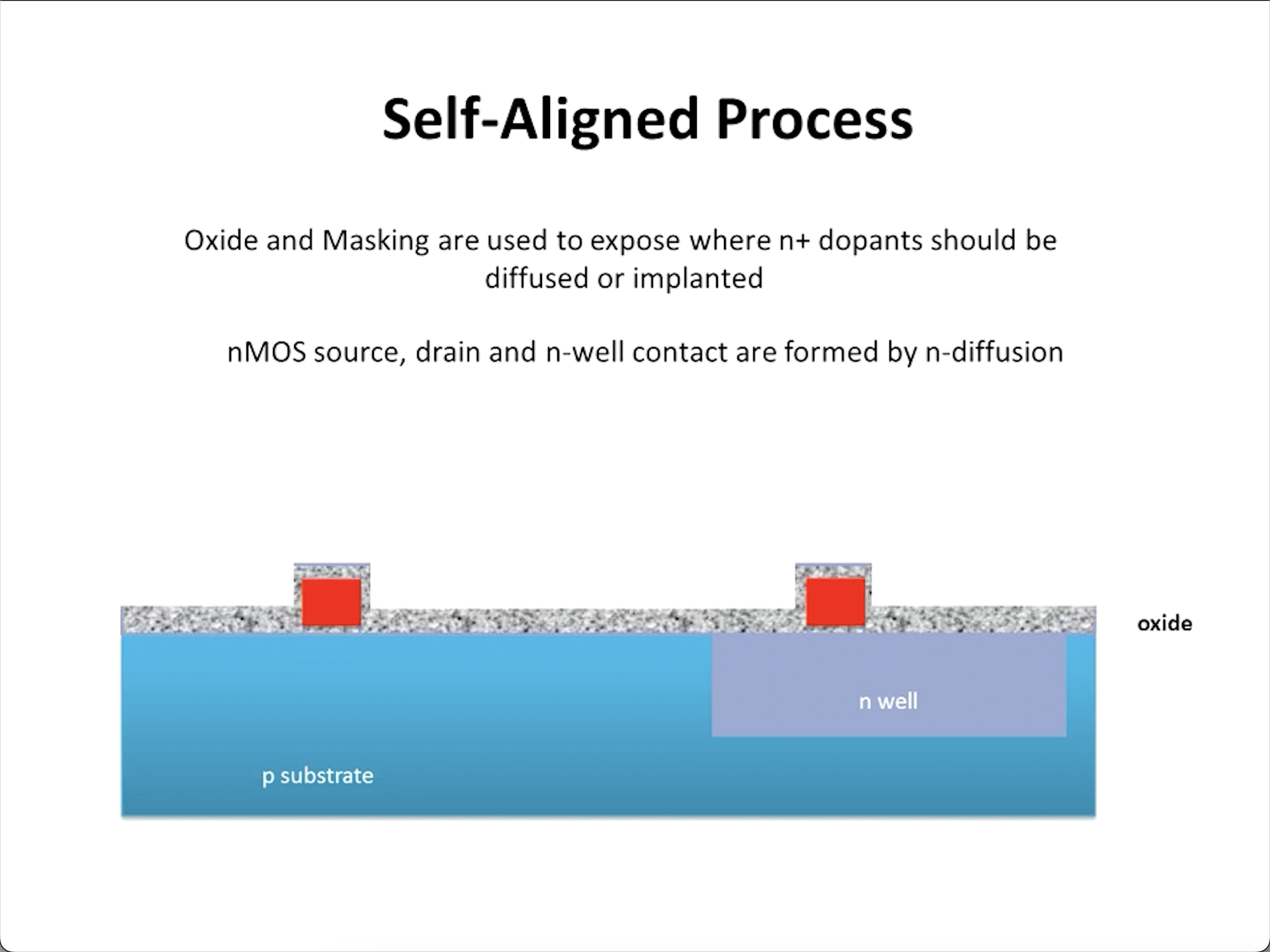
第十五 创建n型扩散区(高掺杂)


第十六 去除多余的二氧化硅
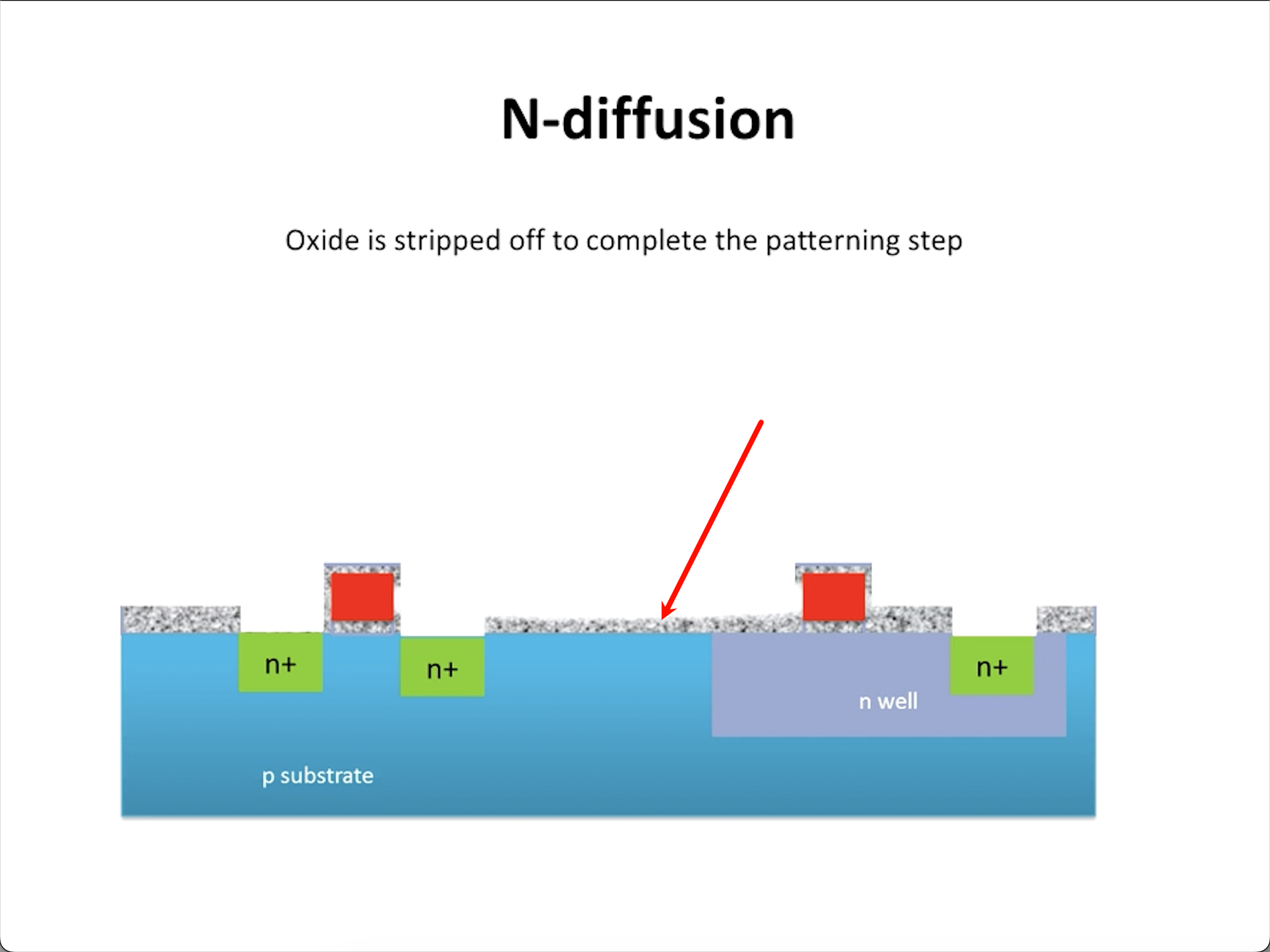
第十七 形成高掺杂p区
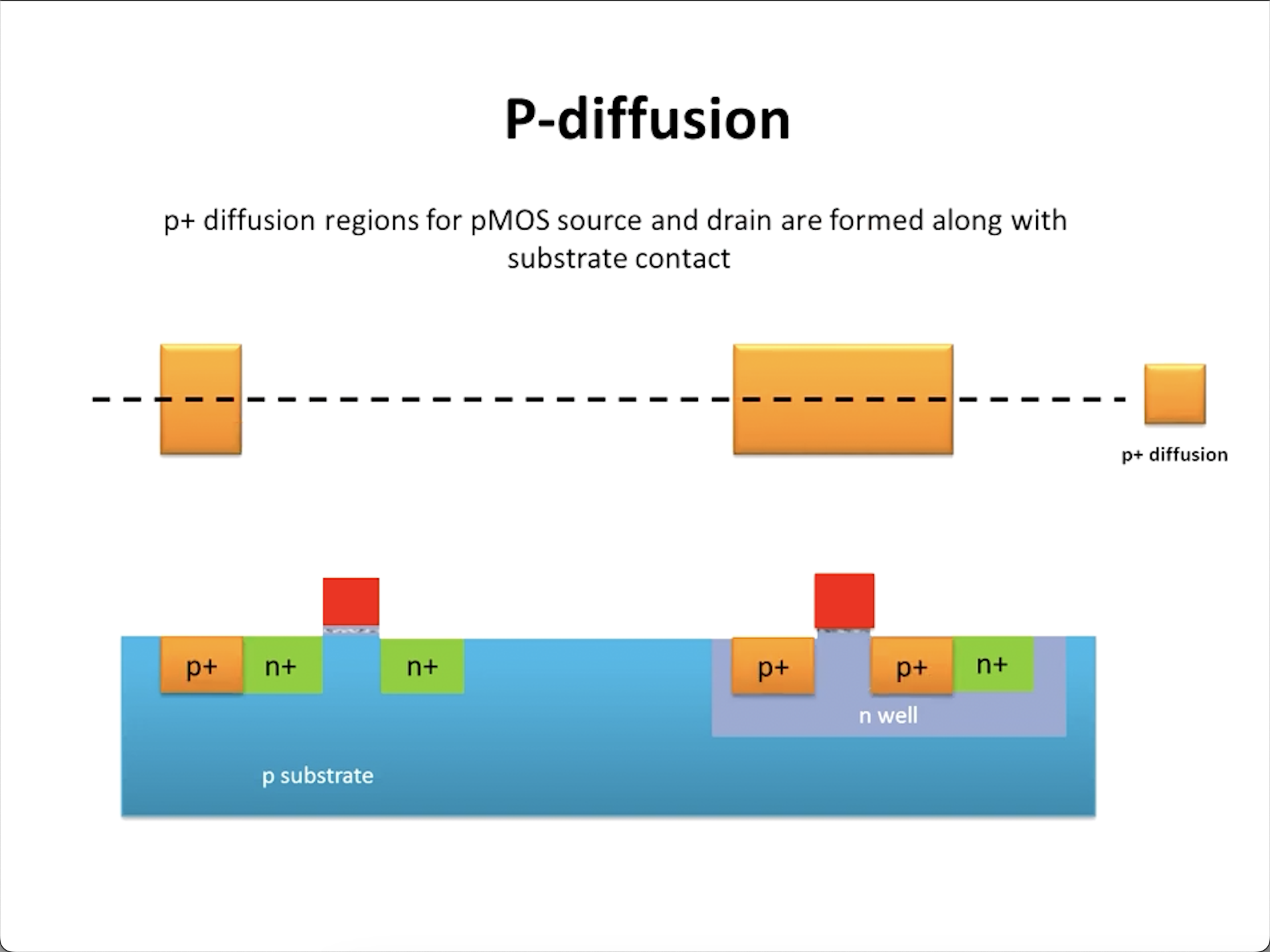
第十八 形成接触点contact 先把表面用二氧化硅氧化

第十九 再用盖子盖住保留区域, 随后蚀刻 ,暴露出连接点
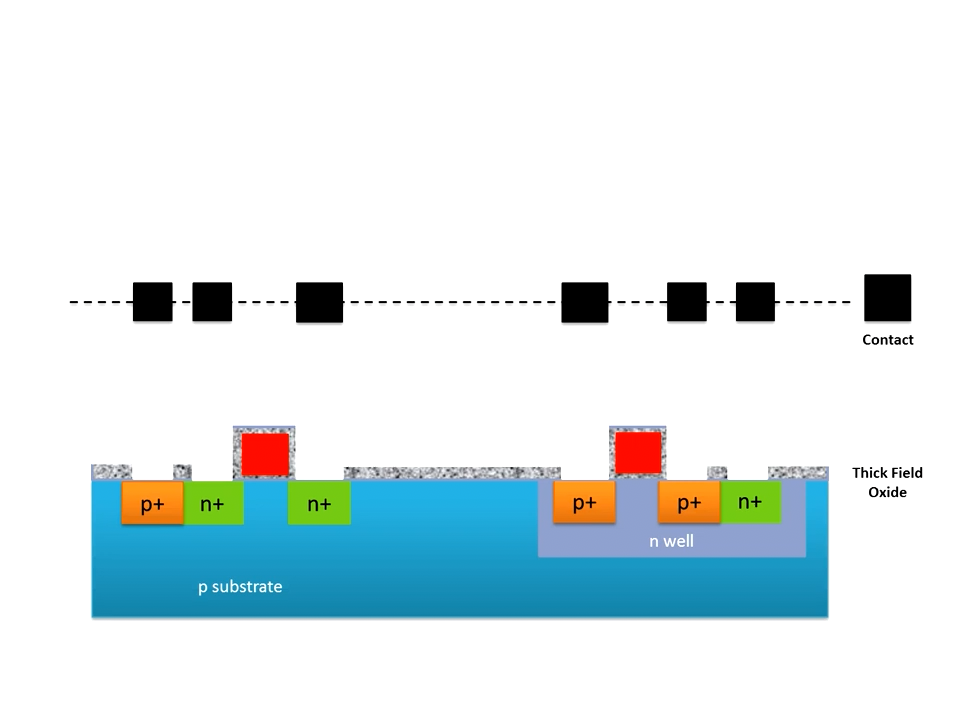
第二十步 金属化表层
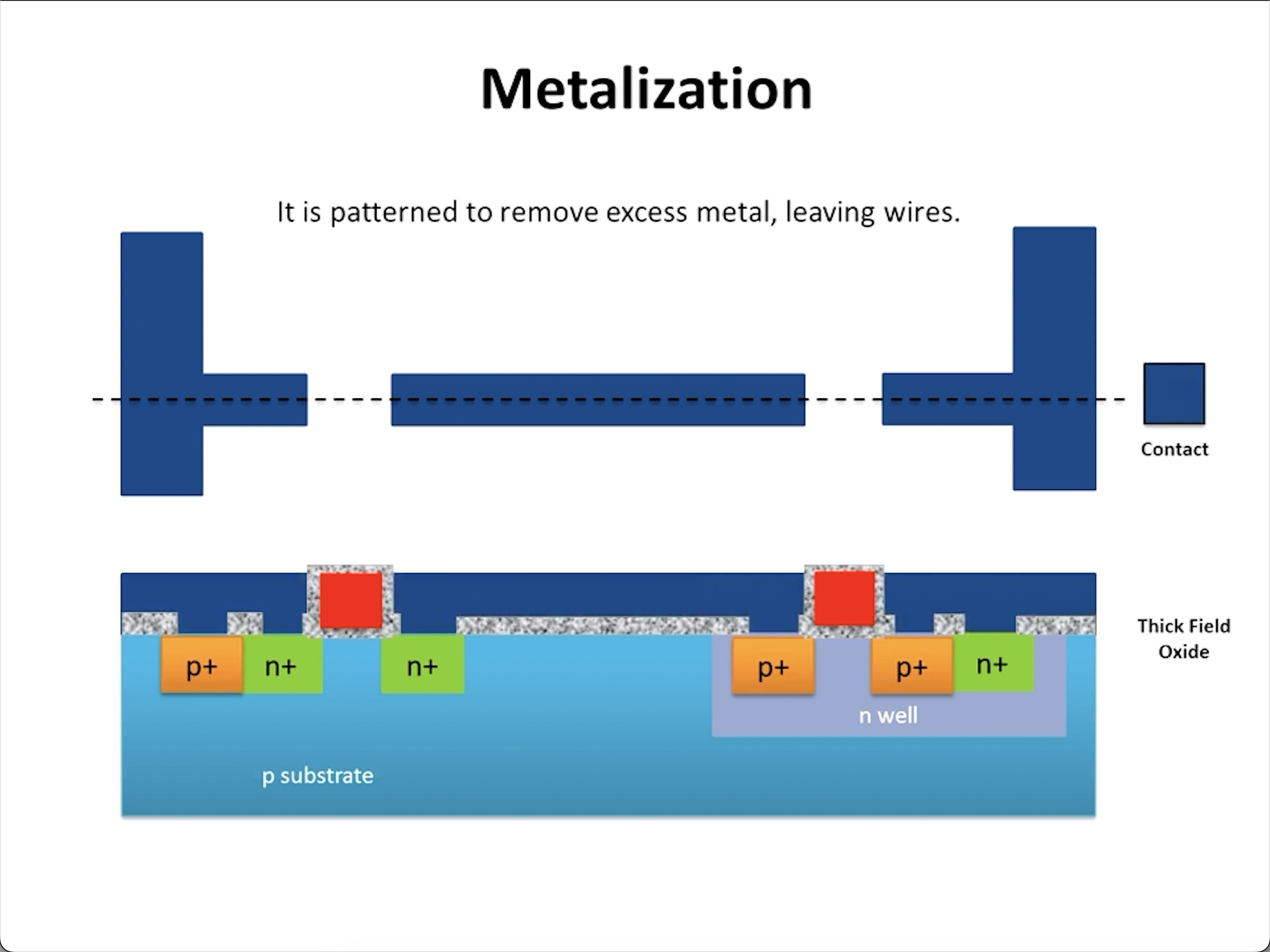
这样我们的cmos就做好了 ,左边就是nmos , 右边是一个pmos
文字的步骤如下
晶圆准备
- 选择合适的晶圆:通常采用单晶硅晶圆作为基础材料,其具有良好的晶体结构和电学性能。晶圆的质量和特性(如电阻率、晶向等)会影响最终 CMOS 器件的性能。
- 清洗和预处理:对晶圆进行严格的清洗,去除表面的杂质、油污和氧化物等,以确保后续工艺的质量。清洗后,还可能进行一些预处理步骤,如表面氧化形成一层薄的氧化层,以保护晶圆表面。
隔离区形成
- 局部氧化(LOCOS)或浅槽隔离(STI)
- LOCOS:通过热氧化工艺在晶圆表面生长一层较厚的二氧化硅层,作为器件之间的隔离区域。该工艺利用氮化硅掩膜来定义氧化区域,未被氮化硅覆盖的区域会被氧化形成隔离氧化物。
- STI:是一种更先进的隔离技术,先在晶圆表面刻蚀出浅槽,然后填充二氧化硅等绝缘材料,形成隔离结构。STI 具有更好的隔离性能和更小的尺寸,适用于先进的 CMOS 工艺。
阱区形成
- N 阱和 P 阱注入
- P 型衬底上的 N 阱:对于在 P 型衬底上制造的 CMOS 工艺,需要通过离子注入和扩散工艺形成 N 阱。首先,在晶圆表面涂覆光刻胶,通过光刻工艺定义出 N 阱区域,然后进行 N 型杂质(如磷或砷)的离子注入,最后通过高温扩散使杂质均匀分布,形成 N 阱。
- N 型衬底上的 P 阱:类似地,在 N 型衬底上制造 CMOS 时,需要形成 P 阱。使用光刻工艺定义 P 阱区域,进行 P 型杂质(如硼)的离子注入和扩散。
栅极氧化和多晶硅栅极形成
- 栅极氧化:通过热氧化工艺在晶圆表面生长一层非常薄且均匀的二氧化硅层,作为 MOSFET 的栅极氧化物。栅极氧化物的质量对器件的性能和可靠性至关重要,其厚度通常在几纳米到几十纳米之间。
- 多晶硅沉积:采用化学气相沉积(CVD)等方法在栅极氧化物上沉积一层多晶硅薄膜。多晶硅将作为 MOSFET 的栅极材料。
- 光刻和刻蚀:在多晶硅层上涂覆光刻胶,通过光刻工艺将栅极图案转移到光刻胶上,然后使用刻蚀工艺去除未被光刻胶保护的多晶硅,形成栅极结构。
源极和漏极形成
- 轻掺杂漏极(LDD)注入(可选):为了减少短沟道效应,在先进的 CMOS 工艺中通常会进行 LDD 注入。通过光刻工艺定义出源极和漏极区域,然后进行低剂量的杂质注入,形成轻掺杂的源极和漏极区域。
- 源极和漏极重掺杂注入:再次使用光刻工艺确定源极和漏极的最终区域,进行高剂量的杂质注入,形成重掺杂的源极和漏极。对于 NMOS,注入 N 型杂质;对于 PMOS,注入 P 型杂质。注入后,通过高温退火激活杂质并修复注入造成的晶格损伤。
金属化和互连
- 接触孔刻蚀:在晶圆表面生长一层绝缘层(如二氧化硅),然后通过光刻和刻蚀工艺在绝缘层上刻蚀出接触孔,使源极、漏极和栅极暴露出来,以便后续的金属连接。
- 金属沉积和图案化
- 第一层金属(Metal 1):采用物理气相沉积(PVD)或化学气相沉积等方法在晶圆表面沉积一层金属(如铝或铜),然后通过光刻和刻蚀工艺将金属图案化,形成第一层金属互连线路,连接各个 MOSFET 的源极、漏极和栅极。
- 层间介质和后续金属层:在第一层金属上生长一层层间介质(ILD),然后重复上述接触孔刻蚀、金属沉积和图案化的步骤,形成第二层、第三层等多层金属互连结构,实现复杂的电路连接。
钝化层形成
- 沉积钝化层:在最后一层金属互连完成后,在晶圆表面沉积一层钝化层(如氮化硅或二氧化硅),保护芯片免受外界环境的影响,如湿气、灰尘和机械损伤等。
- 开孔和划片:通过光刻和刻蚀工艺在钝化层上开设焊盘孔,以便后续的封装连接。最后,将晶圆切割成单个芯片(划片),进行封装和测试。
通过以上一系列复杂的工艺步骤,最终在晶圆上形成了完整的 CMOS 结构,实现了各种逻辑和模拟电路功能。
喜欢的朋友请点赞关注 也可留言
转载请注明 半导体老登
























 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








