随着人工智能、大数据分析、云计算及高端图形处理等领域对高速、高带宽存储需求的激增,下一代高带宽内存(High Bandwidth Memory, HBM)——HBM4已成为全球存储芯片巨头三星、SK海力士和美光竞相追逐的技术高地。
随着AI、机器学习以及高性能计算应用的迅速发展,尤其是生成式AI技术对更高性能计算能力的需求,市场对HBM的需求正以迅猛的速度增长,预计年复合增长率高达82%至35%,并且到2025年市场规模可能翻一番。
随着存储密度的不断提升,工艺微缩面临物理极限的挑战,如量子隧穿效应、漏电流增大等,需要不断创新和优化工艺技术以应对。高密度、高速度的HBM4对电源管理和散热提出了更高要求。从HBM2e逐渐过渡到HBM3e,再到HBM4,各厂商不断推进技术革新,提升内存带宽和容量,满足日益严苛的数据传输需求。韩国已将HBM技术上升为国家战略层面,反映了全球范围内对尖端存储技术重视度的提高。

韩国媒体The Elec和ETNews于4月7日报道,三星电子先进封装团队高管金大宇在韩国微电子封装学会年会上宣布,公司近期已验证了一种16层混合键合HBM(高带宽内存)技术。
金大宇表示,三星电子已成功使用混合键合技术生产出16层堆叠的HBM3内存样品,该样品运行正常,未来将把16层堆叠的混合键合技术应用于HBM4内存的大规模生产。
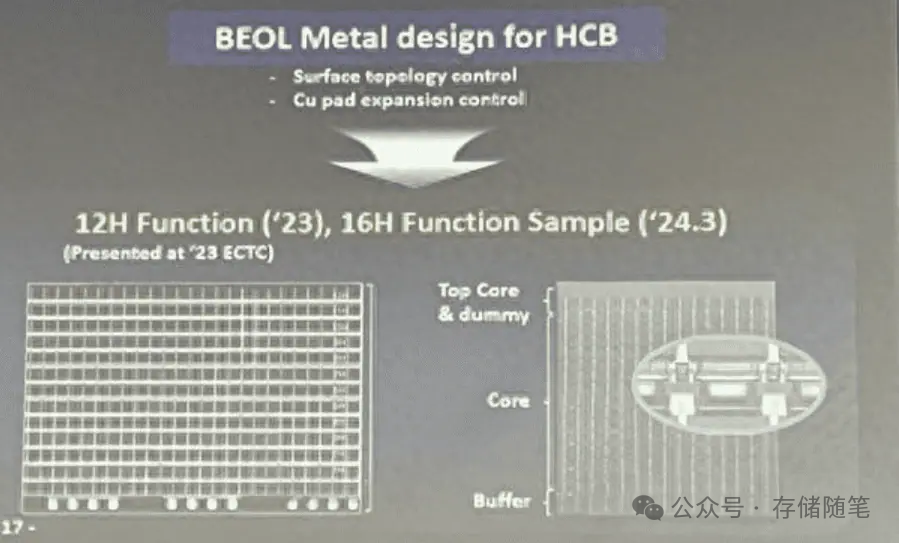
相较于当前的键合工艺,混合键合无需在DRAM内存层之间添加凸点,而是直接利用铜将上下层连接,大大提升了信号传输速率,更适合AI计算所需的高带宽需求。此外,混合键合还能缩小DRAM层间的距离,降低HBM模块的整体高度。然而,该技术面临成熟度不足和应用成本高等挑战。
三星电子在HBM4内存键合技术上采取双轨策略,同时开发混合键合技术和传统的TC-NCF(热压缩氮化硅填充)工艺。
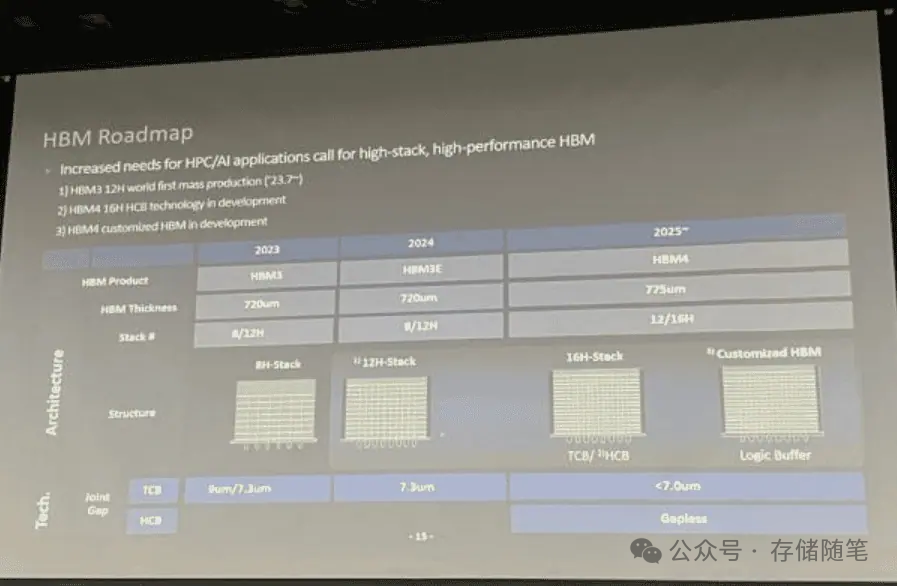
HBM4模块的高度限制将提升至775微米,有利于继续使用TC-NCF工艺。三星正在努力缩小TC-NCF工艺中的晶圆间隙,目标在HBM4中将其高度降至7.0微米以内。
尽管外界对TC-NCF技术持怀疑态度,但金大宇辩护称,与竞争对手SK海力士的MR-RUF相比,三星电子的解决方案更适合用于12层甚至16层的高堆叠模块。
各大厂商HBM研究进度:

-
-
三星:作为HBM市场的领军企业之一,三星已经实现了HBM订单的大幅增长,并且正在持续扩大其生产能力和封装技术,预期将在未来继续保持领先地位,包括下一代HBM产品的开发与生产。
-
SK海力士:已宣布其HBM3e产品进入大规模量产阶段,并制定了明确的时间表,即在2026年开始大规模生产HBM4。同时,该公司积极布局国际市场,计划在美国设立先进封装厂,以应对客户需求的增长。
-
美光:尽管美光并未透露具体关于HBM与逻辑芯片整合的战略,但美光仍在HBM领域保持活跃,提供HBM解决方案给主要GPU和其他加速器芯片制造商,通过HBM-GPU等方式支持市场发展。美光科技开始批量生产HBM3E产品,已经开始发货。对于HBM产品,2024年的库存已经售罄,而且2025年的大部分供应量已被提前预定。
-
如果您看完有所受益,欢迎点击文章底部左下角“关注”并点击“分享”、“在看”,非常感谢!
精彩推荐:

如果您也想针对存储行业分享自己的想法和经验,诚挚欢迎您的大作。
投稿邮箱:Memory_logger@163.com (投稿就有惊喜哦~)
《存储随笔》自媒体矩阵

更多存储随笔科普视频讲解,请移步B站账号:

如您有任何的建议与指正,敬请在文章底部留言,感谢您不吝指教!如有相关合作意向,请后台私信,小编会尽快给您取得联系,谢谢!








 随着AI和高性能计算需求的增长,HBM4成为存储技术焦点,三星、SK海力士和美光加速研发,混合键合技术有望提升性能。存储密度挑战和技术突破推动市场扩大,HBM4的发展被各国视为国家战略层面的重要议题。
随着AI和高性能计算需求的增长,HBM4成为存储技术焦点,三星、SK海力士和美光加速研发,混合键合技术有望提升性能。存储密度挑战和技术突破推动市场扩大,HBM4的发展被各国视为国家战略层面的重要议题。



















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










