在半导体先进封装行业中,清洗场景与设备对应如下:
1. /焊后助焊剂、锡膏、焊膏、球焊膏、焊锡膏、锡渣等残留物的清洗/:
- /超声波清洗设备/:利用超声波在液体中产生的空化效应,形成微小气泡爆破,以物理方式去除污染物。
- /喷淋清洗设备/:高压纯水或溶剂喷射于芯片表面,通过机械冲刷作用清洗污染物。
- /兆声波清洗设备/:比超声波频率更高的清洗方式,能更有效地去除微小颗粒和有机污染物。
- /等离子清洗设备/:利用活性气体等离子体与污染物发生化学反应,达到清洁目的,特别适用于去除有机物。

2. /TSV(硅穿孔)清洗/:
- /等离子清洗设备/:在3D封装中,TSV的制作过程中需要极高的工艺精度,等离子清洗技术能够清洗掉生产过程中形成的分子水平的污染,从而显著地改善封装的可制造性、可靠性及成品率。
3. /UBM/RDL(凸点底层金属/薄膜再分布技术)清洗/:
- /等离子清洗设备/:等离子体清洗技术能够很容易清洗掉生产过程中形成的各种沾污,这些沾污会明显地影响封装生产及产品质量。
4. /键合清洗/:
- /等离子清洗设备/:等离子体表面清洗可用于芯片粘结之前的处理,活化后的表面能改善环氧树脂等高分子材料在表面的流动性能,提供良好的接触表面和芯片粘结浸润性,可有效防止或减少空洞形成,改善热传导能力。
这些清洗设备的特点包括:
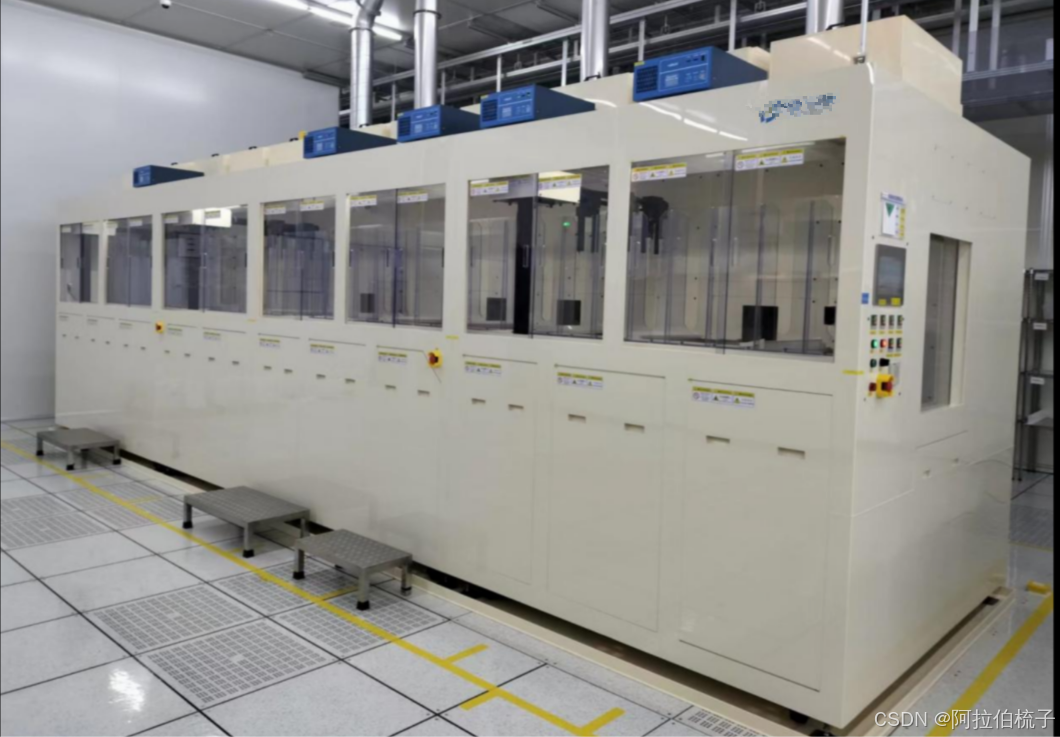
- /高清洁效率/:能够去除晶圆表面极小的颗粒和各种污染物,确保芯片的性能和可靠性。
- /适应不同工艺需求/:不同的清洗设备可以针对不同的污染物和工艺需求,提供定制化的清洗解决方案。
- /环保和安全性/:现代清洗设备趋向于使用更环保的清洗剂,并且在操作过程中保证安全性。
- /技术先进性/:随着技术的发展,清洗设备也在不断进步,例如采用人工智能和自动化技术提高清洗效率。

























 6万+
6万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










