倒装封装 (Flipchip)是相对于引线键合(Wire Bonding)来说的,之所以叫做倒装,是因为flip chip是正面朝下放置。倒装芯片技术是通过芯片上的凸点直接将元器件朝下互连到基板、载体或者电路板上。引线键合的连接方式是将芯片的正面朝上,通过引线(通常是金线)将芯片与线路板连接。
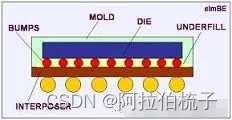
倒装封装 (Flipchip)相对于传统的封装,是一种wafer 级的封装。不是先把晶圆切割成单个die,再进行封装,而是先针对晶圆进行封装,封装好后,再切割。称之为 Wafer Level CSP。

这种封装方式有一个特殊的工艺流程,就是bump。大家可以理解为长金球(锡球)。
要想长金球,首先要做的就是重新布局芯片pad的的位置,利用和芯片制造中相同的后段技术,将边缘部位的pad,安排到芯片中央来。这句话就是bump的核心目的。
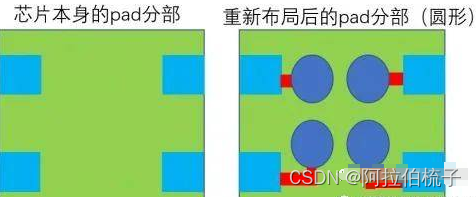
大体思路就是将芯片的pad通过导线(红色)借接出来,然后在想要的位置上重新做一个pad,实际图形长这样子,中间的哪些深色部分就是导线。
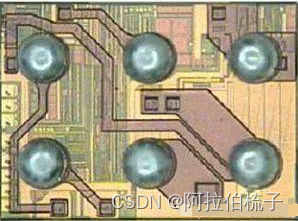
为什么不在芯片的pad上直接长锡球呢?因为当芯片的引脚太多时,直接长金球的方式危险系数会大大提高,很容出现两个引脚短接的情况。这样重新分配pad布局的过程叫做RDL(re-distribution layer)。准确的说它是指连接新pad和旧pad的这一层,但是大家在使用的时候,就不再区分,直接把这个过程叫做RDL。
到这里之后,后面一步就是bump,也就是长金球(锡球)。长金球的过程就不再多说了,和芯片制造工艺中的曝光,刻蚀差不多。
直到长完球(bump)之后,整个wafer还没有被切割,所以这些都是批量操作,成本特别低。这些操作完成后再进行晶圆级测试。也正是因为bump过程是在wafer上制作的,所以大家都把它叫做WLCSP(wafer level CSP)。
测试完成之后再切割,把好的芯片拿出来。最后倒扣到基板上面。就这样,外部电压通过焊接点以及bump产生的球与芯片交流。
这种封装方式,最省面积,封装出来的芯片大小和原始大小相差不大。所以这种方式也是比较主流的封装方式,一般用在高端产品上。










 本文详细介绍了倒装封装(Flipchip)技术,尤其是WaferLevelCSP(晶圆级封装)及其关键步骤bump工艺。通过重新布局芯片pad和长金球(锡球)的方式,减少引脚风险,实现高密度连接。该封装方式适用于高端产品,节省面积并具有低成本优势。
本文详细介绍了倒装封装(Flipchip)技术,尤其是WaferLevelCSP(晶圆级封装)及其关键步骤bump工艺。通过重新布局芯片pad和长金球(锡球)的方式,减少引脚风险,实现高密度连接。该封装方式适用于高端产品,节省面积并具有低成本优势。

















 4964
4964

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










