一、区别
在半导体制造过程中,检测(Inspection)和量测(Metrology)是两个非常重要的环节,它们的主要区别如下:
1. |目的不同|:
- |检测|:主要目的是在晶圆表面上或电路结构中识别是否存在异质情况,如颗粒污染、表面划伤、开短路等对芯片工艺性能具有不良影响的特征性结构缺陷。

- |量测|:则是对被观测的晶圆电路上的结构尺寸和材料特性进行量化描述,例如薄膜厚度、关键尺寸、刻蚀深度、表面形貌等物理性参数的量测。
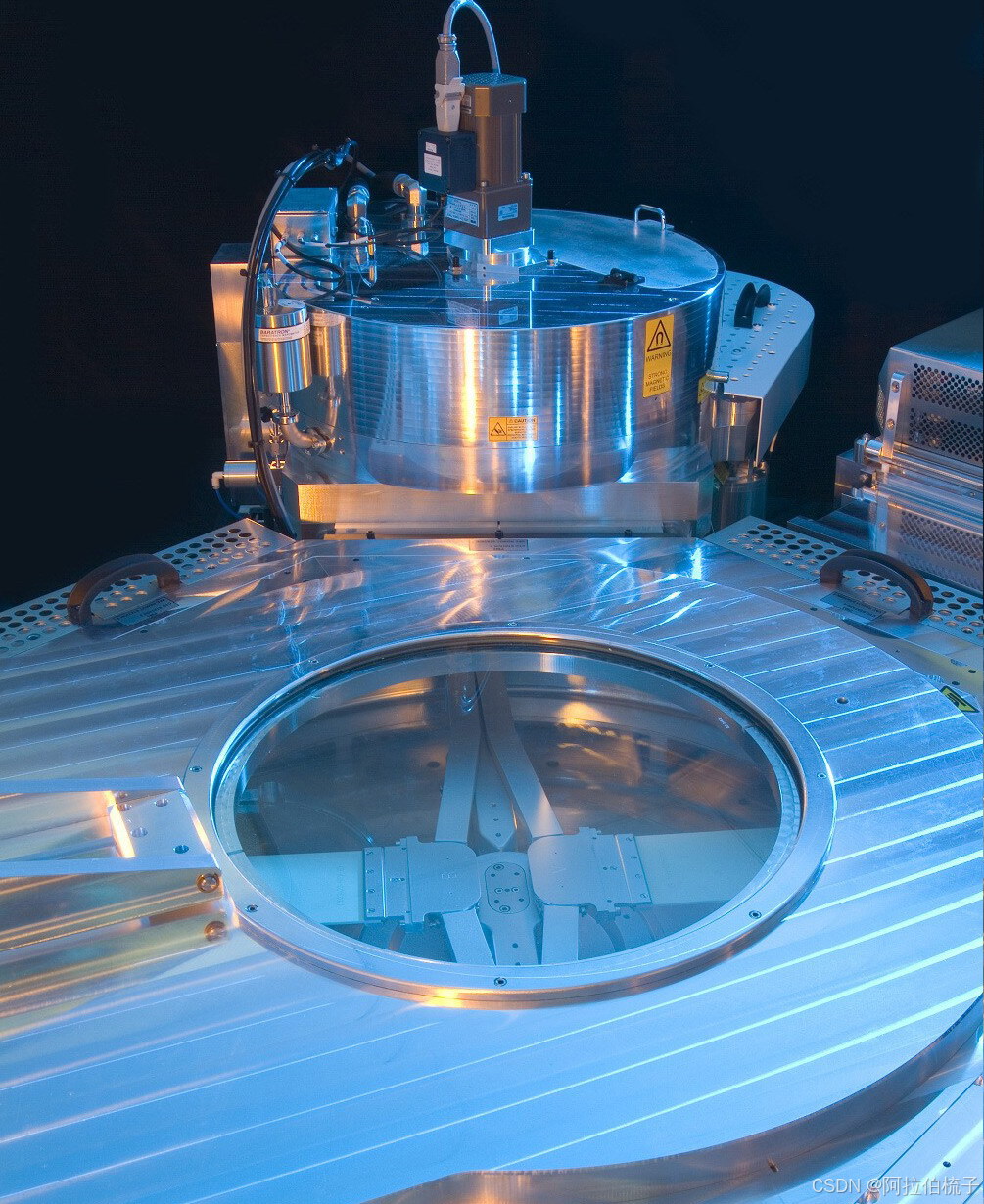
2. |关注点不同|:
- |检测|:更侧重于发现和识别缺陷,比如异物缺陷、气泡缺陷、颗粒缺陷等。
- |量测|:更侧重于对特定参数的精确测量,比如光刻套刻偏移量(OVL)、薄膜厚度(THK)、三维形貌等。








 最低0.47元/天 解锁文章
最低0.47元/天 解锁文章


















 2万+
2万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










