1、MLCC电容的结构
多层陶瓷电容器是由印好电极(内电极)的陶瓷介质膜片以错位的方式叠合起来,经过一次性高温烧结形成陶瓷芯片,再在芯片的两端封上金属层(外电极)制成的电容。
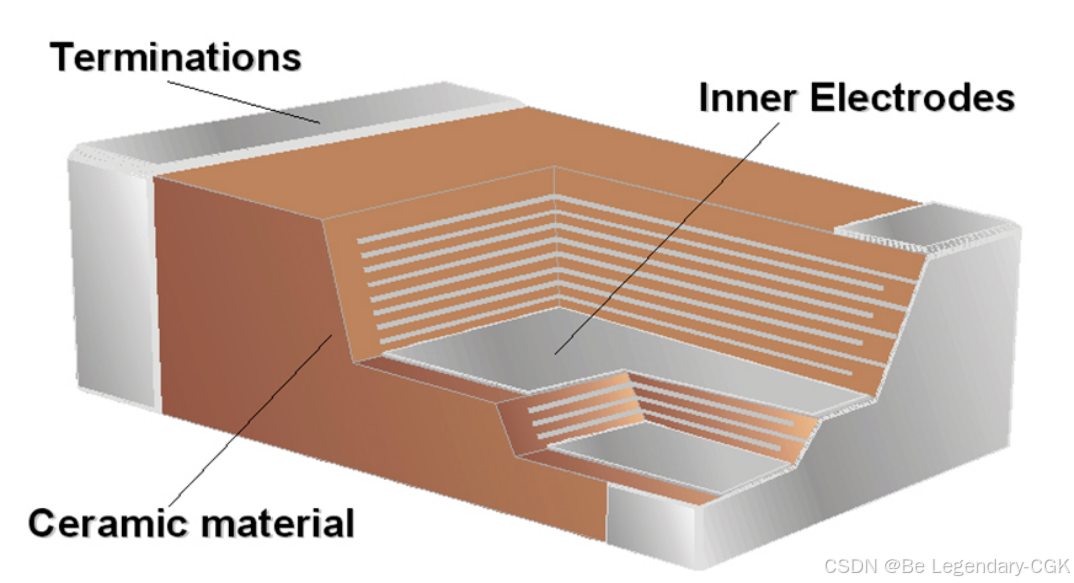 2、MLCC电容的特点
2、MLCC电容的特点
机械强度:硬而脆,这是陶瓷材料的机械强度特点。
热脆性:MLCC内部应力很复杂,所以耐温度冲击的能力很有限。
3、MLCC电容的失效模式

(1) 焊接锡量不当
当温度发生变化时,过量的焊锡在贴片电容上产生很高的张力,会使电容内部断裂或者电容器脱帽,裂纹一般发生在焊锡少的一侧;焊锡量过少会造成焊接强度不足,电容从PCB 板上脱离,造成开路故障。

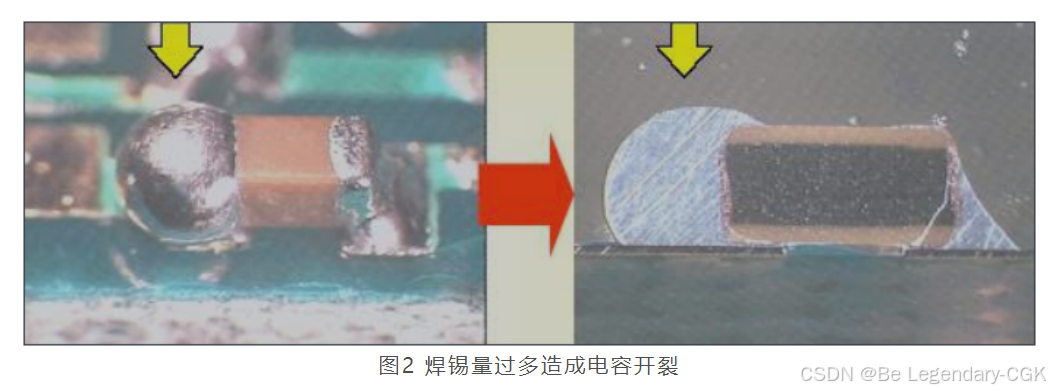
(2) 墓碑效应
在回流焊过程中,贴片元件两端电极受到焊锡融化后的表面张力不平衡会产生转动力矩,将元件一端拉偏形成虚焊,转动力矩较大时元件一端会被拉起,形成墓碑效应。
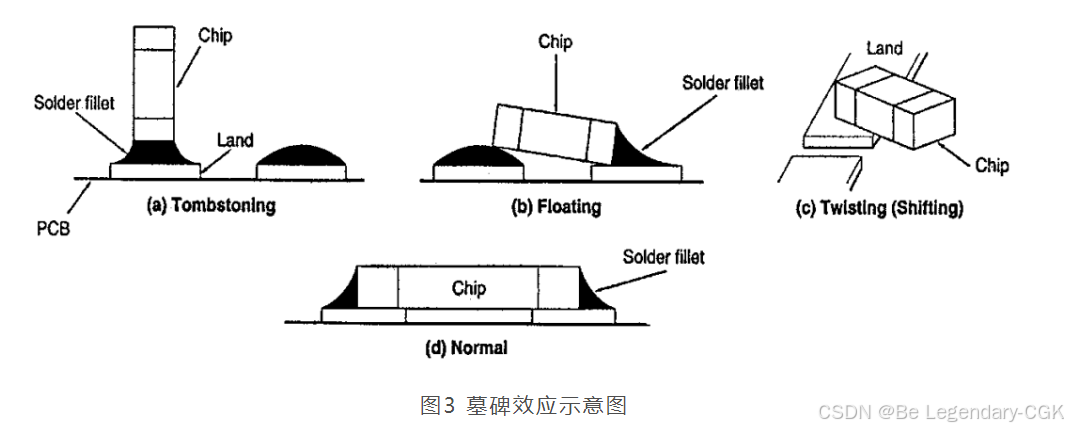
原因:
本身两端电极尺寸差异较大,锡镀层不均匀;PCB板焊盘大小不等、有污物或水分、氧化以及焊盘有埋孔,锡粉氧化等。
措施:
① 焊接之前对PCB板进行清洗烘干,去除表面污渍及水分;
② 进行焊接前检查,确认左右焊盘尺寸相同;
③ 锡膏放置时间不能过长,焊接前需要进行充分的搅拌;
(3) 陶瓷介质内空洞
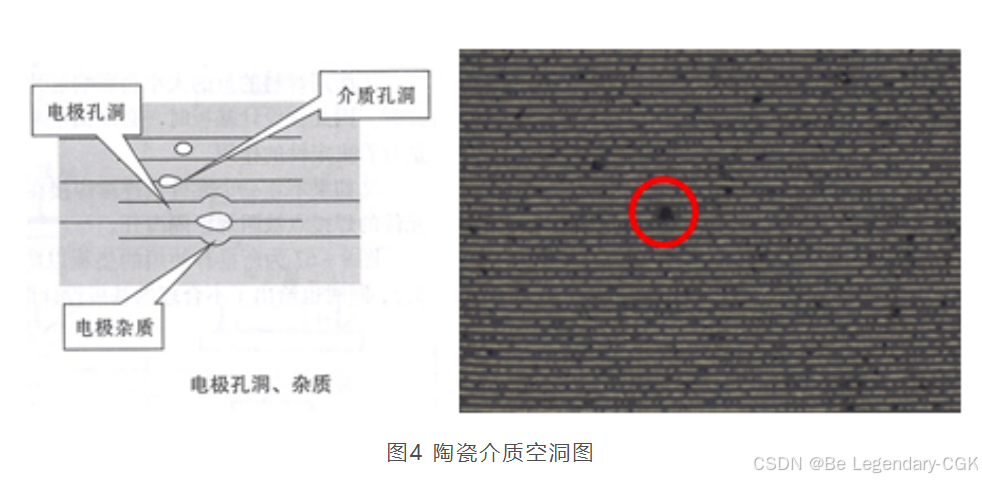
原因:
① 介质膜片表面吸附有杂质;
② 电极印刷过程中混入杂质;
③内电极浆料混有杂质或有机物的分散不均匀。
(4) 电极内部分层
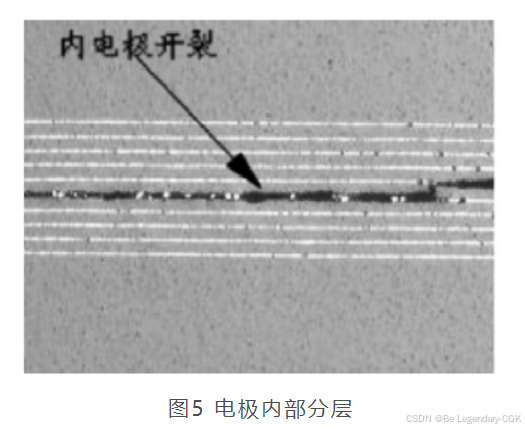
原因:多层陶瓷电容器的烧结为多层材料堆叠共烧。瓷膜与内浆在排胶和烧结过程中的收缩率不同,在烧结成瓷过程中,芯片内部产生应力,使MLCC产生再分层。
预防措施:在MLCC的制作中,采用与瓷粉匹配更好的内浆,可以降低分层开裂的风险。
(5) 浆料堆积
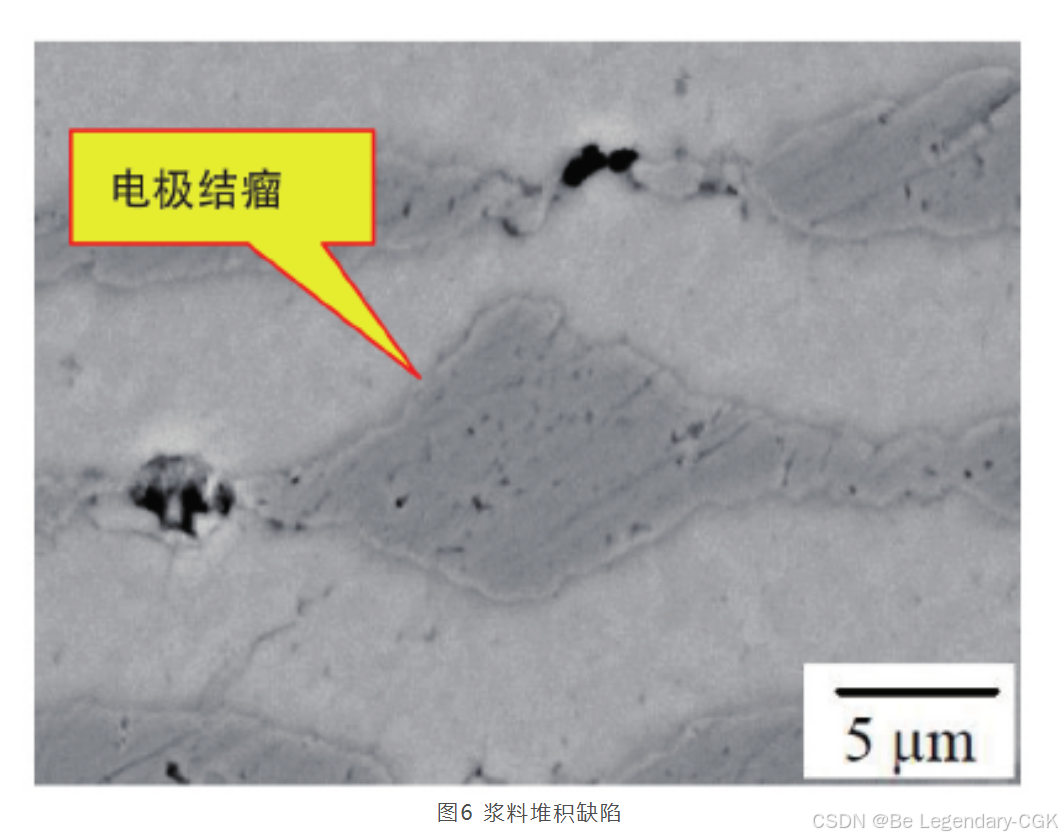
原因:
① 内浆中的金属颗粒分散不均匀;
② 局部内电极印刷过厚;
③ 内电极浆料质量不佳。
(6)机械应力裂纹
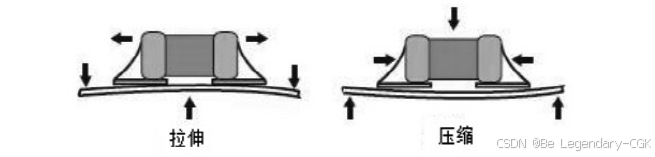
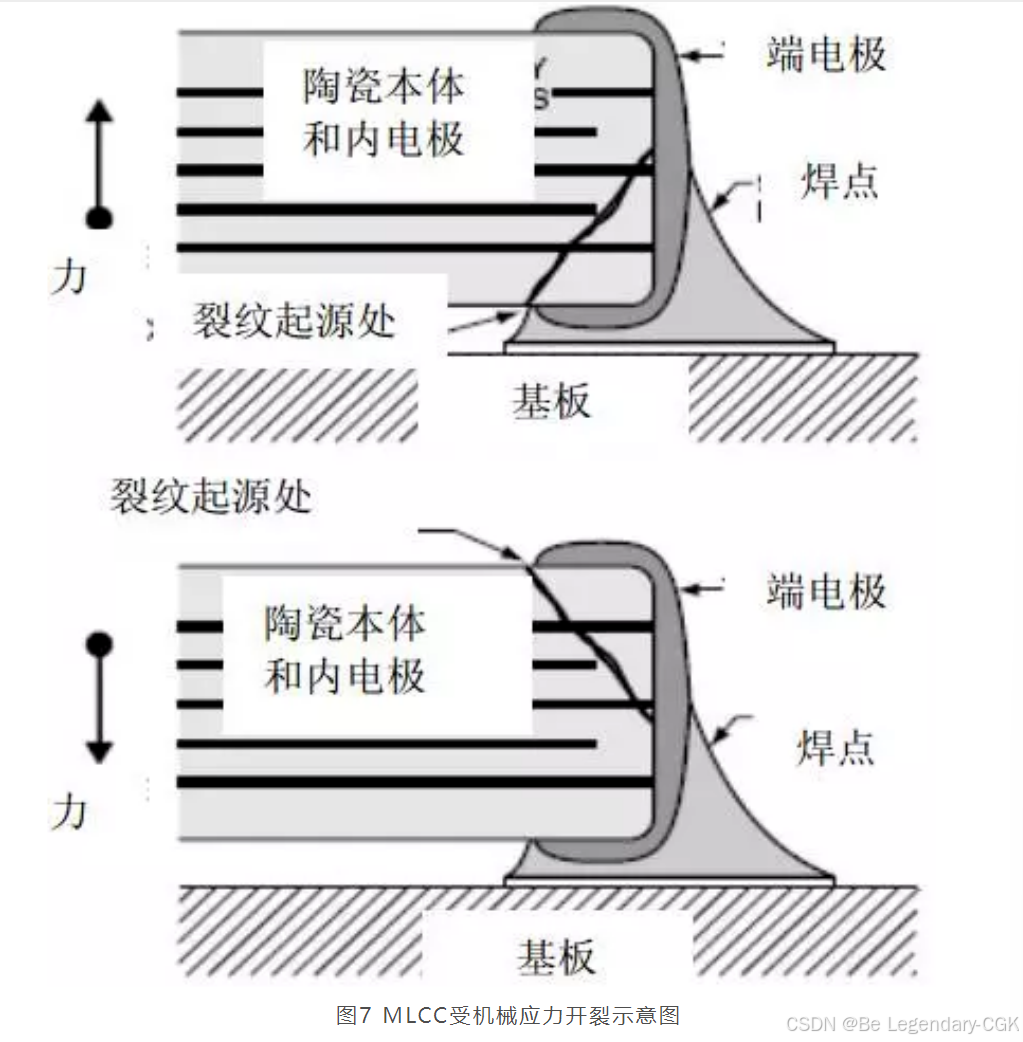
原因:多层陶瓷电容器的特点是能够承受较大的压应力,但抗弯曲能力比较差。当PCB板发生弯曲变形时,MLCC的陶瓷基体不会随板弯曲,其长边承受的应力大于短边,当应力超过MLCC的瓷体强度时,弯曲裂纹就会出现。电容在受到过强机械应力冲击时,一般会形成45度裂纹和Y型裂纹。
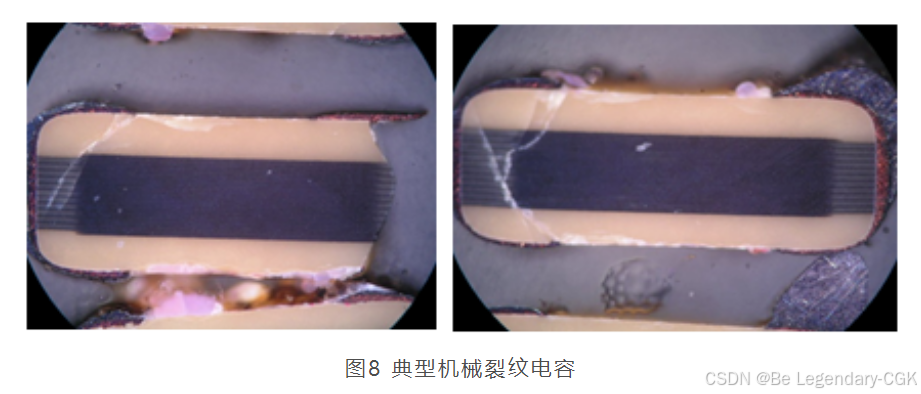
常见应力源:工艺过程中电路板操作;流转过程中的人、设备、重力等因素;通孔元器件插入;电路测试,单板分割;电路板安装;电路板点位铆接;螺丝安装等。
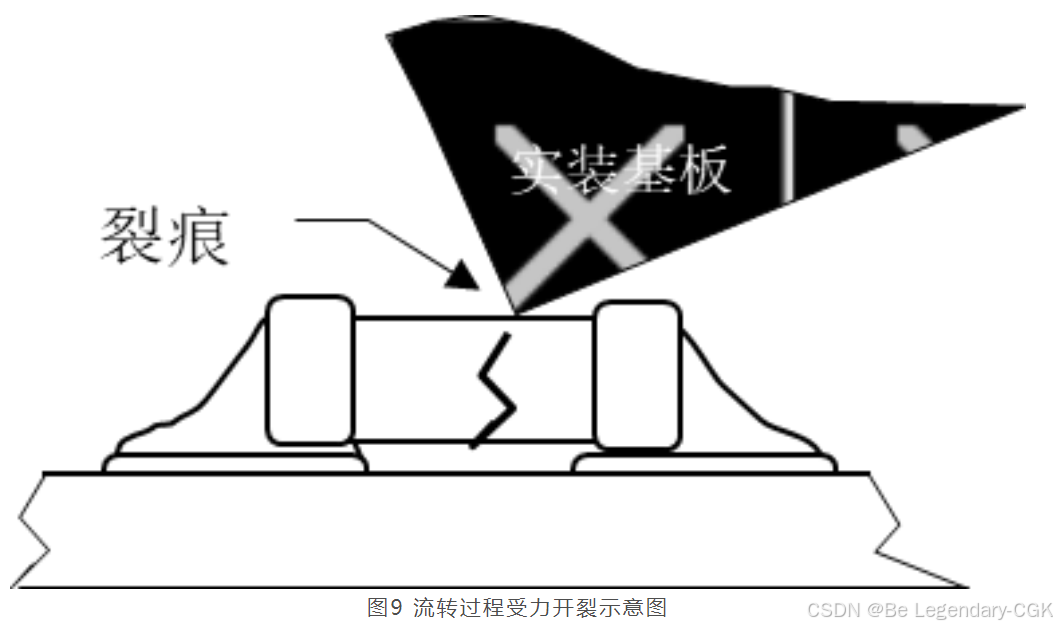
措施:
①选择合适的PCB厚度。
②设计PCBA弯曲量时考虑MLCC能承受的弯曲量。比较重的元器件尽量均匀摆放,减少生产过程中由于重力造成的板弯曲。
③优化MLCC在PCB板的位置和方向,减小其在电路板上的承受的机械应力,MLCC应尽量与PCB上的分孔和切割线或切槽保持一定的距离,使得MLCC在贴装后分板弯曲时受到的拉伸应力最小。
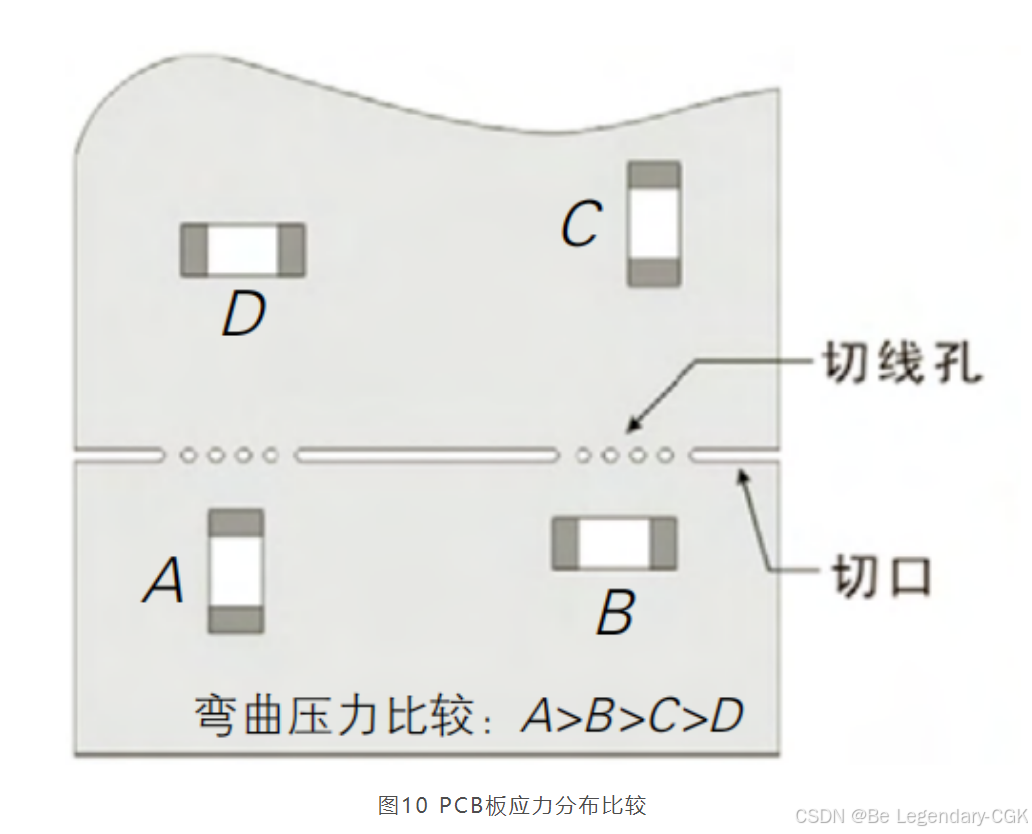
④MLCC的贴装方向应与开孔、切割线或切槽平行,以确保MLCC在PCB分板弯曲时受到的拉伸应力均匀,防止切割时损坏。
⑤MLCC尽量不要放置在螺丝孔附近,防止锁螺丝时撞击开裂。在必须放置电容的位置,可以考虑引线式封装的电容器。 ⑥测试时合理使用支撑架,避免板受力弯曲。
⑥测试时合理使用支撑架,避免板受力弯曲。
(7)热应力裂纹
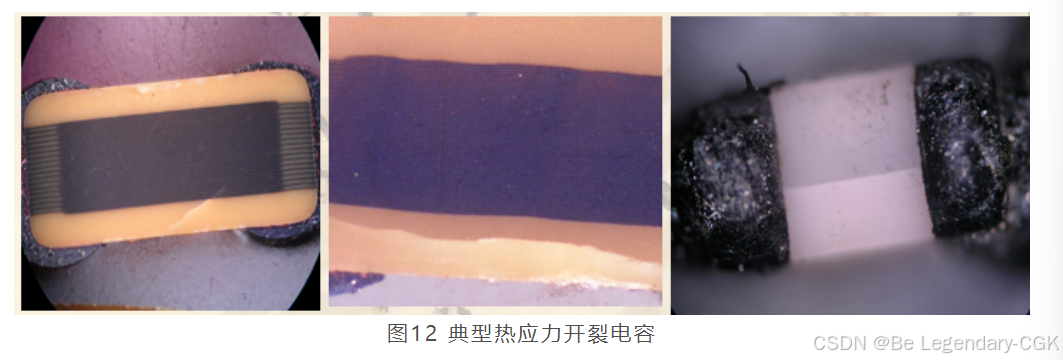
电容在受到过强热应力冲击时,产生的裂纹无固定形态,可分布在不同的切面,严重时会导致在电容侧面形成水平裂纹。
原因:热应力裂纹产生和电容本身耐焊接热能力不合格与生产过程中引入热冲击有关。可能的原因包括:烙铁返修不当、SMT炉温不稳定、炉温曲线变化速率过快等。
措施:
①工艺方法应多考虑MLCC的温度特性和尺寸,1210以上的大尺寸MLCC容易造成受热不均匀,产生破坏性应力,不宜采用波峰焊接;
②注意焊接设备的温度曲线设置。参数设置中温度跳跃不能大于150℃,温度变化不能大于2℃/s,预热时间应大于2 min,焊接完毕不能采取辅助降温设备,应自然随炉温冷却。
③手工焊接前,应增加焊接前的预热工序,手工焊接全过程中禁止烙铁头直接接触电容电极或本体。复焊应在焊点冷却后进行,次数不得超过2次
(8)电应力裂纹
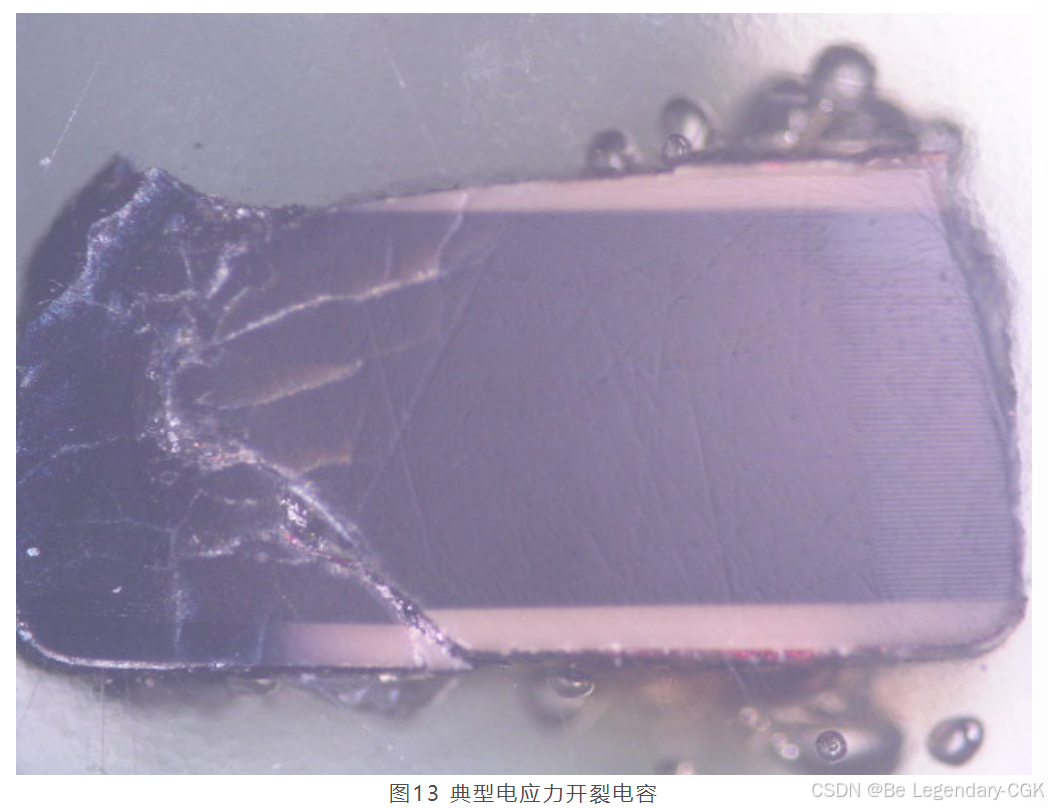
过电应力导致产品发生不可逆变化,表现为耐压击穿,严重时导致多层陶瓷电容器开裂、爆炸,甚至燃烧等严重后果。遭受过度电性应力伤害的MLCC,裂纹从内部开始呈爆炸状分散。
措施:
①在器件选型时应注意实际工作电压不能高 于器件的额定工作电压;
②避免浪涌、静电现象对器件的冲击。
























 658
658

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








