作者:周元,巧雲雲,向敏
(中国电子科技集团公司第二十四研究所,重庆400060)
摘要:
介绍了混合电路中功率芯片典型散热结构及其热阻的数学计算方法,以及运用Icepak热仿真软件对散热结构建模并对其热阻进行计算的过程。对计算结果进行了验证,并运用仿真软件建模求解的方式,得到各典型散热结构的热阻数据。
关键词:功率芯片;散热结构;热阻;电子设计自动化
1 引言
在功率IC中,通常会有大量功率半导体器件,如功率MOSFET、整流二极管等。送些器件工作时会产生大量热量,热量的积累会导致电路内部温度升高,如果不加以控制,过高的温度会影响元器件的特性,甚至造成元件的损环,导致电路失效。为了提高功率IC的可靠性,设计中必须进行热分析和热控制。相对于传统的热设计方法,借助仿真手段可大大减少计算量,缩短研制周期和降低成本,提高一次成功率,并改善电子产品的性能。
本文详细介绍了利用Icepak热仿真软件对混合集成电路中功率芯片散热结构的热阻进行分析计算的过程,对仿真结果进行了验证,并计算整理出实际散热结构的热阻数据。
2 功率芯片典型散热结构及其热阻的计算
2.1典型散热结构及热传导路径
热阻是指热流在发散传递过程中受到阻碍的一种表象,也指1 W功率在传热路径上产生的温度差,热阻R的表达式为:
![]()
在混合集成电路中,热量从芯片散发到环境过程中的热阻为总热阻。总热阻为内热阻Rj℃与外热阻R℃a之和,其中:
Rj℃=(Tj-T℃)/P (2)
R℃a= (T℃-Ta)/P (3)
式中,Tj,为芯片结温,T℃表示管売温度,Ta为环境温度。内热阻Rj℃等于功率芯片自身热阻和散热结构热阻之和。通常,功率芯片的热阻可以从厂商提供的热设计参数表中直接得到;而散热结构的热阻则与加工工艺、选择的材料等有关。本文只针对混合集成电路中功率芯片散热结构的热阻进行研究。
在混合集成电路中,功率芯片通过焊接的方式安装在基板或散热的金属垫片上,其典型散热结构如图1和图2所示。
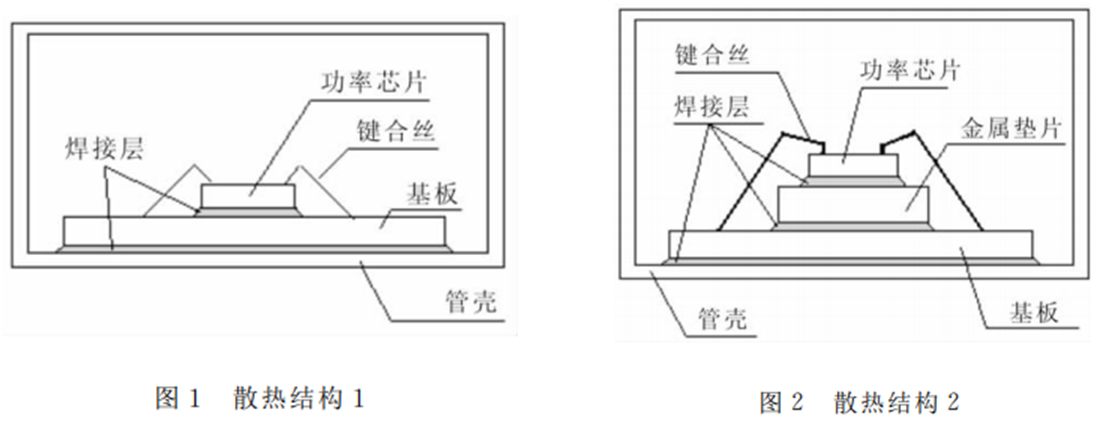
管売、基板、散热金属垫片普遍采用热导率很高的材料,热阻很小,芯片的热量主要是通过传导散热的方式传递到外売的外表面。虽然芯片到管売之间逐存在辐射散热,但由于裸芯片表面的辐射率很低,通过辐射散发的热量远小于传导散发的热量,因此一般情况下不考虑辐射散热。同时,在密闭管売内部不存在对流散热,在计算热阻时也忽略对流的影响,故在典型散热结构的热阻计算中,只考虑传导散热。
2.2散热结构热阻的计算
微电路的热流传导是一个复杂的过程,对其热阻的计算也有多种方法。传导热阻最基本的计算公式为;
R = L/(K - S) (4)
式中,L表示热传导方向的路径长度,K表示导热体的热导率,S表示热流传导的横截面积。
计算采用45°扩散法。由于计算结果与实测值较为接近,故在热阻计算中广为应用。45°扩散法认为,热流是以4 5 °的扩散角从热源向导热体扩散,在传热路径上,热流传导横截面积逐额增大。在计算各层材料的热阻时,通常采用中间面积来近似热流传导横截面积,采用该层厚度来近似传导路径长度。对于不同材料的各层,应分别计算出热阻,总的热阻则等于各层热阻之和。图3所示为混合集成电路典型散热结构的热流传导。
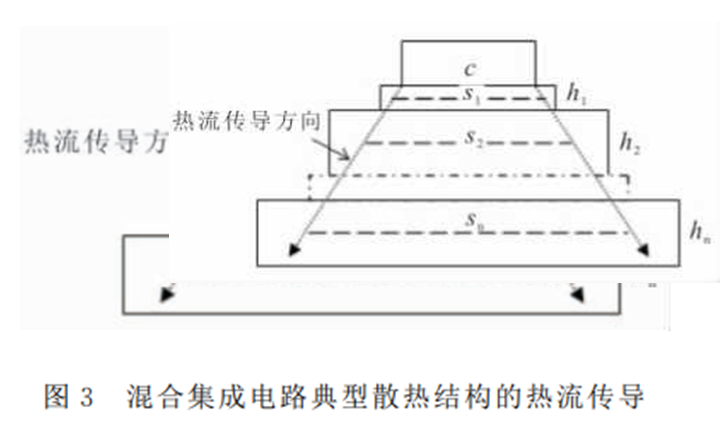
各层材料的传导横截面积为;

式中,℃表示芯片的边长,h表示各层材料的厚度,S表示在各层中热流传导的横截面积。由(4)、(5)式可以计算出每层的热阻:
![]()
由(6)式可知,热阻的大小与芯片面积、各层材料的热导率和厚度有关。
以图2中加散热金属垫片的典型散热结构为例,各层常用材料的热导率和厚度如表1所示。
表1典型散热结构各层材料的热导率和厚度

当芯片尺寸为2 mmX 2 rnrn时,由( 6 )式可以计算出该散热结构的理论热阻,如表2所示。
表2各层理论热阻值

3 散热结构热阻的计算机仿真计算
点击完整阅读全文
基于Icepak的功率芯片散热结构热阻计算
您可能感兴趣
结构流体电磁干货文章
结构流体电磁优质课程(部分免费)
结构流体电磁仿真培训,企业内训,职业培训
结构流体电磁CAE/CAD仿真行家服务
























 3972
3972











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








