0. 一个问题
我们在电路设计时常用到的芯片如OPA、LDO、MOS管、PLL等在使用过程中都存在发热现象,在发热量不大的情况下,对整体电路产生的影响微乎其微,但当发热量过大时,结温过高,可能会导致电路性能下降,增加金属迁移率和退化变化,从而导致芯片加速老化、故障率升高。因此在设计电路时,我们需要提前考虑到热设计。但问题是:芯片发热量多大才算大?如何判断设计的电路板是否需要散热片等措施呢?
1. 电路板上的各种温度定义
在JEDEC标准中,与“热”相关的标准主要有两个(1)JESD51系列,包括IC等封装的“热”的大多数标准;(2)JESD15系列,对仿真用的热阻面模型进行标准化。电路板上芯片工作时的各种温度测试点如下图所示
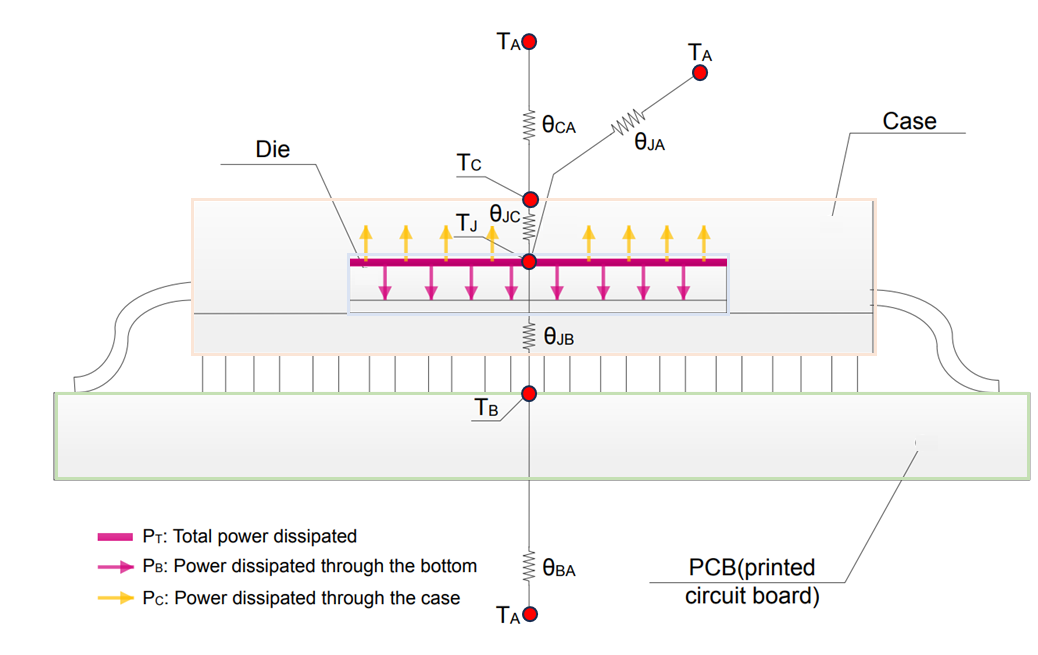
1.1 环境温度TA (Ambient Temperature) :
芯片在静置状态下工作时周围的环境温度
1.2 壳体表面温度TC (Case Temperature) :
芯片在静置状态下工作时壳体表面的温度
1.3 结温TJ (Junction Temperature) :
指内部核心晶体管的温度,这个温度有个最高允许值叫最高结温Tj,如果在实际应用中结温超过了最高允许结温,可能导致芯片损坏。查阅常见芯片的数据手册可以得知,一般IC的最高结温在70℃,工业级IC可能在85℃,车规级IC的最高结温在125℃,甚至有些在150℃。
1.4 电路板温度TB (PCB Temperature) :
芯片在静置状态下工作时电路板的温度
2. 热阻相关定义
各温度点之间的热量传递系数,用热阻来表示,在JEDEC标准里,这样定义芯片封装的热性能参数
2.1 热阻(thermal resistance):
是一个和热有关的性质,是指在有温度差的情形下,物体抵抗传热的能力,单位是℃/W,意为单位功率下的温升。在数据手册中的热阻分为热阻参数(RθJA、RθJB、RθJC)与热表征参数(φJT、φJB)两类。
早期的半导体器件通常封装在金属罐中。带引线的器件组装后立在PCB上,因此器件的热量几乎完全通过金属外壳散发到空气环境中。由于热传导路径单一,与PCB的关系较小,因此在这种应用条件下定义了热阻参数RθJA、RθJC与RθJB。如今许多新的封装类型,特别是在SMD封装中,芯片结温具有不同的热传导路径,并且与PCB设计有很大的关系,如果继续简单地用电阻参数估计结温将导致错误的结果。因此JEDEC定义了热表征参数(φJT、φJB)
2.2 RθJA — Junction-to-Ambient thermal resistance
指芯片内部的PN结在静止空气条件下对外部环境的热阻 (此外部环境在测试中不受器件自身发热影响,在实际应用中会影响,所以RθJA只用来粗略估算,可以只能用来快速估算结温。)
2.3 RθJC(top) — Junction-to-Case(top) thermal resistance
指芯片内部的PN结到外壳封装上表面的热阻,测试时其他方向不散热,只有上表面散热。
2.4 RθJC(buttom) — Junction-to-Case(top) thermal resistance
指芯片内部的PN结到外壳封装下表面的热阻,测试时其他方向不散热,只有下表面散热。
2.5 RθJB — Junction-to-PCB thermal resistance
指芯片内部的PN结到PCB(并非封装底部,而是电路板)的热阻,测试时其他方向不散热,这意味着PCB必须是器件散热的主要途径。
2.6 φJT — Junction-to-Top characterization parameter
指芯片内部的PN结到封装外表面上部中心点的热阻,可以用来较为准确地计算结温。φJT是在JEDEC标准JESD51-2A中定义的环境中所测的值,通过在特定的应用下测量设备的封装温度,如果在同样条件下测量温度特性参数,则可以估计结温度。
2.7 φJB — Junction-to-Board characterization parameter
指结到电路板PCB的热阻。
几乎所有的半导体器件都会给出RθJA与RθJC参数。但我们在一般的电路设计时还会关注能用来准确计算的φJT 。例如,下图是一款TPS7A91电源芯片的热参数指标

3 常用计算公式
如下图所示,热阻参数可以用来估计芯片结温,使用不同的热阻参数需要代入不同的计算公式,那么如果一个芯片给出了以下五个热阻参数,应该选择哪一个计算式更准确呢?实际上每个计算式都有适用范围(见最后一列备注)。

3.1 用RθJA估算
一般的电路外部环境都是空气,因此只要知道外部气温,可以很方便的估算内核温度。计算方法如下:
TJ=TA+( RθJA × PT) ,
其中PT指的是器件运行时的功率损耗,通过实测或计算求得。例如一个二极管通过了1安的电流,其在1安时的线路压降为0.7V,那么其消耗的功率为10.7=0.7W;
TA指外部环境温度,即工作时器件附近的空气温度,假设此二极管工作在30℃的户外;若其数据手册的热阻参数为RθJA=30℃/W,
则结温 TJ=TA+( RθJA × P ) =30+(300.7)=51℃,若其允许最高结温为125℃,那么完全满足要求。
但需要明确的是,RθJA的环境温度在测试中是不会受自身发热影响的,但实际应用中如果工作在空气对流不好的条件下,器件自身发热也会导致外部空气温升,此时还按照30℃的外部环境温度来估算的结果就不准确了,如果上面的二极管例子中,其最高允许结温为70℃,理论计算出是51℃,那么19℃的裕度能否包含计算误差呢?其实是很危险的,因此要根据实际工况预留相应大小的裕度。
3.2 用φJT计算
φJT 的计算方法与RθJA类似,不同的是,φJT需要在电路设计好后去实测器件封装表面中心点的温度。计算方法如下:
TJ=Tc-top+( φJT × PT ) ,Tc-top指实测封装表面中心点温度,φJT一般比较小,而RθJA一般比较大,因此相同消耗功率下,即使φJT有误差,用φJT计算出来的结果误差也会比较小。
3.3 用RθJC计算
有些器件的数据手册没有给出RθJA或φJT的值,只给了RθJC的值,因此只能用RθJC来计算结温,其计算方法与φJT一样,实测封装表面平均温度,然后用TJ=TC+( RθJC × PT ) ,TC指封装表面平均温度,仅仅用作粗浅的估算。如果使用散热器,应该用另一个公式计算,如下表里θJC这一列所示

因此,具体计算方法要根据现有参数和需求选择,一般可以先用RθJA估算,然后电路板做好后再φJT用实测计算更为准确。如果使用散热器,则使用RθJC计算式。
3.4 测温方法
上述两种计算方法都提到了要测器件表面的温度,如何能准确测得芯片实际温度呢?推荐用热电偶来测温度,如果没有这个条件,在一般的应用电路中,也可以用测温枪代替。使用RθJC参数的难点在于如何准确测量与散热器相连的封装的表面温度。测量外壳温度可以使用(按精度顺序)红外相机,荧光光学探头,热电偶或红外枪 (按精度顺序)。
4. 实际案例
4.1 下图是运算放大器OPA827的运用电路,在室温下正常工作时会升温多少度?

如下图所示,是OPA827的相关参数

计划采用TJ=TA+( RθJA × PT) 公式进行估算TJ, 则
(1)运放的功耗(PT值)计算
运放的功耗计算,分为两部分,一部分是本身静态功率PQ(quiescent power),一部分是负载导致的运放自身损耗PD(power dissipation-dc load)
a. PQ的计算

b. PD的计算

c. 总功耗的计算

(2)结温的计算(非散热片的热阻模型)

总结以下,整个计算过程为

4.2 下面电路采用自然冷却方式是否合适,如果加散热片需要如何选型?
电路:一功率运算放大器PA02用作低频功放,元器件为8引脚TO-3金属外壳封装,元器件工作电压Us=18V, 负载阻抗RL=4Ω,直流条件下工作频率为5kHz,环境温度为40℃。
分析:
首先用TJ=TA+( RθJA × PT) 估算自然冷却散热是否合适,如果需要散热片设计,则需要根据TJ=( RθJC+RθCH+RθHA ) × PT + TA去计算
计算过程,查PA02元器件资料,相关参数如下表所示

运放的功耗PD估计,同例4-1计算过程,则由

如果没有散热片的话,根据TJ=TA+( RθJA × PT), 当环境温度TA=40℃,RθJA=30℃/W,PT=21.69W带入计算式后,TJ值远远大于125℃。因此采用自然冷却的方式不合适,需要采用散热片设计。
当采用散热片设计时,根据公式TJ=( RθJC+RθCH+RθHA ) × PT + TA

查阅散热器技术手册,应该选择热阻不大于1.119℃/W的规则既可以满足该电路的使用要求。
5. 其他热设计因素
5.1 PCB铺铜面积与热阻关系
随着芯片底部铺铜面积的增加,芯片的热阻会降低,但当铺铜面积增加到一定值之后,热阻不再变化,如下图所示

具体铺多少面积铜合适呢?在没有空气对流与散热片的前提下,有这样一个简单公式可以用来计算参考值。

5.2 芯片封装与热阻的关系
如下图所示,同一个器件不同的封装,其热阻值会有显著的差异,当芯片在某一封装下散热不足时,第一步是考虑其他封装选项。这也是为什么供应商会提供多种封装的原因之一,因为一味的追求最小的封装并不总是合适的。
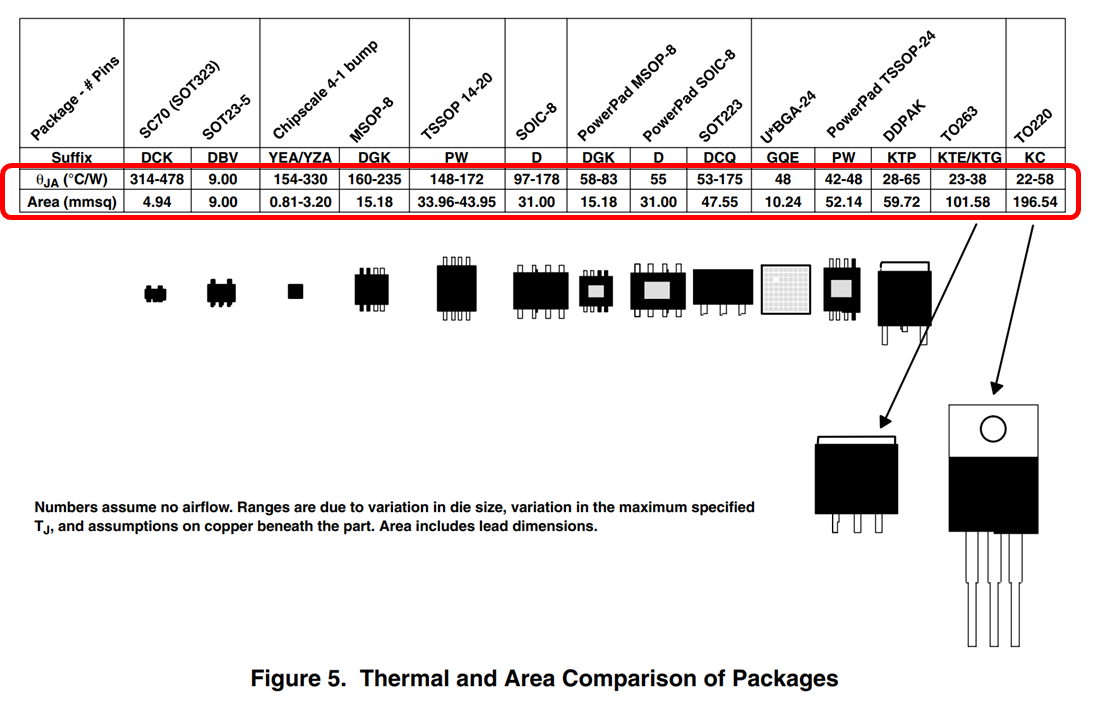
如下面的例子









 文章探讨了电路设计中芯片发热问题,介绍了JEDEC标准中的温度定义、热阻参数以及如何通过RθJA、RθJC、φJT等计算结温。强调了实际应用中考虑散热片的必要性,并提供了运算放大器的实际案例和热设计因素,如PCB铺铜面积和封装选择的影响。
文章探讨了电路设计中芯片发热问题,介绍了JEDEC标准中的温度定义、热阻参数以及如何通过RθJA、RθJC、φJT等计算结温。强调了实际应用中考虑散热片的必要性,并提供了运算放大器的实际案例和热设计因素,如PCB铺铜面积和封装选择的影响。
















 3321
3321

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








