一、DIP双列直插式(知识分享来自知乎大佬)
DIP(Dual Inline-pin Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。采用DIP封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
特点:
⒈适合在PCB(印刷电路板)上穿孔焊接,操作方便。
⒉封装面积与芯片面积之间的比值较大,故体积也较大。

Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
二、组件封装式

PQFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。采用SMD安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。将芯片各脚对准相应的焊点,即可实现与主板的焊接。用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与PQFP方式基本相同。唯一的区别是PQFP一般为正方形,而PFP既可以是正方形,也可以是长方形。
特点:
⒈适用于SMD表面安装技术在PCB电路板上安装布线。
⒉适合高频使用。⒊操作方便,可靠性高。
⒋芯片面积与封装面积之间的比值较小。
Intel系列CPU中80286、80386和某些486主板采用这种封装形式。
三、PGA插针网格式

PGA(Pin Grid Array Package)芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。根据引脚数目的多少,可以围成2-5圈。安装时,将芯片插入专门的PGA插座。为使CPU能够更方便地安装和拆卸,从486芯片开始,出现一种名为ZIF的CPU插座,专门用来满足PGA封装的CPU在安装和拆卸上的要求。
ZIF(Zero Insertion Force Socket)是指零插拔力的插座。把这种插座上的扳手轻轻抬起,CPU就可很容易、轻松地插入插座中。然后将扳手压回原处,利用插座本身的特殊结构生成的挤压力,将CPU的引脚与插座牢牢地接触,绝对不存在接触不良的问题。而拆卸CPU芯片只需将插座的扳手轻轻抬起,则压力解除,CPU芯片即可轻松取出。
特点:
⒈插拔操作更方便,可靠性高。
⒉可适应更高的频率。
Intel系列CPU中,80486和Pentium、Pentium Pro均采用这种封装形式。
四、BGA球栅阵列式

随着集成电路技术的发展,对集成电路的封装要求更加严格。这是因为封装技术关系到产品的功能性,当IC的频率超过100MHz时,传统封装方式可能会产生所谓的“CrossTalk(串扰)”现象,而且当IC的管脚数大于208 Pin时,传统的封装方式有其困难度。因此,除使用PQFP封装方式外,现今大多数的高脚数芯片(如图形芯片与芯片组等)皆转而使用BGA(Ball Grid Array Package)封装技术。BGA一出现便成为CPU、主板上南/北桥芯片等高密度、高性能、多引脚封装的最佳选择。
BGA封装技术又可详分为五大类
⒈PBGA(Plastic BGA)基板:一般为2-4层有机材料构成的多层板。Intel系列CPU中,Pentium Ⅱ、Ⅲ、Ⅳ处理器均采用这种封装形式。
⒉CBGA(CeramicBGA)基板:即陶瓷基板,芯片与基板间的电气连接通常采用倒装芯片(FlipChip,简称FC)的安装方式。Intel系列CPU中,Pentium I、Ⅱ、Pentium Pro处理器均采用过这种封装形式。
⒊FCBGA(FilpChipBGA)基板:硬质多层基板。
⒋TBGA(TapeBGA)基板:基板为带状软质的1-2层PCB电路板。
⒌CDPBGA(Carity Down PBGA)基板:指封装中央有方型低陷的芯片区(又称空腔区)。
特点:
⒈I/O引脚数虽然增多,但引脚之间的距离远大于QFP封装方式,提高了成品率。
⒉虽然BGA的功耗增加,但由于采用的是可控塌陷芯片法焊接,从而可以改善电热性能。
⒊信号传输延迟小,适应频率大大提高。
⒋组装可用共面焊接,可靠性大大提高。
BGA封装方式经过十多年的发展已经进入实用化阶段。1987年,***西铁城(Citizen)公司开始着手研制塑封球栅面阵列封装的芯片(即BGA)。而后,摩托罗拉、康柏等公司也随即加入到开发BGA的行列。1993年,摩托罗拉率先将BGA应用于移动电话。同年,康柏公司也在工作站、PC电脑上加以应用。直到五六年前,Intel公司在电脑CPU中(即奔腾Ⅱ、奔腾Ⅲ、奔腾Ⅳ等),以及芯片组(如i850)中开始使用BGA,这对BGA应用领域扩展发挥了推波助澜的作用。BGA已成为极其热门的IC封装技术。
五、CSP芯片尺寸式
随着全球电子产品个性化、轻巧化的需求蔚为风潮,封装技术已进步到CSP(Chip Size Package)。它减小了芯片封装外形的尺寸,做到裸芯片尺寸有多大,封装尺寸就有多大。即封装后的IC尺寸边长不大于芯片的1.2倍,IC面积只比晶粒(Die)大不超过1.4倍。
CSP封装又可分为四类
⒈Lead Frame Type(传统导线架形式),代表厂商有富士通、日立、Rohm、高士达(Goldstar)等等。
⒉Rigid Interposer Type(硬质内插板型),代表厂商有摩托罗拉、索尼、东芝、松下等等。
⒊Flexible Interposer Type(软质内插板型),其中最有名的是Tessera公司的microBGA,CTS的sim-BGA也采用相同的原理。其他代表厂商包括通用电气(GE)和NEC。
⒋Wafer Level Package(晶圆尺寸封装):有别于传统的单一芯片封装方式,WLCSP是将整片晶圆切割为一颗颗的单一芯片,它号称是封装技术的未来主流,已投入研发的厂商包括FCT、Aptos、卡西欧、EPIC、富士通、三菱电子等。
特点:
⒈满足了芯片I/O引脚不断增加的需要。
⒉芯片面积与封装面积之间的比值很小。
⒊极大地缩短延迟时间。
CSP封装适用于脚数少的IC,如内存条和便携电子产品。未来则将大量应用在信息家电(IA)、数字电视(DTV)、电子书(E-Book)、无线网络WLAN/GigabitEthemet、ADSL/手机芯片、蓝牙(Bluetooth)等新兴产品中。
六、MCM多芯片模块式
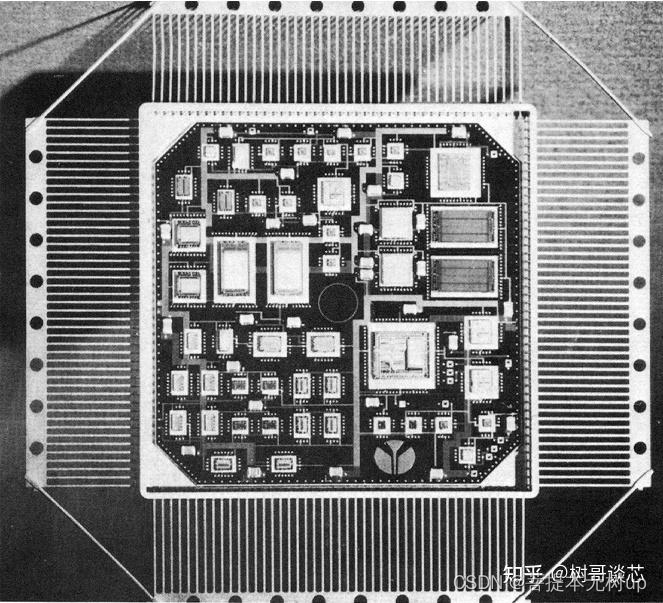
为解决单一芯片集成度低和功能不够完善的问题,把多个高集成度、高性能、高可靠性的芯片,在高密度多层互联基板上用SMD技术组成多种多样的电子模块系统,从而出现MCM(Multi Chip Module)多芯片模块系统。
特点:
⒈封装延迟时间缩小,易于实现模块高速化。
⒉缩小整机/模块的封装尺寸和重量。
⒊系统可靠性大大提高。
七、LGA封装

LGA全称是Land Grid Array,直译过来就是栅格阵列封装,与英特尔处理器之前的封装技术Socket 478相对应,它也被称为Socket T。说它是“跨越性的技术革命”,主要在于它用金属触点式封装取代了以往的针状插脚。
BGA封装和LGA封装区别
1)、含义不同。BGA的全称叫做“ball grid array”,中文意思是“球栅网格阵列封装”;LGA的全称叫做“land grid array”,中文意思是“平面网格阵列封装”;
2)、体积不同。BGA封装体积小,LGA相对于BGA封装,体积较大;
3)、使用范围不同。LGA主要应用于桌面CPU的封装,如桌面处理器、AMD 皓龙、霄龙等;BGA主要应用于笔记本CPU和智能手机CPU,如AMD低压移动处理器、所有的手机处理器等。
4)、封装方式不同。LGA封装的特点是触点都在CPU的PCB上,主板承担了提供针脚的工作,针脚都在主板上。BGA封装是一次性封装,外面看不到针脚。
5)、更换性能不同。BGA封装由于是一次性封装,不可单独更换,且需要使用专业工具,由专业人士更换;LGA封装可以单独更换。
6)、导热性能不同。BGA封装由于体积小,导热性能一般。LGA封装体积较大,导热性能好于BGA封装。
7)、功耗不同。面积越大,功耗越大。BGA封装承受功耗小,LGA封装承受功耗较大
八、QFN封装
QFN是日本电子机械工业协会定义的名称,取英文Quad Flat No-lead Package的首字母简写,中文全称叫方形扁平无引脚封装;DFN(Dual Flat No-lead Package)封装属于QFN封装的延伸封装。DFN封装的管脚分布在封装体两边且整体外观为矩形,而QFN封装的管脚分布在封装体四边且整体外观为方形。

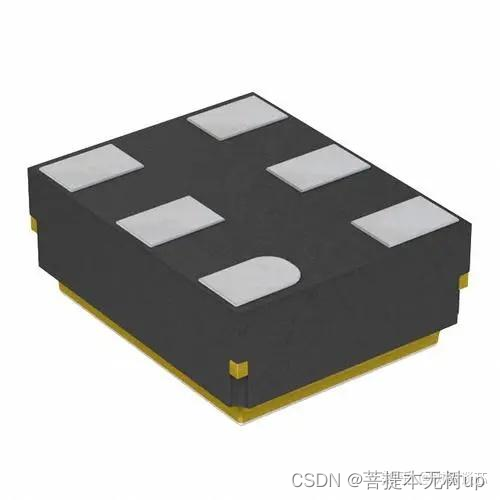
DFN的优势
(1)物理方面:体积小、重量轻
(2)品质方面:散热性好、电性能好、可靠性好
(3)性价比高
目前采用QFN封装形式的芯片应用非常广泛:蓝牙芯片、音频芯片、电源管理芯片、功率放大芯片、基站时钟芯片、视频监控芯片等;QFN封装是一种极具适用能力强、结构简单、高性价比的封装形式,在可预见的5年内出现替代封装的可能性不高。







 本文介绍了集成电路的几种常见封装形式,包括DIP的双列直插式、PQFP和PFP的贴片封装、PGA的插针网格式、BGA的球栅阵列式、CSP的芯片尺寸式以及MCM的多芯片模块式,还提到了LGA封装和QFN/DFN封装的特点和应用。这些封装技术在不断发展,以适应更高密度、更快频率和更小体积的需求。
本文介绍了集成电路的几种常见封装形式,包括DIP的双列直插式、PQFP和PFP的贴片封装、PGA的插针网格式、BGA的球栅阵列式、CSP的芯片尺寸式以及MCM的多芯片模块式,还提到了LGA封装和QFN/DFN封装的特点和应用。这些封装技术在不断发展,以适应更高密度、更快频率和更小体积的需求。
















 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








