这几天出差江阴长电科技交流学习,有机会参观了长电封装车间和高密度集成电路封装技术国家工程实验室,学习了解IC封装工艺主要流程步骤和FA分析设备及流程。趁热打铁,把今天参观的一点记忆,结合网络参考专业博主的资料,简单整理下,汇总成这篇IC封装主要工艺简介文档。

借用下这个网上的流程图,这个图90%记录和还原了今天参观的IC封装的主要流程。下面就按照这个流程图分别对每一步具体做什么操作做一下解释。
步骤一:晶圆贴膜(Wafer Typing)
晶圆(Wafer)制作好以后通过特定的装箱,密闭真空保存运输至封测厂,这时Wafer表面没有其他保护膜,第一步就是给Wafer正面贴上粘性膜(蓝膜,这个过程有点类似给新手机贴膜),这层膜的作用是在Wafer的正面粘住,以便Wafer背面进行研磨,同时也起到保护Wafer的作用。
贴膜时,膜会倾斜角度,以避免气泡和杂质的产生。

那为啥不能在Wafer出厂的时候就给他贴上,这样运输起来不就更安全了么?工程师答复是粘性膜本身有粘连性,时间久了会粘在Wafer上,造成良品率下降,封测厂的粘性膜好像也只有24h;
步骤二:晶圆打磨(Wafer Grinding)和去膜
为什么需要打磨呢?Wafer从晶圆厂制作好出厂的时候,为了保证运输过程不被振动损坏,厚度相对较厚,一般是700uM左右,而实际需要的厚度实际可能是200uM甚至更低,那么就需要对Wafer进行打磨使其变薄以满足实际需要。
这个过程打磨是通过机械磨削的方式,在水中进行的。水的冲洗一方面可以给磨削过程降温,另一方面可以清洗Wafer。
下图展示了Wafer从贴膜到研磨,再到划片过程中的贴膜、揭膜的过程。简单理解,磨片膜贴在Wafer正面,保护Wafer并给研磨提供一个载体;划片膜贴在Wafer背面,给划片提供一个支撑载体,同时也起到一定保护作用。

步骤三:切割(Wafer Saw)
使用什么切割Wafer呢?有两种方式:刀具和激光。
激光好理解,Wafer那么小,刀具具体长什么样呢?
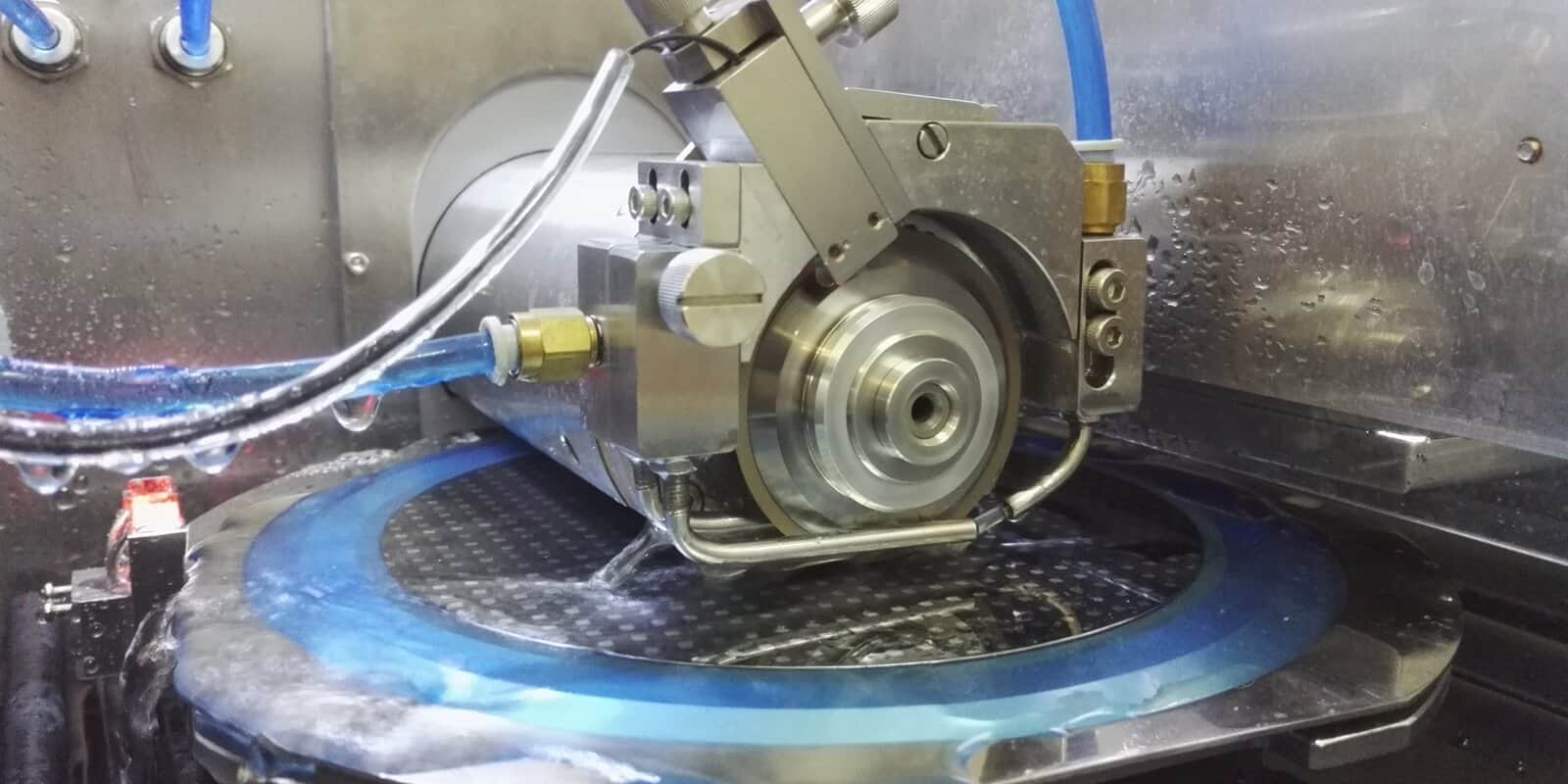
这个刀片是金刚石材质,说是刀片,实际是一个类似与小光盘圆型的刀具,最外侧的刀片厚度只有20uM,静态下非常脆弱,老师说手一碰就可能会碎掉。但当电机转速达到4万转时便可以十分锋利地切割Wafer了。
切割的时候一般是两个刀具分两个步骤切割,一个刀具宽度厚一点,先切一刀划一个凹槽,再换薄一点的刀片沿着凹槽切第二刀,这样可以保证切出来的晶圆好看,良品率高。同样切割过程中也是泡在水里的。刀头会通过光传感器检测透光率自动检测磨损程度,达到损坏程度35%后,停机提示更换。
步骤四:芯片粘贴(Die bonding)
粘贴是将从切割完的Die通过机械臂吸嘴吸出,放到基板上,再用银浆固定或者晶圆背面胶加热固定。涂胶的工艺根据封装的大小有圆形、米形等。
银浆具备优异的导电和导热性能,作为导电粘结剂,可以将封装基材、芯片本体可靠的粘结在一起,起到保护器件和加固结构的作用。 银浆具有较高的黏附性,可以提供良好的黏结效果,保证封装的可靠性。
涂完银浆或者背面带粘胶的Die安装到基材后,通过烘焙固化,使得胶快速固定可靠。
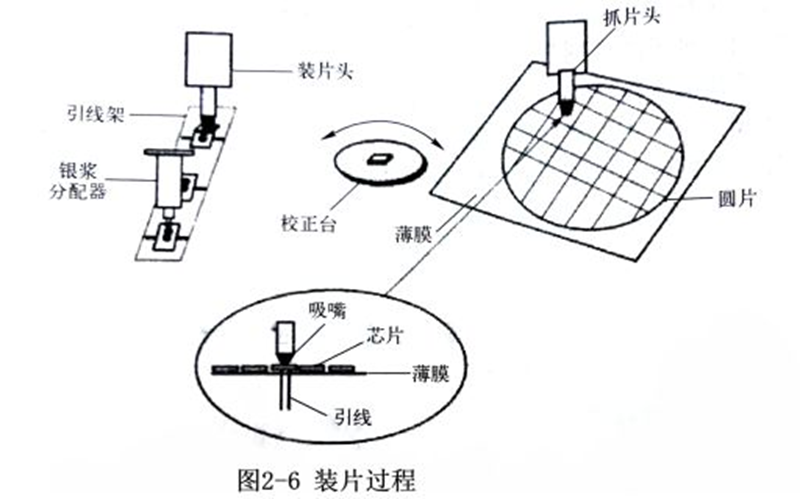
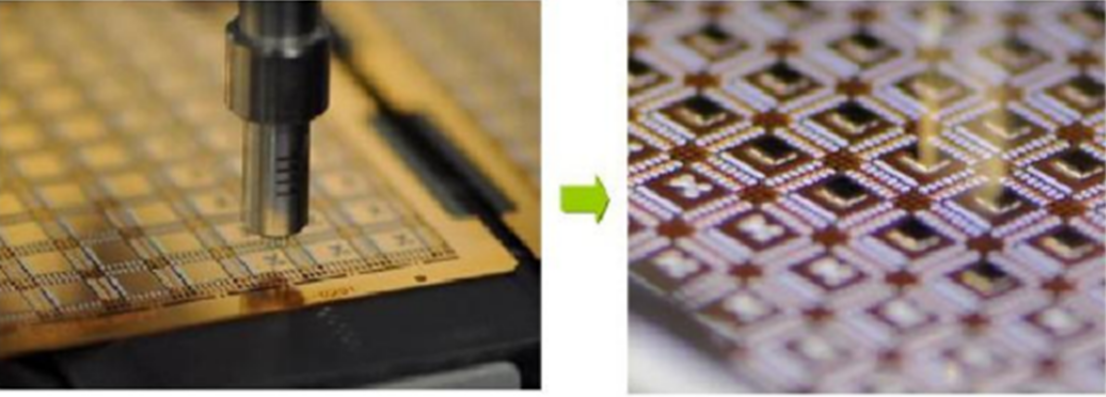
步骤五:键合(Wire bonding)
这个应该是封装比较关键的一步。
键合这一步Die通过Wire 线焊接到焊盘上。其制造工艺分为传统键合工艺(wire bonding)和倒装工艺(Flip chip bonding),示意如下。

参观看到的键合是传统工艺,0.8mil的铜线在机头上快速跳跃完成bonding线的焊接。据老师介绍其点火装置会在机头位置产生几十A的电流,同时喷嘴会喷射特殊的混合气体,产生的热迅速熔化铜线并固定在焊盘上。相关设备示意如下(图片来源于网络)
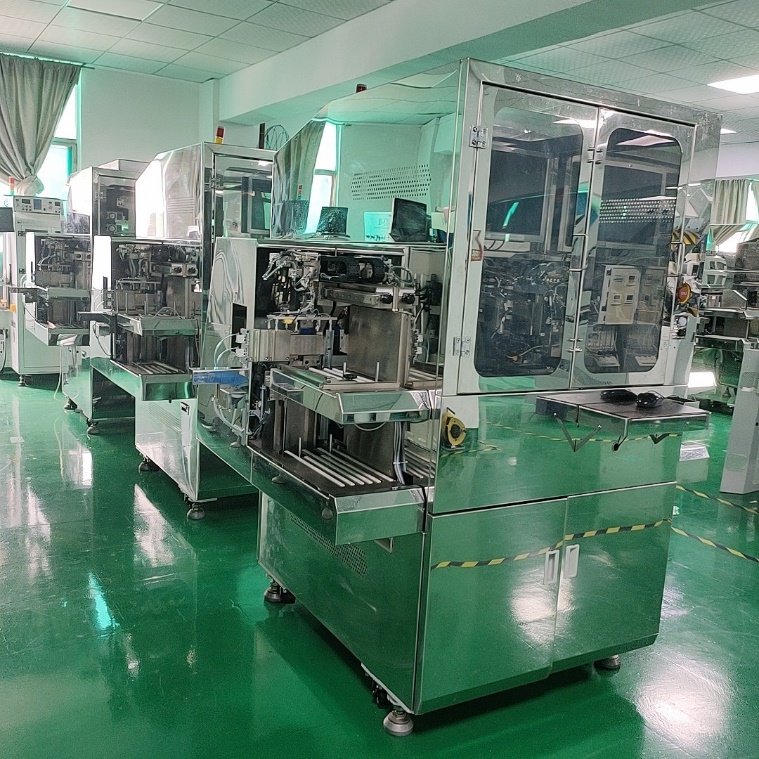
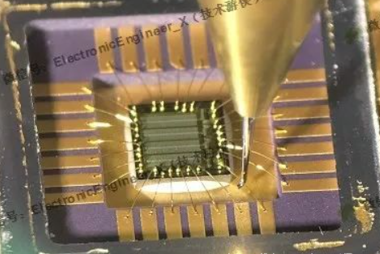
步骤六:压模注塑(Seal)
将引线键合完成的基板放入塑封模中,用塑封料把芯片、金属引线及支架包裹保护起来,同时达到塑封料外观成型的目标。
塑封料颗粒加入模具中,压模冲杆向上(下)推挤;塑封料受热及受压软化,沿着通道被推挤流动向前;塑封料被推挤进入模腔中;塑封料填满整个模腔,开始固化,完成压模成型工艺;大致示意如下。
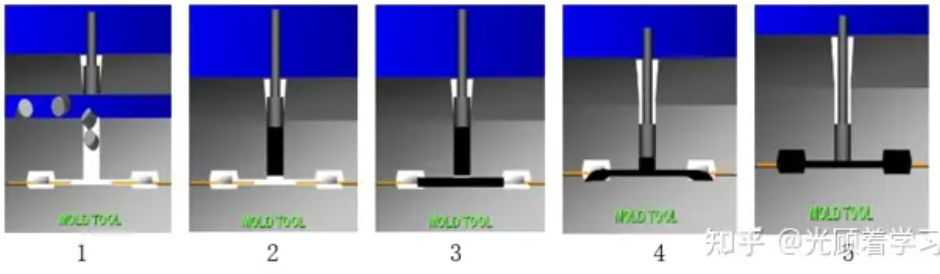
注:参考《芯片封装-3-塑封成型(压模成型,Mold)》
步骤七:电镀(Planting)和激光打字(Laser Marking)
电镀:这个阶段会在芯片的底面镀上锡,以增强可焊接性及放置管脚氧化。但是IC的侧面由于没有完成切割,无法电镀。
激光打字:按照客户要求,在芯片表面镭雕品牌logo、型号、datacode信息等,与PCB的镭雕过程比较接近。
值得注意的是,IC封装过程中存在故障的单体,在生产过程中会被标记,在最终的激光打字过程会被剔除,不会被打上相关丝印信息。
步骤八:IC切割(packing)
这个步骤与晶圆的切割比较类似,就是将封装好的IC通过刀头切割成独立的IC,过程相对比较好理解,这里不在赘述。
参考资料:
- 傻白入门芯片设计,芯片键合(Die Bonding)(四)_什么是键合-CSDN博客;
- https://www.zhihu.com/tardis/zm/art/695095735?source_id=1005# 芯片封装-3-塑封成型(压模成型,Mold)
- https://zhuanlan.zhihu.com/p/22913298612 半导体“晶圆(Wafer)磨划”工艺技术的详解
特别感谢:
江阴长电科技及SILERGY的工艺流程分享及参观活动接待支持!
=========================================================================
如果上面的内容对你可能有一点帮助,欢迎点赞、收藏、关注支持!你的点赞是博主更新的动力来源。哈哈
























 382
382

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








