2.5D和3D最本质的区别是:2.5D有中介层interposer, 3D没有interposer层面!
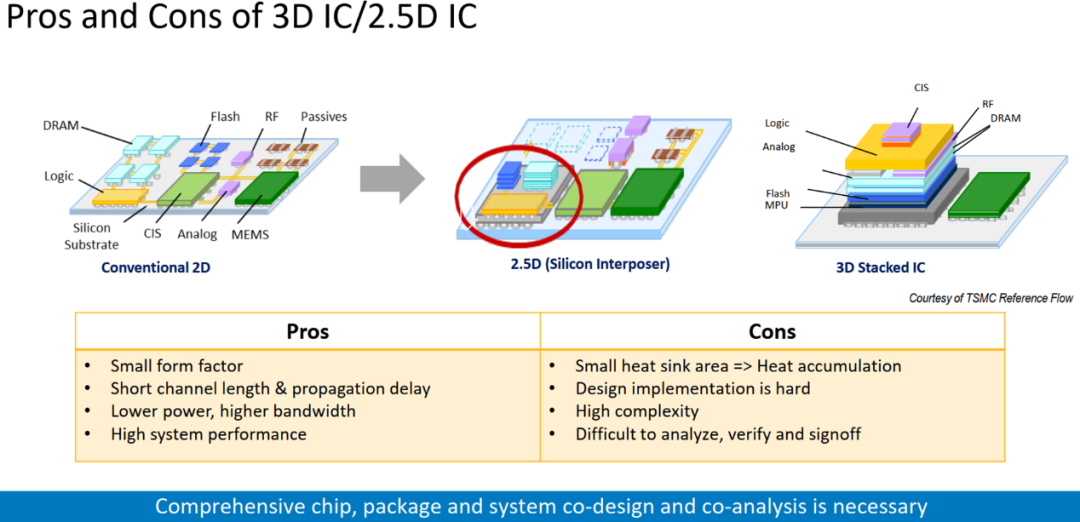
硅通孔(Through Silicon Vias,简称TSV)是一种在硅晶圆(而不是基板或PCB上)上制作垂直贯通的微小通孔,并在通孔中填充导电材料,实现芯片内部不同层面之间的电气连接的技术。这种技术能够显著提高芯片内部的互连密度,降低信号传输延迟,提高系统的整体性能。TSV技术广泛应用于存储器、处理器、图像传感器等高性能芯片中,尤其是在3D IC封装中具有重要应用。
2D、2.5D和3D封装是集成电路封装技术的不同发展阶段,它们在物理结构、电气连接和集成度上有所区别:
2D封装
物理结构:所有芯片和无源器件均安装在基板平面上,芯片和无源器件与XY平面直接接触。
电气连接:通过基板上的布线和过孔实现电气互连,通常使用键合线将芯片与基板连接。
特点:技术成熟,成本较低,但集成度有限,信号传输距离相对较长,可能导致信号延迟。
2.5D封装
物理结构:芯片堆叠或并排放置在具有TSV的中介层(interposer)上,中介层提供芯片之间的连接性。
电气连接:通过中介层上的微型凸点(micro-bumps)和TSV实现电气互连。
特点:集成度较高,可以提供更高的I/O密度和更低的传输延迟,但相比3D封装,其垂直堆叠的芯片数量较少。
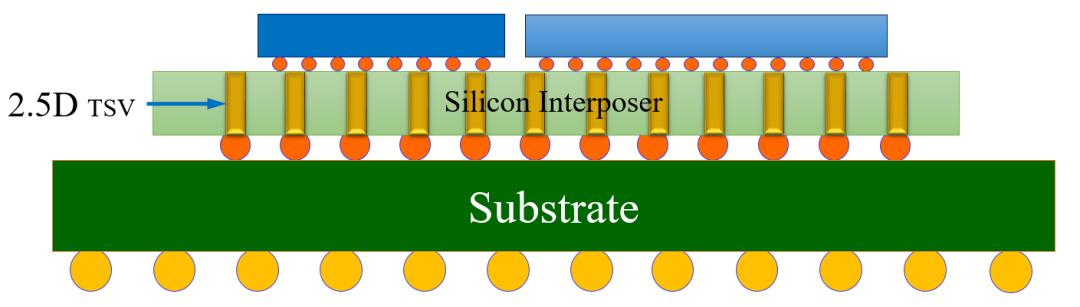
3D封装
物理结构:逻辑裸晶或存储裸晶垂直堆叠在一起,通过TSV实现硅芯片之间的垂直互连。
电气连接:TSV技术实现多层硅晶圆与采用TSV的组件之间的连接。
特点:集成度最高,可以实现高密度的垂直互连,提供更高的带宽和更低的功耗,但技术难度和成本也相对较高。
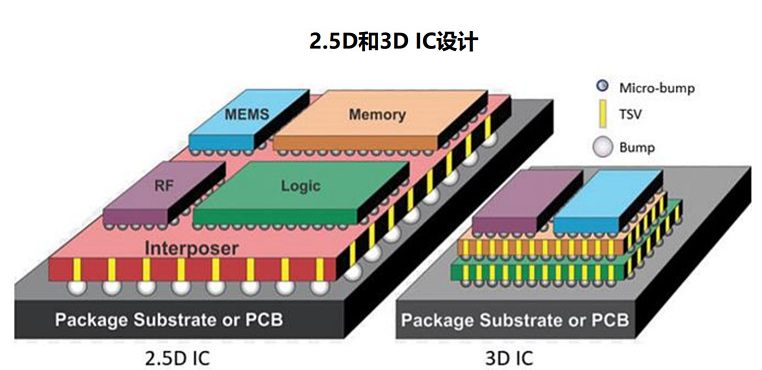
硅通孔(TSV)与2D、2.5D、3D封装的关系
TSV技术是2.5D和3D封装中的关键技术,它允许在芯片内部或芯片之间实现垂直电气连接。
在2.5D封装中,TSV通常用于中介层上,实现芯片与中介层之间的连接。
在3D封装中,TSV直接在芯片上实现多层硅晶圆的垂直互连。
类比分析
如果将2D封装比作平房,那么2.5D封装就像是两层楼房,而3D封装则可以类比为摩天大楼。TSV技术就像是连接不同楼层的电梯,使得数据和电力可以在不同楼层之间快速传输。
2D封装在空间利用和性能上较为有限,类似于平房的居住空间和设施。2.5D封装通过增加中介层,提高了空间利用率和性能,类似于增加了一个楼层的楼房。3D封装则通过多层垂直堆叠,最大化了空间利用和性能,类似于高密度的摩天大楼。
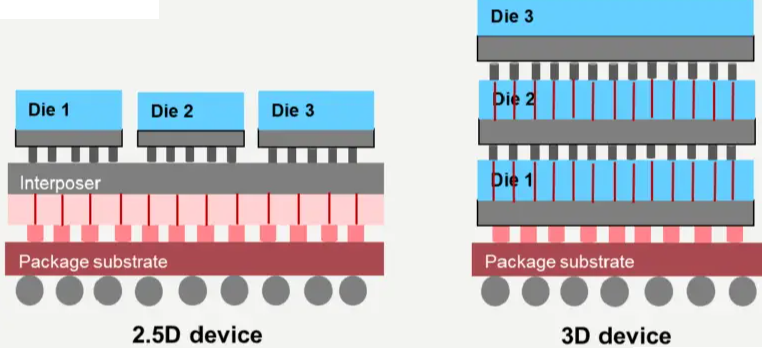























 451
451

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










