第三章、器件
一、超深亚微米工艺条件下MOS 管主要二阶效应:
1、速度饱和效应:主要出现在短沟道NMOS 管,PMOS 速度饱和效应不显著。主要原因是TH G S V V -太大。在沟道电场强度不高时载流子速度正比于电场强度(μξν=)
,即载流子迁移率是常数。但在电场强度很高时载流子的速度将由于散射效应而趋于饱和,不再随电场
强度的增加而线性增加。此时近似表达式为:μξυ=(c ξξ
,出现饱和速度时的漏源电压D SAT V 是一个常数。线性区的电流公式不变,但一旦达到DSAT V ,电流即可饱和,此时DS I 与GS V 成线性关系(不再是低压时的平方关系)。
2、Latch-up 效应:由于单阱工艺的NPNP 结构,可能会出现VDD 到VSS 的短路大电流。
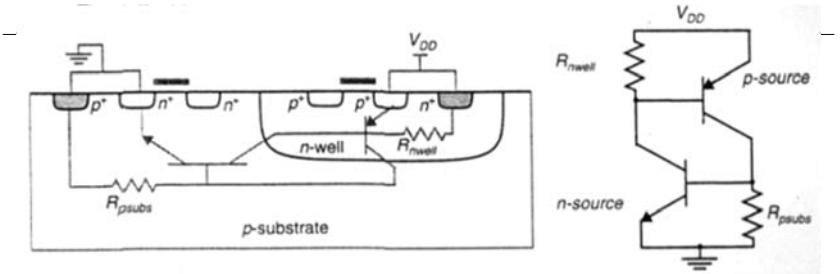
正反馈机制:PNP 微正向导通,射集电流反馈入NPN 的基极,电流放大后又反馈到PNP 的基极,再次放大加剧导通。
克服的方法:1、减少阱/衬底的寄生电阻,从而减少馈入基极的电流,于是削弱了正反馈。
2、保护环。
3、短沟道效应:在沟道较长时,沟道耗尽区主要来自MOS 场效应,而当沟道较短时,漏衬结(反偏)、源衬结的耗尽区将不可忽略,即栅下的一部分区域已被耗尽,只需要一个较小的阈值电压就足以引起强反型。所以短沟时VT 随L 的减小而减小。
此外,提高漏源电压可以得到类似的效应,短沟时VT 随VDS 增加而减小,因为这增加了反偏漏衬结耗尽区的宽度。这一效应被称为漏端感应源端势垒降低。
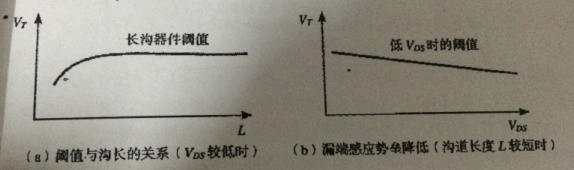




















 972
972











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








