在整个半导体制造过程中,有许多操作需要将晶圆表面平滑或“平面化”。这是因为许多氧化物和铜沉积操作会在晶圆片上产生粗糙的上表面,因此需要平面化,这被称为“topographical variation”。
由于微芯片制造包括一系列堆叠在一起的结构的沉积和图案(称为“planar”过程),因此在沉积后对每一层进行抛光以使其上表面光滑平坦是很重要的。
化学机械抛光(Chemical & Mechanical Polishing, CMP)是半导体器件制造工艺中的一种技术,用来对正在加工中的硅片或其他衬底材料进行平坦化处理。与传统的纯机械或纯化学的抛光方法不同,CMP工艺是通过表面化学作用和机械研磨的技术结合来实现晶圆表面微米/纳米级不同材料的去除,从而达到晶圆表面纳米级平坦化,使下一步的光刻工艺得以进行。CMP在半导体制造过程中被多次使用,是一项关键的工艺技术,没有它就无法生产先进的集成电路。
CMP Technology
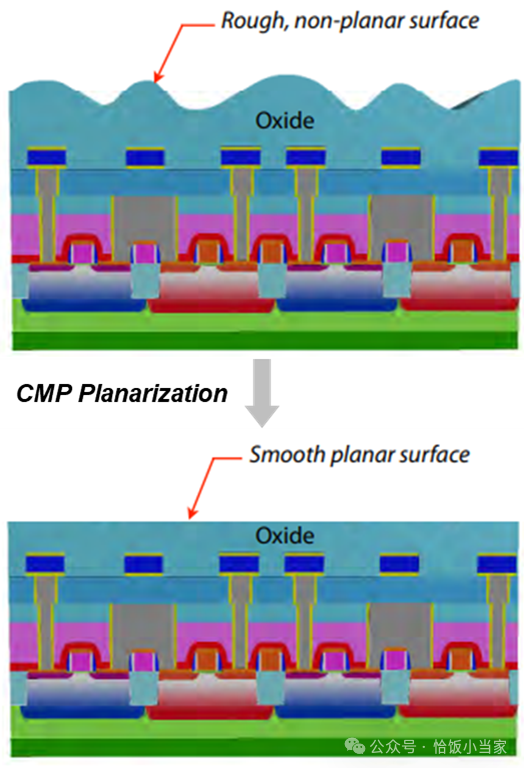
Fig1. CMP Technology
-
CMP的工作原理是在研磨液浆中抛光晶圆片,同时施加一个小的向下的力。
-
晶圆面朝下装入晶圆载体。然后将晶圆载体压在一个称为压板的旋转垫片上。
-
压板和晶圆载体都在旋转,同时被称为研磨液(slurry)的液体磨料被涂抹器分配到压板上。
-
当晶圆片在载体中旋转时,其上表面被缓慢而细致地抛光。这使得晶圆片表面光滑、平坦。
-
抛光后的晶圆片进行冲洗和清洁,以清除所有的浆液。
-
CMP works by polishing the wafer in an abrasive liquid slurry while applying a small downward force.
-
The wafer is loaded into a wafer carrier face-down. The wafer carrier is then pressed against a rotating pad called a platen.
-
Both the platen and the wafer carrier rotate while a liquid abrasive known as a slurry is dispensed onto the platen by a slurry applicator.
-
As the wafer rotates in the carrier its upper surface is slowly and carefully polished. This results in a smooth, flat upper surface on the wafer.
-
After being polished the wafer is rinsed and cleaned to remove all of the slurry.
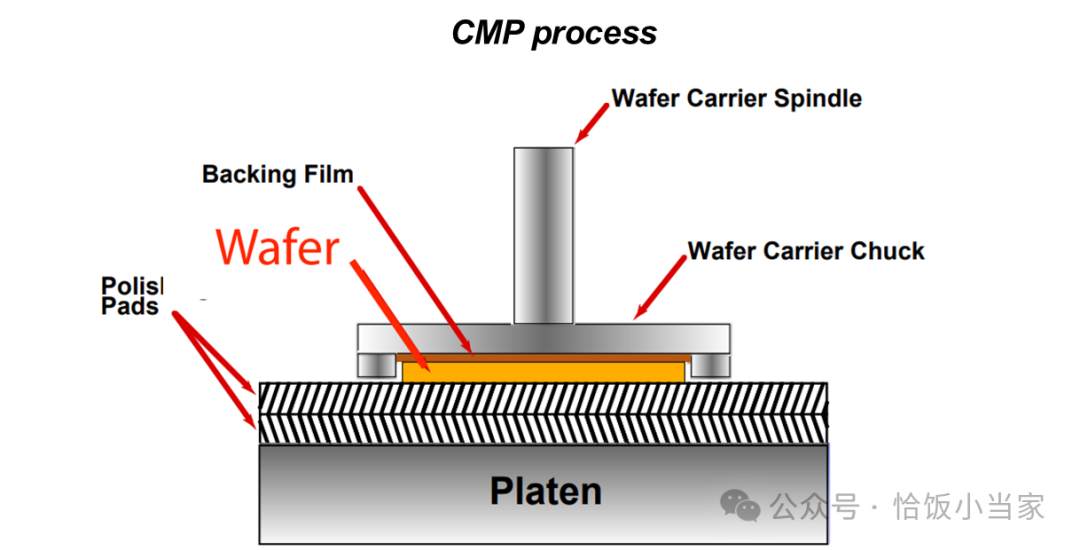
Fig2. 晶圆片面朝下放置在载体中,并压在抛光垫上
CMP系统的核心组成部分:
1. Platen 抛光盘
2. Polishing Pad 抛光垫
3. Wafer Carrier 晶圆/基板/承载wafer
4. Downward Force 施压
5. Slurry Applicator 研磨液装置
6. Slurry Nozzles 喷头
7. Pad Conditioner 修整器
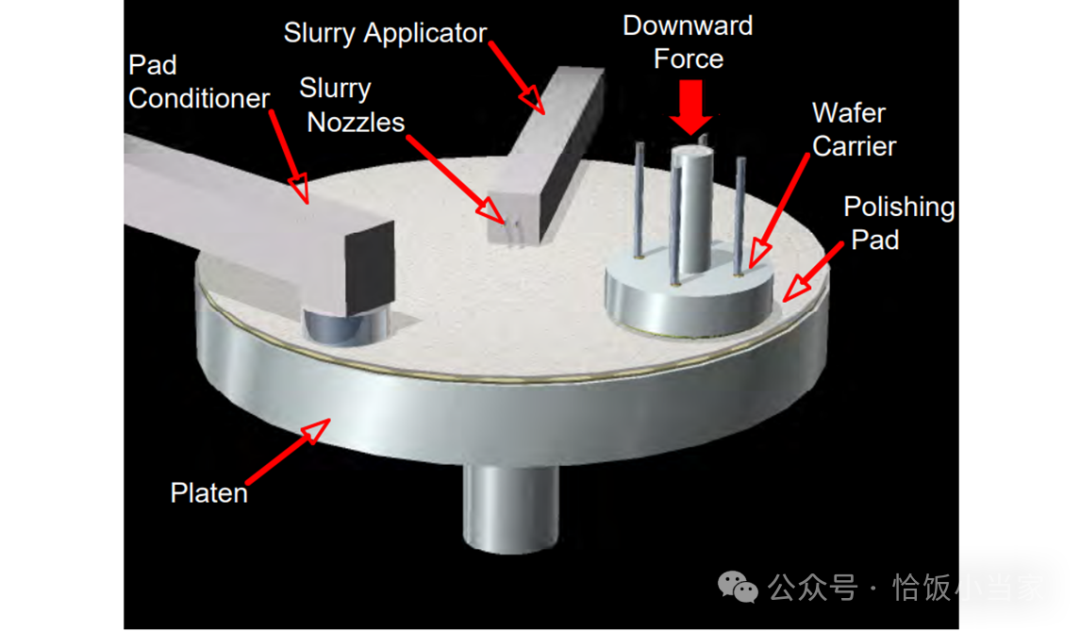
Fig3. CMP系统的核心组成部分
最后,CMP抛光液是由磨料、缓冲液、抛光剂和添加剂等组成的。其中,磨料主要起到去除硅片表面氧化物和金属残留物的作用,缓冲液主要起到调节PH值和维持液体稳定性的作用,抛光剂主要起到润滑和减少表面摩擦的作用,添加剂主要改善CMP抛光液的分散、化学反应性能。


























 8557
8557

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








