

在淀积保护层后,晶圆制作结束,在实现最终的集成电路之前仍需要经历一些制造步骤,首先就是晶圆级测试。在晶圆级测试中,测试人员使用自动化测试设备来测试晶圆上所有芯片的电性能和功能。这种测试是在芯片分离前进行的,因此可以检测到整个晶圆上所有芯片的缺陷,节省了大量的时间和成本。晶圆级测试也可以帮助芯片制造商在芯片分离之前检测硅片上的缺陷,从而提高芯片制造的可靠性和质量。
测试完成后可以利用带有金刚石刀口的锯条沿划片道切割芯片,然后将切好的芯片进行组装。
组装的目的是将芯片转化为实用的器件,使其能够在实际应用中发挥作用。组装分为三个主要步骤:安装、键合和封装。
安装是组装的第一步,在这个过程中,芯片被安装到线框里,线框由矩形的安装基板和引线脚构成。引线通常是由金属材料制成,如铜、银、金等。它们通过焊接、压接或粘合等方法与芯片连接。
键合是组装的第二步,也就是用焊线将露出芯片保护层的通孔位置(焊盘)连接到引线脚上。使用最多的焊线是金线,用于金线键合的最常见的技术是球焊,如下图。
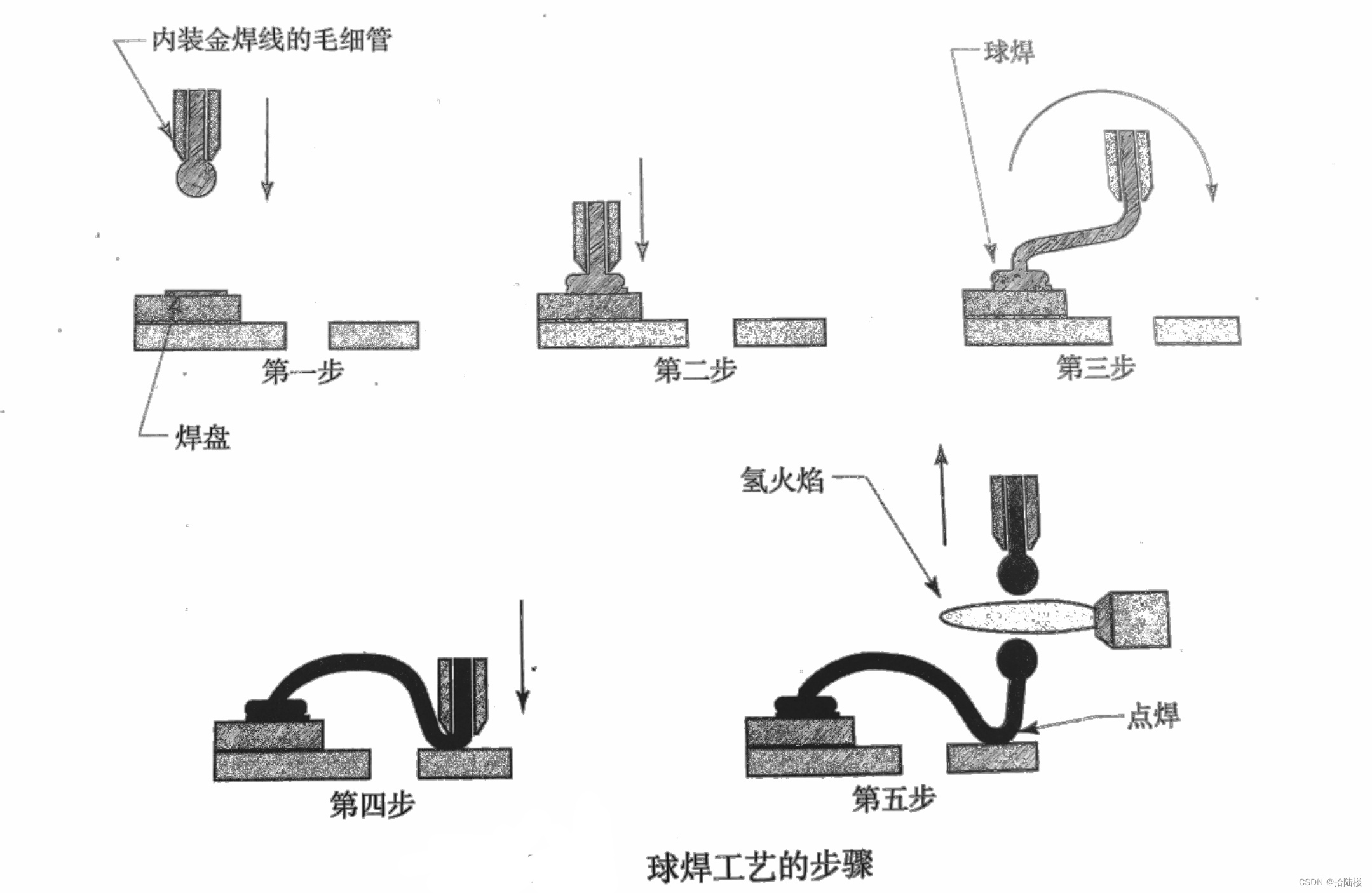
键合机将金线放入毛细管中,用氢火焰将焊线端荣华城一个小金球,然后压在焊盘上形成焊点,然后毛细管移动到旁边引线脚处再次下降将金线打入引线脚中形成焊点,最后毛细管升起氢火焰穿过金线将之熔断。
封装是组装的最后一步,它是将已完成的芯片和引线封装到外壳中的过程。封装的目的是保护芯片和引线免受环境中的损害,例如:湿气、灰尘、腐蚀和机械损伤。
封装可以采用多种材料和形式。最常见的封装材料是塑料和金属。具体的封装形式通常受到器件的性能和应用领域的限制。例如,一些应用需要封装在高温和高压的环境中,这就需要使用能够承受这样的环境的材料和形式。
封装的关键是确保器件内部的稳定性。如果封装不良,例如:封装不严密或者存在漏洞,环境中的气体和湿气将会影响器件内部的稳定性,从而导致电气性能的下降或设备的损坏。


























 4443
4443

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










