以下是我们建议的热风回流焊工艺所采用的温度曲线,可以用作回焊炉温度设定之参考。 该温度曲线可有减少锡膏的垂流性以及锡球的产生,对绝大多数的产品和工艺条件均适 用。(回流焊)
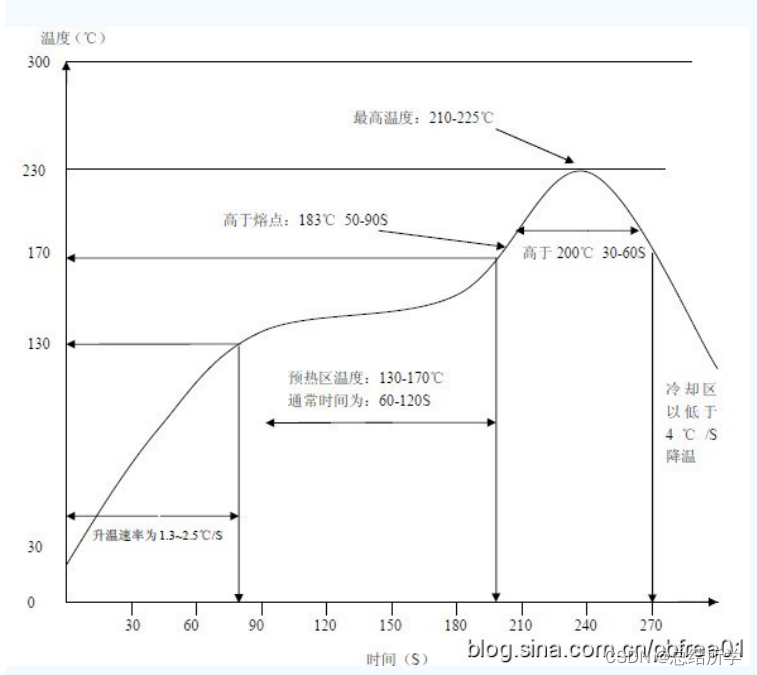

A.预热区 在预热区,焊膏内的部分溶剂被蒸发,并降低对元器件之热冲击;
要求:升温速率为1.5~2.5℃/秒 若升温速度太快,则可能会引起锡膏中焊剂成分恶化,形成锡球、桥连等现象。同时会使元 器 件承受过大的热应力而受损。
B.恒温区(活性区) 在该区焊剂开始活跃,并使 PCB 各部分在到达回流区前润湿均匀。
要求:温 度:140~180℃ 时 间:60~100 秒 升温速度:<2℃/秒
C.回焊区 锡膏中的金属颗粒熔化,在液态表面张力作用下形成焊点。
要求:最高温度:210~225℃(Sn63/Pb37) (高于溶点30~50℃)
时 间:183℃(溶点以上)30~60秒/60~90秒(非热敏感器件)
高于210℃时间为10~20 秒。
若峰值温度过高或回焊时间过长,可能会导致焊点变暗、助焊剂残留物碳化变色、元器件 受损等。
若温度太低或回焊时间太短,则可能会使焊料的润湿性变差而不能形成高品质的焊点,具 有较大热容量的元器件的 焊点甚至会形成虚焊。
D.冷却区 离开回流区后,基板进入冷却区,控制焊点的冷却速度十分重要,焊点强度会随冷却速率 增加而增 加。
要求:降温速率≤4℃
若冷却速率太快,则可能会因承受过大的热应力而造成元器件损伤,焊点有裂纹现象。
若冷却速率太慢,则可能会形成大的晶粒结构,使焊点强度变差或元件移位。
注:
• " 对于 Sn62/Pb36/Ag2合金锡膏的温度曲线与上述相似;
• " 上述温度曲线是指焊点处的实际温度,而非回焊炉的设定加热温度(不同)
• " 上述回焊温度曲线仅供参考,可作为使用者寻找在不同制程应用之最优曲线 的基础。实际温度设定需结合产品性质、元器件分布状况及特点、设备工艺条件等因 素综合考虑,事前不妨多做试验,以确保曲线的最佳化。
• " 对于 SMT 车间要求恒温恒湿车间(23-25摄氏度为宜),最近天气突变影响室 内温度,室内温度低于20摄氏度,同样会影响回流焊 PCB 板实际焊接温度,如天气突 变建议重新再作曲线,温度回升同样要注意调整回来。























 1780
1780

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








