目录
>>DRC设置


>>LOGIC设置&自动备份设置



>>View

>>Netlist导入
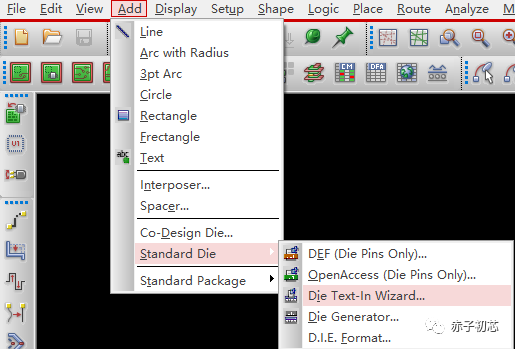
>>删除floorplan

>>Create Wire
-
设置孔是从cu?到cu?
-
设置走线角度,off选任意角度走线,任意角度要修改夹膜问题
-

-
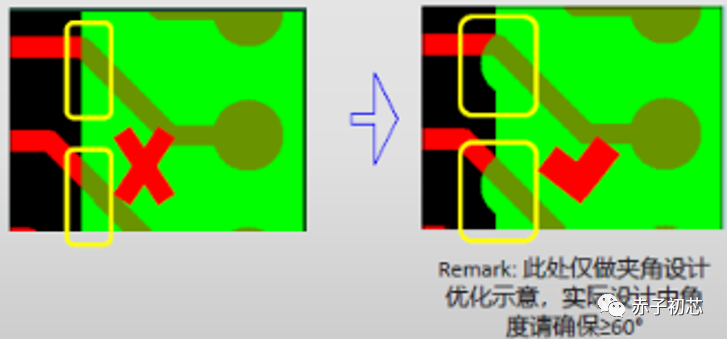
>>设置走线宽度
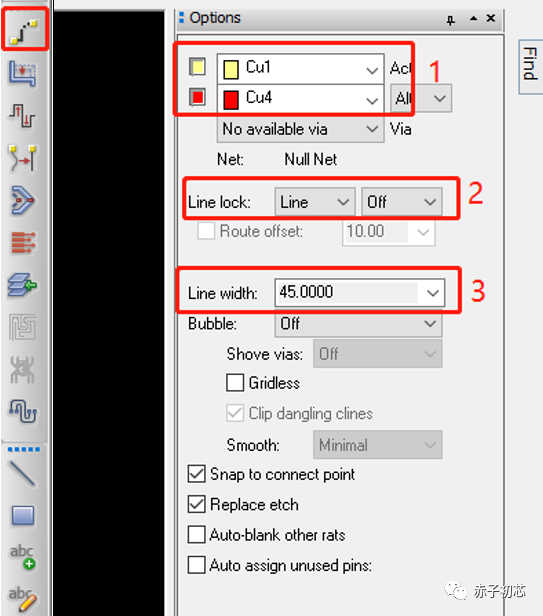
>>Assign Net
方式1:右击asssign
方式2:Logic-Net Logic
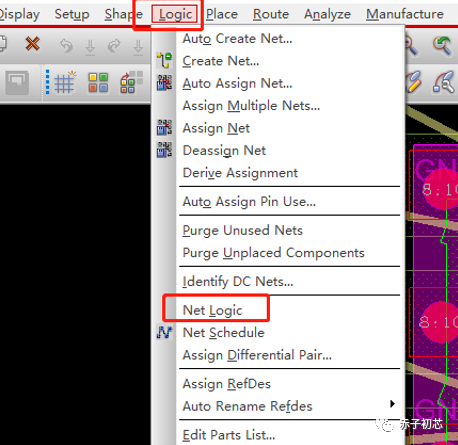
方式3:静态铜皮改成动态铜皮再Assign net

>>产生铜皮
View-Customize Toolbar

>>裁剪铜皮

>>Create VIA
选好起始Cu

按F3画线,选另一层

右击Add Via或双击
<rule>
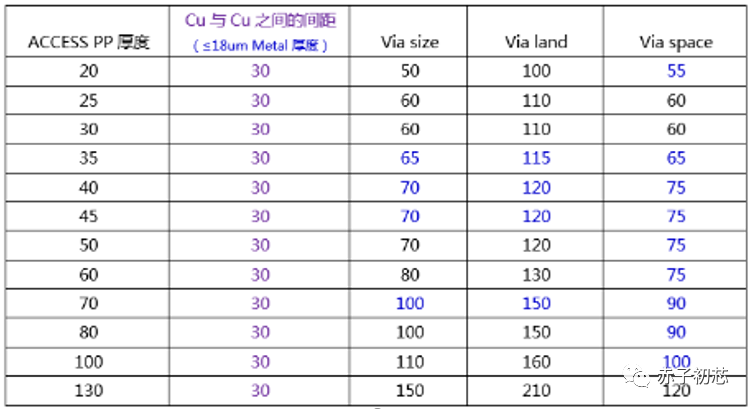
<VIA复制>

<VIA属性>
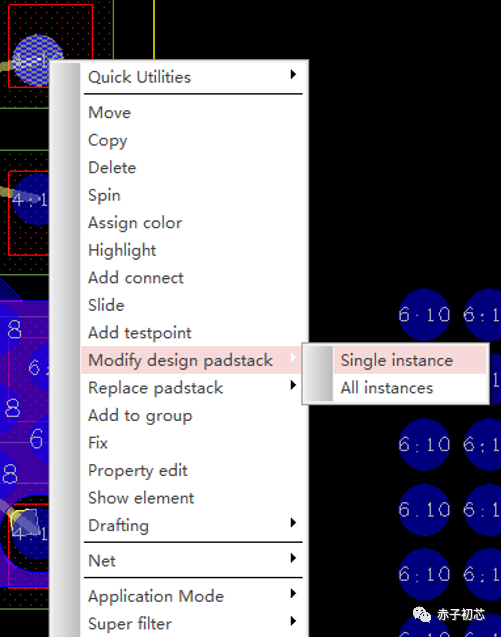
>>Create Bump
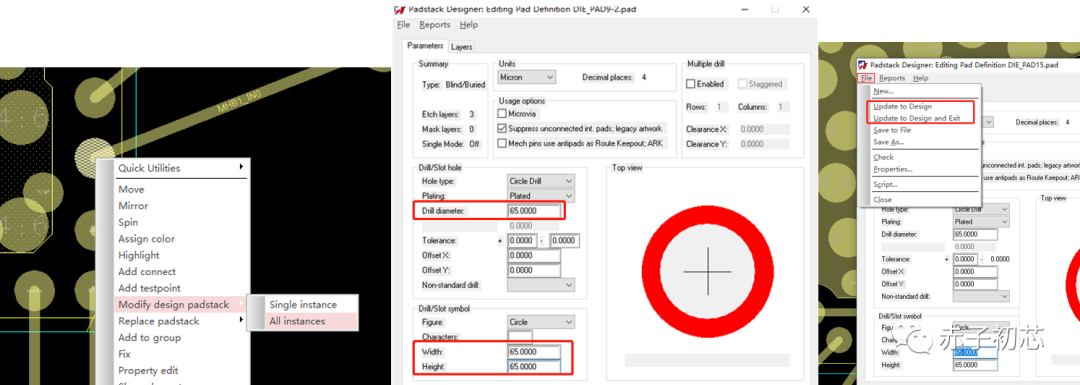
>>去泪目
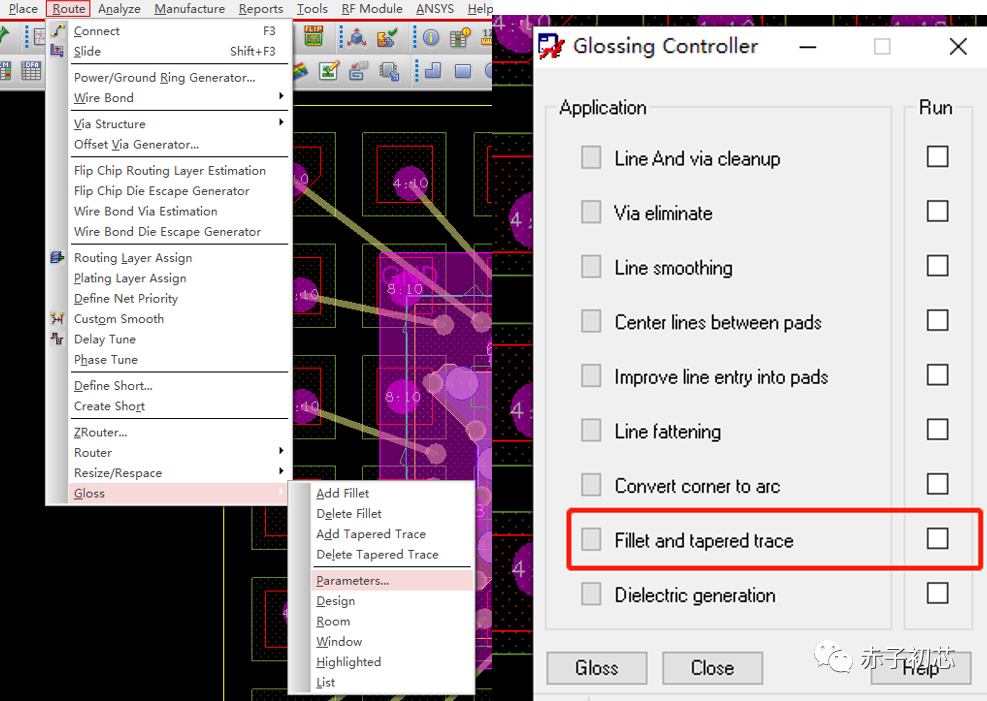
>>快捷键补充
去除上一个走线节点:快捷键F8
居中:快捷键F2:Fit to Zoom
原地复制:Edit-Z-copy
快捷键失效时,删除错误语句即可

>>补充:OSP和ENEPIG
OSP是印刷电路板(PCB)铜箔表面处理的符合RoHS指令要求的一种工艺OSP是Organic Solderability Preservatives的简称,中译为有机保焊膜,又称护铜剂,英文亦称之Preflux。简单地说,OSP就是在洁净的裸铜表面上以化学的方法长出一层有机皮膜。这层膜具有防氧化,耐热冲击,耐湿性,用以保护铜表面于常态环境中不再继续生锈(氧化或硫化等) ,但在后续的焊接高温中,此种保护膜又必须很容易被助焊剂所迅速清除,如此方可使集露出的干净铜表面得以在极短的时间内与熔融焊锡立即结合成为牢固的焊点。
ENEPIG (化镍浸金)技术应用于封装基板表面处理,在化镍浸金工艺过程中,通过对镍层上化学镀把控制、浸金控制,获得精确的沉积厚度和金层均匀性,达到良好的接触面。
化金(化学镀金)不需要通电,是通过溶液内的化学反应把金沉积到板面上。





















 1213
1213











 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








