目录
2.4.1 门极可关断晶闸管
GTO(Gate-Turn-Off Thyristor)是晶闸管的一种派生器件,但可以通过在门极施加负的脉冲电流使其关断,因而属于全控型器件。GTO的电压、电流容量较大,与普通晶闸管接近,因而在兆瓦级以上的大功率场合仍有较多的应用。
1)GTO的结构和工作原理
GTO的结构:
与普通晶闸管的相同点:PNPN四层半导体结构;外部同样引出三个电极。
与普通晶闸管的不同点:GTO是一种多元的功率集成器件。内部包含数十个甚至数百个共阳极的小GTO元,这些GTO元的阴极和门极则在器件内部并联在一起。

b)并联单元结构断面示意图
c)电气图形符号
GTO的工作原理:
Ⅰ、仍然可以用双晶体管模型来分析,、
的共基极电流增益分别是
、
。
是器件临界导通的条件,大于1导通,小于1则关断。
Ⅱ、GTO与普通晶闸管的不同:设计较大,使晶闸管
控制灵敏,易于GTO关断;导通时
更接近1,导通时接近临界饱和,有利门极控制关断,但导通时管压降增大;多元集成结构,使得
基区横向电阻很小,能从门极抽出较大电流。
Ⅲ、而关断时,给门极加负脉冲,即从门极抽出电流,当两个晶体管发射极电流和
的减小使
时,器件退出饱和而关断。
结论:
Ⅰ、GTO的导通过程与普通晶闸管是一样的,只不过导通时饱和程度较浅。
Ⅱ、GTO的关断过程中有强烈正反馈使器件退出饱和而关断。
Ⅲ、GTO的多元集成结构使得其比普通晶闸管开通过程更快,承受di/dt的能力增强。
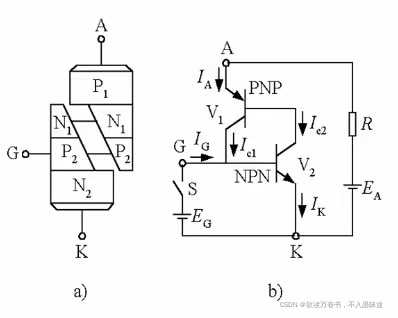
2)GTO的动态特性
开通过程与普通晶闸管类似。
关断过程:
Ⅰ、储存时间(使等效晶体管退出饱和)、下降时间
、尾部时间
(残存载流子复合时间)。通常
比
小得多,而
比
要长。
Ⅱ、门极负脉冲电流幅值越大,前沿越陡,就越短。使门极负脉冲的后沿缓慢衰减,在
阶段仍能保持适当的负电压,则可以缩短尾部时间。

3)GTO的主要参数
GTO的许多参数都和普通晶闸管相应的参数意义相同。
Ⅰ、开通时间:延迟时间
和上升时间
之和。延迟时间一般约1~2
,上升时间则随通态阳极电流的增大而增大。
Ⅱ、关断时间:一般指储存时间和下降时间之和,不包括尾部时间。下降时间一般小于2
。
Ⅲ、最大可关断阳极电流:用来标称GTO额定电流。
Ⅳ、电流关断增益:最大可关断阳极电流与门极负脉冲电流
之比。
一般很小,只有5左右,这是GTO的一个主要缺点。
注意:不少GTO都制造成逆导型,类似于逆导晶闸管(内部反并联二极管,失去承受反向电压的能力),需承受反压时,应和电力二极管串联。
GTO类型:逆阻GTO,可承受反向电压;逆导型GTO,为感性无功分量提供续流通路;非逆阻GTO,不能承受阳极反压。
2.4.2 电力晶体管
电力晶体管(Giant Transistor——GTR)按英文直译为巨型晶体管,是一种耐高电压、大电流的双极结型晶体管(Bipolar Junction Transistor——BJT),英文有时候也称为Power BJT。
应用:20世纪80年代以来,在中、小功率范围内取代晶闸管,但目前又大多被IGBT和电力MOSFET取代。
1)GTR的结构和工作原理
与普通的双极结型晶体管基本原理是一样的。最主要的特性是耐压高、电流大、开关特性好。
GTR的结构:
采用至少由两个晶体管(多元结构,提高通流能力)按达林顿接法组成的单元结构,并采用集成电路工艺将许多这种单元并联而成。
GTR是由三层半导体(N漂移区提高耐压)(分别引出集电极、基极和发射极)形成的两个PN结(集电结和发射结)构成,多采用NPN结构。
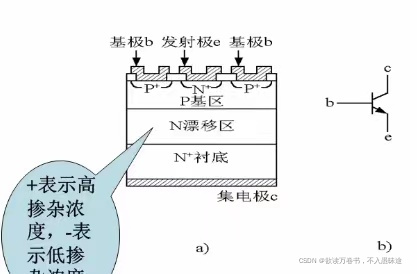
GTR的工作原理:
在应用中,GTR一般采用共发射极接法。集电极电流与基极电流
之比(考虑集电极和发射极间的漏电流)为:
。
称为GTR的电流放大系数,它反映了基极电流对集电极电流的控制能力。
称为穿透电流,
。
单管GTR的值比处理信息用的小功率晶体管小得多,通常为10左右,采用达林顿接法(复合管)可以有效地增大电流增益。

2)GTR的基本特性
静态特性:
在共发射极接法时的典型输出特性分为截止区、放大区和饱和区三个区域。
在电力电子电路中,GTR工作在开关状态,即工作在截止区或饱和区。在开关过程中,即在截止区和饱和区之间过渡时,一般要经过放大区。

动态特性:
开通过程:需要经过延迟时间和上升时间
,二者之和为开通时间
。增大基极驱动电流
的幅值并增大
,可以缩短延迟时间,同时也可以缩短上升时间,从而加快开通过程。
关断过程:需要经过储存时间和下降时间
,二者之和为关断时间
。减小导通时的饱和深度以减小储存的载流子,或者增大基极抽取负电流
的幅值和负偏压,可以缩短储存时间,从而加快关断速度。
GTR的开关时间在几微秒以内,比晶闸管和GTO都短很多。
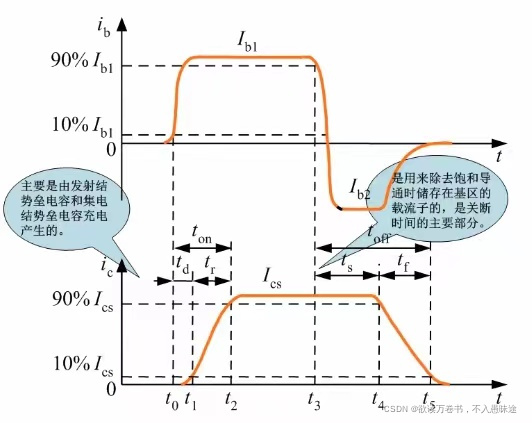
3)GTR的主要参数
电流放大倍数、直流电流增益
、集电极与发射极间漏电流
、集电极和发射极间饱和压降
、开通时间
和关断时间
。
最高工作电压:
GTR上所加的电压超过规定值时,就会发生击穿。击穿电压不仅和晶体管本身的特性有关,还与外电路的接法有关。
发射极开路时(open)集电极和基极间的反向击穿电压;基极开路时集电极和发射极间的击穿电压
;发射极与基极间用电阻(resistance)联接或短路(short)联接时集电极和发射极间的击穿电压
和
;发射极反向偏置(X反向电压)时集电极和发射极间的击穿电压
;且存在以下关系:
。
实际使用GTR时,为了确保安全,最高工作电压要比低得多。
集电极最大允许电流:规定直流电流放大系数
下降到规定的1/2~1/3时所对应的
;实际使用时要留有较大裕量,只能用到的一半或稍多一点。
集电极最大耗散功率:指在最高工作温度下允许的耗散功率。产品说明书中给出
时总是同时给出壳温
,间接表示了最高工作温度。
4)GTR的二次击穿现象与安全工作区
二次击穿现象:
当GTR的集电极电压升高至击穿电压时,集电极电流迅速增大,这种首先出现的击穿是雪崩击穿,被称为一次击穿。出现一次击穿后,GTR一般不会损坏,工作特性也不变。
一次击穿发生时如不有效地限制电流,增大到某个临界点时会突然急剧上升,同时伴随着电压的陡然下降,这种现象称为二次击穿。二次击穿常常立即导致器件的永久损坏,或者工作特性明显衰变,因而对GTR危害极大。
安全工作区(Safe Operating Area——SOA):
将不同基极电流下二次击穿的临界点连接起来,就构成了二次击穿临界线。
GTR工作时不仅不能超过最高电压,集电极最大电流
和最大耗散功率
,也不能超过二次击穿临界线。
可加缓冲电路,使GTR在SOA内工作。

2.4.3 电力场效应晶体管
1)分类和特点
分为结型和绝缘栅型,通常主要指绝缘栅型中的MOS型(Metal Oxide Semiconductor FET),简称电力MOSFET(Power MOSFET)。结型电力场效应晶体管一般称作静电感应晶体管(Static Induction Transistor——SIT)。
电力MOSFET是用栅极电压来控制漏极电流的,它的特点有:
驱动电路简单,需要的驱动功率小(电压驱动型);
开关速度快,工作频率高;
热稳定性优于GTR(单极型器件,一种载流子参与导电,而GTR是双极型器件);
电流容量小,耐压低,多用于功率不超过10kW的电力电子装置。
2)电力MOSFET的结构和工作原理
电力MOSFET的种类
按导电沟道可分为P沟道和N沟道;
耗尽型——当栅极电压为零时漏源极之间就存在导电沟道;
增强型——对于N(P)沟道器件,栅极电压大于(小于)零时才存在导电沟道。
在电力MOSFET中,主要是N沟道增强型。
电力MOSFET的结构
是单极型晶体管。电力MOSFET也是多元集成结构。
结构上与小功率MOS管有较大区别,小功率MOS管是横向导电器件,而目前电力MOSFET大都采用了垂直导电结构,所以又称为VMOSFET(Vertical MOSFET),这大大提高了MOSFET器件的耐压和耐电流能力。
按垂直导电结构的差异,分为利用V型槽实现垂直导电的VVMOSFET(Vertical V-groove MOSFET)和具有垂直导电双扩散MOS结构的VDMOSFET(Vertical Ddouble-diffused MOSFET)。
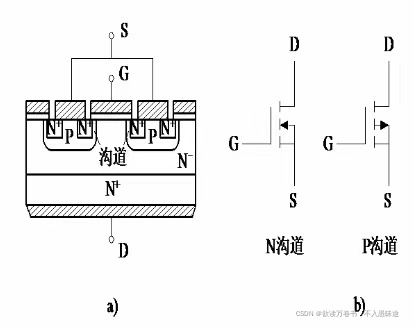
电力MOSFET的工作原理
这里以N沟道增强型为例。
截止:当漏源极间接正电压,栅极和源极间电压为零时——P基区与N漂移区之间形成的PN结反偏,漏源极之间无电流流过。
导通:在栅极和源极之间加一正电压,正电压会将其下面P区中的空穴推开,而将P区中的少子——电子吸引到栅极下面的P区表面,当
大于某一电压值
时,使P型半导体反型成N型半导体,该反型层形成N沟道而使PN结
消失,漏极和源极导电;
称为开启电压(阈值电压),
超过
越多,导电能力越强,漏极电流
越大。
3)电力MOSFET的基本特性
静态特性
转移特性:指漏极电流和栅源间电压
的关系,反映了输入电压和输出电流的关系;
较大时,
与
的关系近似线性,曲线的斜率被定义为MOSFET的跨导
,即
;是电压控制型器件,其输入阻抗极高,输入电流非常小。

输出特性:是MOSFET的漏极伏安特性;截止区(对应于GTR的截止区)、饱和区(对应于GTR的放大区)、非饱和区(对应于GTR的饱和区)三个区域,(对于MOSFET来说)饱和是指漏源电压增加时漏极电流不再增加,非饱和是指漏源电压增加时漏极电流相应增加。
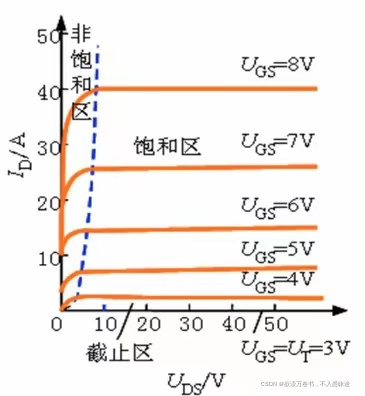
工作在开关状态,即在截止区和非饱和区之间来回切换。
本身结构所致,漏极和源极之间形成了一个于MOSFET反向并联的寄生二极管。
通态电阻具有正温度系数,对器件并联时的均流有利。
动态特性
——脉冲信号源,
——信号源内阻,
——栅极电阻,
——负载电阻,
——检测漏极电流
开通过程:开通延迟时间;(电流)上升时间
;开通时间
:
。
关断过程:关断延迟时间;(电流)下降时间
;关断时间
:
。
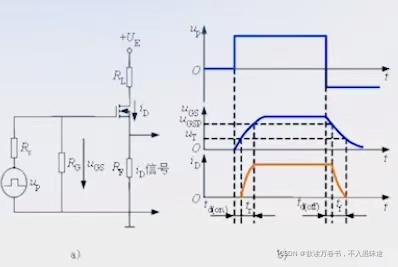
MOSFET的开关速度和其输入电容的充放电有很大关系;可以降低栅极驱动电路的内阻,从而减小栅极回路的充放电时间常数,加快开关速度;不存在少子储存效应,关断过程非常迅速;开关时间在10~100ns之间,工作频率可达100kHz以上,是主要电力电子器件中最高的;场控器件,静态时几乎不需输入电流,但在开关过程中需对输入电容充放电,仍需一定的驱动功率;开关频率越高,所需要的驱动功率越大。
4)电力MOSFET的主要参数
除跨导、开启电压
以及
、
、
和
之外还有:
Ⅰ、漏极电压——电力MOSFET电压定额,所能承受的最高电压,需留有一定的安全裕量
Ⅱ、漏极直流电流(最大值)和漏极脉冲电流幅值
(反映了MOSFET瞬时过载能力)——电力MOSFET电流定额
Ⅲ、栅源电压——其绝对值大于20V将导致绝缘层(很薄)击穿
Ⅳ、极间电容——极间电容、
和
Ⅴ、通态电阻——饱和导通时漏源电压与漏极电流的比值。是影响最大输出电流的重要参数。具有正的温度系数,易于并联使用。有些耐压低的MOSFET通态电阻很小。
一般来说,电力MOSFET不存在二次击穿问题。(安全工作区宽、可靠性高)
2.4.4 绝缘栅双极晶体管
GTR和GTO的特点——双极型,电流驱动,有电导调制效应,通流能力很强,开关速度较低,所需驱动功率大,驱动电路复杂。
MOSFET的优点——单极型,电压驱动,开关速度快,输入阻抗高,热稳定性好,所需驱动功率小而且驱动电路简单。
绝缘栅双极晶体管(Insulated-gate Bipolar Transistor——IGBT或IGT)综合了GTR和MOSFET的优点,因而具有良好的特性。
1986年投入市场,是中小功率电力电子设备的主导器件。
1)IGBT的结构和工作原理
IGBT的结构
是三端器件,具有栅极G、集电极C和发射极E。
由N沟道VDMOSFET与双极型晶体管GTR组合而成的N沟道IGBT;比VDMOSFET多一层注入区,实现对漂移区电导率进行调制,使得IGBT具有很强的通流能力。
简化电路表明,IGBT是用GTR与MOSFET组成的达林顿结构,相当于一个由MOSFET驱动的厚基区PNP晶体管。
IGBT的工作原理
IGBT的驱动原理与电力MOSFET基本相同,是一种场控器件。
其开通和关断是由栅极和发射极间的电压决定的。
导通:当为正且大于开启电压
时,MOSFET内形成沟道,并为晶体管提供基极电流进而使IGBT导通。
关断:当栅极与发射极间施加反向电压或不加信号时,MOSFET内的沟道消失,晶体管的基极电流被切断,使得IGBT关断。
电导调制效应使得电阻减小,这样高耐压的IGBT也具有很小的通态压降。
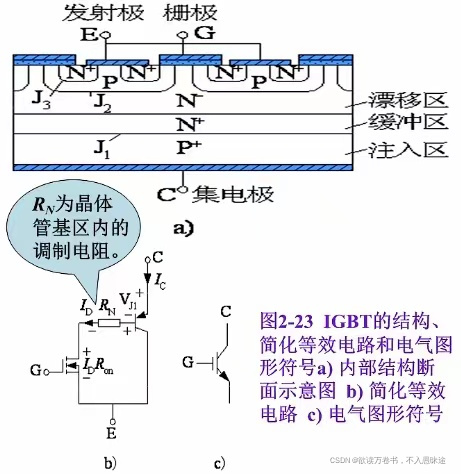
2)IGBT的基本特性
静态特性
转移特性:描述的是集电极电流与栅射电压
之间的关系;开启电压
是IGBT能实现电导调制而导通的最低栅射电压,随温度升高而略有下降。

输出特性(伏安特性):描述的是以栅射电压为参考变量时,集电极电流与集射极间电压
之间的关系;分为三个区域:正向阻断区、有源区和饱和区;当时
,IGBT为反向阻断工作状态;在电力电子电路中,IGBT工作在开关状态,因而是在正向阻断区和饱和区之间来回转换。
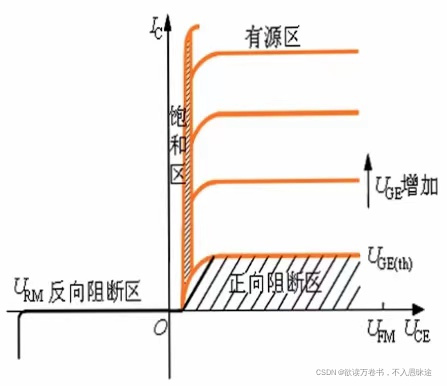
动态特性
开通过程:开通延迟时间;电流上升时间
;电压下降时间
;开通时间
;
分为
(IGBT中MOSFET单独工作的电压下降过程)和
(MOSFET和PNP晶体管同时工作的电压下降过程)两段。
关断过程:关断延迟时间;电压上升时间
;电流下降时间
;关断时间
;
分为
(IGBT器件内部的MOSFET的关断过程,电流下降较快)和
(IGBT内部的PNP晶体管的关断过程,电流下降较慢)两段。
引入了少子储存现象,因而IGBT的开关速度要低于电力MOSFET。
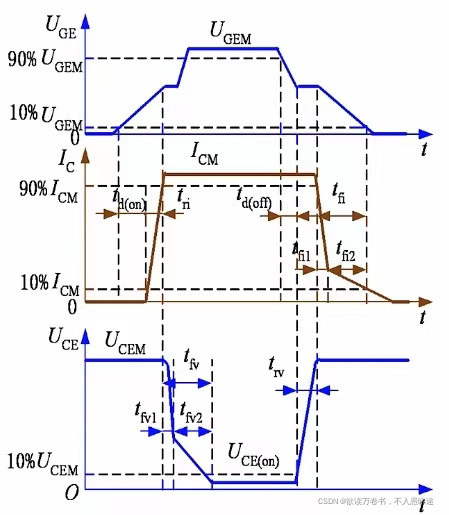
3)IGBT的主要参数
最大集射极间电压:由器件内部的PNP晶体管所能承受的击穿电压所确定的。
最大集电极电流:包括额定直流电流和1ms脉宽最大电流
。
最大集电极功耗:在正常工作温度下允许的最大耗散功率。
IGBT的特性和参数特点可以总结如下:
Ⅰ、开关速度高,开关损耗小。
Ⅱ、在相同电压和电流定额的情况下,IGBT的安全工作区比GTR大,而且具有耐脉冲电流冲击的能力。
Ⅲ、通态压降比VDMOSFET低,特别是在电流较大的区域。
Ⅳ、输入阻抗高,其输入特性与电力MOSFET类似。
Ⅴ、与电力MOSFET和GTR相比,IGBT的耐压和通流能力还可以进一步提高,同时保持开关频率高的特点。
4)IGBT的擎住效应和安全工作区
IGBT的擎住效应
在IGBT内部寄生着一个晶体管和作为主开关器件的
晶体管组成的寄生晶体管。其中NPN晶体管的基极与发射极之间存在体区短路电阻,P形体区的横向空穴电流会在该电阻上产生压降,相当于对
结施加一个正向偏压,一旦
开通,栅极就会失去对集电极电流的控制作用,电流失控,这种现象称为擎住效应或自锁效应。
引发擎住效应的原因,可能是集电极电流过大(静态擎住效应),过大(动态擎住效应),或温度升高。
动态擎住效应比静态擎住效应所允许的集电极电流还要小,因此所允许的最大集电极电流实际上是根据动态擎住效应而确定的。
擎住效应曾限制IGBT电流容量提高,20世纪90年代中后期开始逐渐解决。
IGBT的安全工作区
正向偏置安全工作区(Forward Biased Safe Operating Area——FBSOA):根据最大集电极电流、最大集射极间电压和最大集电极功耗确定。
反向偏置安全工作区(Reverse Biased Safe Operating Area——RBSOA):根据最大集电极电流、最大集射极间电压和最大允许电压上升率。
IGBT往往与反并联的快速二极管封装在一起,制成模块,成为逆导器件。
NPT型IGBT简介
20世纪90年代前期,外延法是生产IGBT(PT型)的主导工艺。
采用同质单晶体硅片和扩散注入式工艺的器件,与PT型IGBT相反,故称非穿通型NPT型IGBT。
NPT型IGBT,通态压降从小电流开始随工作温度升高而变大,构成正温度系数。
NPT型IGBT容易实现并联。
NPT芯片并联已经在牵引机车中应用。

























 4021
4021

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










